一种复合终端逆阻IGBT数值仿真分析
2022-11-16崔磊杨通张如亮马丽李旖晨
崔磊,杨通,张如亮,马丽,李旖晨
(1. 国网智能电网研究院有限公司,北京 102209;2. 西安理工大学 电子工程系,陕西 西安 710048;3. 西安理工大学 应用物理系,陕西 西安 710048)
0 引言
绝缘栅双极型晶体管(insulated gate bipolar transistor,IGBT)以其开关速度快、驱动功率小、自保护能力强、控制精确灵活等优良特性,逐渐成为柔性直流输电和柔性交流系统中电力电子器件的最佳选择。而在矩阵变换器、T型换流器等需要IGBT有反向阻断能力的应用场合,受限于IGBT自身无法提供高的反向阻断电压,通常将IGBT与大功率二极管组合使用,通过引线焊接制成模块。由于该模块引入寄生电感,影响器件的可靠性和各自的性能,且元器件的增多也会导致导通压降变高、成本以及装置体积增加、运行效率降低等不利影响,严重限制了电力电子装置拓扑的发展[1-4]。
为解决这个问题,将续流二极管与IGBT通过工艺方法集成在同一芯片上,形成具有逆向阻断能力的IGBT芯片。逆阻型IGBT(reverse blocking IGBT,RB-IGBT)是在NPT型IGBT的基础上衍生的具有双向耐压能力的集成型功率器件,能够替代IGBT与续流二极管组成的双向开关结构。对比于传统的双向开关结构,RB-IGBT省去了额外的快恢复二极管,不仅使得器件的尺寸、导通压降和开关损耗有效减小,而且节省了元器件的个数,降低了应用成本[5-10]。
目前高压RB-IGBT研究在结构方面的难点主要是终端和隔离结构占用芯片面积过大,导致芯片利用率变小;尤其是采用深硼扩散法制作隔离区导致更大的面积消耗[7-8]。为在不影响终端环耐压的情况下,尽量缩减终端面积,本文采用N-P双环场限环场板(field limiting ring field plate,FLR-FP)复合改进结构,借助TCAD数值仿真工具,设计并比较了典型场限环场板复合结构与改进结构3 300 V RB-IGBT的终端特性差异,给出了优化后的终端环结构参数,分析了改进结构对终端特性影响的工作机理。
1 RB-IGBT器件结构及耐压机理
1.1 RB-IGBT器件结构
RB-IGBT的结构示意如图1 a)所示,在非穿通型IGBT的终端区外围增加了一个采用离子注入形成的深扩散P+隔离区,扩散深度与P+集电极相连,在器件反向阻断时,所形成的深硼扩散区可以看作是将一个二极管与常规IGBT进行串联,由串联在集电极侧的二极管以及P+集电极区与N-drift组成的PN结来实现反向阻断,使得RB-IGBT具有承受反向电压的能力[11-12]。RB-IGBT的等效电路如图1 b)所示,相当于IGBT的集电极正向串联一个二极管,具有双向阻断能力;用于双向开关组件时,元件数量减少一半,如图1 c)所示,一个组件需要2个IGBT和2个FWD共4个开关元件,而用RB-IGBT替代后只需2个开关元件。
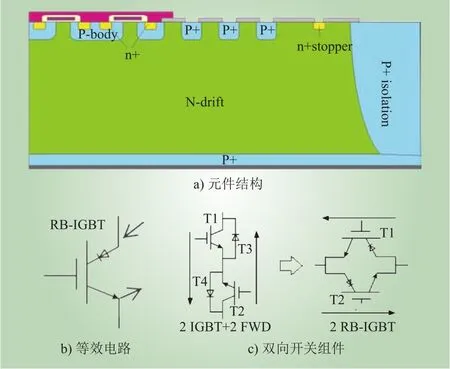
图1 RB-IGBT结构示意图与等效电路Fig. 1 Structure and equivalent circuit of RB-IGBT
1.2 双面耐压机理分析
正向阻断时,集电极相对于发射极正偏,即Uce>0,此时Uge=0,器件MOS沟道关闭,P-well与N-drift区之间形成的J2反偏,此时耗尽层主要向低掺杂一侧的N-drift区扩展[13-18],如图2 a)所示。正向耐压主要由P-well和N-drift区形成的反偏J2来承担。随着Uce不断增加,J2处的电场逐渐增大至临界击穿电场,器件发生雪崩击穿,此时的Uce即为正向阻断电压。RB-IGBT和传统的NPT-IGBT阻断机理相同,其电场分布如图2 b)红线所示,呈三角形分布。此时击穿电压UBV(pp)为
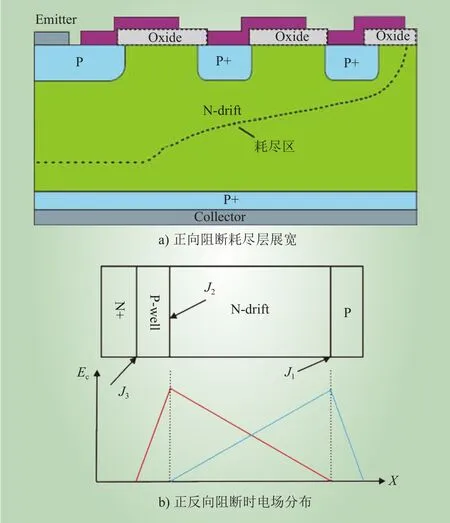
图2 阻断状态时的耗尽层展宽与电场分布Fig. 2 Depleted layer extension and electric field distribution in blocking status

式中:ND为N-drift区的掺杂浓度。耐压大小主要由漂移区决定。
反向阻断时,集电极相对于发射极反偏,即Uce<0,此时Uge=0。常规的IGBT由于存在缓冲层结构,在Uce<0时,主要由集电极与N型缓冲层组成的反偏J1结来承担外加电压,由于缓冲层浓度较高,耗尽层难以扩展至N-drift区,如图3 a)所示,因此常规IGBT反向阻断能力很弱。而RBIGBT采用NPT型结构,并无高掺杂缓冲层,耗尽层主要向低掺杂的N-drift区扩展,如图3 b)所示,此时的反向耐压主要由反偏的J1结来承担,反向阻断时的电场分布与正向电场分布类似。

图3 反向阻断耗尽层分布Fig. 3 Depleted layer profile in reverse blocking
对于常规的IGBT来说,在切割芯片时,由于背面的PN结侧面并没有终端或者隔离区进行保护,切割线会穿过耐高压的PN结,导致边缘处产生晶格损伤,并且产生较大的反向漏电流致使击穿电压大幅度降低,所以常规的IGBT能承受的反向耐压相当小。对于RB-IGBT来说,当集电极相对于发射极反偏时,外加的反向偏压是由背面的P+collector及P+隔离区和N-drift区共同组成的反偏PN结来共同分担,并且P+隔离区能够隔离带有晶格损伤的元胞边缘,减小了漏电流,因此RB-IGBT能够具有稳定的高反向击穿电压。
2 复合终端结构设计与参数研究
结终端技术是功率半导体器件设计制造过程中必须解决的一项关键技术,器件终端结构的设计严重影响着器件的性能和可靠性。随着功率器件的更新换代,终端技术也在不断地改进和发展,已开发的终端结构有场限环、场板、结终端扩展以及横向变掺杂等,这些结构起到将主结耗尽区向外展宽的作用,从而提高击穿电压[19]。
本文器件终端结构模型根据国内现有工艺技术水平,选择了场限环场板(FLR-FP)复合结构,图4给出了本文设计RB-IGBT的终端结构和终端结构参数对终端特性的影响。图4 a)所示的复合终端结构结合了FLR和FP的优点,工艺简单,可靠性高,易实现。由图4 b)看出,当场环掺杂浓度为1×1016cm-3时,耐压为3 083 V,远小于目标值;当掺杂浓度为1×1018cm-3时,耐压为3 400 V,由于掺杂浓度较高,终端环并未完全耗尽,与其他环结的耗尽区重叠,局部电场过大而导致提前击穿,未达到最大耐压;当掺杂浓度为2×1017cm-3时,耐压为3 948 V,掺杂浓度最为理想,场限环全部耗尽,耐压最大。由图4 c)看出,随着场限环环宽的增大,对应的结终端耐压增大,但是存在着一个饱和值;环宽并非越大越好,耐压与结终端尺寸要综合考虑。由图4 d)看出,当环间距为20 μm时耐压接近4 000 V,耐压随环宽的增加呈现先增长后减小的趋势。

图4 本文RB-IGBT结构与环参数对耐压特性的影响Fig. 4 The influence of RB-IGBT structure and ring parameters on blocking characteristics
FLR结构外加偏压较大时,主结处的耗尽层会逐渐扩展至与后面的环结逐一连通,由剩下的环来分摊逐渐增大的电压。若环间距合理,主结处电场可以延伸至其余环结,使得耗尽区展宽,主结处的电场集中现象有所缓解,提高击穿电压。但环间距过小时,会导致后面的环结过早分摊电压,后部分环电场强度大,不利于提高击穿电压;而环间距过大时,如30 μm时,对应的击穿电压急剧下降,此时的电势分布和电场分布如图5所示。可以看出,主结耗尽区还未扩展至后面环结时已经击穿,导致后面的环结并不能有效地替主结分摊耐压,对耐压造成不利影响。因此必须选取合适的环间距才能保证耐压最大。

图5 环间距为30 μm的电势分布和电场分布Fig. 5 Potential and electric field distribution with the termination ring’s gap up to 30 μm
综合以上仿真对比,选取场限环个数为20,对环间距进行拉偏仿真,优化的终端电势分布如图6所示。图6 a)中,正向阻断状态下,电势线在每个环间分布均匀,耗尽区向下向外扩展,说明场环的环间距、环宽等设计合理;图6 b)中,耗尽区向上向内扩展,反向电势分布均匀合理;图6 c)和d)中的电场线在环间均匀分布,每个环承担耐压相当,优化终端后正反向耐压均可达到4 000 V目标值。

图6 终端优化后的3 300 V RB-IGBT电势与电场分布Fig. 6 Potential and electric field distribution of 3 300 V RB-IGBT after terminal optimization
3 双掺杂复合终端结构研究
典型场限环和场板复合结构虽然能增加器件的耐压,但无法突破终端宽度的限制;只增加场限环个数,虽然能使得耐压得到提升,但是会造成芯片面积浪费严重。根据以往经验可知,对于3 300 V耐压等级的IGBT,场限环个数须超过20才能保证耐压需求,既要实现耐压要求、减小终端面积,又要电场分布合理,即尽可能保证主结与环结电场分布持平,因此对场限环结构的仿真优化会导致仿真难度以及耗费时间大大增加。
基于FLR-FP复合终端结构的缺点,考虑在P型环的基础上引入轻掺杂的N型区[20-22],以此减小横向耗尽区的扩展速率,从而节省终端面积。图7给出了改进的终端仿真结构及环参数对终端特性的影响。图7 b)中,结深越浅耐压越大,当结深4 μm时耐压达4 063 V。这是由于N型掺杂区的引入,相当于在纵向引入了缓冲层结构,起到压缩电场、减缓P环横向扩展速率的作用。若结深过大,抑制了耗尽区向外扩展的速率,导致前面的P环处电场峰值变大,因此容易击穿,反而不利于提升击穿电压。图7 c)中,当环宽为10 μm时击穿电压最大。其原因为环宽较大时,N型轻掺杂区一方面起到压缩电场作用,另一方面吸收P-Ring中的多余电荷,导致电场在环宽较宽处截止,后面的环并未起到实际作用,且N-Ring环宽过大也会增加终端面积。图7 d)中,当掺杂浓度为1×1015cm-3时,对应的击穿电压最大。N型轻掺杂区的引入相当于横向加了缓冲层结构,使得P-Ring的耗尽穿透N-drift区到达N型轻掺杂区,因此电场在此处被压缩,能够减小所在环处表面电场峰值、收缩耗尽区横向扩展速率。若N区掺杂浓度过小,对电场的压缩作用有限,因此击穿电压有限;若掺杂浓度较大时,对电场的抑制效果明显,导致电场在该N型掺杂区内截止,后面的环处失效,因此需优化设计。
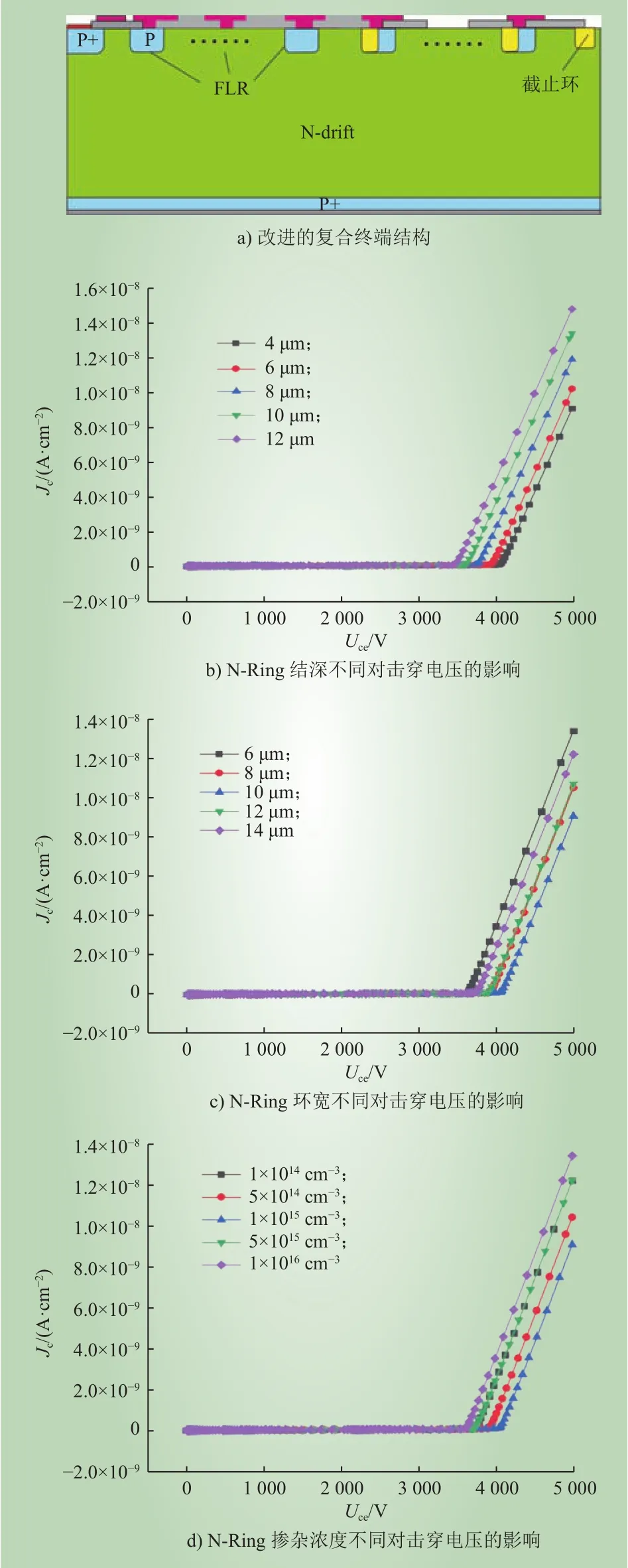
图7 改进的终端仿真结构及环参数对终端特性的影响Fig. 7 The influence of improved terminal structure and ring parameters on terminal characteristics
对N型区参数进行优化,最终得到了耐压为4 000 V的复合终端结构,图8给出了改进复合终端结构RB-IGBT的电场和电势分布情况。由图8可以看出,主结处的电场集中现象有所缓解,且各个环处电场线以及电势线分布均匀,说明环宽、环间距等设置较合理,环结处耐压较为均衡。

图8 N型轻掺杂区为最优时的RB-IGBT的终端特性Fig. 8 Terminal characteristics of RB-IGBT with optimized N region
N型轻掺杂区的引入前后比较表明,在相同的条件下,添加合适的N环结构可有效减小结终端横向扩展效率,缓解所在环的拐角电场;加入N环后只需17个FLR环即可达到耐压目标,终端环尺寸减小了11.5%,有效节省了终端面积,有助于缓解隔离槽面积占用与芯片有效面积之间的矛盾。
4 结语
高压RB-IGBT的主要矛盾是结终端环和隔离结构占用芯片面积过大,导致芯片面积利用率较低。本文先采用典型FLR-FP复合结构,针对3 300 V RB-IGBT进行终端设计,分析了场环参数对耐压的影响,并优化了FLR各项参数,当场环个数为20时,正反向耐压均可以达到4 000 V的预期目标。
高压反偏隔离需要深槽或深结实现,对芯片面积的占用不易减小,因此减少终端环数量是降低终端面积占用的可行措施。文中采用新型双掺杂FLR-FP复合终端改进结构,在P侧引入N型轻掺杂区,可有效减小终端环面积占用。仿真分析表明,与典型FLR-FP复合终端结构比较,改进型结构中N-Ring能够减小耗尽区横向扩展效率,缓解所在环的拐角电场,改善结边缘终端特性;3 300 V器件终端环数由20个缩减为17个,终端尺寸占用减小11.5%,有效地节省了芯片有效面积占用。
