超级结IGBT 击穿特性仿真分析与横向参数优化
2021-05-10关艳霞王卉如
刘 亭,关艳霞,刘 勇,王卉如,邓 杰
(沈阳工业大学信息科学与工程学院,沈阳110870)
1 引 言
IGBT 经历了传统结构到超级结IGBT 结构的演变。传统IGBT 结构具有输入阻抗高、电流处理能力强的优点,但其在导通电阻与阻断电压之间存在矛盾,不利于高压器件体积的缩小[1-4]。超级结IGBT利用交替P 型和N 型漂移区,形成了垂直方向的PN 结。当施加阳极偏压时,栅电极与P、N 漂移区中垂直的PN 结同时形成耗尽层,在x 和y 方向产生了二维的电荷耦合。使y 方向电场从三角形分布变为矩形分布[5],提高了器件厚度的利用率,而且超级结IGBT 中允许对P、N 漂移区使用高掺杂浓度,高掺杂弄浓度会产生一个非常低的导通电阻,这就大大缓解了击穿电压与导通电阻之间的矛盾,有效减小了高压器件的体积,同时也缓解了关断功耗与击穿电压之间的矛盾。但正是因为超级结的存在,使IGBT 的制造工艺变得更加复杂,也使得影响超级结IGBT 击穿电压的因素变的更为复杂。在此对影响超级结IGBT 击穿特性的横向参数进行讨论,通过Silvaco 软件进行仿真,分析超级结IGBT 的P、N 漂移区浓度及宽度变化对击穿电压的影响。
2 器件的结构模型
超级结IGBT 的结构如图1 所示,仿真结构如图2 所示。浓度设计的参数如表1 所示。在此设计中,超级结 IGBT 的 P、N 漂移区长度为 35.5 μm,缓冲层长度为 5 μm,P 型衬底长度为 2 μm,N+区结深为 1μm,P+区结深为 2 μm,宽度为 5 μm。

图1 超级结IGBT 结构示意图

图2 超级结IGBT 仿真图

表1 超级结IGBT 浓度设计参数
3 阻断机理分析
与具有相同设计参数的传统IGBT 相比,超级结IGBT 可以承受更大的阻断电压。两者电学特性比较情况如图3 所示。在图3(a)中可见,传统IGBT的击穿电压为182.324 V;具有相同设计参数的超级结IGBT 的击穿电压则为616.061V,相比之下,比传统结构IGBT 的击穿电压高了433.737 V 之多。
超级结IGBT 的J2结反偏时P、N 漂移区完全耗尽,此时会在P、N 漂移区形成一个横向的电场,与表面MOS 结构还有J3结形成二维电荷耦合[6]。二维电荷耦合的存在改变了P、N 漂移区电场的纵向分布,使P、N 漂移区电场从传统IGBT 的三角形分布变成矩形分布,如图3(b)所示。图中,电场线与坐标轴所围的面积代表器件所能承受的击穿电压,可以观察出矩形面积大于三角形的面积,因此具有相同设计参数的超级结IGBT 的耐压要高于传统结构的IGBT。超级结结构的存在使器件的击穿电压得到了提升,而超级结结构的浓度、宽度都会对超级结IGBT 的击穿电压产生很大的影响。

图3 传统结构与超级结结构IGBT 电学特性比较
4 仿真分析及优化
4.1 掺杂浓度对击穿电压影响仿真
不同P、N 漂移区掺杂浓度下的击穿电压曲线如图4 所示。由图中可见,超级结IGBT 的击穿电压随着P、N 漂移区掺杂浓度的增加而逐渐降低,浓度越高击穿电压随浓度增加而下降的幅度就越大。
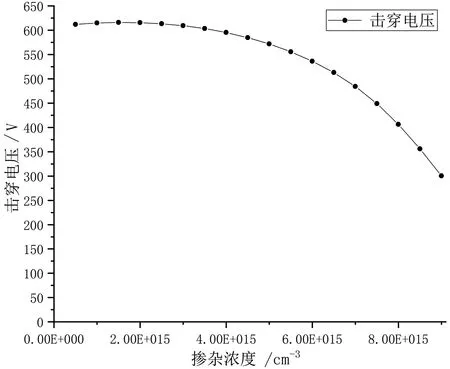
图4 不同P、N 漂移区掺杂浓度的击穿电压
通过对电场分布的仿真可用来分析击穿电压随掺杂浓度的变化情况。在仿真结果中,超级结IGBT 击穿时电场分布如图5 所示。其中图5(a)表示P、N 漂移区掺杂浓度为 1.5×1015cm-3时的电场分布,此时器件内部最高电场出现在A 点附近;图5(b)表示P、N 漂移区掺杂浓度为9×1015cm-3时的电场分布,此时器件内部最高电场出现在J2结附近。仿真结果表明:P、N 漂移区浓度的变化不仅对超级结IGBT 的最大电场强度产生影响,还对最大电场强度发生的位置有影响,此仿真结果与文献[7]结论一致:器件的击穿电压受器件内最高电场强度的影响,在超级结IGBT 的结构中横、纵向最高电场强度随P、N 漂移区掺杂浓度的变化而变化。

图5 超级结IGBT 击穿时电场分布
P、N 漂移区掺杂浓度不同时电场峰值分布曲线如图6 所示。随着P、N 漂移区掺杂浓度的增加,P、N漂移区横、纵向的电场强度均继续增大,但纵向电场强度随P、N 漂移区浓度增加的幅度要小于横向电场增加的幅度。当P、N 漂移区掺杂浓度大于或等于B 点掺杂浓度时,超级结IGBT 首先在J2结发生击穿;而当P、N 漂移区掺杂浓度小于B 点掺杂浓度时,超级结IGBT 首先在A 点附近发生击穿。从器件的损坏机理来看,在J2结处击穿要优于在A 点处击穿,因为J2结的击穿面积大于A 点,雪崩击穿时产生的电流分布更均匀,温度分布更均匀,不会因局部电流集中导致局部温度过高而烧坏器件。在满足器件设计条件的基础上应尽量使P、N 漂移区的掺杂浓度高于B 点处,使雪崩发生在器件内部J2结处,以延长器件使用寿命。但是,J2结空间电荷区的展宽会随着P、N 漂移区浓度的增加而减小,当P、N 漂移区掺杂浓度过高时会出现P、N 漂移区未完全耗尽的情况,反而导致了超级结IGBT 击穿电压的下降。

图6 不同P、N 漂移区掺杂浓度下的电场峰值分布
4.2 超级结横向宽度对击穿电压影响仿真
通过仿真,P、N 漂移区宽度对击穿电压的影响如图7 所示。可见,超级结IGBT 的击穿电压会随着P、N 漂移区宽度增加而略有增加;当P、N 漂移区宽度为3.5 μm 时击穿电压达到最大值622.506 V;当P、N 漂移区宽度继续增大,超级结IGBT 的击穿电压急剧下降。
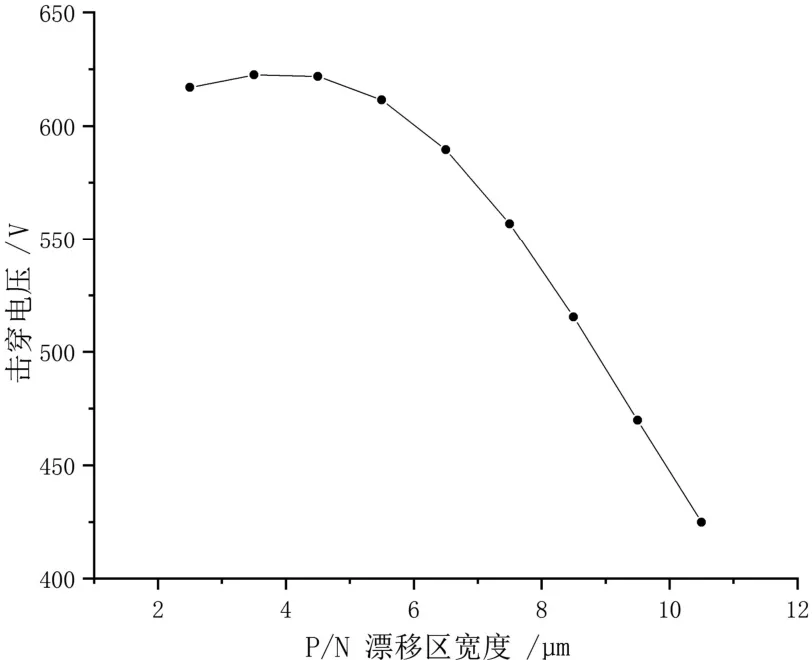
图7 P、N 漂移区宽度对击穿电压的影响
超级结IGBT 中横、纵向电场随P、N 漂移区宽度的变化导致超级结IGBT 内部电势由均匀分布变为不均匀分布,且随着P、N 漂移区宽度增加,阳极侧的电势逐渐减小。超级结IGBT 击穿时电势随P、N 漂移区宽度的变化如图8 所示。超级结IGBT 内横向最大电场强度随P、N 漂移区宽度的增大而增大。不同P、N 漂移区宽度下对应的横向电场分布如图9 所示。由于超级结的电场是典型的二维电场[8],横、纵向电场的变化都会影响超级结内各个位置的电场分布。

图8 击穿时电势随P、N 漂移区宽度变化情况

图9 不同P、N 漂移区宽度下横向电场分布
不同漂移区宽度下超级结IGBT 内部电场分布如图10 所示。当P、N 漂移区宽度较小时,漂移区处于耗尽状态,电场分布相对均匀,此时器件能承受较高的电压。

图10 不同漂移区宽度下电场分布
随着 P、N 漂移区宽度的逐渐增大,在 J2、J3结处电场强度增大,电场分布不均,器件所能承受的耐压开始降低。当P、N 漂移区宽度继续增大时,超级结结构在击穿时还未完全耗尽,将导致器件耐压性能急剧下降。
4.3 横向参数优化
超级结横向参数带来的影响既是独立的,也是相互联系的。P、N 漂移区浓度对击穿电压的影响也与P、N 漂移区宽度有关,不同的宽度要匹配不同的浓度才能使器件既满足设计要求又具有良好的特性。在不同耐压下对超级结IGBT 漂移区浓度、宽度所进行的横向参数优化如图11 所示。超级结IGBT在相同电压下,P、N 漂移区的宽度越窄,对应的优化掺杂浓度就越高。在P、N 漂移区宽度相同时,超级结IGBT 的击穿电压越高,优化掺杂浓度就越低。P、N 漂移区掺杂浓度相同时,超级结IGBT 的击穿电压就越高,优化宽度越窄。

图11 漂移区宽度及掺杂浓度优化图
综合考虑超级结IGBT 横向参数对击穿电压的影响,在超级结IGBT 结构设计时,P、N 漂移区的掺杂浓度和宽度不必完全相同,只要实现超级结二维电荷耦合的电荷平衡,P、N 漂移区的掺杂浓度为最佳掺杂浓度即可,这也为器件的设计提供了更大的选择余地。
5 结 束 语
针对超级结IGBT 的横向电场强度与P、N 漂移区浓度变化的关系,以及击穿电压与P、N 漂移区宽度变化的关系,展开了一系列仿真并对仿真结果进行分析,进而做出设计上的优化。对器件的失效机理也进行了深入探讨。通过仿真研究,能够更加深入了解漂移区参数对超级结IGBT 击穿电压的影响,通过合理改变相应的参数,能够得到一个性能更好的、满足设计要求的器件结构。
