三维集成电路中TTSV的散热性能
2018-11-05崔玉强潘中良
崔玉强 潘中良

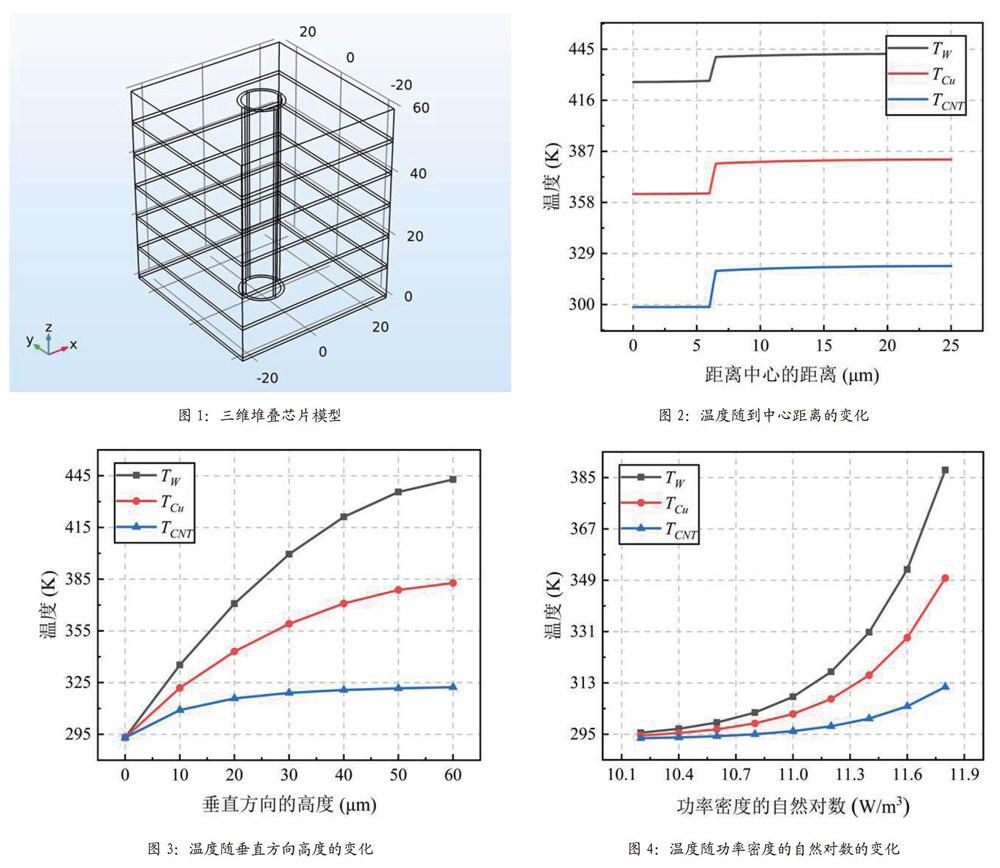

摘要: 三维集成技术取得了突飞猛进的进展,实现了多层堆叠、集成度增加、性能提高以及工艺尺寸降低等成效。然而不可避免的是功耗密度大幅提升,芯片的散热问题上升为限制芯片可靠性的一大因素。热硅通孔(TTSV)在降低芯片温度上具有明显的效果,成为人们关注的焦点。在本文中,我们采用有限元方法,借助COMSOL仿真软件对不同条件下堆叠芯片的散热性能进行了研究,发现用碳纳米管来做硅通孔可以有效地降低芯片的温度,相比其他材料它有着巨大的优势。同时,本文也分析了不同TTSV结构参数对芯片散热的影响,实验得到的数据结果对堆叠芯片的研究具有一定的参考价值。
【关键词】三维集成电路 有限元 热分析 热管理 TTSV 碳纳米管
1 引言
随着三维集成技术的发展,芯片的集成层数逐渐增加,集成电路的集成度越来越高,工艺的尺寸逐渐降低。随之而来的是集成电路的功耗密度逐渐增大,自热问题成为影响芯片总体性能的重要因素之一,逐渐成为人们关注的焦点。在三维堆叠芯片中,热流主要通过垂直方向传输。TTSV具有较高的热导率,有较高的传热能力,不同于传统的传输电信号的硅通孔,是仅用于芯片层间热量传输的硅通孔。TTSV能够迅速将高层的热量传至热沉,并均匀各层的温度。TTSV在降低芯片温度的效果上显著,是解决三维集成电路热点问题的一项关键技术。在本文中我们采用有限元方法,借助COMSOL仿真软件,对TTSV模型的散热性能进行仿真研究,以期望为三维集成电路的热设计提供一定的参考。
2 传热模型
2.1 温度场分布模型
热传导是热传递的三种方式之一,若有温度差存在,热量会从物体的高温部分传向低温部分。傅里叶定律是热传导的基本定律之一,热传导可以由傅里叶定律描述:
其中,k是导热系数,T是绝对温度。根据能量守恒定律,我们可以得到三维热传导方程:
其中,Q是热源,ρ是密度,Cρ是恒定应力下的比热容。边界条件包括三种情况,Dirichlet边界条件,Neumann边界条件和第三边界条件。边界上的温度是位置和时间的函数。在边界Si.处,
T=Ti(x,y,z,t)
确定边界上的最大方向导数。在边界S.处,
确定边界上的温度与其方向导数的线性组合。在边界Si处,
其中a.和b.是常数,是位置和时间的函数。初值条件:
T=T(x,y,z,t0)
2.2 TTSV模型
为了研究三维集成电路模型的温度场,我们将实际中的堆叠芯片进行简化。简化后的三维芯片模型如图1所示。堆叠芯片的每层由两部分组成:Si层(厚9μm)和粘合层(厚lμm)。TTSV由导热芯(直径11 μm)和绝缘材料(厚lμm)组成。芯片模型是长方体结构(50μmx50μmx60μm)。
3 方法
有限元方法将复杂的问题用简单的问题来代替后再求解,可以认为其求解域是由许多小的子域组成,对于每一个子域取一个合适的近似解,再求解这个域的满足条件,从而得到问题的解。所求的解一般是近似解而不是准确解。大多数实际的问题难以得到准确解,然而,有限元不仅计算精度高,而且可以适应各种复杂的形状,是一种行之有效的工程分析手段。本文采用多物理场分析软件COMSOL来实现,其计算方法正是有限元方法。
4 结果和讨论
在本實验中,我们采用钨、铜和碳纳米管作为导热芯材料,研究了不同条件(物理层、热源功率密度、TTSV直径以及绝缘层厚度)下堆叠芯片散热的情况。环境温度以及初始温度设置为293.15K。热源设置在Si层。底面设置为恒定温度293.15K,其他面设置为绝热。材料的热特性参数如表l所示。
在不同材料的导热芯模型中,我们由其上表面的中心沿X方向取不同位置的温度,得到图2。然后沿垂直方向取7个不同高度的平面( Z=Oμm,lOμm,20μm,30μm,40μm,50μm,60μm),得到其峰值温度随高度(层数)的变化如图3所示。接下来,我们取9组功率密度(P=l.26xlO 10W/m3,2.51xlO 1OW/m3,5.01×lO 10W/m31.00Xl0 11 W/m3, 2.00x l0 11W/m3,3.98xl0 11W/m3, 7.94xlO 11W/m3),得到堆叠芯片的温度随热源功率密度的变化。
我们取不同的TTSV直径,从9μm到18μm,步长为lμm,得到温度随TTSV直径的变化,如图5所示。取不同的绝缘层厚度,从0.6μm到3.O μm,步长为0.3 μm,得到温度随绝缘层厚度的变化,如图6所示。
在图2、图3中,热源的功率密度取l0 12 W/m3,图4中的功率密度共有9组,图5、图6中的功率密度为3.16xl0 1lW/m3。
以上的数据结果非常明显,当钨作为TTSV导热芯的填充材料时,芯片的温度最高;铜次之;碳纳米管的散热性能最好,具有良好的导热性,其温度最低。与钨、铜相比,碳纳米管的降温效果非常明显,在芯片降温这方面碳纳米管有着非常显著的优势,反映出碳纳米管材料优越的传热性能。
在实际的TTSV的设计中,可以考虑采用碳纳米管来做TTSV的导热芯,为了进一步降低芯片温度,还应根据不同因素搭配各因素以达到理想的散热性能,从而达到降温目的。
5 总结
本文对多层堆叠芯片结构进行了热分析,并通过改变模型的材料及参数,实现了对多层芯片的仿真。结果表明,用碳纳米管来做硅通孔可以有效地降低芯片的温度,相比其他材料碳纳米管有着巨大的优势。同时,本文也分析了不同结构参数对含TTSV芯片散热的影响。实验得到的数据结果对堆叠芯片的研究具有一定的参考价值。
参考文献
[1]吴际,谢冬青,三维集成技术的现状和发展趋势[J],现代电子技术,2014 (06):104-107.
[2]赵正平,微系统三维集成技术的新发展[J].微纳电子技术,2017,54 (01):1-10.
[3]陈奥博.三维集成中硅通孔互连结构建模[D].电子科技大学,2 016.
[4]CHAO C H,CHEN K C,WU A Y.Routing-based traffic migration and bufferallocation schemes for 3-d network-on-chip systems with thermal limit[J].IEEE Transactions on Very LargeScale Integration (VLSI) Systems,2013, 21 (11): 2118-2131.
[5]刘汉诚.三维电子封装的硅通孔技术[M].化学工业出版社,2014.
[6]王晓鹏,先进三维集成电路(3D-IC)中硅通孔(TSV)和氮化镓(GaN)场效应管中的电-热-力特性研究[D].浙江大学,2011.
[7]战洪仁,张先珍,工程传热学基础[M].中国石化出版社,2014.
[8]杜文雄,唐普英,王舒冰等.基于有限元模型的三维集成电路热分析[J].电子设计工程,2015,23 (10): 79-82.
[9]郭鹏飞,曲艳东.有限元方法[M].东北大学出版社,2 01 5.
[10] RAO S S.The finite element methodin engineering[M].But terworth-heinemann.2017.
