IGBT门氧层老化故障模拟及其对开通特性的影响
2018-10-20张忻庾向大为钟响
张忻庾,向大为,钟响
(同济大学电子与信息工程学院,上海 201804)
0 引言
IGBT(绝缘栅双极型晶体管)是一种全控型电力电子器件,具有驱动简单、开关频率高、容量大等优点。IGBT作为中大功率变换器的核心器件,广泛应用于新能源发电、柔性直流输电、轨道机车牵引、电动汽车驱动以及航空航天等重要领域[1]。然而,由于IGBT通常运行在高电压、大电流以及高频高速开关的恶劣环境下,其封装结构与芯片本体往往会逐渐老化,最终导致IGBT完全失效甚至造成灾难性后果或重大经济损失与严重社会影响。研究IGBT失效机理及其特性可为IGBT健康状态监测与故障预诊断提供依据,相关工作具有重要理论意义与工程价值。
目前,国内外研究的IGBT状态监测与故障预诊断技术可大致归纳为三种方法:基于模型的方法、基于器件参数监测的方法以及基于变流器系统变量检测的方法。基于模型的方法根据器件可靠性模型,利用器件结温变化的历史过程对模块寿命进行预测。通过对器件可靠性模型进行大量研究(如Arrhenius 模型、Coffin-Manson 模型等[2]),并利用典型运行工况对器件设计寿命进行核算,Bryant、Musallam等[3-4]将该技术应用到实际运行的变流器系统中,在运行工况不断变化的条件下进行“在线”寿命预计。文献[5]通过电热仿真研究了系统运行工作点对于发电机PWM谐波以及变流器功率器件结温的影响;基于器件参数监测的预诊断方法对功率器件通态电压Vce(on)、阈值电压Vth、电流变化率di/dt等参数进行监测,一旦参数变化超过一定临界值就表明出现老化或者故障。Brown等[6]将IGBT关断时间作为诊断闩锁失效的故障特征变量,在此基础上提出计及温度影响的IGBT闩锁故障预诊断指标。Oukaoura[7]利用IGBT 通态电压与结温监测数据采用人工神经网络建立器件模型,并通过实验成功识别出故障与健康器件。文献[8]介绍了一种PWM变流器现场双脉冲测试的方法,现场测试利用变频器停机间隙和电容储能对电机绕组放电进行测试,无需额外增加硬件;基于变流器系统变量检测的方法利用现成可测的变流器系统变量(散热器温度、输出电压/电流谐波)对器件运行健康状态进行检测。
如图1所示,IGBT的门氧层是一层实现门极与发射极电气绝缘的二氧化硅薄膜。由于门氧层很薄且击穿电压较低,因此是IGBT芯片中相对薄弱的环节。门氧层老化是一种常见的IGBT芯片类故障,但现有技术对其研究尚不够充分。Patil[9]通过IGBT加速疲劳试验发现门氧层老化会引起阀值电压增加。文献[10]指出,门氧层老化会在电介质中形成导电通路,从而引起IGBT泄漏电流的增加。Chen等[11]通过设计一种新型的智能门极驱动电路,可以实现对IGBT门氧层老化故障的诊断。文献[12]中提出了一种基于FPGA的先进门极驱动器用,通过测量通态门极电压、门极开通电荷等物理量,实现门氧层老化故障的诊断。由于现有技术均需要对变流器的门极驱动进行重新设计与调整,可能会增加系统的复杂性与成本。
为深入理解IGBT 的门氧层老化故障,论文开展了相关研究。首先对IGBT门氧层老化的机理进行讨论;然后分析了IGBT门氧层老化故障对IGBT开通特性的影响;接下来研究IGBT门氧层老化故障的模拟方法;最后,通过实验研究验证IGBT门氧层老化故障对其开通特性的影响。论文工作可为研发IGBT门氧层老化故障预诊断技术提供一定参考。
1 IGBT门氧层老化机理
IGBT门氧层老化的主要机理包括经时击穿(time dependent dielectric breakdown-TDDB)与热载流子注入(hot carrier injection-HCI)。

图1 IGBT结构Fig.1 IGBT structure
1.1 经时击穿(TDDB)
经时击穿(TDDB)是指当施加在MOS栅氧化层上的电场低于其本征击穿场强时,并未引起本征击穿,但经历一定时间后栅氧化层发生了击穿。TDDB是威胁器件和系统的寿命和长期工作可靠性的主要失效机制。当恒定电压施加在IGBT内部MOS栅氧化层,氧化物的持续老化会在其内部产生导电通路,从而使得器件失去控制并击穿短路。这一过程会随着IGBT门极氧化层的厚度减小而急剧恶化。
经时击穿通常分为两个发展阶段[13]。在第一阶段中,全新的IGBT门氧层的陷落电荷密度很低,但直接隧穿电流会在电介质中产生中性缺陷。这些缺陷导致的陷阱辅助隧穿会对门氧层产生两种影响。首先,现有的缺陷会捕获到电荷,其外部特性表现为器件的阈值电压与泄漏电流发生变化;其次,在氧化层内产生新缺陷。因此,IGBT门氧层由于分布在其内部或者表面的捕获空穴或电子而遭到破坏。在第二阶段中,氧化层内的陷落电荷密度逐渐升高,最终在氧化层内形成导电通路将MOS栅极与源极短路,最终导致IGBT的门极失效。
氧化层内产生的导电通路会导致两种不同的失效类型。一旦形成导电通路,其流过的电流会急剧提高损耗,继而产生局部热点。如果IGBT依然继续运行,则结果为软击穿;若门极由于氧化物层局部融化而失效,则为硬击穿。对于软击穿,虽然IGBT阈值电压与泄漏电流的变化幅度不大并且不会严重影响器件运行,但其效果会随时间或者老化个体数目而积累,最终导致器件完全失效[14]。
1.2 热载流子注入(HCI)
热载流子注入(HCI)诱生的MOS器件老化是由于高能量的电子和空穴注入栅氧化层引起的,注入的过程中会产生界面态和氧化层陷落电荷,造成氧化层的损伤。热载流子注入发生概率直接取决于沟道长度、氧化层厚度与器件的运行电压。当流经沟道的漏源电流获得的能量高于晶格温度,就会产生热载流子。对于尺寸很小的器件,即使在不很高的电压下,也可产生很强的电场,从而易于导致出现热载流子。这些热载流子具有足够的能量,从而被射入门氧层,导致电荷陷落与界面态。后者会使IGBT的外部特性(例如阈值电压、跨导与漏电流等)发生变化,并随着损伤程度的增加最终引起器件失效。射入的载流子通常会引起三种主要的损伤形式:先前存在的陷阱捕获到空穴或者电子、形成新的电荷陷阱以及形成界面陷阱[15]。这些陷阱是根据其分布位置确定的,并且其影响不同。界面陷阱位于Si与SiO2的交界面,直接影响到跨导、泄漏电流与噪音水平。氧化层陷阱分布位置离交界面较远,会影响到阈值电压[16]。
2 IGBT门氧层老化对开通特性的影响
2.1 IGBT开通过程分析
如图2 所示的IGBT等效模型,IGBT在结构上可近似等效为基极电流由MOSFET提供的晶体管。其中CGE为输入电容,CGC为米勒电容,CCE为输出电容,均为可变电容。针对IGBT门氧层老化对开通特性的影响,本节重点对米勒电容CGC进行分析。根据IGBT芯片结构,米勒电容是由IGBT的基区耗尽层电容Cdep与MOS氧化层电容COX串联组成,两者由如下公式确定:

其中,A为芯片总面积,αi为氧化层面积交叠比例,tox为氧化层厚度,εox为氧化物介电常数,εsi为硅介电常数,q为元电荷,NB为基区掺杂浓度。可见,Cdep及CGC均与VCE成负关系。
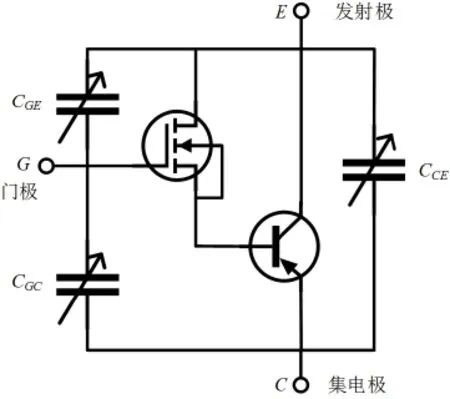
图2 IGBT等效模型Fig.2 IGBT equivalent model
如图3所示,在箝位感性负载条件下典型的IGBT开通过程可分为以下四个阶段。
阶段一(t0<t<t1):在t0时刻,IGBT 门极电容开始充电,门极电压VGE(t)按指数规律上升并在t1时刻到达阈值电压VTH,IGBT门极沟道导通。
阶段二(t1<t<t2): 集电极电流iC(t)开始增大但集射极电压VCE(t)保持不变。在达到负载电流之前,可认为IGBT集电极电流近似线性增大[17]。实际系统中主回路存在杂散电感LS。在集电极电流上升过程中,二极管尚未建压(其通态压降可忽略不计),因此IGBT集射极电压可由VCE'=VDC-LsdiC/dt确定。在t1,时刻,集电极电流到达负载电流IL后,续流二极管的开始反向恢复,集电极电流继续增大。由于IGBT的实际集射极间电压并没有下降,因此内部耗尽层尚未开始收缩,米勒电容依然保持较小值。Vge(t)仍按指数规律上升并超过米勒电压VGP。在t2时刻,二极管反向恢复电流达到最大。
阶段三(t2<t<t3):在t2时刻后,IGBT集电极电流开始下降,续流二极管开始建压,因此IGBT集射极电压开始下降,同时米勒电容迅速增大,门极电流iG(t)为CGE放电,为CCE充电,引起米勒效应。从t2时刻到t2'时刻,门极电压降至米勒电压VGP,门极电流增大,从而导致VCE(t)以极快的速度下降(具体过程如下文(3)~(5)式分析)。在t2'时刻之后,门极电流iG(t)增大到IGP为米勒电容充电,门极电压VCE(t)维持在米勒电压(VGP)。此时,IGBT集射极电压缓慢下降。
阶 段 四(t3<t<t4): 当 IGBT 集 射 极 电 压VCE(t)下降到通态压降后,米勒电容不再变化,米勒效应结束,门极电流iG(t)给输入电容与米勒电容充电。VGE(t)按指数规律上升直到门极供电电压VGE,ON。至此IGBT开通过程结束。
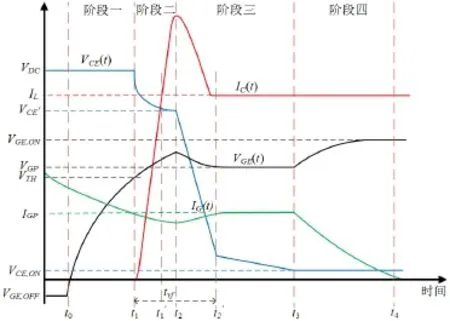
图3 典型的IGBT开通过程(箝位感性负载)Fig.3 Turn-on characteristics of IGBT in a clamped inductive load circuit
根据图2所示的IGBT等效模型,门极电流可根据公式(3)得出:

在第三阶段t2-t2'时刻间,门极电流增大并导致IGBT集射极电压迅速减小。由于此时CGC>>CGE,d VCE(t)/d t>>d VGE(t)/d t, 公 式(3)等号右侧前两项可近似忽略,则集射极电压VCE(t)的变化率为:

在第三阶段t2'-t3中,由于门极电流只给米勒电容充电且门极电压维持在米勒平台不变,则集射极电压VCE(t)的变化率为:

其中米勒电容CGC(vce)可用在第三阶段中的平均值CGC,AVE代替。则第三阶段IGBT集射极电压与时间的关系可以近似线性表示为:

2.2 IGBT门氧层老化对开通特性的影响
论文采用电压下降时间tvf(IGBT集射极电压从90%VDC下降到10%VDC,如图3所示)表征IGBT的开通特性,即近似为t2'-t1。当t1<t< t1,集电极电流由零近似线性增大到负载电流IL,且dIC/dt=(VDCVCE)/Ls。由此可得,tirise= t1'- t1=ILLS/(VDC-VCE),与IGBT的门极特性无关。当t1,<t<t2,此阶段时间tREV取决于续流二极管的特性,与IGBT的门氧层老化故障无关。当t2<t<t2’,此阶段时间和续流二极管的反向恢复与门氧化层老化情况均有关系,在二极管状态不变的前提下,当门氧化层发生故障时,该时间会发生变化。在此阶段,集射极电压VCE从VCE’下降到VCE,ON,由公式(6)可得

综上可得,tvf= tirise+trev+tgp。
如图4所示,当IGBT门氧层发生老化时,氧化层内部形成导电通路,一部分电荷会经其由门极流向发射极,可以等效为在IGBT的门极与发射极间并联一个电阻Rleak,流过的电流即为泄漏电流ileak。在第三阶段时,真正流进IGBT门极的电流IGP从(VGE,ON-VGP)/RG减小到(VGE,ONVGP)/RG-VGP/ Rleak。由公式(7)可知,IGP的降低会增大时间tgp,从而增长电压下降时间tvf,减慢IGBT开通速度从而改变IGBT开通特性。

图4 IGBT门极老化等效电路Fig.4 Equivalent circuit of IGBT gate aging
3 IGBT门氧层老化模拟方法
Patil等[9]通过IGBT加速疲劳试验发现门氧层老化会引起阀值电压增加。文献[10]指出,门氧层老化会在电介质中形成导电通路,从而引起IGBT泄漏电流的增加。因此设法增加IGBT的阈值电压与泄漏电流均可模拟门极氧化层发生老化。但考虑到门氧层老化模拟的便捷性与有效性,采用在IGBT的门极与发射极间并联电阻Rsim,人为产生由IGBT门氧层老化引起的泄漏电流,如图5所示。Rsim电阻值越小,其模拟的门氧层老化情况则越严重。需要注意的是,在进行老化模拟实验时需要根据器件参数设定Rsim的最小值,避免产生的泄漏电流过大导致正常的IGBT失去控制从而引发系统故障。
4 实验研究
为了验证论文理论分析的正确性,搭建了如图6所示的感性负载H桥测试电路。被测IGBT模块为英飞凌公司的FF50R12RT4(1200V/50A),负载电感为8 mH,直流母线电压600 V。采用双脉冲实验,控制被测IGBT开通电流为18 A,被测IGBT的门极与发射极间依次不并联电阻、并联180 Ω电阻和并联112 Ω电阻模拟不同的门氧层老化程度,记录被测IGBT开通的集射极电压、集电极电流与门极电压波形。其中,示波器型号为RIGOL-DS1104示波器,带宽100 MHz、采样率为250 MSa/s 。电流探头为Cybertek CP8030B,带宽50 MHz,精度2%。高压差分电压探头为Cybertek DP6130A,带宽100 MHz,精度为2%。实验波形如图7所示,实验数据见表1。

图6 实验测试平台Fig.6 Experiment test platform
在三组实验结果中,当被测IGBT门极与发射极间无并联电阻时,代表IGBT门氧层尚未发生老化,因此泄漏电流极小,电压上升时间最短;当被测IGBT门极与发射极间并联112 Ω电阻时,代表IGBT门氧层老化程度最严重,因此泄漏电流最大,同时电压上升时间最长。这一实验结果与前文的理论分析结果一致,验证了当IGBT发生门氧层老化故障,其电压上升时间会变长,开通速度减慢,开通特性发生变化。反之,在IGBT工况没有发生变化的情况下,若检测到IGBT电压上升时间变长,则可说明IGBT门氧层发生老化。实验结果可为IGBT门氧层老化故障的预诊断技术提供参考。
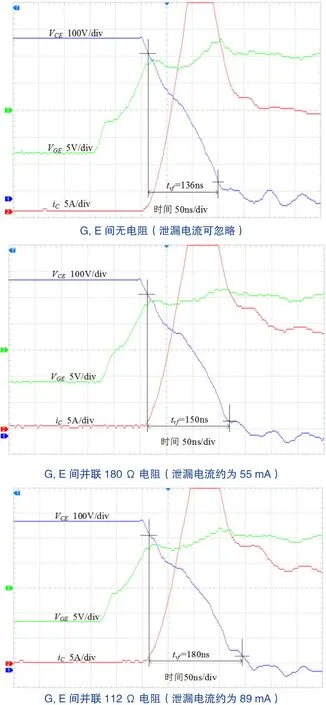
图7 模拟不同门极老化条件下IGBT的开通特性的实验波形Fig.7 Experimental waveforms of IGBT turn-on characteristic under different simulated gate oxide aging degrees

表1 模拟不同门极老化条件下测得的IGBT电压上升时间Table 1 Measured IGBT voltage rising times under different simulated gate oxide aging degrees
5 结论
论文针对IGBT门氧层老化故障,在理解故障机理的基础上,分析了在感性负载条件下,IGBT门氧层老化故障将减慢IGBT的开通速度,对IGBT的开通特性产生影响。根据氧化层老化会改变IGBT外部特性的特点,论文设计了一种IGBT门氧层老化故障的模拟方法。最终,通过实验验证了前文理论分析的正确性。论文工作可为进一步研发IGBT门氧层老化故障的预诊断技术提供参考。
