高In组分InGaNAs/GaAs量子阱的生长及发光特性
2017-11-21周海春郝瑞亭欧全宏云南省光电信息技术重点实验室云南昆明650500云南师范大学物理与电子信息学院云南昆明650500
单 睿, 周海春, 郝瑞亭, 欧全宏, 郭 杰*(1. 云南省光电信息技术重点实验室, 云南 昆明 650500; 2. 云南师范大学 物理与电子信息学院, 云南 昆明 650500)
高In组分InGaNAs/GaAs量子阱的生长及发光特性
单 睿1,2, 周海春1,2, 郝瑞亭1,2, 欧全宏1,2, 郭 杰1,2*
(1. 云南省光电信息技术重点实验室, 云南 昆明 650500; 2. 云南师范大学 物理与电子信息学院, 云南 昆明 650500)
采用分子束外延技术(MBE)在GaAs衬底上外延生长高In组分(>40%)InGaNAs/GaAs量子阱材料,工作波长覆盖1.3~1.55 μm光纤通信波段。利用室温光致发光(PL)光谱研究了N原子并入的生长机制和InGaNAs/GaAs量子阱的生长特性。结果表明:N组分增加会引入大量非辐射复合中心;随着生长温度从480 ℃升高到580 ℃,N摩尔分数从2%迅速下降到0.2%;N并入组分几乎不受In组分和As压的影响,黏附系数接近1;生长温度在410 ℃、Ⅴ/Ⅲ束流比在25左右时,In0.4Ga0.6N0.01As0.99/GaAs量子阱PL发光强度最大,缺陷和位错最少;高生长速率可以获得较短的表面迁移长度和较好的晶体质量。
InGaNAs; 量子阱; 分子束外延; 光致发光光谱
1 引 言
1.3~1.55μm激光器和探测器是光纤通信波分复用中的关键器件,主要有InP基、Si基和GaAs基材料体系。InP基InGaAs(P)材料在光通讯领域应用广泛,并在红外光谱仪、激光、单光子探测等军用和民用方面有巨大的应用价值。但是由于传统的InP基材料的导带差ΔEC很小,俄歇复合大、温度敏感性强烈,限制了其在高特征温度、高效光电器件方面的应用[1-3]。Si基材料主要是采用大应变SiGe作为吸收层,但是在1.3μm以上应变太大,且间接带隙特性导致量子效率较低。对于GaAs基材料,InGaAs/GaAs的大应变将量子阱的工作波长限制在1.2μm以下。微量N元素掺入InGaAs中可以增加张应力,降低导带并明显减小禁带宽度。另一方面,提高In组分可以进一步降低导带。合适的N组分和In组分,可以将工作波长覆盖1.3~1.55μm并与GaAs晶格相匹配。更重要的是,GaAs和InGaNAs形成较大的导带带隙差(470meV),有效阻止电子的热泄漏,在1.3~1.55μm长波长高特征温度激光器、共振腔增强型光电探测器、高效率太阳电池等方面有着很大的应用潜力[4-6]。
虽然InGaNAs材料研究了十几年,但是N、As的原子半径和电负性相差非常大,以及N原子在GaAs中的固溶度较小等原因,导致晶体质量和光学性质下降。此外,长波长响应的高In组分在材料中引入的大应变会产生大量的缺陷[7-8]。这些问题都限制了InGaNAs材料的应用。本文采用分子束外延(MBE)技术生长高In组分InGaNAs/GaAs量子阱材料,研究如何在提高N含量的同时尽可能地提高晶体质量,优化生长条件,分析了影响InGaNAs量子阱晶体质量和光学性质的主要因素。
2 实 验
采用VG-80H MBE 系统在GaAs(001)衬底上制备样品。实验中,采用13.56MHz 射频(RF)产生等离子氮源,在氮源出口处外加一个平行金属板产生的匀强电场消除N离子造成的损伤,让杂质离子不能到达衬底。在GaAs衬底上依次生长GaAs缓冲层、InGaNAs阱层、GaAs过渡层和盖层。缓冲层的厚度为300nm,GaAs缓冲层和盖层的生长温度为580℃,生长时As压保持在1×10-4Pa,Ga的束流在整个生长过程中保持在5×10-6Pa,对应GaAs的生长速度为1μm/h。In的束流为3.5×10-6Pa。在InGaNAs生长之后,410℃左右生长2~3nm的GaAs过渡层,以保证量子阱中的In在随后的升温过程中不会分凝出来。本文中的InGaNAs/GaAs量子阱样品采用高In组分(>40%)和低N组分(<1%)方法生长。
3 结果与讨论
3.1N并入InGaAs的MBE生长
N的掺入可以有效减小InGaAs的禁带宽度,实现长波长的GaAs基量子阱光电器件。但是随着N含量的提高,N相关缺陷会导致量子阱的晶体质量和光学性能下降。为了排除In的干扰,我们对GaAs中掺N进行研究,如图1所示。在Ga1-xNxAs/GaAs量子阱中,当x从1.5%增加到4.5%时,禁带宽度从1.32eV明显减小到1.03eV。同时,N含量增加引起PL峰强度迅速降低,半高宽明显展宽。这说明材料内部缺陷增多引起了非辐射复合中心的增加。内插图是同In组分的InGaNAs和InGaAs多量子阱的XRD图。两个量子阱都观测到清晰的卫星峰。N原子的并入使得量子阱的衍射峰向GaAs峰靠拢,也就是说,N原子的并入减小了整个InGaNAs量子阱层的应变。但是N并入后,衍射峰个数明显减少,卫星峰明显展宽。造成这种现象的主要原因是N组分在量子阱中的分布不均匀。

图1不同N摩尔分数的GaNAs量子阱的PL光谱(插图:相同In组分的InGaNAs和InGaAs量子阱的XRD图)
Fig.1PL spectra of GaNAs QWs with different mole fraction of N(inset: XRD patterns of InGaNAs and InGaAs QWs)
为了精确控制N的微量掺入,需要对N掺入的生长条件进行研究。图2显示了InGaNAs中N组分随生长温度的变化关系。随着生长温度从480℃升高到580℃,N摩尔分数从2%迅速下降到0.2%。低于480℃时,N组分几乎不变。图3显示了N组分随In组分的变化关系,内插图是InGaNAs的PL峰值波长与As/Ga束流比的关系。从图中发现,N原子的并入几乎不受In组分和As压的影响,说明在MBE方法生长InGaNAs量子阱时,N原子的并入行为显然与P和Sb等同族元素不同,反而类似于Be和Si等掺杂元素,其黏附系数近似为1[8]。

图2InGaNAs材料中N摩尔分数随生长温度的变化关系
Fig.2N mole fraction in InGaNAsvs. growth temperature

图3InGaNAs中N摩尔分数随In摩尔分数的变化关系(插图:PL谱峰值波长随As/Ga束流比的变化关系)
Fig.3N mole fractionvs.In mole fraction in InGaNAs (inset: the wavelength of peak at PL spectravs.As/Ga BEP ratio)
值得注意的是,InGaNAs/GaAs量子阱在生长过程中必须面对非故意生长的GaNAs层对InGaNAs的破坏。因为N源快门即使关闭也无法完全阻止从等离子源出射的N原子到达衬底,部分N原子仍然会反射到衬底上形成GaNAs层,容易触发后面InGaNAs量子阱层的3D生长,使得InGaNAs量子阱层材料质量下降。为了避免GaNAs的影响,尽可能将N源的功率降至最小值。此外,将等离子体N源安装在一个真空腔内,通过一个气动阀门来保证在InGaNAs阱层生长前不会有N原子逃逸出来到达衬底,也保证了GaAs过渡层和垒层的质量[9]。图4是采用真空腔和未采用真空腔生长InGaNAs量子阱的PL谱。通过采用N真空腔,InGaNAs量子阱的PL谱峰值强度增加一倍,FWHM也更窄。

图4采用/未采用N真空腔生长的InGaNAs量子阱的PL谱
Fig.4PL spectra of InGaNAs QW with/without N vacuum
3.21.3μm InGaNAs/GaAs量子阱的PL谱
要获得工作波长大于1.3μm的晶格匹配InGaNAs/GaAs量子阱材料,可以采用较小的In组分(10%)和较大的N组分(>3%),或者采用较大的In组分(>35%)和较小的N组分(~1%)。前一种方法的优点是减小应变增加有源层厚度,但是如前面讨论,N组分的轻微增加会使材料质量急剧降低。因此,采用高In组分和低N组分的InGaNAs/GaAs量子阱是实现长波长光电器件的优化选择。本文以波长在1.3μm的In0.4Ga0.6-N0.01As0.99/GaAs量子阱的生长为例,在不同生长条件下测量样品的PL谱并分析。
图5是发光波长为1.3μm 的InGaNAs量子阱在不同生长温度下的PL谱。根据图2结果,N组分变化的临界生长温度为480℃,实验选择430℃以下的生长温度。由图5可以看到,在生长温度为410℃时的InGaNAs量子阱室温PL谱峰值强度最大。当生长温度为400℃或420℃时,样品的峰值迅速下降,FWHM相对稳定;当温度升高到430℃时,样品的峰值强度继续下降,且FWHM随温度的升高而逐渐加宽。当生长温度低于410℃时,缺陷和位错是影响InGaNAs量子阱材料的主要因素[10],降低了量子阱的发光质量。在忽略其他因素的影响下,将生长温度控制在410℃左右是保证InGaNAs/GaAs量子阱材料质量的最佳生长条件。

图5不同生长温度下生长的的InGaNAs量子阱的PL谱
Fig.5PL spectra of InGaNAs QWs grown at different temperature
图6是在410℃生长温度下,生长速度分别为0.5ML/s和1ML/s 的InGaNAs/GaAs(相同N组分)的量子阱室温PL谱。高速生长的InGaNAs/GaAs量子阱的PL谱峰值强度是低速生长量子阱PL谱峰值强度的2倍,而FWHM由66nm下降到57nm。造成这种现象的原因可能是高速生长缩短了In、N原子在生长表面的平均驻留时间,降低了原子的表面迁移长度,抑制了原子聚集到一起形成3D岛状生长,促进二维生长[11],同时抑制了In和N原子的分凝现象的发生,从而提高了InGaNAs/GaAs量子阱的材料质量。

图6 不同生长速率下的InGaNAs量子阱PL谱
Fig.6PL spectra of InGaNAs QW at different growth rates
图7是不同生长速率的InGaNAs量子阱PL谱峰值强度随Ⅴ/Ⅲ束流比的变化关系,衬底生长温度为410℃。随着Ⅴ/Ⅲ比由10增加到40,PL强度先增大后减小。当Ⅴ/Ⅲ比为25左右时,PL谱峰值强度达到最大。由于前面已经讨论过InGaNAs中的N组分不受Ⅴ/Ⅲ比的影响,因此可以不必考虑N组分的变化对材料质量的影响。那么,当Ⅴ/Ⅲ比小于25时,提高Ⅴ/Ⅲ比可以减小Ⅲ族原子在表面的迁移长度,抑制材料3D生长,从而提高材料的质量[12]。但是,过分地提高Ⅴ/Ⅲ比会使得Ⅲ族原子在表面的迁移长度过低而产生Ⅲ族原子积聚成团,甚至使As原子在表面积聚成团造成材料质量下降[12]。所以当Ⅴ/Ⅲ比高于25时,量子阱PL谱的峰值强度会下降。综上所述,过低和过高的Ⅴ/Ⅲ比都会造成材料质量的下降。
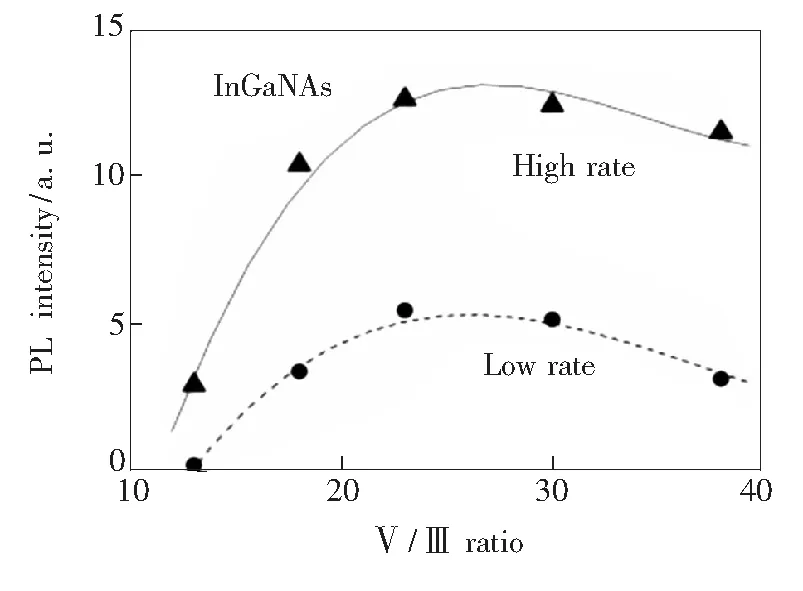
图7 不同Ⅴ/Ⅲ束流比下生长的InGaNAs QW的PL谱
Fig.7PL spectra of InGaNAs QWs grown under different Ⅴ/Ⅲ BEP ratio
3.31.55μm InGaNAs/GaAs量子阱
对于激光器的有源区而言,InGaNAs/GaAs单量子阱材料即可满足器件要求;但是对于探测器而言,需要足够厚的吸收区来提高响应率,需要生长多量子阱。图8是5个InGaNAs/GaAs量子阱的PL谱,其中In的摩尔分数达到42.5%。PL峰值波长为1.52μm,50%截止波长超过1.55μm,FWHM为60meV。尽管较宽的FWHM说明样品出现一定的弛豫,但PL截止波长和较高的发光强度为1.55μm长波长InGaNAs/GaAs量子阱光电探测器的制备奠定了基础。

图8 1.55 μm InGaNAs多量子阱的PL谱
Fig.8PL spectra of InGaNAs multi-QWs for1.55μm wavelength
4 结 论
微量N掺入InGaNAs是重要的1.3~1.55μm光电器件。合适的In、N组分可以获得应变小、缺陷少的长波长量子阱材料。InGaNAs/GaAs量子阱的MBE生长受N并入、生长温度、生长速度和Ⅴ/Ⅲ比的影响。本文通过研究MBE生长参数对PL谱的影响,获得了工作波长在1.3~1.55μm的InGaNAs/GaAs量子阱材料。并获得N原子并入InGaAs生长机制:N组分增加会引入大量非辐射复合中心,随生长温度从480℃升高到580℃,N组分从2%迅速下降到0.2%;N原子的组分几乎不受In组分和As压的影响,与其他V族P、Sb不同,N的黏附系数接近1。优化生长条件生长温度在410℃,Ⅴ/Ⅲ束流比在25左右时,In0.4Ga0.6N0.01As0.99/GaAs量子阱PL发光强度最大,缺陷和位错最少;高生长速度可以获得较短的表面迁移长度和较好的晶体质量。这些研究结果为研制长波长InGaNAs/GaAs量子阱的光电器件提供了材料生长基础。
[1] 安宁, 韩兴伟, 刘承志, 等. 2 μm InGaAsSb/AlGaAsSb双波导半导体激光器的结构设计 [J]. 光子学报, 2016, 45(9):0914001.
AN N, HAN X W, LIU C Z,etal.. Simulation analysis of 2 μm InGaAsSb/AlGaAsSb laser diode with dual waveguide [J].ActaPhoton.Sinica, 2016, 45(9):0914001. (in Chinese)
[2] 郑新和, 夏宇, 刘三姐, 等. GaNAs基超晶格太阳电池的分子束外延生长与器件特性 [J]. 发光学报, 2015, 36 (8):923-926.
ZHENG X H, XIA Y, LIU S J,etal.. MBE growth of GaNAs-based superlattice solar cells and device properties [J].Chin.J.Lumin., 2015, 36(8):923-926. (in Chinese)
[3] 胡伟, 曾庆高, 叶嗣荣, 等. GaAs/AlxGa1-xAs多量子阱外延结构及其LP-MOCVD生长工艺研究 [J]. 光子学报, 2017, 46(3):0325001.
HU W, ZENG Q G, YE S R,etal.. Epitaxial structure of multiple quantum well and its LP-MOCVD growth for GaAs/AlxGa1-xAs [J].ActaPhoton.Sinica, 2017, 46(3):0325001. (in Chinese)
[4] 高雁, 刘洪波, 王丽, 等. 实用型三谱段太阳模拟器的设计与研制 [J]. 中国光学, 2015, 8(6):1004-1006.
GAO Y, LIU H B, WANG L,etal.. Design and manufacture of a practical triple spectrum solar simulator [J].Chin.Opt., 2015, 8(6):1004-1006. (in Chinese)
[5] OKSAL K, AHIN M S. The effect of dilute nitrogen on nonlinear optical properties of the InGaAsN/GaAs single quantum wells [J].Eur.Phys.J. B, 2012, 85:333-336.
[6] 李臻, 雒超, 路腾腾, 等. 并行雪崩光电二极管阵列红外单光子探测系统 [J]. 光学 精密工程, 2016, 24(10):6-9.
LI Z, LUO C, LU T,etal.. Infrared single photon detection system based on parallel avalanche photodiode array [J].Opt.PrecisionEng., 2016, 24(10):6-9. (in Chinese)
[7] LI J L, ZHANG S G, GAO F L,etal.. The temperature dependence of atomic incorporation characteristics in growing GaInNAs films [J].J.Appl.Phys., 2015, 117(5):78-80.
[8] WU T H, SU Y K, CHUANG R W,etal.. 1-eV InGaAsN/GaAs quantum well structure for high efficiency solar application grown by MOVPE [J].J.Cryst.Growth, 2013, 370:236-239.
[9] ARKAD M, GRZE S, KRZYSZTOF R,etal.. Oscillator strength of optical transitions in InGaAsN/GaAsN/GaAs quantum wells [J].Opt.Appl., 2013, 43(1):53-60.
[10] DONMEZ O, SARCAN F, LISESIVDIN S,etal.. Analytic modeling of temperature dependence of 2D carrier mobility in asgrown and annealed GaInNAs/GaAs quantum well structures [J].Semicond.Sci.Technol., 2014, 29(12):125009.
[11] XU L F, DINESH P, CARMEN S,etal.. Carrier recombination dynamics investigations of strain compensated InGaAsN quantum wells [J].IEEEPhoton.J., 2012, 4(6):2382-2389 .
[12] KHALIL M, MAZZUCATO S, ARDALI S,etal.. Temperature and magnetic field effect on oscillations observed in GaInNAs/GaAs multiple quantum wells structures [J].Mater.Sci.Eng. B, 2012, 177(10):729-733.

单睿(1991-),男,云南曲靖人,硕士研究生,2013年于楚雄师范学院获得学士学位,主要从事半导体光电材料与器件的研究。

E-mail: 1983725283@qq.com郭杰(1979-),男,河南安阳人,博士,副教授,2010年于西北工业大学获得博士学位,主要从事新型光电材料与器件的研究。
E-mail: jieggg1020@sina.com
GrowthandPhotoluminescenceCharacteristicsofInGaNAs/GaAsQWwithHighInComposition
SHANRui1,2,ZHOUHai-chun1,2,HAORui-ting1,2,OUQuan-hong1,2,GUOJie1,2*
(1.YunnanKeyLaboratoryforOpti-electronicInformationTechnology,Kunming650500,China;2.CollegeofPhysicsandElectronic,YunnanNormalUniversity,Kunming650500,China)
*CorrespondingAuthor,E-mail:jieggg1020@sina.com
InGaNAs/GaAs quantum-well (QW) with high In composition (>40%) which covered the optical fiber communication wavelength range of1.3-1.55μm was grown on GaAs substrate by molecular beam epitaxy (MBE). The characteristics of N atom incorporation and growth properties for InGaNAs/GaAs QW were studied by photo luminescence (PL) spectra at room temperature. The results show that the increasing of N composition can result in a large number of non-radiative recombination centers. The mole fraction of N decreases sharply from2% to0.2% with the growth temperature increasing from480℃ to580℃. The change of In composition and As pressure cannot influence the incorporation of N atoms and the adhesion coefficient of N is about1. The PL intensity at1.3μm for InGaNAs/GaAs QW is strongest at the growth temperature of410℃ and Ⅴ/Ⅲ ratio of ~25. Higher growth rate can obtain shorter surface migration length and improve the crystal quality.
InGaNAs; quantum well; molecular beam epitaxy; photoluminescence
1000-7032(2017)11-1510-06
TN21
A
10.3788/fgxb20173811.1510
2017-04-13;
2017-09-07
国家自然科学基金(61274137,11304274); 云南省教育厅基金(2014Z043)资助项目
Supported by National Natural Science Foundation of China(61274137,11304274); Department of Education Fund of Yunnan Province(2014Z043)
