石墨烯射频器件研究进展∗
2017-11-10卢琪吕宏鸣伍晓明吴华强钱鹤
卢琪 吕宏鸣 伍晓明 吴华强 钱鹤
1)(清华大学微电子所,北京 100084)
2)(莱斯大学,得克萨斯州休斯敦市 77005)
3)(清华信息科学与技术国家实验室,北京 100084)
石墨烯射频器件研究进展∗
卢琪1)吕宏鸣2)伍晓明1)吴华强1)3)钱鹤1)3)†
1)(清华大学微电子所,北京 100084)
2)(莱斯大学,得克萨斯州休斯敦市 77005)
3)(清华信息科学与技术国家实验室,北京 100084)
(2017年7月4日收到;2017年8月4日收到修改稿)
石墨烯,场效应晶体管,射频,截止频率
1 引 言
随着集成电路制造技术的不断发展,硅基互补金属氧化物半导体(CMOS)晶体管的工艺节点逐渐进入了10 nm及以下,集成电路的集成度在不断提高.但是,由于短沟效应等物理规律的限制,集成电路制造工艺节点进一步提升的难度越来越大,摩尔定律可能终结.因此,研究器件新结构以及新的半导体材料是近年来解决这些问题的主要技术路径.
自2004年英国曼彻斯特大学的两位科学家Geim和Novoselov使用机械剥离得到单层石墨烯材料之后,这种二维材料由于其优越的电学、机械、和热学等性能,获得了广泛关注与研究[1,2].解决短沟道效应引起的晶体管阈值电压降低、漏致势垒降低等问题的有效方法是减薄栅介质层以及栅控区域的厚度.单层石墨烯作为沟道材料只有一个原子层厚度,使栅控区域厚度降低到极限,从而为解决短沟道效应提供可能[3].另外,由于石墨烯单层结构声子散射小,使得石墨烯具有超高的载流子迁移率,室温下实测超过100000 cm2/(V·s)[4].如此高的迁移率使石墨烯在高频领域中具有非常广阔的应用前景.此外,石墨烯具有超高的强场漂移速度,能够承受由于栅长减小导致的超高的沟道电场强度[3].基于石墨烯材料的这些优点,石墨烯晶体管的研究得到了广泛的关注.
大面积石墨烯单层的生长转移技术及其适用于光刻、刻蚀等微纳加工技术的特点,为实现石墨烯晶体管的集成提供了保障.然而,石墨烯沟道晶体管与传统硅金属氧化物半导体场效应晶体管(MOSFET)在结构及性能都有一些区别,图1为典型硅基MOSFET和顶栅石墨烯晶体管的结构示意图,以及石墨烯晶体管的转移特性和输出特性[3].由图1(c)可以看出,由于石墨烯没有禁带,导致石墨烯晶体管的关态电流很大,器件开关比很小,不能直接用于数字电路.但是在射频(radio frequency,RF)领域,通常不会关心开关比的大小.考虑到石墨烯有很高的载流子迁移率,石墨烯晶体管在射频领域有很大的应用潜力,因此,其高频特性以及其射频电路的研究受到了极大的关注.本文主要介绍近年来射频石墨烯场效应晶体管的结构设计、制作工艺、性能测试及其在射频电路方面的研究进展.
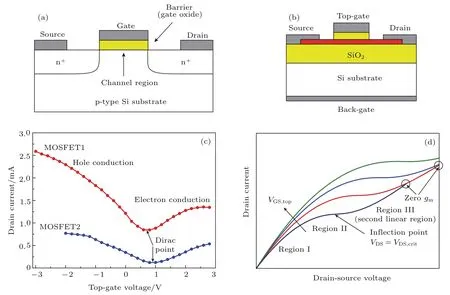
图1 MOSFET与石墨烯晶体管结构特点[3] (a)n型沟道硅MOSFET截面示意图;(b)石墨烯晶体管结构示意图,红色区域代表石墨烯;(c)石墨烯晶体管转移特性曲线;(d)石墨烯晶体管输出特性曲线Fig.1.Structure of MOSFET and graphene field effect transistors[3]:(a)Cross-section of an n-channel Si MOSFET;(b)schematics of graphene transistor,where red block refers to graphene;(c)transfer curve of graphene transistor;(d)output curve of graphene transistor.
2 高性能石墨烯材料的制备
石墨烯的制备方法有很多,包括机械剥离、液相分离[5−7]、碳化硅外延[8−10]、化学气相沉积(chemical vapor deposition,CVD)[11−13]等. 机械剥离法获得的石墨烯质量好,但是材料面积很小,无法用于生产,主要应用于材料性能研究和器件原理性验证;液相分离得到的石墨烯一般杂质较多,无法获得大面积单层石墨烯,常应用于电子墨水、能量储存等领域;而CVD与碳化硅外延方法得到的石墨烯材料更适合在电子领域的应用,质量较好并且面积较大[14].
2.1 CVD法制备石墨烯
CVD法制备石墨烯材料时,常用金属铜、铂作为衬底,得到的石墨烯多为多晶材料.多晶材料存在晶界,晶界散射将影响石墨烯载流子的迁移率.因此,有很多工作致力于生长高质量、大面积的单晶石墨烯,目前单晶石墨烯的晶筹已经可以达到毫米甚至厘米量级[15−21].
此外,在金属衬底上生长的石墨烯,还需要通过转移工艺将其置于硅或者其他基片表面进行后续的晶体管工艺.而转移过程会对石墨烯引入沾污和缺陷,如残余的聚合物支撑层等.因此,Feng等[22]、Liu等[23,24]、Wu等[25]在绝缘或宽禁带半导体材料如SrTiO3、熔融态玻璃及SiC上直接生长、外延石墨烯,该方法能够避免转移过程对石墨烯性能的影响.
常用的SiO2等介质材料对石墨烯载流子有很大的散射,使其实际迁移率远小于本征值.六方氮化硼(hexagonal boron nitride,hBN)是一个宽禁带、性能稳定的二维材料,其表面比SiO2等更平滑、更干净,且没有悬空键,是提高二维材料晶体管特性的良好衬底.直接在hBN衬底上生长高质量的石墨烯材料,也是当前研究的热点之一[26−29].
2.2 CVD石墨烯的转移
金属衬底上CVD生长的石墨烯样品通常需要转移到其他衬底上进行器件制备.常用的方法是使用聚甲基丙烯酸甲酯(PMMA)或者其他高分子聚合物作为支撑物进行转移,但高分子聚合物容易残留在石墨烯表面,引入沾污,从而影响石墨烯的性能.利用小分子聚合物,例如:2-(diphenylphosphory)spiro fl uorene(SPPO1)[30]或松香[31]作为支撑层的缓冲层、或者代替传统的支撑层,去除更加容易、干净,可以改善转移后石墨烯的质量.此外,还可以选择使用金属材料作为转移支撑物,能够在对石墨烯进行保护的同时,作为器件结构的一部分[32].
3 石墨烯射频场效应晶体管的建模与结构
3.1 石墨烯射频场效应晶体管的建模
半导体器件的电路模型是半导体制造与电路设计者之间的桥梁,在半导体领域具有重要的作用[33].在单管器件的电学特性方面,北京大学Lü等[34]使用第一性原理量子传输模拟构造了沟道长度小于10 nm的石墨烯场效应晶体管,并计算其射频特性.该课题组在典型石墨烯场效应晶体管结构(如图1(b)所示)的基础上设计了两种沟道结构:六方氮化硼/单层石墨烯/六方氮化硼与双层石墨烯,这两种结构在垂直外加电场的作用下都能够打开石墨烯禁带.石墨烯禁带打开后可以观察到明显的漏极电流饱和,从而提高器件的最大本征电压增益.仿真结果表明,当栅长从9.86 nm减小至0.91 nm时,石墨烯晶体管本征截止频率(cut-o ff frequency,fT)从3.4 THz提高到了21 THz,展示出石墨烯晶体管在高频下的应用潜力.
在晶体管电路设计方面,器件的集约模型(compact model)能够准确地描述晶体管的性能,并且可解析,不含微分、积分,常用在电路以及系统级的设计仿真中.与MOSFET相比,石墨烯场效应晶体管的集约模型需要改进电荷层模型(charge sheet model)[35]、虚拟源电流电压模型(virtualsource current–voltage model)[36]等. 此外, 针对石墨烯晶体管在模拟、射频领域应用时不需要对能带进行调控,以及锥形能带导致的载流子速度一致的特点,提出了漂移-扩散模型(drift-diffusion model)[37,38]以及以玻尔兹曼方程为基础建立的模型[39]等.武汉大学[40]、清华大学[38,41]在石墨烯场效应晶体管集约模型的基础上,对石墨烯射频倍频器、混频器及放大器电路进行了仿真,为石墨烯射频电路的设计与实验研究提供了有效的支持.
3.2 双指/多指栅结构
双指及多指栅结构是改善晶体管射频特性的常用方法之一:通过并联多个同样的栅线条,可以有效减小栅极电阻,从而增大器件的最高振荡频率(fmax).石墨烯射频晶体管常采用双指及多指栅结构[42−44],如图2所示.此外,栅极与源漏电极之间的间距也是影响射频性能的一个重要因素.通过缩小栅极与源漏之间的间距,可以减小石墨烯沟道未被栅覆盖区域的接入电阻(access resistance,RA),有效改善石墨烯晶体管直流特性,增大跨导gm,从而改善晶体管的本征截止频率fT.同时,RA的减小在改善晶体管fmax上也发挥了重要作用[44].

图2 典型的栅结构示意图 (a)六指栅结构[43];(b)双指栅结构[44]Fig.2.Typical gate structure used in radio frequency graphene field effect transistor design:(a)Six- finger gate structure[43];(b)duel-gate structure[44].
3.3 T型栅结构
T型栅结构是超高速射频晶体管设计时常用的一种结构,此结构能够增大栅极的横截面积,从而在保证沟道长度尽可能小的同时减小栅极电阻,改善晶体管的射频性能[42].典型的T型栅结构如图3(b)所示.

图3 T型栅石墨烯场效应晶体管示意图[32] (a)双栅结构石墨烯场效应晶体管扫描电子显微镜图;(b)局部放大的T型栅结构剖面聚焦离子束图Fig.3.Images of T-gate graphene field effect transistor[32]:(a)Scanning electron microscope image of a typical dual-gate graphene field effect transistor;(b)cross-section focused ion beam image of the T-gate.
通常情况下,将T型栅结构与多指栅结构结合起来,如图3(a)所示,并且精心设计工艺流程,可以最大程度地改进石墨烯晶体管器件的射频性能.
4 石墨烯射频场效应晶体管的制造工艺
在制备石墨烯射频场效应晶体管的过程中,石墨烯材料接触光刻胶、经过湿法和刻蚀工艺,都会对石墨烯产生表面沾污、造成缺陷损伤等影响,将极大地恶化单原子层石墨烯材料的电学性质.为了更好地保留石墨烯的本征性能,需要针对性地开发更适合石墨烯器件的工艺流程,提升石墨烯射频晶体管及电路的性能.
4.1 器件工艺流程的改进
4.1.1 自对准工艺的改进
2014年,河北半导体研究所Feng等[45]针对顶栅石墨烯晶体管,改进了栅电极自对准工艺.制备栅电极前,在石墨烯上沉积一层金属金作为保护层,此金属层同时也形成了源漏电极.金属保护层能够使得石墨烯有效避免后续工艺带来的沾污,从而改善晶体管的射频特性.工艺流程如下:首先,在SiC(0001)衬底上外延生长好单层石墨烯样品后,沉积20 nm的金属金;随后,使用三层胶工艺光刻出T型栅结构,并且使用湿法工艺刻蚀掉T型栅结构下的金属金;接下来,沉积2 nm的金属铝并使其自然氧化,得到Al2O3介质层;在介质层上沉积180 nm铝形成T型栅;最后,经过剥离,形成石墨烯场效应晶体管.未被刻蚀的Au形成晶体管的源漏电极.使用此工艺制备的石墨烯场效应晶体管展示出良好的栅极耦合及较小的寄生效应,获得了良好的器件直流及射频性能.对于栅长100 nm的石墨烯晶体管,测得fT达到93 GHz,fmax达到了105 GHz.
2015年,西安电子科技大学Wu等[46]用物理气相沉积(physical vapor deposition,PVD)的方法在石墨烯上沉积SiO2作为栅介质层,同时也作为自对准栅极、源漏接触的掩膜.随后使用热蒸发工艺沉积Ti/Au(20 nm/20 nm)作为栅极及源漏电极.为了对栅、源、漏进行更好的隔离,在栅介质层侧面再次使用PVD工艺沉积SiO2,之后再沉积金,增加电极的厚度.此工艺流程能够有效减小栅极与源漏之间由于重叠引起的寄生电容以及RA的影响.对于栅长1µm的晶体管,测得fT为0.32 GHz.
4.1.2 埋栅结构与倒置工艺
2011年,IBM的Han等[47]提出了石墨烯晶体管的埋栅结构,此结构与传统的集成电路工艺顺序一致,先制备有源器件,后制备引线及无源元件.这就使得无源元件制备过程中可能引入对石墨烯的沾污,影响器件性能.
2014年,清华大学与IBM的Han等几乎同时提出了石墨烯倒置工艺流程[48−50].该流程先制备无源元件与互连线,随后制备出埋栅结构,之后再转移石墨烯,形成晶体管结构.工艺示意图如图4所示.此方法与CMOS工艺能很好地兼容,能够实现石墨烯与CMOS电路的集成,并且能够有效避免复杂的工艺流程对石墨烯的沾污及性能的影响.清华大学先在通用8寸CMOS生产线完成了石墨烯射频器件栅、源、漏电极和电路中无源元件、互连线的制备,再自主完成石墨烯材料的相关工艺,制成的200 nm栅长石墨烯晶体管的fT和fmax分别达到35.4 GHz和50 GHz,与同技术节点下硅基晶体管性能相近[50].

图4 倒置工艺的工艺流程图[50] (a)准备高阻的硅衬底;(b)使用α-Si硬掩模定义栅极;(c)刻蚀出栅极区域;(d)定义并刻蚀出源漏区域的底电极;(e)沉积金属W并且进行化学机械抛光;(f)沉积栅介质层HfO2;(g)转移石墨烯;(h)制备源漏的顶电极Fig.4.Process flow of a graphene IC integration with the “inverted process”[50]:(a)High-res Si substrate;(b)de fi nition of the gate on hard mask sacri fi cing layer;(c)etching of the gate;(d)de fi nition and etching of the source/drain region bottom contacts;(e)W deposition and chemically mechanical polishing;(f)deposition of HfO2gate dielectric;(g)graphene transfer;(h)patterning source/drain top contacts by lift-o ff process.
4.2 石墨烯材料质量的改进
石墨烯晶体管中,沟道材料的质量、衬底材料都是影响石墨烯射频晶体管及电路性能的重要因素.因此,石墨烯材料本身的工艺进步对石墨烯射频晶体管性能的提升起到关键作用.
4.2.1 绝缘衬底上外延石墨烯
直接在绝缘衬底上外延石墨烯可以避免转移过程对石墨烯引入沾污.通过对生长温度、碳源浓度的精确控制,可以使得石墨烯表面起伏更小,一致性更好,从而改善石墨烯晶体管的性能.2014年,河北半导体研究所的Feng等[51]在2 in(1 in=2.54 cm)蓝宝石衬底上外延石墨烯,并制备了射频晶体管.测试结果表明,栅长100 nm的石墨烯晶体管fT为32 GHz,fmax为21.5 GHz.
4.2.2 单晶石墨烯材料
使用金属作为衬底的CVD石墨烯多为多晶材料,多晶材料的晶界处存在载流子的散射,从而影响石墨烯载流子迁移率等.2014年,北京大学Fu等[52]使用毫米尺度的石墨烯单晶材料制备了石墨烯射频晶体管阵列,对同一块单晶石墨烯材料上不同位置处拉曼光谱峰位进行对比,得到较好的一致性.实验测得50 nm栅长单晶石墨烯晶体管的fT达到178 GHz,栅长600 nm的晶体管fmax达到33 GHz.
4.2.3 双层石墨烯材料
2014年,河北半导体研究所的Feng等[53,54]使用双层石墨烯材料制备了射频场效应晶体管,并研究了其与单层石墨烯射频场效应晶体管性能的差异.单层及双层石墨烯材料是在4H-SiC衬底上外延得到的,采用自对准工艺制备出晶体管器件.测试结果表明,双层石墨烯晶体管具有更大的电流密度、更大的跨导gm、以及更小的方阻Ron,并且能够实现电流的饱和,如图5所示.由于晶体管的fT与gm直接相关,如(1)式所示:

式中,gm为跨导,Cgs与Cgd为栅电容,故双层石墨烯晶体管的fT要明显高于单层石墨烯晶体管.晶体管的fmax与gm和多个外在寄生参数有关,如下式所示:

式中,gds为输出电导,Ri为栅极覆盖处的沟道电阻,Rs为源极电阻,RG为栅极电阻.
双层石墨烯晶体管的fmax也比单层石墨烯晶体管高.实验结果表明,对于栅长100 nm的器件,单层石墨烯晶体管的fT为40.3 GHz,双层石墨烯晶体管的fT则达到124.5 GHz;至于fmax,单层石墨烯晶体管为17.1 GHz,双层石墨烯晶体管达到49.8 GHz.

图5 单层和双层石墨烯场效应晶体管的直流特性比较[54] (a)单层、(b)双层石墨烯场效应晶体管的输出特性曲线;(c)层、(d)双层石墨烯场效应晶体管的转移特性曲线;Lg=100 nm,Wg=4µmFig.5.DC characteristics of monolayer and bilayer graphene field effect transistors[54]:(a)Monolayer and(b)bilayer graphene field effect transistor output characteristics;(c)monolayer and(d)bilayer graphene field effect transistor transfer curves.Lg=100 nm,Wg=4µm.
4.2.4 石墨烯转移工艺
目前,大多数制作晶体管的石墨烯材料都是在金属衬底上用CVD工艺制作的,因此,一定时期内,转移工艺仍然是制作石墨烯晶体管难以避免的步骤.常用的石墨烯转移方法是使用PMMA或者其他有机高分子聚合物作为支撑材料,但是存在的问题是这些聚合物很难完全去除干净,从而影响制备器件的性能.为了消除聚合物的影响,使用金属作为转移支撑层与热解保护层是一种有效的改进方式[55].2016年,南京电子技术研究所的Wu等[32]使用金属金作为支撑层,用于石墨烯的转移,避免了聚合物对石墨烯的沾污.除了支撑作用,金属金还能避免石墨烯在后续光刻过程中被光刻胶污染,同时,也形成了晶体管的源漏接触电极.这种转移方法,配合改进的自对准工艺及T型栅结构的使用,减小了工艺流程对石墨烯性能的影响,也减小了晶体管RG及寄生电阻,故而得到迄今为止文献报道的最大fmax值:200 GHz.
4.3 接触电阻的改善
在石墨烯场效应晶体管中,石墨烯与源漏电极金属之间的接触电阻是影响晶体管射频特性的一个重要因素.若接触电阻较大,则漏电流会较小,从而导致跨导较小,根据(1)和(2)式可知,晶体管的fT与fmax会随之减小[56].
二维半导体材料与三维金属材料的接触主要有两种形式:面接触与边缘接触(edge contact).理论分析及实验结果表明,边缘接触比面接触的接触电阻更小,但是完全的边缘接触很难实现,通常的接触形式是二者的结合[57].实现边缘接触是降低接触电阻的一个有效方法[58−60].此外,如果石墨烯在转移及光刻过程中有残胶留在表面,形成沾污,也会影响接触电阻.为了减小石墨烯表面的沾污,常用的手段是使用等离子体、氧化性气体以及热退火清理石墨烯表面[61−64].2013年,北京大学Li等[65,66]使用紫外臭氧处理石墨烯表面,使得接触电阻降低至200 Ω·µm,并且有较好的可重复性与可靠性.随后,北京大学Peng等[67]及清华大学[50]都曾采用此方法对石墨烯表面进行处理,改善了石墨烯射频晶体管的射频特性.
4.4 石墨烯射频场效应晶体管的性能
在过去的几年里,石墨烯晶体管的射频性能被不断地提升.自2010年以来,加州大学洛杉矶分校的Cheng等[68]、Liao等[69]、以及IBM的Wu等[55]均实现了fT超过300 GHz的石墨烯晶体管.但是,这些晶体管的fmax仍然低于fT,而fmax表征了晶体管的功率放大能力,是晶体管最关键的参数之一.
2014年,河北半导体研究所的Feng等[45]使用改进的T型栅自对准工艺制备出的晶体管,在栅长为100 nm时fT达到97 GHz,fmax则超过100 GHz.2016年,南京电子技术研究所的Wu等[32]在T型栅自对准工艺基础上,改进了石墨烯的转移方法,得到200 GHz的fmax,这是迄今为止石墨烯晶体管fmax的最高值.同年,清华大学采用与硅CMOS工艺兼容的“倒置工艺”流程得到的200 nm栅长晶体管,其fT和fmax分别达到了35.4 GHz和50 GHz,与同技术节点下硅基射频晶体管性能相近[50].
图6汇总了近几年石墨烯射频场效应晶体管所达到的射频性能[32,42,43,45,50−55,68−78].总体上,石墨烯晶体管的截止频率fT与栅长基本符合1/L率关系,这说明载流子的传输是在接触限制的区域,源漏接触电阻在调控沟道的电场中起主要作用,而栅长的影响很小;这与栅长较长时沟道电阻起主要作用的1/L2率有一定区别[78].石墨烯晶体管的最高振荡频率fmax与栅长之间有更复杂的关系,它与fT,RG,gds等多个参数都有关系[55].最高振荡频率fmax代表了晶体管的功率放大能力,但由于石墨烯没有禁带,严重影响了fmax的值.图6(c)展示了文献报道的石墨烯晶体管fmax与fT的相对关系,虚线为fT与fmax相等的示意线.由图6(c)可以看出,目前多数文献报道的石墨烯晶体管的fmax仍然小于fT,与硅材料制备的射频晶体管性能还有一些差距.使用双层石墨烯、打开石墨烯禁带、进一步改进器件结构和工艺、提高石墨烯材料质量,是进一步提升石墨烯晶体管射频特性的方向.

图6 石墨烯射频场效应晶体管性能总结[32,42,43,45,50−55,68−78](a)fT与栅长的关系;(b)fmax与栅长的关系;(c)fmax与fT的关系Fig.6.Summary of graphene radio frequency field effect transistors[32,42,43,45,50−55,68−78]:(a)fT versus gate length;(b)fmaxversus gate length;(c)fmaxversus fT.
5 石墨烯场效应晶体管射频电路
基于石墨烯场效应晶体管制作多种类型的射频电路,可以验证石墨烯晶体管的射频特性并探索其在射频领域的应用前景.同时,石墨烯晶体管具有双极型特性等有别于硅基晶体管的特点,使得一些石墨烯晶体管射频电路具有独特的工作原理和结构.
5.1 倍频器
倍频器是一个输出频率为输入频率整数倍的电路,广泛应用于通信、调频设备、太赫兹成像等领域中.2009年,IBM的Wang等[79]利用石墨烯晶体管独特的“V”形转移特性,设计制作了结构十分简单的石墨烯晶体管倍频器.该电路利用栅极直流电压将石墨烯晶体管偏置在转移曲线中电导最小的点,即石墨烯的狄拉克点,并且在栅极叠加频率为f0的正弦信号,则会在晶体管漏极得到频率为2f0的信号.该石墨烯倍频器可以实现输入10 kHz、输出20 kHz的倍频功能,输出频谱的纯度达到94%.
2014年,清华大学使用倒置工艺制备出石墨烯倍频器集成电路,包含一个石墨烯射频场效应晶体管和一个片上电感[49],片上电感实现了带通滤波的功能[47],过滤掉其他倍频、射频及漏端偏置等信号.此电路实现了4 GHz的3 dB带宽,并且在输入信号为3 GHz时,转换增益达到−26 dB.
2015年,北京大学Peng等[67]在聚萘二甲酸乙二醇酯(polyethylene naphthalate,PEN)衬底上制备出电子、空穴迁移率均超过10000 cm2·V−1·s−1的柔性晶体管,并以此为基础制备出石墨烯倍频器.电路的输入频率为10 kHz时,倍频器的转换增益达到−13.6 dB,频谱纯净度达到96.6%.将输入频率提高至10 MHz时,倍频器仍能正常工作,转换增益为−17.7 dB,频谱纯净度为97.7%.
5.2 混频器
混频器输出信号的频率为输入信号频率的差、和、或为两者的组合.2010年,Wang等[80]利用石墨烯的双极输运特性制备出新型的混频器电路.利用石墨烯对称的双极输运特性,混频器可以有效地消除偶次交调的影响.通过栅电压将晶体管偏置在电导最小点的附近,并且引入10.5 MHz的射频(RF)输入信号及10 MHz的本振(LO)信号,得到电路的转换损耗为35—40 dB.使用双音法(twotone test)测得输入三阶交调点(input third-order intermodulation intercept,IIP3)为13.8 dBm.
2015年,清华大学选用交叉耦合的双平衡电路结构设计了石墨烯晶体管混频器,此结构具有抑制RF信号、LO信号穿通,消除偶次交调等优点.电路的制备使用了倒置工艺,电路芯片上集成了4个石墨烯晶体管、4个片上电感以及4个金属-绝缘体-金属电容.图7为石墨烯双平衡阻性混频器电路的结构示意图及测试实物照片[81].当此电路的本振频率为3.5 GHz、射频信号为3.6 GHz时,得到下变频信号(100 MHz处)的转换损耗为33 dB,使用双音法测得的IIP3为21 dBm.通过与单个石墨烯晶体管制备的阻性混频器对比可知,双平衡结构可以有效地改善混频器的线性度.此外,即使混频器中的4个晶体管转移特性的不完全一致,此电路仍能保持较好的混频性能.

图7 石墨烯双平衡混频器[81] (a)结构示意图;(b)焊接在PCB版上的混频器实物图Fig.7.Double-balanced mixer diagram[81]:(a)Schematic of the double-balanced mixer;(b)fabricated doublebalanced mixer on PCB.
5.3 射频放大器
射频放大器是射频电路中的一类重要单元.由于石墨烯没有禁带,无法实现输出的饱和特性,限制了其在放大器方面的应用.尽管如此,如果使用双层石墨烯[82,83]等方式打开石墨烯材料的禁带,改善衬底材料使载流子达到速度饱和[84−86],还是可以在石墨烯晶体管的输出特性曲线中观察到饱和特性,从而用于构建射频放大器.
2015年,清华大学提出了石墨烯分布式放大器的结构[41].分布式放大器的增益为每节晶体管增益的叠加[87],从而可以在一定程度上解决目前石墨烯场效应晶体管放大性能不足的缺点.仿真结果表明,四节石墨烯分布式放大器可以实现3.5 GHz的带宽以及最高4 dB的增益.
2016年,河北半导体研究所的Feng等[88]使用SiC(0001)衬底上外延生长的双层石墨烯,设计并制备出石墨烯放大器微波单片集成电路(monolithic microwave integrated circuit,MMIC).此石墨烯放大器电路在14.3 GHz处实现了3.4 dB的小信号功率增益,最小噪声系数为6.2 dB.这是第一次实现石墨烯放大器MMIC,为石墨烯在射频领域的应用打下了基础.
6 总结与展望
本文从石墨烯材料的制备、射频晶体管结构设计、工艺设计、射频电路设计与测试等多个方面,介绍了国内外石墨烯晶体管在射频领域的成果与发展.在石墨烯晶体管器件方面,最高的fmax已经提升至200 GHz.通过进一步优化器件的结构与工艺,如改善接触电阻、接入电阻影响等,可以更进一步展示出石墨烯在射频领域的优势.此外,如果进一步减小栅电极长度,制备出特征尺寸小于10 nm的晶体管,可能同时解决石墨烯禁带为零的问题,增强石墨烯晶体管在射频领域的应用潜力,也为解决硅基材料10 nm下的短沟道效应问题提供了一种方案.在射频电路应用方面,石墨烯基的倍频器、混频器及放大器等射频电路的基本结构已经实现,但是集成度、性能等仍与商业化的硅、III-IV族电路有一些差距,这些差距主要来源于目前石墨烯晶体管射频性能的限制.但是,基于石墨烯晶体管独特的电学特性,一些石墨烯射频电路与传统射频电路相比仍然具有结构简单、性能优异等优点.
随着石墨烯制备技术以及相关的集成工艺技术的快速发展,石墨烯晶体管在射频领域应用的潜力和可行性将进一步增大.
首先在材料方面,开发制备出低成本、大面积高质量的石墨烯材料的方法是将其应用在电路中的基础.北京大学Liu等[89]在预处理过的单晶铜衬底上制备出尺寸为(5×50)cm2的石墨烯单晶,温度为4 K时迁移率达到23000 cm2/(V·s),这为石墨烯在半导体工业领域的应用提供了一种可行性.但是在金属衬底上生长的石墨烯材料无法直接使用,需要通过转移技术将其转移到合适的衬底上.转移工艺现阶段仍存在未完全解决的问题:一是会引入随机的沾污以及应力的分布,从而影响石墨烯的性能;二是如何将转移大面积石墨烯材料的工艺工业化,实验室常用方法对转移面积、成本、效率等要求不高,不适合工业化生产,而大面积卷对卷工艺虽然可以进行量产,但是仅限于柔性衬底的应用场景,无法与硅基半导体工艺很好地兼容.如何解决这些问题是未来值得研究的方向.可替代的一个思路是设法将石墨烯直接在目标衬底上合成,如在SiC,hBN等衬底上制备以及使用硅插层等技术,避免转移工艺对石墨烯质量造成影响.但是这些方法也有待进一步改进:SiC上外延成本较高,并且不同SiC晶面上外延的石墨烯质量与CVD法生长石墨烯质量有一定差距,如(0001)面上外延时石墨烯与衬底间存在缓冲层,极大地影响了石墨烯电学特性,而其他晶面上制备的石墨烯材料存在较多的晶格缺陷[90];hBN衬底上直接生长的石墨烯晶筹较小[91],目前还无法满足工业应用的需求;硅插层石墨烯技术主要实现了插入Si原子层[92],如何实现插入高质量SiO2等介质层是实现石墨烯与硅基半导体融合需要努力的研究方向.
其次在工艺方面,减小载流子散射的衬底材料选择、高质量介质层的生长、更小的接触电阻设计等都是可以提升石墨烯射频器件性能的重要因素.以接触电阻为例,常用的改善接触电阻的方式有改变接触使用的金属从而增加石墨烯态密度,采用边缘接触以及对石墨烯表面进行等离子体处理等,得到的最低接触电阻约为100 Ω·µm[93],这与硅基晶体管的接触电阻相比还有一定差距.Park等[94]首先对石墨烯进行掺杂处理,再配合精心设计的边缘接触,得到了低至23 Ω·µm的接触电阻,可以满足硅基晶体管接触电阻的要求.此方法得到的场效应迁移率最高为4267 cm2/(V·s),仍有改进的空间,并且制备过程需要使用电子束曝光形成边缘接触,增加了工艺的复杂度及成本.接下来的一个研究方向是进一步优化,并且将这些改进接触电阻的设计应用在石墨烯射频器件的制造过程,从而进一步改善其射频特性.此外,工艺上,如何保证同一批器件以及不同批次器件性能的均一性也是增大石墨烯射频器件应用的可行性需要解决的问题.
电路设计方面,除了以上提到的倍频器、混频器外,Cheng等[95]通过单层/双层石墨烯沟道结构得到有两个狄拉克点的“W”型转移特性曲线,从而直接构造出三倍频器,得到的频谱纯净度高于其他三倍频器;Han等[48]使用三级石墨烯晶体管实现了含有信号放大、滤波及下变频功能的射频接收电路模块.这些电路模块功能的实现利用了石墨烯不同于硅基晶体管的特性,简化了电路,优化了性能.如何利用石墨烯独特的电学特性,如双极特性等,设计出更多结构简单、性能优异的电路结构,也是发挥石墨烯在射频领域优势的一个重要研究方向.
[1]Novoselov K S,Geim A K,Morozov S V,Jiang D,Zhang Y,Dubonos S V,Grigorieva I V,Firsov A A 2004Science306 666
[2]Geim A K,Novoselov K S 2009Nat.Mater.6 183
[3]Schwierz F 2007Nat.Nanotechnol.5 487
[4]Mayorov A S,Gorbachev R V,Morozov S V,Britnell L,Jalil R,Ponomarenko L A,Blake P,Novoselov K S,Watanabe K,Taniguchi T,Geim A K 2011Nano Lett.11 2396
[5]Hernandez Y,Nicolosi V,Lotya M,Blighe F,Sun Z,De S,McGovern I T,Holland B,Byrne M,Gun’ko Y,Boland J,Niraj P,Duesberg G,Krishnamurthy S,Goodhue R,Hutchison J,Scardaci V,Ferrari A,Coleman J 2008Nat.Nanotechnol.3 563
[6]Schniepp H C,Li J L,Mcallister M J,Sai H,Herrera-Alonso M,Adamson D H,Prud’homme R,Car R,Saville D,Aksay I 2006J.Phys.Chem.B110 8535
[7]Segal M 2009Nat.Nanotechnol.4 612
[8]Forti S,Emtsev K V,Coletti C,Zakharov A A,Riedl C,Starke U 2008Phys.Rev.B78 245403
[9]Forbeaux I,Themlin J M,Debever J M 1998Phys.Rev.B58 16396
[10]Yu C,Li J,Liu Q B,Cai S J,Feng Z H 2014Acta Phys.Sin.63 038102(in Chinese)[蔚翠,李佳,刘庆彬,蔡树军,冯志红2014物理学报63 038102]
[11]Li X,Cai W,An J,Kim S,Nah J,Yang D,Riner R,Velamakanni A,Jung I,Tutuc E,Banerjee S,Colombo L,Ruo ffR 2009Science324 1312
[12]Bae S,Kim H,Lee Y,Lee Y,Xu X,Park J,Zheng Y,Balakrishnan J,Lei T,Kim H,Song Y,Kim Y,Kim K,Kim K,Ozyilmaz B,Ahn J,Hong B,Iijima S 2010Nat.Nanotechnol.5 574
[13]Xiao K,Wu H,Lü H,Wu X,Qian H 2013Nanoscale5 5524
[14]Novoselov K S,Fal V I,Colombo L,Gellert P,Schwab M,Kim K 2012Nature490 192
[15]Wang H,Wang G,Bao P,Yang S,Zhu W,Xie X,Zhang W 2012J.Am.Chem.Soc.134 3627
[16]Gao L,Ren W,Xu H,Jin L,Wang Z,Ma T,Ma L,Zhang Z,Fu Q,Peng L,Bao X,Cheng H 2012Nat.Commun.3 699
[17]Gan L,Luo Z 2013ACS Nano7 9480
[18]Wu T,Ding G,Shen H,Wang H,Sun L,Jiang D,Xie X,Jiang M 2013Adv.Functional Mater.23 198
[19]Chen S,Ji H,Chou H,Li Q,Li H,Suk J W,Piner R,Liao L,Cai W,Rou ffR 2013Adv.Mater.25 2062
[20]Wu T,Zhang X,Yuan Q,Xue J,Lu G,Liu Z,Wang H,Wang H,Ding F,Yu Q,Xie X,Jiang M 2016Nat.Mater.15 43
[21]Xu X,Zhang Z,Qiu L,Zhuang J,Zhang L,Wang H,Liao C,Song H,Qiao R,Gao P,Hu Z,Liao L,Liao Z,Yu D,Wang E,Ding F,Peng H,Liu K 2016Nat.Nanotechnol.11 930
[22]Yu C,Liu Q,Li J,Lu W,He Z,Cai S,Feng Z 2014Appl.Phys.Lett.105 183105
[23]Sun J,Gao T,Song X,Zhao Y,Lin Y,Wang H,Ma D,Chen Y,Xiang W,Wang J,Zhang Y,Liu Z 2014J.Am.Chem.Soc.136 6574
[24]Chen Y,Sun J,Gao J,Du F,Han Q,Nie Y,Chen Z,Bachmatiuk A,Priydarshi M,Ma D,Song X,Wu X,Xiong C,Rummeli M,Ding F,Zhang Y,Liu Z 2015Adv.Mater.27 7839
[25]Cai T,Jia Z,Yan B,Yu D,Wu X 2015Appl.Phys.Lett.106 013106
[26]Ding X,Ding G,Xie X,Huang F,Jiang M 2011Carbon49 2522
[27]Tang S,Ding G,Xie X,Chen J,Wang C,Ding X,Huang F,Lu W,Jiang M 2012Carbon50 329
[28]Zhang C,Zhao S,Jin C,Koh A L,Zhou Y,Xu W,Li Q,Xiong Q,Peng H,Liu Z 2015Nat.Commun.6 6519
[29]Gao T,Song X,Du H,Nie Y,Chen Y,Ji Q,Sun J,Yang Y,Zhang Y,Liu Z 2015Nat.Commun.6 6835
[30]Han Y,Zhang L,Zhang X,Ruan K,Cui L,Wang Y,Liao L,Wang Z,Jie J 2014J.Mater.Chem.C2 201
[31]Zhang Z,Du J,Zhang D,Sun H,Yin L,Ma L,Chen J,Ma D,Chen H,Ren W 2017Nat.Commun.8 14560
[32]Yun W,Zou X,Sun M,Cao Z,Wang X,Shuai H,Zhou J,Ynag Y,Yu X,Kong Y,Yu G,Liao L,Chen T 2016ACS Appl.Mater.Interfaces8 25645
[33]Lu N D,Wang L F,Li L,Liu M 2017Chin.Phys.B26 036804
[34]Zheng J,Lu W,Ruge Q,Liu Q,Hong L,Yu D,Mei W,Shi J,Gao Z,Lu J 2013Sci.Rep.3 1314
[35]Meric I,Han M Y,Young A F,Ozyilmaz B,Kim P,Shepard K L 2008Nat.Nanotech.3 653
[36]Wang H,Hus A,Kong J,Antoniadis D A,Palacios T 2011IEEE Trans.Electron Dev.58 1523
[37]Frégonese S,Magallo M,Maneux C,Happy H,Zimmer T 2013IEEE Trans.Nanotech.12 539
[38]Zhu W N,Linghu C,Zhang J,Zhang L,Yu Z 2012SISPADDenver,CO,USA September 5–7,2012 pp79–82
[39]Scott B W,Leburton J P 2011IEEE Trans.Nanotech.10 1113
[40]Zhu R,Zhang Y,Luo J,Chang S,Wang H,Huang Q,He J 2015Key Eng.Mater.645-646 139
[41]Lü H,Lu Q,Huang Y,Ma T,Zhang J,Wu X,Yu Z,Ren W,Cheng H,Wu H,Qian H 2015Sci.Rep.5 17649
[42]Han S J,Oida S,Jenkins K A,Lu D,Zhu Y 2013IEEE Electron Dev.Lett.34 1340
[43]Han S J,Jenkins K A,Valdes G A,Franklin A D,Bol A A,Haensch W 2011Nano Lett.11 3690
[44]Peng S,Jin Z,Zhang D,Shi J,Wang X,Wang S,Li M,Liu X,Yu G 2015Appl.Phys.Lett.106 033503
[45]Feng Z H,Yu C,Li J,Liu Q B,He Z Z,Song X B,Wang J,Cai S 2014Carbon75 249
[46]Wu Y,Ma Z F,Du L,Zhang P,He L 2015Mater.Sci.Forum815 36
[47]Han S J,Valdes-Garcia A,Bol A A,Franklin A D 2011IEEE Electron Dev.Meeting326 pp.2.2.1–2.2.4
[48]Han S J,Garcia A V,Oida S,Jenkins K A,Haensch W 2014Nat.Commun.5 3086
[49]Lü H,Wu H,Liu J,Huang C,Li J,Yu J,Niu J,Xu Q,Yu Z,Qian H 2014Nanoscale6 5826
[50]Lyu H,Qi L,Liu J,Wu X,Zhang J,Li J,Niu J,Yu Z,Wu H,Qian H 2016Sci.Rep.6 35717
[51]Liu Q B,Yu C,Li J,Song X B,He Z Z,Lu W L,Gu G D,Wang Y G,Feng Z H 2014Chin.Phys.Lett.31 078104
[52]Wei Z J,Fu Y Y,Liu J B,Wang Z D,Jia Y H,Guo J,Ren L M,Chen Y F,Zhang H,Huang R,Zhang X 2014Chin.Phys.B23 117201
[53]Yu C,He Z Z,Li J,Song X B,Liu Q B,Cai S J,Feng Z 2016Appl.Phys.Lett.108 013102
[54]He Z Z,Yang K W,Yu C,Liu Q B,Wang J J,Song X B,Han T T,Feng Z H,Cai S J 2016Chin.Phys.Lett.33 086801
[55]Wu Y,Jenkins K A,Valdesgarcia A,Farmer D B,Zhu Y,Bol A A,Dimitrakopoulos C,Zhu W,Xia F,Avouris P,Lin Y 2012Nano Lett.12 3062
[56]Islam M R,Haque M A,Fahim-Al-Fattah M,Alam M N K,Islam M R 2016International Conference on Informatics,Electronics and VisionDhaka,Bangladesh,May 13–14,2016 pp21–25
[57]Allain A,Kang J,Banerjee K,Kis A 2015Nat.Mater.14 1195
[58]Smith J T,Franklin A D,Farmer D B,Dimitrakopoulos C D 2013ACS Nano7 3661
[59]Wang L,Meric I,Huang P Y,Gao Q,Gao Y,Tran H,Taniguchi T,Watanabe K,Campos L,Muller D,Guo J,Kim P,Hone J,Shepard K,Dean C 2013Science342 614
[60]Song S M,Kim T Y,Jae Sul O,Cheol Shin W 2014Appl.Phys.Lett.104 183506
[61]Kwon T,An H,Seo Y S,Jung J 2012Jpn.J.Appl.Phys.51 638
[62]Gahng S,Chang H R,Yu J C,Kim J A,Kim T,Yoo W J 2014Appl.Phys.Lett.104 223110
[63]Robinson J A,Labella M,Zhu M,Hollander M 2011Appl.Phys.Lett.98 053103
[64]Wei S L,Chang T N,Thong J T L 2014Nano Lett.14 3840
[65]Li W,Liang Y,Yu D,Peng L 2013Appl.Phys.Lett.102 183110
[66]Li W,Hacker C A,Cheng G,Liang Y 2014J.Appl.Phys.115 487
[67]Liang Y,Liang X,Zhang Z,Li W,Huo X,Peng L 2015Nanoscale7 10954
[68]Cheng R,Bai J,Liao L,Zhou H,Chen Y,Liu L,Lin Y,Jiang S,Huang Y,Duan X 2012Proc.Natl.Acad.Sci.USA109 11588
[69]Liao L,Lin Y C,Bao M,Cheng R,Bai J,Liu Y,Qu Y,Wang K,Huang Y,Duan X 2010Nature467 305
[70]Lin Y M,Jenkins K A,Valdesgarcia A,Small J P,Farmer D B,Avouris P 2009Nano Lett.9 422
[71]Meric I,Baklitskaya N,Kim P,Shepard K L 2008IEEE Int.Electron Dev.MeetingSan Francisco,CA,USA,December 15–17,2008 pp1–4
[72]Meric I,Dean C R,Han S J,Wang L 2011Electron Devices MeetingWashington,DC,USA,December 5–7,2011 pp2.1.1–2.1.4
[73]Dimitrakopoulos C,Lin Y M,Grill A,Farmer D B 2010J.Vacuum Sci.Technol.B:Microelectron.Nanometer Struct.28 985
[74]Lin Y M,Dimitrakopoulos C,Jenkins K A,Chiu H Y,Grill A,Avouris P 2010Science327 662
[75]Guo Z,Dong R,Chakraborty P S,Lourenco N,Palmer J,Hu Y,Ruan M,Hankinson J,Kunc J,Cressler J,Berger C,Heer W 2013Nano Lett.13 942
[76]Badmaev A,Che Y,Li Z,Wang C,Zhou C 2012ACS Nano6 3371
[77]Han S J,Garcia A V,Oida S,Jenkins K A 2013IEEE Int.Electron Dev.MeetingWashington,DC,USA,December 9-11,2013 pp19.9.1–19.9.3
[78]Wu Y,Lin Y,Bol A A,Jenkins K A,Xia F,Farmer D B,Zhu Y,Avouris P 2011Nature472 74
[79]Wang H,Nezich D,Kong J,Palacios T 2009IEEE Electron Dev.Lett.30 547
[80]Wang H,Hsu A,Wu J,Kong J,Palacios T 2010IEEE Electron Dev.Lett.31 906
[81]Lyu H,Wu H,Liu J,Lu Q,Zhang J,Wu X,Li J,Ma T,Niu J,Ren W,Cheng H,Yu Z,Qian H 2015Nano Lett.15 6677
[82]Ohta T,Bostwick A,Seyller T,Horn K,Rotenberg E 2006Science313 951
[83]Oostinga J B,Heersche H B,Liu X,Morpurgo A F,Vandersypen L M 2008Nat.Mater.7 151
[84]Meric I,Han M Y,Young A F,Ozyilmaz B,Kim P,Shepard K 2008Nat.Nanotechnol.3 654
[85]Meric I,Dean C R,Young A F,Baklitskaya N,Tremblay N,Nuckolls C,Kim P,Shepard K 2011Nano Lett.11 1093
[86]Dorgan V E,Bae M H,Pop E 2010Appl.Phys.Lett.97 082112
[87]Pozar D M 1990Microwave Engineering(MA:Addison-Wesley)
[88]Yu C,He Z Z,Liu Q B,Song X B,Xu P,Han T T,Li J,Feng Z,Cai S 2016IEEE Electron Dev.Lett.37 684
[89]Xu X,Zhang Z,Dong J,Yi D,Niu J,Wu M,Lin L,Yin R,Li M,Zhou J,Wang S,Sun J,Duan X,Gao P,Jiang Y,Wu X,Peng H,Ruo ffR,Liu Z,Yu D,Wang E,Ding F,Liu K 2017Sci.Bull.62 1074
[90]Yu W C,Chen X F,Hu X B,Xu X G 2016J.Synthetic Crystals45 1(in Chinese)[郁万成,陈秀芳,胡小波,徐现刚2016人工晶体学报45 1]
[91]Chen X,Wu B,Liu Y 2016Chem.Soc.Rev.45 2057
[92]Li G,Zhou H,Pan L,Zhang Y,Huang L,Xu W,Du S,Ouyang M,Ferrari A,Gao H J 2015J.Am.Chem.Soc.137 7099
[93]Leong W S,Gong H,Thong J T 2014ACS Nano8 994
[94]Park H Y,Jung W S,Kang D H,Jeon J,Yoo G,Park Y,Lee J,Jang Y H,Lee J,Park S,Yu H,Shin B,Lee S,Park J 2016Adv.Mater.28 864
[95]Cheng C,Huang B,Liu J,Zhang Z 2016IEEE Electron Dev.Lett.37 1
PACS:85.30.Tv,73.50.–h,73.22.–f,73.40.Cg DOI:10.7498/aps.66.218502
*Project supported by the National Basic Research Program of China(Grant No.2013CBA01604),the National Natural Science Foundation of China(Grant Nos.61377106,61474072),and the Natural Science Foundation of Beijing,China(Grant No.4162031).
†Corresponding author.E-mail:qianh@mail.tsinghua.edu.cn
Research progress of graphene radio frequency devices∗
Lu Qi1)Lyu Hong-Ming2)Wu Xiao-Ming1)Wu Hua-Qiang1)3)Qian He1)3)†
1)(Institute of Microelectronics,Tsinghua University,Beijing 100084,China)
2)(Rice University,Houston,TX 77005,USA)
3)(Tsinghua National Laboratory for Information Science and Technology,Tsinghua University,Beijing 100084,China)
d 4 July 2017;revised manuscript
4 August 2017)
Graphene,the first realized two-dimensional material,has received much attention in electronic applications in recent years.With ultra-high carrier mobility and one atom thick structure,graphene becomes a promising semiconductor candidate for solving the problem of short channel effect in nanoscale metal-oxide-semiconductor field-effect transistor(MOSFET),and exploring its applications in radio frequency devices.How to develop the advantages of graphene transistor in radio frequency is an attractive research area.The first step is to obtain high quality graphene material.In this article we summarize the graphene growth methods commonly used in electronic field,including chemical vapor deposition on metal substrates and epitaxial method on wide bandgap semiconductor and insulator substrates.Another key factor to improve graphene transistor performance is to carefully design the device structure and process flow.Multi- finger gate and T-shaped gate are widely used in MOSFET.These two structures can signifi cantly reduce gate resistance,and result in a better radio frequency performance. “Inverted process”is introduced for graphene FET fabrication,which is compatible with silicon-based back-end-of-line technology.It can reduce the damages to graphene during fabrication.Another improved self-aligned gate deposition process can lead to a good gate coupling and less parasitic parameters.These newly developed process play a prominent part in increasing the cut-o fffrequency and maximum oscillation frequency of graphene radio frequency devices.In addition,single crystal graphene is helpful in eliminating carriers scattering and improving the radio frequency properties of graphene transistor.So far,the highest cut-o fffrequency of graphene transistor reaches over 300 GHz by a few groups,but the maximum oscillation frequency remains low.Record-high maximum oscillation frequency is 200 GHz when gate length is 60 nm.Further improvement of maximum oscillation frequency needs to be tried out.Several graphene radio frequency circuits are also discussed in the paper.Some of the circuits have similar structures to silicon-based circuits,and others are designed based on the unique property of graphene transistor,like ambipolar transport properties.The new concept circuits have simpler structures than conventional circuits.With the rapid development of graphene growth and related integrating technology,the potential to use graphene in radio frequency field will be further increased.
graphene, field effect transistors,radiofrequency,cut-o fffrequency
石墨烯因具有优良的电学特性,在半导体行业中受到广泛关注,特别因其具有超薄的结构和极高的载流子迁移率,为解决短沟道效应提供了可能,并且在高速电子领域具有应用前景.近年来,使用石墨烯作为沟道材料制备射频晶体管及射频电路是发挥石墨烯材料优势的一个重要研究方向.制造高性能的射频器件,首先要制备出高性能的石墨烯材料.在金属衬底上沉积均匀的单层石墨烯材料或者在绝缘衬底上外延生长单层、双层石墨烯材料都是获得高质量石墨烯材料的常用方法.器件结构及工艺流程的设计也是提升晶体管射频性能的重要因素,多指栅结构、T型栅结构、埋栅结构以及自对准工艺的发展能够有效改善石墨烯射频晶体管的截止频率及最大振荡频率.石墨烯晶体管独特的电学特性使得其除了可以构造与其他半导体材料电路相似的射频电路结构,还可以构造出功能完整并且结构更加简单的新型射频电路结构.
10.7498/aps.66.218502
∗国家重点基础研究发展计划(批准号:2013CBA01604)、国家自然科学基金(批准号:61377106,61474072)和北京市自然科学基金(批准号:4162031)资助的课题.
†通信作者.E-mail:qianh@mail.tsinghua.edu.cn
©2017中国物理学会Chinese Physical Society
