GaN基半导体异质结构的外延生长、物性研究和器件应用
2017-07-24杨学林王茂俊许福军王新强秦志新
沈 波*,唐 宁,杨学林,王茂俊,许福军,王新强,秦志新
1北京大学宽禁带半导体研究中心2北京大学人工微结构和介观物理国家重点实验室3北京大学信息与科学技术学院微纳电子学系
GaN基半导体异质结构的外延生长、物性研究和器件应用
沈 波1,2*,唐 宁1,2,杨学林1,2,王茂俊1,3,许福军1,2,王新强1,2,秦志新1,2
1北京大学宽禁带半导体研究中心2北京大学人工微结构和介观物理国家重点实验室3北京大学信息与科学技术学院微纳电子学系
GaN基宽禁带半导体异质结构具有非常强的极化效应、高饱和电子漂移速度、高击穿场强、高于室温的居里转变温度、和较强的自旋轨道耦合效应等优越的物理性质,是发展高功率微波射频器件不可替代的材料体系,也是发展高效节能功率电子器件的主要材料体系之一,在半导体自旋电子学器件上亦有潜在的应用价值。GaN基异质结构材料、物理与器件研究已成为当前国际上半导体科学技术的前沿领域和研究热点。本文从GaN基异质结构的外延生长、物理性质及其电子器件应用三个方面对国内外该领域近年来的研究进展进行了系统的介绍和评述,并简要介绍了北京大学在该领域的研究进展。
GaN基宽禁带半导体;外延生长;二维电子气;输运性质;自旋性质;GaN基电子器件
I.引言
新型半导体材料和器件的发展,及相关的半导体物理进步,往往推动着新的技术革命和新兴产业的诞生。以GaN为代表的III族氮化物(又称GaN基)宽禁带半导体及其低维量子结构以其优异的光电物理特性,继第一代半导体Si、Ge和第二代半导体GaAs、InP之后,成为第三代半导体的主要材料体系,也成为当前半导体科学技术和半导体物理的主要研究领域之一。
GaN基半导体由InN、GaN、AlN三种直接带隙化合物半导体材料及其组分可调的三元、四元合金组成,其禁带宽度室温下从 InN的 0.63 eV到 AlN的6.2 eV连续可调,覆盖了从中红外到深紫外的宽广波长范围,是迄今禁带宽度调制范围最宽的半导体体系。同时,由于平衡态的GaN基半导体是六方对称的纤锌矿晶体结构,在[0001]方向缺乏反演对称性,加上化学键极性很强,GaN基半导体及其异质结构具有很强的自发和压电极化效应,极化感应电场高达MV/cm量级。带隙调制范围宽和极化效应强是GaN基半导体区别于其他半导体体系最重要的两个物理特征。
上世纪 80年代末、90年代初日本名古屋大学Akasaki、Amano课题组和日亚化学公司Nakamura课题组分别在GaN及其InGaN/GaN量子阱材料的外延生长和 p型掺杂上取得了重大突破[1−3],并研制出高亮度蓝光发光二极管(LED),直接导致了半导体照明产业的高速发展,引发了照明技术的革命性变化,为此,这三位科学家获得了2014年诺贝尔物理学奖。近年来,随着高效蓝光、白光LED研究的不断成熟,GaN基半导体材料质量快速提升,基于GaN基半导体异质结构和二维电子气(2DEG)特性的电子材料和器件逐渐成为GaN基宽禁带半导体新的研究热点,主要涉及GaN基半导体异质结构的外延生长、物理性质研究和电子器件研制。
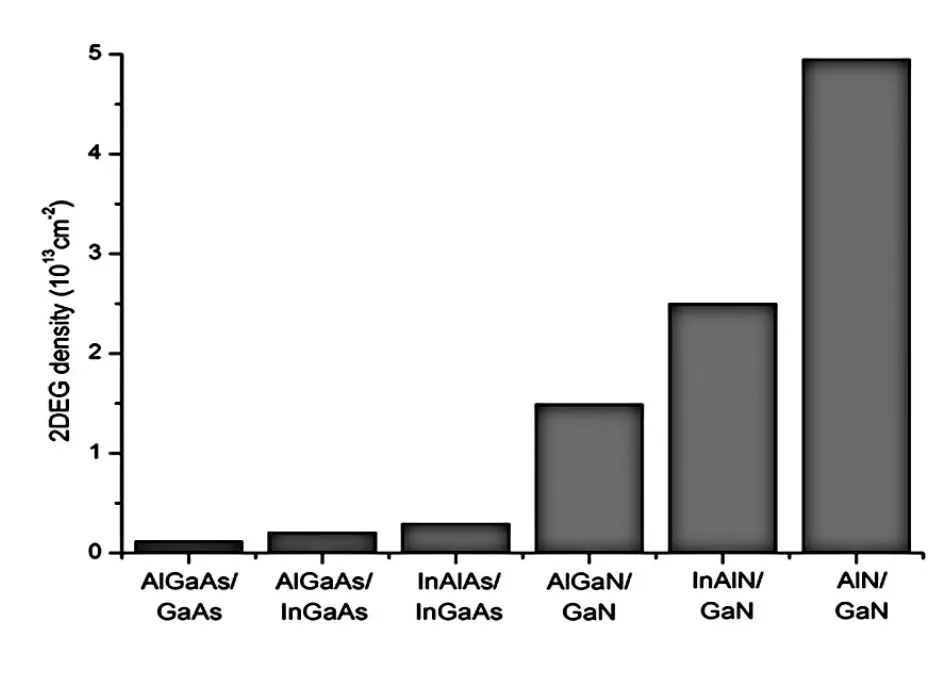
图1.各种化合物半导体异质结构中2DEG面密度比较
GaN基半导体异质结构主要包括AlGaN/GaN、InAlN/GaN和AlN/GaN等,其中AlGaN/GaN异质结构是目前使用最广、材料综合性能最好的GaN基异质结构。根据不同的应用需求,GaN基异质结构可以外延生长在蓝宝石、SiC或 Si衬底上。由于很强的极化效应,GaN基异质结构中2DEG面密度可达1013cm−2量级,是迄今2DEG密度最高的半导体材料体系,如图1所示意。加上其具有的高饱和电子漂移速度、高击穿电场、抗辐射、耐腐蚀等优越的物理、化学性质,非常适合发展高功率微波射频器件和高效节能功率电子器件。在微波功率器件方面,基于GaN基异质结构,特别是AlGaN/GaN异质结构的高电子迁移率晶体管(HEMT)具有输出功率密度高、工作频率高、工作温度高、工作带宽高等优越性能,能满足新一代电子装备对微波射频器件更大功率、更高传输速度、更小体积以及更高工作温度的要求,在相控阵雷达、卫星通讯、电子对抗等军事领域和移动通讯等民用领域具有不可替代的重大应用价值。在功率电子器件(又称电力电子器件、功率开关器件)方面,由于GaN基异质结构的高2DEG密度,基于GaN基异质结构的功率电子器件的导通电阻比相应的Si和SiC器件分别低两个和一个数量级,节能效益显著,并具有开关速度快、体积小、工作温度高等优势,在工业控制、电动汽车、IT以及消费电子领域具有广泛应用价值。现今全球70%以上的电力电子系统是由基于功率电子器件的电力管理系统所控制,而目前占主导地位的Si功率电子器件自身有5∼8%的能量损耗,且体积较大、工作温度低,经过多年的发展器件性能已接近Si材料性质的物理极限,进一步提升空间有限,迫切需要在新的半导体材料体系下发展新型的高效节能功率电子器件。基于GaN基异质结构的HEMT器件有望成为下一代高效节能功率电子器件最有希望的竞争者之一。
II.GAN基半导体异质结构的外延生长
A.GaN基异质结构外延生长概述
1991年,就在GaN基LED取得突破不久,美国APA Optics公司和南卡大学的Khan等利用金属有机物化学气相沉积(MOCVD)方法首次在蓝宝石衬底上外延生长出AlGaN/GaN异质结构[4],室温下2DEG迁移率只有620 cm2/Vs。 1993年他们进一步研制出国际上第一只GaN基HEMT器件[5],由于异质结构2DEG迁移率较低,器件只有静态特性,没有微波特性。他们的工作开创了GaN基异质结构及其电子器件研究。
高阻GaN外延层生长是获得高质量GaN基异质结构的基础。如果异质界面2DEG沟道下面的GaN层电阻不够高,将会产生并行沟道,使电子器件的夹断特性和频率特性恶化。而外延生长的非故意掺杂GaN因点缺陷的存在一般呈n型,不能满足GaN基异质结构制备的需要。瑞典皇家理工学院Aggerstam等最早提出了掺Fe杂质实现高阻GaN[6]。考虑到MOCVD外延生长中Fe掺杂源关断后的残留效应,仅在1/3厚度GaN中掺Fe,以保证AlGaN/GaN异质界面处没有Fe杂质残留。采用这种方法实现的AlGaN/GaN异质结构既没有并行沟道,也基本避免了 Fe杂质的散射,2DEG室温迁移率提高到了1720 cm2/Vs[6]。这一高阻GaN外延方法目前已在GaN基微波功率器件研制中被广泛采用。 但是强电场下GaN中Fe的稳定性不够好,而需要承受高压的GaN基功率电子器件中存在强电场。加拿大微观结构科学研究所的Webb等在分子束外延(MBE)中以CH4作为掺杂源发展了C掺杂实现高阻GaN的方法[7],电阻率达106Ω·cm[7]。由于C杂质在强电场下比Fe杂质稳定,掺C实现高阻GaN在GaN基功率电子器件研制中获得了广泛使用。2007年,北京大学许福军等采用MOCVD位错自补偿方法也实现了高阻GaN外延生长[8,9],如图2所示,GaN薄膜方块电阻最高超过了1011Ω/sq,表面平整度可保持在0.16 nm,在此高阻GaN薄膜上制备出了高质量AlGaN/GaN异质结构。

图2.GaN外延薄膜方块电阻(Rs)、刃型位错(ETD)密度、螺型位错(STD)密度随MOCVD外延生长中成核层退火压力的变化规律[8]。
2001年,美国卡内基梅隆大学的 Hsu等提出在 AlGaN/GaN异质界面采用一层很薄的 AlN插入层 (interlayer)[10],如图 3所示,该插入层可显著改善AlGaN/GaN异质结构中2DEG的输运性质。UCSB的Shen等人实验确认采用这一方法,2DEG室温迁移率可超过 2000 cm2/Vs[11−12]。他们的工作大大推动了GaN基异质结构材料质量的改善和HEMT器件性能的提升。日本名古屋工业大学 Miyoshi等对AlN插入层的功能进行了详细分析[13],确认1 nm厚的AlN插入层可显著改善异质结构中2DEG输运性质的原因主要有:(1)AlN将沟道中的2DEG与三元合金AlGaN势垒隔开,而且AlN与GaN的导带阶跃更大,大大提高了电子向AlGaN层中隧穿的势垒高度,降低了隧穿几率,从而显著降低了沟道电子受到的合金无序散射;(2)由于AlN插入层很薄,在GaN外延层生长时,不会因为大晶格失配出现晶格驰豫使界面变得粗糙,因此在减少合金无序散射的同时,并没有增加界面粗糙度散射,从而2DEG的迁移率可大幅提高。
无疑增加 AlGaN势垒层中 Al组分能有效提高 AlGaN/GaN异质结构中的势垒高度,从而增强对2DEG的量子限制效应。然而在MOCVD外延生长过程中,由于 Al原子的表面迁移困难,会使 Al-GaN势垒层随Al组分提高出现质量下降现象,从而对2DEG的散射增强。另一方面,Al组分的增加会提高AlGaN势垒层的合金无序程度,从而增加合金无序散射。因此,对AlGaN/GaN异质结构而言,AlGaN势垒层中Al组分存在一个最佳范围,大量实验确认这个范围为0.2∼0.3之间,对应的势垒层厚度最佳范围为15∼25 nm,这样的组份和厚度一般不会引起势垒层的应变弛豫。
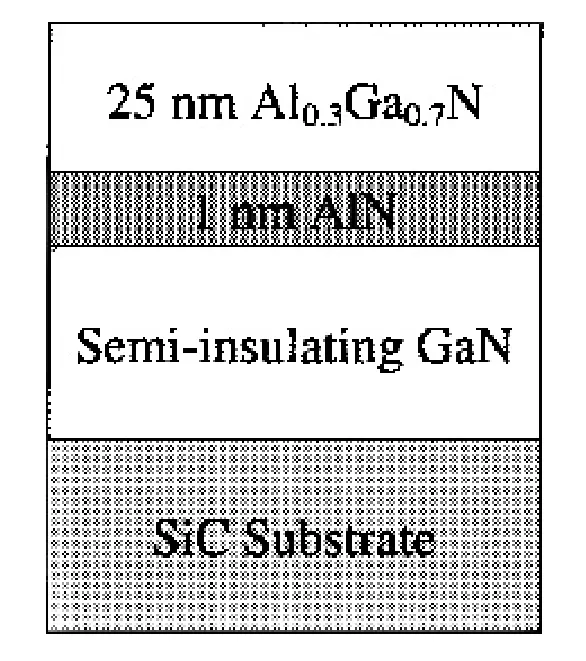
图3.有AlN插入层(Interlayer)的AlGaN/GaN异质结构示意图[10]。
B.SiC衬底上GaN基异质结构的外延生长
由于SiC的热导率远大于GaN、Si和蓝宝石,应用于相控阵雷达和室外移动通讯基站的高功率 GaN基微波器件必须采用SiC衬底,以提高器件的散热特性,降低器件结温。随着 SiC单晶生长技术的进步,目前3∼4英寸SiC单晶衬底已广泛使用于GaN基微波功率器件研制,6英寸SiC单晶衬底在国际上也已开始使用。
SiC衬底上GaN基异质结构外延生长遇到的主要问题有:(1)由于GaN在SiC衬底上的浸润性很差,很难成核,直接在SiC上生长的高温GaN一直处于岛生长状态,很难合并成二维台阶流生长,表面十分粗糙;(2)由于SiC的热膨胀系数(4.2×10−6K−1)小于 GaN(5.6×10−6K−1),当外延片从高温生长温度降至室温过程中,GaN将受到来自SiC衬底的张应力,容易产生裂纹。考虑到Al原子在SiC表面有很好的粘附性,SiC衬底上外延GaN一般先选用AlN或者AlGaN作为成核层,它们不仅能促进成核,还能够在生长过程中引入压应力,从而平衡降温过程中的张应力,防止外延层龟裂。1995年,美国北卡罗来纳州立大学Weeks等在6H-SiC衬底上用AlN作为成核层,得到了表面光滑平整的 GaN外延薄膜[14]。1999年,法国CNRS的Lahreche等采用AlGaN成核层生长出高质量GaN[15],并比较了与AlN成核层的差异。比利时IMEC的Boevkens等在4H-SiC衬底上用 AlGaN作为成核层[16],发现至少需要生长 250 nm厚度的成核层,后续外延的GaN才不会出现裂纹。2010年,我国山东大学徐现刚等通过优化AlN缓冲层温度,在6H-SiC衬底上生长了4.5µm无龟裂GaN外延薄膜[17],XRD摇摆曲线(002)和(102)半峰宽分别为159′′和194′′。2015年,瑞典Link¨oping大学课题组对SiC衬底在高温下进行H2预期处理再外延GaN[18],也获得了1.6µm厚高质量GaN外延层,XRD摇摆曲线(002)和(102)半峰宽分别达到149′′和194′′。
由于晶格失配较小,相对于Si和蓝宝石衬底,一旦解决了浸润层和龟裂问题,SiC衬底上GaN晶体质量更好,因而SiC衬底上GaN基异质结构2DEG的输运性质也更好。UCSB、Link¨oping大学等国际上多个研究机构,以及Cree、TriQuint/RFMD、Fujitsu、IAF等美、日、欧知名的化合物半导体公司均已开展 SiC衬底上 GaN基异质结构外延生长和微波功率器件研究多年, 多个研究机构和公司的 SiC衬底AlGaN/GaN异质结构2DEG室温迁移率普遍超过2000 cm2/Vs[19−21],2007年我国中科院半导体所王晓亮等研制的SiC衬底AlGaN/GaN异质结构2DEG室温迁移率达到了2215 cm2/Vs[22],随后国内多所大学和研究机构,如中电集团13所、55所、西安电子科技大学、北京大学、中科院物理所等也可以制备出高质量的SiC衬底AlGaN/GaN异质结构材料。
C.晶格匹配InAlN/GaN异质结构的外延生长
为了使GaN基HEMT器件达到超高频率,如毫米波、太赫兹波段的应用要求,需要进一步降低异质结构势垒层厚度来避免短沟道效应。但是AlGaN势垒层厚度降到10 nm以下时,2DEG密度会随厚度减小急剧下降,这一因素限制了AlGaN/GaN异质结构在超高频电子器件上的应用潜力。
2001年,斯洛伐克科学院 Kuzm´ık首先提出利用In组分0.17∼0.18、与GaN晶格匹配的InAlN合金代替 AlGaN作为异质结构势垒层[23],虽然没有了压电效应, 但很强的自发极化效应使超薄势垒层的InAlN/GaN异质结构依然具有很高的2DEG密度(可达到3×1013cm−2)。同时,InAlN/GaN异质结构具有较大的导带阶跃,可以增强2DEG的空间量子限制效应。
2006年,瑞士洛桑联邦理工学院 (EPFL)Gonschorek等成功地外延生长出较高质量的InAlN/GaN异质结构[24],室温下2DEG面密度2.6×1013cm−2,迁移率达1170 cm2/Vs。2008年,该课题组制备的3 nm超薄势垒层InAlN/GaN异质结构2DEG面密度达到 1.0×1013cm−2[25]。2014年,UCSB研究组在GaN自支撑衬底上外延的InAlN/GaN异质结构室温下2DEG迁移率达到1800 cm2/Vs[26],方块电阻低至123 Ω/?,用其制备的HEMT器件饱和输出电流密度达到1 A/mm。2015年,我国中电集团13所房玉龙等外延生长出3 nm厚势垒层的InAlN/GaN异质结构,室温2DEG迁移率达到2175 cm2/Vs[27],面密度为1.39×1013cm−2。2015年,北京大学桑玲等通过界面控制和位错抑制,将InAlN/GaN异质结构室温2DEG迁移率进一步提高到了2220 cm2/Vs[28],面密度为1.25×1013cm−2。该课题组苗振林等经过量子输运测量,测定InAlN/GaN异质界面量子阱中第一和第二子带上的 2DEG面密度分别为 1.92×1013cm2和1.67×1012cm−2,两个子带的能量差高达191 meV,远大于AlGaN/GaN异质结构[29]。由于晶格匹配 InAlN/GaN异质结构材料质量的进步, 2013年美国圣母大学Grace Xing等研制的InAlN/GaN异质结构HEMT器件截止频率达到了400 GHz[30]。但目前InAlN/GaN异质结构材料质量与AlGaN/GaN异质结构相比,依然还有较大差距,制备的器件栅漏电比较严重,输出功率密度较低。
另外,具有超薄势垒层的AlN/GaN异质结构也可以避免短沟道效应,用于研制毫米波、THz波段的超高频电子器件。2013年美国 HRL实验室研制的AlN/GaN异质结构HEMT器件截止频率超过了 450 GHz[31]。 类似于 InAlN/GaN异质结构,目前AlN/GaN异质结构材料质量在2DEG迁移率以及低阻值欧姆接触等方面与AlGaN/GaN异质结构相比也还有较大差距,相关工作需进一步深入。
D.Si衬底上GaN基异质结构的外延生长
Si衬底上GaN基异质结构的外延生长和功率电子器件研制是近几年国际上GaN基宽禁带半导体领域的研究热点之一。采用Si衬底的主要原因是材料和器件成本的考虑。尽管GaN基功率电子器件相对广泛使用的Si器件节能效益明显,器件其他性能优势也很突出。但目前GaN基功率电子器件制备成本相对于Si器件依然非常昂贵。解决成本问题的唯一出路是采用Si衬底外延生长GaN基异质结构,然后用生产Si器件的互补金属氧化物半导体(CMOS)工艺来制备GaN基器件,从而使器件性价比可优于 Si器件。另外,目前大尺寸Si晶片材料已经非常成熟,如采用 6∼8英寸Si衬底,GaN的MOCVD外延成本可大幅降低。但Si衬底外延GaN的难度远高于SiC和蓝宝石衬底。GaN晶体(0001)面和Si晶体(111)面的晶格失配高达16.9%,热膨胀系数失配(热失配)更是高达56%,因此,Si衬底上外延生长GaN及其异质结构在应力控制和缺陷控制上面临严峻的挑战。

表I.Si衬底上AlGaN/GaN异质结构2DEG室温迁移率国际对比
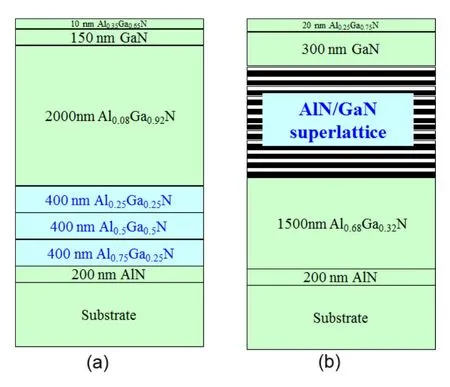
图4.Si衬底上外延生长 GaN基异质结构的两种主流技术路线。(a)以比利时IMEC为代表的Al组分梯度渐变多层AlGaN缓冲层方法样品结构示意图[33],(b)以日本NTT为代表的AlN/GaN超晶格缓冲层方法样品结构示意图[34]。
经过多年探索,国际上先后发展了低温AlN插入层[32],梯度渐变AlGaN缓冲层[33]、AlN/GaN超晶格缓冲层[34]等基于柔性衬底物理思想的 Si衬底 GaN外延生长方法。1999年,日本名古屋大学Ishikawa等在AlN成核层与GaN之间插入250 nm的AlGaN缓冲层[35],第一次在 Si衬底上实现了 1µm 厚无龟裂的GaN外延薄膜。2000年,德国马德堡大学 Krost课题组采用低温AlN插入层方法实现了Si衬底上超过 1µm厚的无龟裂 GaN外延生长[32]。2011年他们进一步采用6层低温AlN插入层方法使无龟裂GaN外延层厚度达到了 14.3µm[36]。 2009年,日本名古屋工业大学课题组采用AlN/GaN超晶格缓冲层方法,在4英寸Si衬底上生长了厚度达9µm的无龟裂GaN外延层[37]。目前国际上形成了以比利时IMEC为代表的Al组分梯度渐变多层AlGaN缓冲层方法,和以日本NTT为代表的AlN/GaN超晶格缓冲层方法制备Si衬底上GaN的两种主流技术路线,如图4所示。
近几年,国际上 Si衬底 GaN基异质结构材料晶体质量和电学性质提升很快,高阻 GaN外延层的 XRD摇摆曲线半高宽 (002)和 (102)可分别小于400和600 arcsec,非高阻GaN外延层(002)摇摆曲线半高宽可降到300 arcsec以下。国际上多个课题组实现了2DEG室温迁移率超过2000 cm2/V·s的高质量Si衬底AlGaN/GaN异质结构,相关国际对比和参考文献出处见表I。同时Si衬底上GaN基异质结构的外延尺寸不断增大,外延片直径已经从2∼4英寸扩大到了6∼8英寸。
2015年,北京大学程建朋等发展了拥有自主知识产权的一种大晶格失配诱导应力调控方法外延生长Si衬底上GaN[38−39],即采用单层低Al组分AlGaN为控制层,同时实现对Si衬底上GaN外延层的应力控制和位错抑制,在4∼6英寸Si衬底上外延生长出高质量的无龟裂GaN,实验确认大部分刃型位错在AlN和低Al组分AlGaN界面处发生转弯或湮灭,进一步外延生长的AlGaN/GaN异质结构室温2DEG迁移率达到了2240 cm2/Vs,面密度7.7×1012cm−2.室温下异质结构方块电阻均匀性为1.3%。
随着Si衬底上GaN基异质结构外延质量的不断改善,近年来国际上Si衬底GaN基功率电子器件的性能也不断提升,已实现了比导通电阻为1.6 mΩ·cm2,耐压为 1900 V 的耗尽型器件,以及比导通电阻为 1.48 mΩ·cm2,耐压为 705 V的增强型器件[40]。日本Panasonic和美国Transphorm、EPC等公司先后推出了200∼600 V等级的GaN基功率电子器件试用产品,示范应用包括电动汽车,分布式光伏发电、大数据中心和无线充电等需要高效电源管理的领域。但迄今为止,Si衬底上GaN基异质结构的材料质量和电学性质与已经比较成熟的蓝宝石、SiC衬底上异质结构相比,依然存在明显差距,特别是Si衬底上GaN外延片可观的残余应力、局域陷阱态及其带来的材料、器件可靠性问题还相当严重,应力和缺陷控制问题尚没有根本解决。如何研究制备出更高质量的 Si衬底上GaN基异质结构,依然是当前该领域高度关注的核心问题之一。
III.GAN基半导体异质结构的物理性质
A.GaN基异质结构的基本物理性质
GaN基半导体被认为是最适合于高温、高频、高功率电子器件的优选半导体材料体系,这是由其一系列优异物理性质决定的。表II列出了主要的电子器件用半导体材料的一些基本物理性质[41−45],可以对比发现GaN基材料独具的优异特性。
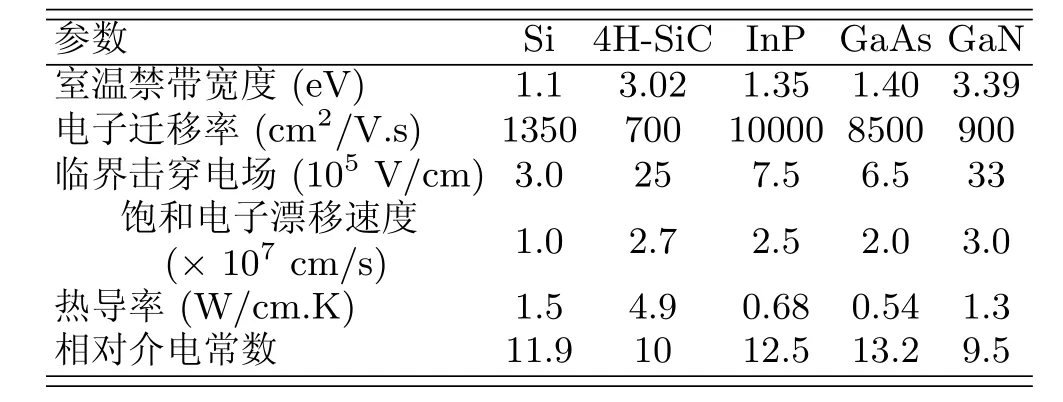
表II.常见电子器件用半导体材料的基本性质对比
第一,GaN基半导体非常大的禁带宽度。决定半导体器件输出功率和最高工作温度的主要因素之一是材料的禁带宽度。GaN的禁带宽度远大于Si和GaAs,因而 GaN基材料在高温和高辐射的情况下本征激发载流子较少,对研制高温、大功率器件非常有利。理论计算表明 GaN基器件的最高有效工作温度可达900◦C[46]。实验也表明基于AlGaN/GaN异质结构的HEMT器件在500◦C时依然有很好的微波放大性能[47]。此外,高工作温度有利于大大降低功率转换系统中冷却系统的负担,易于实现轻量化、小型化和高集成度。
第二,GaN和 AlGaN合金之间很大的导带阶跃(∆EC)。由于均为六方晶体结构,GaN和AlGaN合金之间可以形成高晶体质量的半导体异质结构,从而在异质界面形成具有高迁移率的2DEG。这是GaN基材料在电子器件应用上相对于另一类宽禁带半导体材料SiC的最大优势。更加重要的是GaN和AlN之间禁带宽度差异很大,而且理论计算表明禁带宽度差异的75%以上落在导带上[48]。因此,AlGaN/GaN异质界面 ∆EC远大于 AlGaAs/GaAs界面。例如:室温下 AlN/GaN异质界面禁带宽度差异为 2.8 eV, AlAs/GaAs界面禁带宽度差异仅为0.75 eV,相差接近4倍。这一特点决定了AlGaN/GaN异质界面三角形量子阱远比AlGaAs/GaAs界面深。
第三,GaN基异质结构中非常强的自发和压电极化效应[49]。这也是GaN基异质结构最为显著的特点。理论计算表明当AlGaN合金中的Al组份大于0.2时,异质界面压电极化电场高于106V/cm[50]。极化效应对异质界面能带产生极强的调制,导致垂直于异质界面方向上1.0 nm的空间间距就会产生大于0.1 eV的导带弯曲。由于AlGaAs/GaAs异质结构中不存在极化效应,这种极化效应的巨大差异导致AlGaN/GaN异质界面的能带弯曲远大于AlGaAs/GaAs界面,进而前者异质界面三角形量子阱远深于后者。因此,即使不采用势垒层调制掺杂,AlGaN/GaN异质界面的2DEG面密度也可高达 1013cm−2量级,比 AlGaAs/GaAs大5∼10倍。而HEMT器件的输出功率密度显著依赖于异质结构的2DEG密度。
第四,GaN基半导体非常高的临界击穿电场。这一特性对于功率电子器件至关重要,是决定器件最大功率处理能力的基本参量。GaN的临界击穿电场大于3×106V/cm[51],比Si和GaAs大得多,AlGaN合金的临界击穿电场又高于GaN。
第五,GaN基半导体非常高的饱和电子漂移速度。实验表明 GaN的饱和电子漂移速度约为 3.0×107cm/s,而Si和GaAs分别为1.0×107cm/s和2.0× 107cm/s[52]。在高频器件中电流增益特征频率和电子渡越时间成反比,饱和漂移速度直接影响电子器件的频率特性,因此具有高饱和漂移速度的GaN基材料拥有很好的高频特性。此外,GaN基半导体还具有很低的介电常数、比较高的热导率,都非常有利于高功率、高频电子器件研制。
B.GaN基异质结构2DEG的高场输运性质
影响GaN基异质结构中2DEG迁移率的散射机制主要包括合金无序散射,离化杂质散射,界面粗糙度散射,声学声子散射(包括形变势散射和压电散射),以及极化光学声子散射等。随着外延方法的不断改进,蓝宝石、SiC、Si等不同衬底上GaN基异质结构性能不断改善,室温2DEG迁移率(也可称为低场迁移率)均已突破2000 cm2/Vs[38,53−54]。

图5.高电场下,GaN中电压控制型负微分电导效应在数十ns时间内转变为电流控制型负微分电导效应[55]。
然而,随着电子器件特征尺寸不断缩小,沟道中的电场不断增加,强电场下GaN基异质结构中2DEG的输运行为对器件性能的影响日趋明显,发展到当今的GaN基电子器件工作性能更多地取决于高场条件下非平衡载流子(热电子)的输运行为。相关研究表明高电场下热电子的能量耗散是决定其漂移速度的关键因数,受热声子效应影响,GaN中实际能够实现的电子最高漂移速度远低于理论预期[55]。北京大学马楠等对这一问题进行了持续的研究,他们运用自行设计并搭建的高场测量设备,与中电集团13所合作,系统研究了GaN基材料的高场输运性质,观察到了GaN中由耿氏不稳定性导致的电流控制型负微分电导效应[55],结果如图 5所示。马楠等结合样品结构设计,进一步观察到高场下GaN沟道中电子漂移速度的尺寸效应[56],即在微米到数十微米的尺度范围内,较窄沟道中的电子漂移速率更快,结果如图6所示。结合理论计算确认此效应与热电子在高场下的能量弛豫和动量弛豫机制有关,据此提出了在GaN基异质结构中有效提高电子漂移速度的途径。最近,北京大学郭磊等进一步发现通过光照方法,可把 GaN沟道中电子漂移速度从1.4×107cm/s提高至2.0×107cm/s[57],进一步实验确认,由于空穴和晶格之间的强耦合作用使空穴在高场下难以被加速,其能量(温度)低于热电子而成为“冷”空穴,通过电子和空穴之间的能量转移过程,这种“冷”空穴可以加速高场下热电子的能量弛豫,进而提高高场下的电子漂移速度。
C.GaN基异质结构2DEG的量子输运性质
在半导体物理研究中,磁输运(量子输运)测量一直是研究半导体低维量子体系精细能带结构、电子态占据状态和载流子散射机制的主要研究手段之一。通过改变温度﹑磁场、光照等外加条件,可以获得丰富的半导体低维量子体系输运信息。
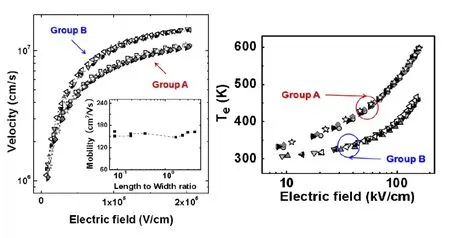
图6.GaN沟道中电子漂移速度的尺寸效应,宽沟道中电子漂移速度低于于窄沟道[56]。 左图是电子漂移速度随场强的变化关系,右图是电子温度随场强的变化关系。Group A表示宽沟道样品,沟道宽度∼10µm,Group B表示窄沟道样品,沟道宽度∼µm。

图7.实验观测到的AlGaN/GaN异质结构中SdH振荡的双周期现象(左)及其对应的异质界面量子阱中双子带占据示意图(右)[58]
AlGaN/GaN是迄今GaN基电子器件研制最重要的异质结构材料,对其异质界面量子阱中子带占据和散射的研究对于提升器件性能非常重要,我国科学工作者在这方面做了较为系统的研究。2000年,南京大学郑泽伟等首次观察到了AlGaN/GaN异质结构中舒伯尼科夫—德哈斯(SdH)振荡的双周期现象[58],如图 7所示,揭示了异质界面量子阱的双子带占据行为。他们进一步发现当异质结构中 2DEG面密度达到7.3×1012cm−2时,异质界面量子阱中的第二子带开始被2DEG占据,并确定界面量子阱中第一子带和第二子带之间的能量间距为75 meV。随后,同课题组进一步用迁移率谱方法测定了第一子带和第二子带上载流子不同的迁移率和量子散射时间[59]。中科院上海技物所蒋春萍等对不同势垒厚度AlGaN/GaN异质结构中2DEG量子输运性质进行了系统研究,发现当势垒层厚度超过25 nm后,部分的晶格弛豫造成2DEG量子输运性质的恶化[60]。北京大学的唐宁等在双子带占据的AlGaN/GaN异质结构中观察到子带间散射引起的磁电阻振荡[61],如图8所示,其振荡幅度随温度上升而略有减小,振荡的频率为两个子带SdH振荡频率之差。
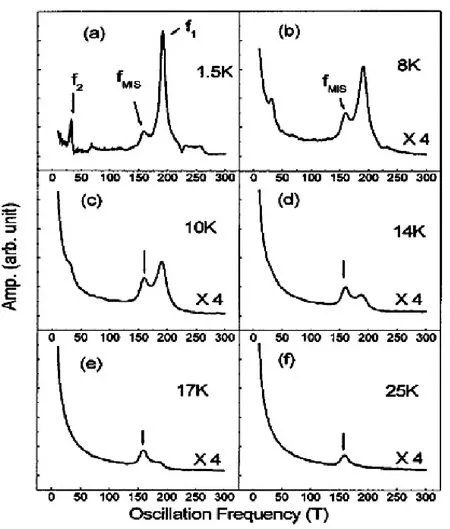
图8.不同温度下AlGaN/GaN异质结构中子带间散射引起的磁电阻振荡频率的变化[61]
AlGaN/GaN异质结构中2DEG密度很高,电子被限制在距离界面数 nm的区域,在此情况下,合金无序散射和界面粗糙度散射成为影响 2DEG迁移率的主要散射机制。实验发现随着 2DEG密度的提高,异质界面量子阱中的高阶子带被电子占据,这时第二子带上的电子相对于第一子带离界面较远,因而第一子带中电子受到的合金无序散射和界面粗糙度散射明显大于第二子带中的电子,因而迁移率小于第二子带中的电子[58],异质界面2DEG的总迁移率也会降低。北京大学刘思东等研究了以AlN/GaN超晶格替代高Al组分AlGaN为势垒的GaN基异质结构中 2DEG的量子输运性质[62],异质结构中 2DEG面密度可达 2×1013cm−2,第一子带和第二子带能级间距高达180 meV,远大于通常的AlGaN/GaN异质结构。这样的异质结构中没有合金无序散射,界面粗糙度散射是决定 2DEG迁移率的最主要散射机制。量子输运实验表明AlN/GaN超晶格替代高Al组分AlGaN势垒,可以在进一步提高2DEG密度的同时,保持2DEG较高的迁移率。
D.GaN基异质结构2DEG的本征自旋性质
以电子自旋自由度为基础的自旋电子学器件以速度快、功耗低、集成度高等优点,在未来的信息技术领域有着广泛的应用前景。GaN基半导体具有较长的自旋驰豫时间和高于室温的居里转变温度,同时GaN基异质结构具有很强的极化电场,导致了较强的自旋轨道耦合。因此,GaN基异质结构是研制自旋场效应晶体管富有竞争力的材料体系之一。
材料的有效g因子是决定磁场中塞曼自旋分裂能谱的重要参数。Knap等人通过AlGaN/GaN异质结构磁输运测量得到的有效g因子为g∗=2.00±0.08[63],随后得到的结果为 g∗=2.06±0.04[64]。北京大学的唐宁等也通过磁输运测量研究了AlGaN/GaN异质结构中2DEG的塞曼自旋分裂[65],发现由于交换相互作用,g∗有了显著的增加。随后该课题组卢芳超等制作出AlGaN/GaN异质结构量子点接触器件结构,用低温磁输运研究了量子点接触中各向异性的塞曼分裂[66],测量所得的g∗远大于常规2DEG体系,它们随子带数的减少、沟道的变窄而逐渐增大。分析确认量子点接触结构中g∗的各向异性和异常增大与该结构中自旋轨道耦合和电子交换相互作用随维度的变化有关。
Rashba自旋轨道耦合效应所调制的零场自旋分裂是实现自旋场效应晶体管的主要物理基础。根据Rashba理论,自旋轨道耦合系数和电场成正比,与有效质量和禁带宽度成反比[67]。GaN带隙比较宽,不利于零场自旋分裂的产生。但是AlGaN/GaN异质结构有很强的极化感应电场和很高的2DEG密度,强电场可以增强自旋轨道相互作用,使导带能级的自旋简并度解除,高密度载流子也有利于自旋分裂[68],因此宽带隙的AlGaN/GaN异质结构中也能观察到相当大的零场自旋分裂。日本NTT的Tsubaki等首先用SdH方法观测到了AlGaN/GaN异质结构中2DEG的零场自旋分裂[69],得到的自旋分裂能量为 2.7∼3.6 meV,自旋轨道耦合系数α为2.2×10−12eV·m。 随后北京大学的唐宁等用SdH方法在只有一个子带被占据、Al组分0.11的低Al组分AlGaN/GaN异质结构中也得到类似的结果[70],如图 9所示,说明低 Al组分异质结构中的极化电场已足以产生相当大的自旋分裂,同课题组进一步测定了自旋轨道耦合系数α随异质结构 Al组分(这里可转化为极化电场大小)的变化规律[71]。台湾大学的 Cho和唐宁等用持续光电导方法改变异质结构中的电场,从SdH振荡的变化中观测电场对自旋分裂的调控规律[72−73],证明 Rashba效应是AlGaN/GaN异质结构中2DEG零场自旋分裂的主要来源,并且能够被外加栅压调制,由此证明从Rashba效应的调控角度讲,AlGaN/GaN异质结构在自旋电子学器件上有着很好的应用前景。

图9.自旋分裂引起的的AlGaN/GaN异质结构中2DEG磁阻的拍频振荡(左)及其傅里叶转换图谱(右)[70]
自旋光电流效应是研究半导体中自旋注入及自旋极化的常用方法。由于角动量守恒,圆偏振光在半导体材料中将引起载流子的自旋不平衡分布,从而引起自旋光电流效应。北京大学汤一乔等与中科院半导体所陈涌海课题组合作,首先在室温下观测到了 AlGaN/GaN异质结构中圆偏振自旋光电流效应 (CPGE)[74]。北大同课题组贺小伟等人测量发现AlGaN/GaN异质结构的CPGE电流随外加应力呈线性变化[75],如图 10所示,确认在该型异质结构中Rashba自旋轨道耦合大于Drasselhaus自旋轨道耦合,两者的比例为16:1。同组尹春明等进一步发展了这一工作,测量了不同Al组分AlGaN/GaN异质结构中Rashba/Dresselhaus系数之比[76]。
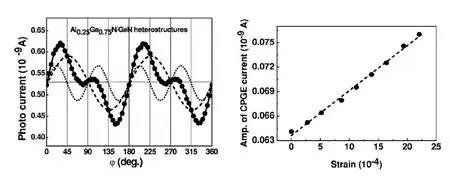
图10.AlGaN/GaN异质结构中CPGE电流随外加应力的变化[75]。左图是不同应力下CPGE电流的测量曲线,右图是CPGE电流随外加应力的变化关系。
根据半导体自旋电子学理论,自旋轨道耦合会引起自旋霍尔效应和逆自旋霍尔效应。通过自旋轨道耦合,电流能够产生垂直电流方向的自旋流,反之自旋流可以产生垂直于其方向的电流[75]。由于这个重要的性质,自旋霍尔效应从提出起就受到了广泛的关注。如图11所示,北京大学的贺小伟等在AlGaN/GaN异质结构中发现了反常CPGE(ACPGE)效应[78],这一室温条件下观测到的实验结果可以运用逆自旋霍尔效应获得合理而唯一的解释,因此AlGaN/GaN异质结构中反常CPGE效应的发现可以被理解为少数室温下可观测到的由逆自旋霍尔效应产生的物理现象之一。

图11.AlGaN/GaN异质结构中反常CPGE的观测结果[78]。左图表明垂直入射时可观测到反常CPGE电流信号,且光斑在电极连线的中垂线上移动时,该流相对于光斑位置是奇对称的。右图是反常CPGE电流随圆偏振光入射角度的化,0◦角度(垂直入射)时反常CPGE电流最大。
同课题组尹春明等进一步研究了AlGaN/GaN异质结构光致反常霍尔效应 (PIAHE)[79]。实验中利用圆偏振光在样品中形成不平衡的自旋极化,而通过外加电场使自旋极化电子往同一个方向漂移,从而形成稳定的自旋流。测量得到AlGaN/GaN异质结构中光致自旋霍尔电导率为 σAH=9.0×10−10Ω−1,与理论计算吻合得很好。随后,同组梅伏洪等提出了一种基于PIAHE和ACPGE研究自旋输运的方法[80],测定了AlGaN/GaN异质结构中2DEG的自旋扩散系数和自旋霍尔迁移率比值。
半导体自旋电子学的发展目前还面临着很大挑战。要实现GaN基异质结构在自旋电子学器件中的应用,除了进一步对自旋输运和自旋弛豫机制进行深入研究,还需要实现高的自旋注入效率。一旦实现了高效率的自旋注入,结合长的自旋弛豫时间,可被栅压调控的自旋分裂等输运性质,GaN基异质结构将会在自旋逻辑器件,量子存储器件,量子计算等方面有着很好的应用前景。
IV.GAN基半导体异质结构的电子器件应用
A.GaN基电子器件研究概况
GaN基电子器件主要有场效应晶体管(FET),双极型晶体管 (BJT),和二极管三大类。国际上最受重视,发展最快的是GaN基FET,主要是GaN基异质结FET(HFET,又称为GaN基HEMT),另外还有GaN基MESFET和GaN基MISFET。GaN基HEMT器件通过栅极电压调控异质界面的能带弯曲,从而控制界面沟道中的 2DEG密度,达到调制源漏间电导的目的。GaN基HEMT,特别是基于Al-GaN/GaN异质结构的器件有一个显著特点,就是异质界面2DEG的面密度ns和迁移率µ的乘积ns×µ远高于GaAs基 HEMT。同时,2DEG的高迁移率进一步拓展了GaN基HEMT的高频功率应用,目前器件工作频率可达到∼100 GHz的W波段。另一方面,2DEG的高输运能力显著降低了GaN基HEMT器件的源漏导通电阻 (ON-resistance),具有很好的高频电能转换效率,因此GaN基HEMT器件在功率电子应用中也非常具有竞争力。
随着GaN基异质结构材料外延质量的不断提升,GaN基电子器件研制近10年来取得了一系列突破。在微波功率器件领域,2004年及随后几年,美国UCSB的吴毅峰、张乃千等创新采用PECVD-SiNx钝化技术和场板技术,使SiC衬底上GaN基HEMT在4GHz频率下输出功率密度超过了40W/mm[81],这是迄今为止所报道的GaN基微波功率器件的最高输出功率密度。同一课题组的Palacios等在2005年报导的GaN基HEMT器件在40 GHz下输出功率密度达到了10.5 W/mm[82]。2012年美国HRL实验室的Shinohara等研制出20 nm栅长的增强型GaN基HEMT,工作截止频率达到 342 GHz,最高振荡频率 fmax高达 518 GHz[83]。在国内,2011年,我国西安电子科技大学郝跃等在3 GHz频率下实现了功率附加效率达73%的高性能MOS-HEMT器件[84],这是迄今为止国际上所报道的GaN基微波器件的最高功率附加效率。近期,中电集团13所吕元杰等结合n型重掺GaN外延再生长欧姆接触技术,研制出fT/fmax为149/263 GHz的GaN基HEMT器件,fT、fmax乘积为当前国际报道最高值。中电集团 55所吴少兵等采用新型电子束一次成型技术,研制的W波段GaN基微波功放芯片在92 G时的输出功率密度达到3.46 W/mm,为目前国际报道最高值[85]。中科院微电子所也在 GaN基微波功率器件和模块上做出了一系列有特色的研究工作。这些单位的工作对满足国家重大需求做出了贡献。
在功率电子器件领域,目前 Si衬底 GaN基 HEMT器件是主流研究方向[86]。尽管GaN基功率电子器件与微波功率器件都是基于GaN基异质结构的HEMT,但功率电子器件有更为苛刻的要求。一方面,功率电子器件的耐压要求在200 V以上乃至上千伏,而射频器件的工作电压在100 V以下,这不仅对 Si衬底 GaN基异质结构外延质量提出了更高要求,而且在器件的栅和场板结构,表面钝化质量等方面也带来了挑战。2012年,美国HRL实验室的Chu等采用原子层沉积(ALD)Al2O3栅介质和复合栅源场板结构研制出耐压1200V的GaN基MIS-HEMT器件[87],并获得了较低的动态导通电阻。另一方面,微波射频用GaN基HEMT器件是耗尽型的,而功率电子器件由于安全性要求,必须采用增强型结构,即不施加栅压时栅下2DEG沟道是断开的。目前制备增强型GaN基功率电子器件的方法主要有3种[88]:(1)采用栅槽刻蚀方法减薄AlGaN势垒层以削弱异质结构中的极化效应,从而耗尽2DEG;(2)采用F离子注入在AlGaN势垒层中引入电负性较强的间隙F−离子,利用其产生的电场来耗尽2DEG;(3)p型帽层方法,即通过在AlGaN/GaN异质结构上加一层p型GaN或者AlGaN,通过pn结形成的空间电荷区耗尽沟道中的2DEG。
虽然当前GaN基电子器件研制已取得了很大发展,并已在军用和民用领域开始实际应用。但依然还存在制约其性能和可靠性的一系列关键科学和技术问题。这里讨论的问题主要有:(1)增强型GaN基电子器件与异质结构能带调制工程,(2)GaN基电子器件表面/界面局域态特性与调控,(3)GaN基器件中的深能级陷阱与强场下的性能退化。
B.增强型GaN基电子器件与异质结构能带调制工程
高性能增强型器件的实现是GaN基电子器件的一大难题。从原理上讲,GaN也可以和Si或SiC半导体一样,在体材料上通过制备MOSFET结构形成增强型器件。但异质结构中高密度2DEG是GaN基异质结构的最大优势,可以大幅降低电子器件的导通电阻。因此如何在具有高密度2DEG的异质结构中实现增强型工作模式是近年及未来一段时间GaN基电子器件的研究焦点之一。
目前GaN基HEMT中实现增强型工作模式的方法主要有栅刻蚀、F离子注入、p型帽层三种方法,以及在电路模块中采用的级联方法[88]。前三种方法均是通过去除或耗尽栅极下异质结构中2DEG的途径实现增强型,最后一种方法采用Si的MOSFET与耗尽型的GaN基 HEMT级联实现增强型,在工作原理上与前三者完全不同,是一种电路技术。
栅刻蚀是国际上最早实现增强型GaN基HEMT的方法,利用刻蚀工艺,部分或全部去除栅下的 Al-GaN 势垒层,削弱极化电场的作用,去除和降低 2DEG密度,进而实现增强型。由于在器件微加工过程中需要对AlGaN势垒层进行减薄,ICP等干法刻蚀过程引起晶格的较大损伤,降低了增强型沟道的电子迁移率,导致增强型器件导通电阻上升。针对这一问题,韩国庆北大学和三星公司的联合研究组采用TMAH湿法处理,可有效去除刻蚀表面的高缺陷层,明显提升了沟道中载流子迁移率[89]。北京大学王野等发展了氧化加湿法腐蚀的数字化AlGaN势垒层刻蚀方法,把增强型GaN器件MOS沟道中载流子的峰值场效应迁移率提高到了 251 cm2/V·s[90]。全刻蚀AlGaN势垒层之后形成的增强型沟道本质上是MOS沟道,由于无法生长出像Si器件中近乎完美的SiO2介质层,GaN基MOS沟道中载流子迁移率较低,制约了器件性能。近年国际上的发展趋势是采用AlGaN势垒层局部刻蚀,形成增强型2DEG沟道,即增强型MOS-HEMT器件,可提高沟道中的载流子迁移率。中科院微电子所黄森等采用高温ICP刻蚀方法,有效减小了刻蚀损伤,把增强型沟道中载流子迁移率提高到600 cm2/V·s[91]。香港科技大学陈敬等通过在GaN沟道中引入AlN插入层,增强型沟道电子的峰值场效应迁移率达1801 cm2/V·s[92]。但由于极化电场的影响,这种器件结构难以同步实现3 V以上的阈值电压。
GaN基半导体化学稳定性好,难以被刻蚀。与此同时,由于在 GaN基半导体表面存在氧化层,基于 Cl基的等离子体刻蚀存在刻蚀速率不稳定、刻蚀深度重复性差等问题。更为严重的是由于强极化电场,AlGaN势垒层的能带弯曲很剧烈,所保留的AlGaN势垒层厚度决定了器件所能达到的阈值电压。美国MIT的研究人员采用AlN插入层和SF6作为刻蚀气体,利用AlF3不易挥发的特点,在n-GaN/AlN/GaN结构中实现了自停止刻蚀[93]。北京大学徐哲等发展了基于干法氧化加湿法腐蚀的自停止AlGaN势垒层刻蚀方法,该方法有效提高了栅刻蚀的一致性[94]。同课题组林书勋等在此基础上进一步发展了自停止、无等离子体、部分势垒层刻蚀的方法[95],如图12所示,准增强型沟道的载流子迁移率提升到了1400 cm2/V·s,阈值电压均匀性可保持在±0.1 V。
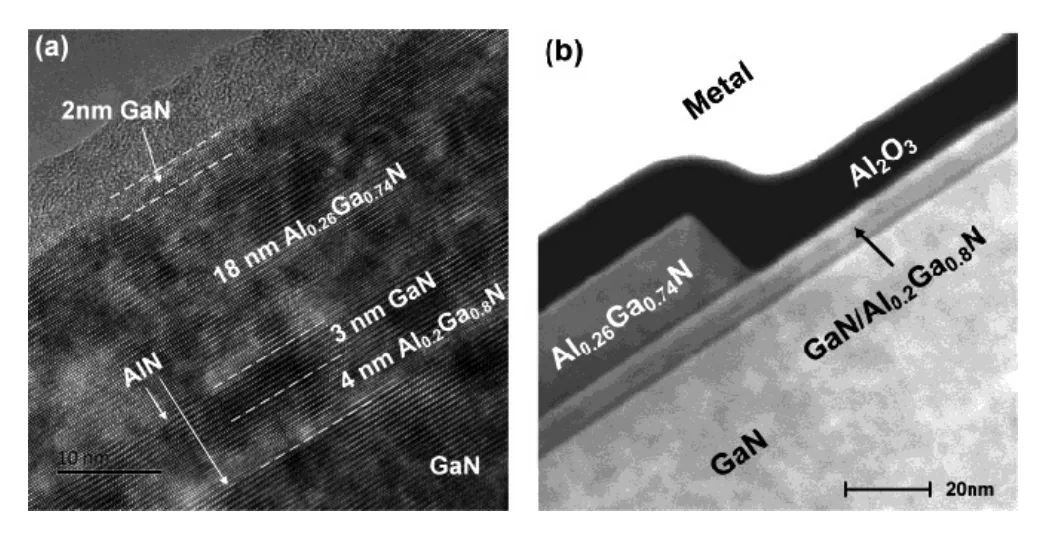
图12.实现自停止/无等离子体/部分势垒层刻蚀的 GaN基HEMT材料结构(左) 和器件结构(右)的TEM照片[95]
香港科大陈敬等提出的 F离子注入法是增强型 GaN基器件发展过程中富有特色的技术路线[88]。由于F离子具有较强的电负性,在离子注入或等离子体处理后进入势垒层,形成带负电的固定电荷,从而调制能带结构,耗尽沟道中2DEG,形成增强型器件。F离子的稳定性是人们对这种方法最大的顾虑,后续的分子动力学模拟以及高温、高场下的可靠性试验表明F离子在适当的条件下在GaN基半导体中可以保持较好的稳定性。
p型帽层增强型GaN基器件从半导体器件的角度看属于JFET器件结构[96],如图13所示,该方法利用栅下的pn结耗尽2DEG,实现增强型工作。器件阈值电压由 pn结的开启电压决定。由于器件结构中存在pn结,可以利用其实现GaN基HEMT器件无法实现的功能,如缓冲层电导调制等[97],这对电流坍塌有较好的抑制作用。目前该方法已被国际上多家电子器件公司,如Panasonic、EPC、GaN Systems等采用。该方法相对不足的是当栅压摆幅增加时,存在pn结的正向导通电流。另外,p型帽层外延生长过程中p型杂质易于引起MOCVD生长系统的记忆效应,使得GaN基异质结构输运性质退化。
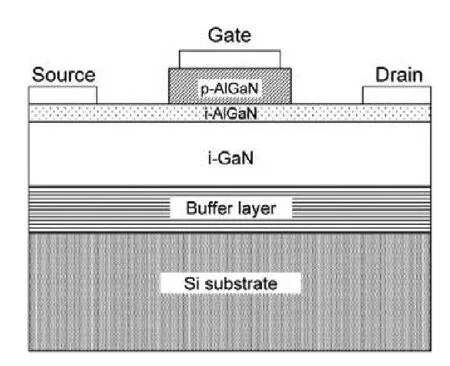
图13.日本 Panasonic公司采用的 p型 AlGaN帽层增强型GaN基HEMT器件结构示意图[96]
Cascode级联方法是从电路层次调整功率电子器件阈值电压的电路技术[88],由于其完全由Si基MOSFET决定阈值电压和其他电路特性,GaN基器件只承担阻断功能,因此对GaN基异质结构材料质量要求和器件制备工艺要求均可以降低。不足的地方是封装时的互联使得器件寄生电感较大,影响了器件在高开关频率下的应用。同时Si器件的引入使得cascode的器件失去了GaN基电子器件可高温工作的优点,整个电路模块工作温度被限定在150◦C以下。
C.GaN基电子器件表面/界面局域态特性与调控
无论是微波射频还是功率电子应用,GaN基HEMT器件一般会经历高漏极偏置OFF-state工作状态,在该状态下构成栅极漏电的电子在栅边缘高场作用下极易隧穿到AlGaN势垒层的表面局域态上。另一方面,2DEG沟道下面的GaN缓冲层中的深能级陷阱态在高漏极偏置下也会由于准费米能级的变化被电子填充。当器件再次回到ON-state时,由于表面态或缓冲层中深能级的放电时间常数较长,跟不上器件工作的特征频率,2DEG在较长时间内处于部分耗尽状态,最终导致器件的高场电流坍塌[98]。对GaN基微波功率器件,电流坍塌表现为DC-RF频散,输出功率严重压缩。而对功率电子器件,电流坍塌则表现为动态导通电阻的明显增大,在高速开关过程中器件的静态能耗和动态损耗变大,造成电能转换效率降低。为抑制GaN基HEMT表面局域态导致的电流坍塌,目前主要是采用CVD方法在HEMT表面沉积一层SiNx介质层以钝化表面局域态[99]。
另一方面,为了抑制GaN基HEMT肖特基栅极的漏电,人们会在栅金属与AlGaN间插入一层高绝缘栅介质制备成MIS-HEMT器件结构,以满足GaN基功率电子器件低漏电、高击穿电压的要求。ALDAl2O3和LPCVD-SiNx是目前GaN基MIS-HEMTs中采用的两种主要栅介质。栅介质的引入可显著抑制栅极正反向漏电,然而也带来了界面局域态问题。栅介质与AlGaN间的界面态分布很广,特别是位于导带以下1 eV左右的深能级,其电子发射时间常数在几百秒甚至更长时间,在栅极开关过程中,这些深能级的充放电会导致严重的栅极阈值电压不稳定[100]。
因此,钝化介质和栅介质与 AlGaN间的深能级表/界面局域态是导致GaN基HEMT和MIS-HEMT器件电流坍塌和阈值不稳定性的主要因素。美国德克萨斯大学达拉斯分校 Hinkle等发现在含有 Ga元素的 III-V半导体材料表面,含有三价 Ga3+的自然氧化层是其表面费米钉扎的主要原因[101]。在纤锌矿结构Ga面GaN中,自然氧化所导致的表面Ga-O键被认为是表面/界面态的主要来源。香港科技大学杨树等发展了一种原位低损伤GaN和AlGaN表面处理方法,如图12所示。研究确认NH3/Ar/N2原位处理不仅能有效去除GaN表面的Ga-O键,而且充分的氮化处理能防止氧化物栅介质淀积造成的表面再氧化[102],这一方法将导带下EC-0.3 eV到EC-0.78 eV范围内的界面态密度降到了2.0×1012cm−2eV−1。

图14.香港科大发展的原位低损伤GaN表面处理过程示意图[102]。先采用NH3/Ar远程等离子体去除其表面的自然氧化层,然后进行N2等离子体处理补偿近表面的N空位,紧接着淀积一层ALD-Al2O3介质。
尽管界面氮化插入层方法在降低GaN基功率电子器件界面态上取得了显著进展,然而相对于Si/SiO2系统,介质层/GaN或AlGaN界面态密度仍然偏高.同为氧化成键,Si与高温本征氧化层 SiO2间的界面态密度可以低到 1011cm−2eV−1量级,而GaN上高质量本征氧化层很难获得.因此需要从GaN基半导体独特的强极化特性,以及界面原子结构等微观层面切入,来深入探讨GaN基器件表面/界面态起源的物理原因和调控方法。
D.GaN基器件中的深能级陷阱与强场下的性能退化
GaN基半导体异质结构的一大优势是高击穿场强,理论计算其临界击穿电场高于3 MV/cm,是Si器件的10倍,因此高工作电压是GaN基异质结构材料和器件的一大优势。但迄今为止,由于GaN基异质结构是不同衬底上的异质外延方法所制备,晶体中缺陷密度高,GaN基器件还不具备真正的雪崩能力,软击穿依然是器件失效的主导原因。前几年研究发现栅极反向隧穿漏电[103]或者表面hopping[104]是GaN基电子器件的击穿机制,击穿电场较低。近几年随着异质结构外延质量和器件微加工技术的不断改进,GaN基电子器件的有效击穿电场已提高到接近2 MV/cm[105]。
由于GaN基HEMT是多子器件,异质结构中需要采用高阻GaN缓冲层。非故意掺杂引入的O等杂质导致非故意掺杂GaN呈n型,在未充分补偿的条件下器件易于穿通[106],引起源端注入导致的三端击穿[107]。如何补偿施主杂质而不引起明显的局域态陷阱效应是实现高质量、高阻GaN缓冲层的关键。由于GaN基微波功率器件的工作电压当前仍限制在50 V以下,目前采用Fe掺杂实现半绝缘GaN缓冲层的方法已可满足微波功率器件的应用需求。
但GaN基功率电子器件对GaN缓冲层的要求苛刻得多,国际上一般采用 C杂质补偿方法实现半绝缘GaN缓冲层,杂质的引入在提高耐压的同时引起了各种局域态陷阱效应。一般认为在高电场下,电子通过隧穿或者热电子注入到缓冲层的陷阱中且不易回到2DEG沟道[108],使得器件导通时的动态导通电阻增加,动态特性退化。迄今为止,人们对高阻GaN缓冲层中的局域态性质以及高电场条件下局域态对沟道载流子的捕获和释放机制的研究还比较欠缺,甚至对C杂质在GaN中行为的理解也不充分,主要原因是GaN的禁带宽度大、2DEG沟道和陷阱态在实空间上分离、以及GaN缓冲层的高阻性质,使得常规的半导体局域态研究方法难以直接获得高阻缓冲层中陷阱态的相关物理信息。意大利Podova大学的研究人员在这方面开展了较系统的工作,发现缓冲层中引起动态导通电阻增加的局域态陷阱来源于具有热激活捕获截面的点缺陷[109]。进一步深入研究还需要发展针对宽禁带和高阻半导体的局域态测量方法,以获得GaN高阻缓冲层中陷阱态的物理信息及其与异质结构外延生长参数的关联规律。与此同时,器件的耐压和动态导通电阻存在客观的矛盾,需要根据应用需求,寻找合适的平衡点。
另外,Si衬底的采用导致GaN基功率电子器件所能承受的电压被器件垂直方向的电场所限制,耐压特性与外延层结构的总厚度密切相关。比利时IMEC采用部分刻蚀Si衬底的方法在2µm厚缓冲层上实现了高达2200 V耐压的 GaN基功率电子器件[110],如图15所示。
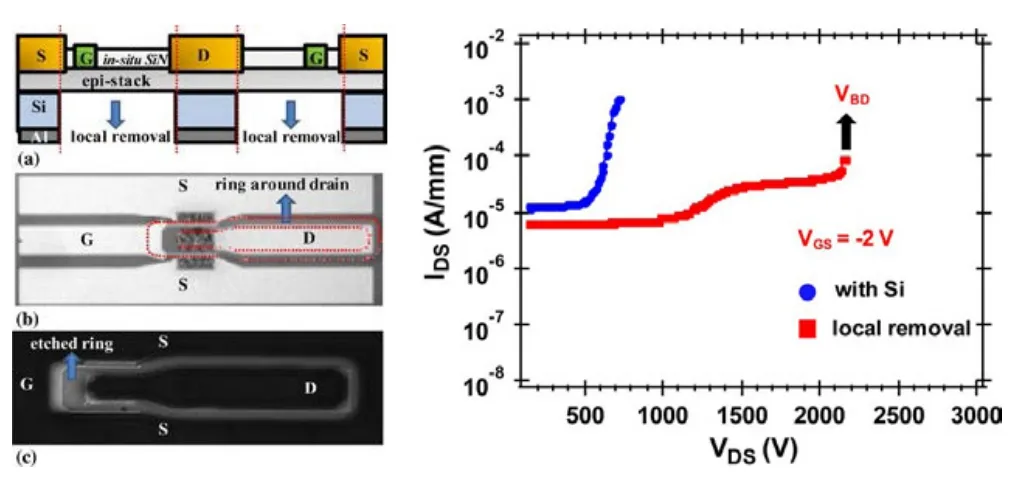
图15.比利时IMEC研制的局部Si衬底去除GaN基HEMT器件结构示意图(左)和器件击穿特性曲线(右)[110]
综上所述,如何在大晶格失配和大热失配Si衬底上生长出高阻、高耐压、低陷阱效应的异质结构材料是提高GaN基功率电子器件性能的关键。迄今人们对这一问题,及其背后的缺陷物理的认识和理解还很不够,针对GaN基异质结构和功率电子器件特定需求的缺陷物理表征方法也有待发展,需要进一步深入的研究工作。
V.小结与展望
GaN基宽禁带半导体异质结构具有非常强的压电和自发极化效应、高饱和电子漂移速度、高击穿场强、抗辐射、耐腐蚀等优越的物理、化学性质,是发展高功率微波射频器件不可替代的材料体系,也是发展高效节能功率电子器件的主要材料体系之一。同时,由于具有较长的自旋驰豫时间、高于室温的居里转变温度、以及由极化电场导致的较强自旋轨道耦合,GaN基异质结构也是研制自旋场效应晶体管富有竞争力的材料体系之一。过去10多年,GaN基异质结构的外延生长、物性研究与电子器件研制一直是国际上半导体科学技术和半导体物理的前沿领域和研究热点,已取得一系列重要突破。
在异质结构材料的外延生长方面,经过多年的努力,蓝宝石和SiC衬底上GaN基异质结构的外延生长方法已比较成熟,基本可满足器件研制和物性研究的需要,而受到高度关注的Si衬底GaN基异质结构的外延生长也取得了很大进展,材料质量已接近器件应用的要求,但在异质结构的应力控制、缺陷控制上离实用化还有差距。目前,GaN基异质结构根据不同应用的需要,复合势垒结构和复合沟道结构,如超晶格势垒、背势垒、双沟道等被广泛采用,用于毫米波工作频率的晶格匹配InAlN/GaN、AlN/GaN异质结构等也受到了人们的关注。
GaN基异质结构物性研究主要围绕其高密度2DEG性质展开,在2DEG的高场输运性质、量子输运性质等方面取得了一系列进展,目前已基本清楚GaN基异质结构界面量子阱的精细能带结构、子带占据和散射机制,以及高场下的负微分电阻性质和耿氏振荡特性。在2DEG的本征自旋性质研究上,人们对其塞曼自旋分裂及其各向异性、Rashba自旋轨道耦合及其零场自旋分裂有了比较清楚的认识,对自旋输运和自旋驰豫也有了一定程度的了解,但异质结构的自旋注入效率尚待突破。另外,近几年面向GaN基电子材料和器件应用的缺陷物理和缺陷控制研究取得了很大进展,有效促进了材料和器件性能的提升,但这方面工作还不能满足需求,有待进一步深入。
在GaN基电子器件研制方面,目前GaN基微波功率器件已取得一系列关键突破,除军事应用外,未来几年将在5G移动通讯基站上开始规模应用,在5G手机微波功放上的应用也有可能实现。高功率散热、线性度提升、高工作电压器件、毫米波器件是未来几年GaN基微波功率器件的主要研究方向。GaN基功率电子器件是当前的研究热点,市场潜力巨大,但目前还有一系列关键科学和技术问题有待攻克。其中应力/缺陷可控的高质量Si衬底GaN基异质结构外延生长、高阈值电压增强型器件、表面/界面态特性和GaN缓冲层陷阱态特性与调控等问题将是未来一段时间的研究重点。GaN自支撑衬底上的垂直结构GaN基功率电子器件由于在降低开态电阻及提高击穿电压方面的潜在优势,也将受到人们的重视。另外,尽管还面临很大挑战,GaN基自旋电子学器件,特别是自旋FET依然是该领域追求的目标之一,一旦突破,将在自旋逻辑器件、量子存储器件、量子计算等方面有很好的应用前景。
致谢
感谢南京大学郑有炓老师,中科院上海技术物理研究所褚君浩老师,中科院半导体研究所郑厚植老师,香港科技大学葛惟昆老师,北京大学甘子钊、张国义老师在该文涉及的研究工作上多年的指导和帮助。感谢国家科技重点专项 (2016YFB0400100、2016YFB0400200)、国家重点基础研究发展计划项目 (2013CB921901、2013CB632804),国家自然科学基金(11634002、61521004、61361166007、61376095、61522401、61574006、61204099)和北京市科技计划项目(Z151100003315002)对本文涉及工作的大力支持。
[1]Hiroshi A,Masahiro K,Kazumasa H,Isamu A.Jpn. J.Appl.Phys.,1989,28(12A):L2112
[2]Shuji N,Takashi M,Masayuki S,Naruhito I.Jpn.J. Appl.Phys.,1992,31(2B):L139
[3]Shuji N.Jpn.J.Appl.Phys.,1991,30(10A):L1705
[4]Asif Khan M,Van Hove J M,Kuznia J N,Olson D T. Appl.Phys.Lett.,1991,58:2408
[5]Khan M,Bhattarai A,Kuznia J,Olson D.Appl.Phys. Lett.,1993,63:1214
[6]Aggerstam T,Lourdudoss S,Radamson H H,Sj¨odin M,Lorenzini P,Look D C.Thin Solid Films,2006, 515:705
[7]Webb J B,Tang H,Rolfe S,Bardwell J A.Appl.Phys. Lett.,1999,75:953
[8]Xu F.J,Xu J,Shen B,Miao Z.L,Huang S,Lu L, Yang Z J,Qin Z X,Zhang G Y.Thin Solid Films, 2008,517:588-591
[9]Xu F J,Shen B,Wang M J,Xu J,Lu L,Miao Z L, Yang Z J,Qin Z X,Zhang G Y,Lin B,Bai S L,Appl. Phys.Lett.,2007,91(9):091905-091905-3
[10]Hsu L,Walukiewicz W.J.Appl.Phys.,2001,89:1783
[11]Shen L,Heikman S,Moran B,et al.IEEE Electron Dev.Lett.,2001,22:457
[12]Smorchkova I P,Chen L,Mates T,Shen L,et al.J. Appl.Phys.,2001,90:5196
[13]Miyoshi M,Egawa T,Ishikawa H,Solid State Electron.,2006,50:1515
[14]Warren W Jr T,Bremser M D,Ailey K S,Carlson E, Perry W G,Davis R F.Appl.Phys.Lett.,1995,67: 401-03
[15]Lahr`eche H,Venn´egu`es P,Vaille M,Beaumont B,et al.Semicond.Sci.Technol,1999,14:L33
[16]Boeykens S,Leys M R,Germain M,Belmans R, Borghs G,J.Cryst.Growth,2004,272:312-317
[17]Qu S,Li S Q,Peng Y,Zhu X L,Hu X B,Wang C X, Chen X F,et al.J.Alloy Compd.,2010,502:417-422
[18]Chen J T,Pomeroy J W,Rorsman N,et al.J.Cryst. Growth,2015,428:54-58
[19]Raymond S.P,Simon M.W,et al.IEEE Trans.Microw.Theory Tech.,2012,60:1764 h
[20]Guo S P,Gao X,Gorka D,Pan M,Olive M.ECS Transactions,2011,41:295
[21]Chen J T,Forsberg U,Janz´en E.Appl.Phys.Lett., 2013,102:193506
[22]Wang X L,Hu G X,Ma Z Y,et al.J.Crystal Growth, 2007,298:835
[23]Kuzm´ık J.IEEE Trans.on Electron Dev.,2001,22: 510
[24]Gonschorek M,Carlin J F,Feltin E,Py M A,Grandjean N.Appl.Phys.Lett.,2006,89:062106
[25]Gonschorek M,Carlin J F,Feltin E,Py M A,Grandjean N,Darakchieva V,Monemar B,Lorenz M,Ramm G.J.Appl.Phys.,2008,103:093714
[26]Kaun S W,Ahmadi E,Mazumder B,Wu F,H Kyle E C,Burke P G,Mishra U K,Speck J S.Semicond. Sci.Technol.,2014,29:045011
[27]Fang Y L,Feng Z H,Yin J Y,Zhang Z R,Lv Y J, Dun S B,Liu B,Li C M,Cai S J.Phys.Status Solidi B,2015,252:1006
[28]Sang L,Yang X L,Cheng J P,et al.Appl.Phys.Lett., 2015,107:052102
[29]Miao Z L,Tang N,Xu F J,et al.J.Appl.Phys.,2011, 109:016102.
[30]Yue Y Z,Hu Z,Gu J,et al.Jpn.J.Appl.Phys.,2013, 52:08JN14
[31]Shinohara K,Regan D C,Tang Y,et al.IEEE Trans. Electron Dev.,2013,60:2982
[32]Dadgar A,Blasing J,Diez A,Alam A,Heuken M, Krost A.Jpn.J.Appl.Phys.,2000,Part 239:L1183
[33]Feltin E,Beaumont B,Laugt M,Mierry P de,Vennegues P,Lahreche H,Leroux M,Gibart P.Appl. Phys.Lett.2001,79:3230.
[34]Cheng K,Leys M,Degroote S,et al.J.Electron. Mater.2006,35:592
[35]Ishikawa H,Zhao G Y,Nakada N,Egawa T,Jimbo T,Umeno M.Jpn.J.Appl.Phys.,1999,38:L492
[36]Dadgar A,Hempel T,Bl¨asing J,Schulz O,Fritze S, Christen J Krost A.Physica Status Solidi(c),2011, 8:1503-1508
[37]Selvaraj S L,Suzue T,Egawa T.IEEE Electron Dev. Lett.,2009,30:587
[38]Cheng J.P,Yang X L,Sang L,Guo L,Hu A Q,XuF J,Tang N,Wang X Q,Shen B.Appl.Phys.Lett., 2015,106:142106
[39]Cheng J P,Yang X L,Sang L,et al.Scienti fi c Report, 2016,6:23020
[40]Wei J,Liu S,Li B,Tang X,et al.IEEE Electron Dev. Lett.,2015,36(12):1287–1290
[41]Levinshtein M E,Rumyantsev S L.Shur M S.编,杨树人殷景志译,先进半导体材料性能与数据手册,北京:化学工业出版社2003
[42]Nakajima S.Compound semiconductor IC’s Indium Phosphide and related Materials,2005.International Conference on 8-12 May 2005 P.603
[43]http://www.ioffe.rssi.ru/SVA/NSM/Semicond.
[44]Yoder M N.IEEE Trans.Electron Dev.,1996,43: 1633
[45]Pearton S J,Ren F,Zhang A P,Lee K P.Mat.Sci. and Eng.R,2000,30:55
[46]Meada N,Tsubaki K,Saitoh T,Kobayashi N.Appl. Phys.Lett.,2001,79:1634
[47]Arulkumaran S,Egawa T,Ishikawa H,Jimbo T.Appl. Phys.Lett.,2002,80:2186
[48]Baur J,Maier K,Kunzer M,Kaufmann U,Schneider J.Appl.Phys.Lett.,1994,65:2211
[49]Ambacher O,Smart J,Shealy J R,et al.Appl.Phys., 1999,85:3222
[50]Ambacher O,Foutz B,Smart J,et al.J.Appl.Phys., 2000,87(1):334-344
[51]Hashimoto S,Akita K,Tanabe T,Nakahata N, Takeda K,Amano H.SEI Tech.Rev.,2010,71:83
[52]Jacob K,Ding Y J,Jena D.Appl.Phys.Let.,2007, 91(25):252104
[53]Wang X L,Wang C M,Hu G X,Xiao H L,et al.J. Cryst.Growth,2007,298:791
[54]Chen Z,Pei Y,Newman S,Brown D,Chung R,Keller S,Denbaars S P,Nakamura S,Mishra U K.Appl. Phys.Lett.,2009,94:112108
[55]Ma N,Shen B,Xu F J,Lu L W,et al.Appl.Phys. Lett.,2010,96(24):242104
[56]Ma N,Shen B,Lu L W,Xu F J,et al.Appl.Phys. Lett.,2012,100:052109
[57]Guo L,Yang X L,Feng Z H,et al.Appl.Phys.Lett., 2014,105:242104
[58]Zheng Z,Shen B,Zhang R,et al.Phys.Rev.B,2000, 62:R7739
[59]Zheng Z W,Shen B,Gui Y S,Jiang C P,et al.Appl. phys.lett.,2003,82:1872-1874
[60]Jiang C P,Guo S L,Huang Z M,et al.Appl.Phys. Lett.,2001,7(9):374
[61]Tang N,Shen B,Zheng Z,et al.J.Appl.Phys.,2003, 94:5420-5422
[62]Liu S,Tang N,Shen X,et al.J.Appl.Phys.,2013, 114:033706-033704
[63]Knap W,Frayssinet E,Skierbiszewski C,et al.physica status solidi(b),1999,216:719-725
[64]Knap W,Frayssinet E,Sadowski M,et al.Appl.phys. lett.,1999,75:3156-3158
[65]Tang N,Shen B,Han K,et al.J.Appl.Phys.,2006, 100:073704
[66]Lu F C,Tang N,Huang S Y,et al.Nano Lett.,2013, 13:4654-4658
[67]EAdA e S.Phys.Rev.B,1992,46:1921
[68]Litvinov V.Physical Review B,2003,68:155314.
[69]Tsubaki K,Maeda N,Saitoh T,Kobayashi N.Appl. phys.lett.,2002,80:3126-3128
[70]Tang N,Shen B,Wang M,et al.Appl.phys.lett.,2006, 88(17):172112
[71]Tang B,Shen B,Han K,Lu F C,Xu F J,Qin Z X, Zhang G Y.Appl.Phys.Lett.,2008,93:172113
[72]Cho K S,Huang T Y,Wang H S,et al.Appl.phys. lett.,2005,86:222102-222103
[73]Tang N,Shen B,He X W,et al.Phys.Rev.B,2007, 76:155303
[74]Tang Y Q,Shen B,He X W,et al.Appl.phys.lett., 2007,91:071920
[75]He X,Shen B,Tang Y,et al.Appl.phys.lett.,2007, 91:071912-071913
[76]Yin C,Shen B,Zhang Q,et al.Appl.phys.lett.,2010, 97:181904-181903
[77]D’ˆakonov MI.Spin physics in semiconductors. Springer,2008
[78]He X,Shen B,Chen Y,et al.Phys.Rev.Lett.,2008, 101:147402
[79]Yin C,Tang N,Zhang S,et al.Appl.phys.lett.,2011, 98:122104-122103
[80]Mei F H,Zhang S,Tang N,et al.Sci.Rep.,2014,4: 4030
[81]Mishra U K,Shen L K,Kazior T E,Wu Y F.Proc. IEEE,2008,96(2):287-305
[82]Palacios T,Chakraborty A,Rajan S,Poblenz C,et al.IEEE Electron Dev.Lett.,2015,26(11):781-783
[83]Hao Y,Yang L,Ma X H,et al.IEEE Electron Dev. Lett.,2011,32(5):626-628
[84]Shinohara K,Regan D,Corrion A,et al.in 2012 International Electron Devices Meeting,2012:27.2.1-27.2.4
[85]Wu S B,Gao J F,Wang W B,Zhang J Y.IEEE Trans. Electron Dev.,2016,63(10),3884-3889
[86]Ikeda N,Niiyama Y,Kambayashi H,et al.Proc. IEEE,2010,98(7):1151-1161
[87]Chu R,Corrion A,Chen M,Li R,et al.IEEE Electron Dev.Lett.,2011,32(5):632-634
[88]Nishikawa K.in 2013 IEEE Bipolar/BiCMOS Circuits and Technology Meeting(BCTM),2013:143-150
[89]Kim K W,Jung S D,Kim D S,et al.IEEE Electron Dev.Lett.,2011,32(10):1376-1378
[90]Wang Y,Wang M,Xie B,et al.IEEE Electron Dev. Lett.,2013,34(11):1370-1372
[91]Huang S,Jiang Q,Wei K,et al.in 2014 IEEE International Electron Devices Meeting,2014:17.4.1-17.4.4
[92]Wei J,Liu S,Li B,Tang X,et al.IEEE Electron Dev. Lett.,2015,36(12):1287-1290
[93]Lu B,Sun M,Palacios T.IEEE Electron Dev.Lett., 2013,34(3):369-371
[94]Xu Z,Wang J,Liu Y,et al.IEEE Electron Dev.Lett., 2013,34(7):855-857
[95]Lin S,Wang M,Sang F,et al.IEEE Electron Dev. Lett.,2016,37(4):377-380
[96]Uemoto Y,Hikita M,Ueno H,et al.IEEE Trans.Electron Dev.,2007,54(12):3393-3399
[97]Kaneko S,Kuroda M,Yanagihara M,et al.Proceedings of ISPSD,2015:41-44
[98]Vetury R,Zhang N Q,Keller S,Mishra U K.IEEE Trans.Electron Dev.,2001,48(3):560-566
[99]Koley G,Tilak V,Eastman L F,Spencer M G.IEEE Trans.Electron Dev.,2003,50(4):886-893
[100]Huang S,Yang S,Roberts J,Chen K J.Jpn.J.Appl. Phys.,2011,50(11):110202
[101]Hinkle C L,Milojevic M,Brennan B,et al.Appl.Phys.Lett.,2009,94(16):162101
[102]Yang S,Tang Z,Wong K Y,Lin Y S,Lu Y.,Huang S,Chen K J.in 2013 IEEE International Electron Devices Meeting,2013:6.3.1-6.3.4
[103]Hashizume T,Kotani J,Hasegawa H.Appl.Phys. Lett.,2004,84(24):4884-4886
[104]Tan W S,Houston P A,Parbrook P J,Wood D A,Hill G,Whitehouse C R.Appl.Phys.Lett.,2002,80(17): 3207-3209
[105]Rowena I B,Selvaraj S L,Egawa T.IEEE Electron Dev.Lett.,2011,32(11):1534-1536
[106]Uren M J,Nash K J,Balmer R S,et al.IEEE Trans. Electron Dev.,2006,53(2):395-398
[107]Wang M,Chen K J.IEEE Trans.Electron Dev.,2010, 57(7):1492-1496
[108]Hwang I,Kim J,Chong S,et al.IEEE Electron Dev. Lett.,2013,34(12):1494-1496
[109]Bisi D,Meneghini M,Marino F A,et al.IEEE Electron Dev.Lett.,2014,35(10):1004-1006
[110]Srivastava P,Das J,Visalli D,Hove M V,et al.IEEE Electron Dev.Lett.,2011,32(1):30-32
Study of the epitaxial growth,physical properties and electronic devices of GaN-based semiconductor heterostructures
Shen Bo1,2,,Tang Ning1,2,Yang Xue-Lin1,2,Wang Mao-Jun1,3,Xu Fu-Jun1,2,Wang Xin-Qiang1,2,Qin Zhi-Xin1,2
1.Research Center of Wide band-gap semiconductors,Peking University,Beijing 100871,China 2.State Key Laboratory of Arti fi cial Microstructure and Mesoscopic Physics,Peking University,Beijing 100871,China 3.Institute of Microelectronics,School of Electronics Engineering and Computer Science,Peking University,Beijing 100871,China
Owing to their excellent physical properties,such as strong piezoelectric and spontaneous polarization,high saturation drift velocity,high critical breakdown electric fi eld,high Curie temperature,and strong spin–orbit coupling e ff ect,GaN-based wide band-gap semiconductor heterostructures are the most favorite materials in developing high-power microwave electronic devices as well as energy-saving power electronic devices.Potential applications in semiconductor spintronics are also expected.Therefore,the study of GaN-based heterostructure materials, physics,and devices has attracted great interest in the world in recent years.In this paper, world-wide research progresses on the epitaxial growth,physical properties and device fabrication of GaN-based heterostructures in recent years are reviewed,including a brief introduction of the academic achievements in this fi eld at Peking University.
GaN-based wide band-gap semiconductors,epitaxial growth,two dimensional electron gas(2DEG),transport properties,spin properties,GaN-based electronic devices
date:2016-12-30
O47
A
10.13725/j.cnki.pip.2017.03.001
*E-mail:bshen@pku.edu.cn
1000-0542(2017)03-0081-17
