InGaN/GaN 多量子阱LED载流子泄漏与温度关系研究
2017-02-15刘诗涛伍菲菲何沅丹张建立全知觉黄海宾
刘诗涛, 王 立*, 伍菲菲, 杨 祺, 何沅丹, 张建立, 全知觉, 黄海宾
(1. 南昌大学 材料科学与工程学院, 江西 南昌 330031;2. 南昌大学 国家硅基LED工程技术研究中心, 江西 南昌 330047; 3. 南昌大学 光伏研究院, 江西 南昌 330031)
InGaN/GaN 多量子阱LED载流子泄漏与温度关系研究
刘诗涛1,2,3, 王 立1,2,3*, 伍菲菲1,2,3, 杨 祺1,2,3,
何沅丹1,2,3, 张建立1,2,3, 全知觉1,2,3, 黄海宾1,2,3
(1. 南昌大学 材料科学与工程学院, 江西 南昌 330031;
2. 南昌大学 国家硅基LED工程技术研究中心, 江西 南昌 330047; 3. 南昌大学 光伏研究院, 江西 南昌 330031)
通过测量光电流,直接观察了InGaN/GaN量子阱中载流子的泄漏程度随温度升高的变化关系。当LED温度从300 K升高到360 K时,在相同的光照强度下,LED的光电流增大,说明在温度上升之后,载流子从量子阱中逃逸的数目更多,即载流子泄漏比例增大。同时,光电流的增大在激发密度较低的时候更为明显,而且光电流随温度的增加幅度与激发光子的能量有关。用量子阱-量子点复合模型能很好地解释所观察到的实验现象。实验结果直接证明,随着温度的升高,InGaN/GaN量子阱中的载流子泄漏将显著增加,而且在低激发密度下这一效应更为明显。温度升高导致的载流子泄漏增多是InGaN多量子阱LED发光效率随温度升高而降低的重要原因。
InGaN/GaN多量子阱; 发光二极管; 载流子泄漏; 量子效率
1 引 言
自从1991年Nakamura等[1]成功研制出GaN基蓝光LED以来,GaN材料在固态照明领域中成为了研究热点。随着生长技术与工艺的发展,GaN基LED已经广泛应用于生活中。与传统光源荧光灯和白炽灯的发光效率 (70 lm/W 和15 lm/W) 相比,GaN基LED不仅发光效率高,并且无汞污染,又可通过节能减少了二氧化碳和其他温室气体的产生,在环保方面有其明显的优势[2-3]。
虽然GaN基LED经过20多年的发展已取得很多进步,但仍存在许多问题,阻碍着GaN基LED 在照明领域的进一步推广,其中之一便是量子效率的droop效应。LED的droop效应可以分为两种:一是量子效率随电流密度的增大而降低(简称电流密度droop效应或J-droop效应);二是量子效率随温度的升高而降低(简称温度droop效应或T-droop效应)。J-droop效应是近年来LED研究中最受关注的热点问题之一[4-10]。其机理被归结为极化效应引起的载流子泄漏[4]、p型掺杂效率低导致载流子输运不对称[5]、载流子的去局域化[6-7]、高密度电流激活缺陷复合[8-9]和俄歇复合[10]等因素。关于如何消除J-droop效应的研究也非常多。例如,设计晶格更加匹配的多量子阱(MQW)结构、双异质结结构和制作大尺寸器件(减少电流密度)等。与J-droop效应相比,T-droop效应获得的关注还相对较少。Meyaard 等认为,T-droop效应主要归结于高温下新的非辐射复合中心的产生[11]。然而,也有部分文献指出,高温下的载流子泄漏也将导致效率的下降[12]。在这些工作中,T-droop与载流子泄漏的关系是通过定性或半定量地分析SRH复合所占的比例来间接推断的[11,13-14]。在这些研究中,LED都是正向驱动的,载流子从阱中泄漏后也终将在p型层等区域被复合,因而无法直接得知泄漏的载流子数量。为了直接观察载流子从量子阱中的泄漏程度与温度的关系,本文将InGaN/GaN 多量子阱LED作为光电池并置于零偏压下,通过光激发载流子的方式,对载流子泄漏与温度的关系进行研究。我们发现,当样品温度从300 K升高到360 K时,光电流显著增加,为载流子泄漏导致T-droop效应这一物理机制提供了直接证据。
2 实 验
实验中所用到的样品结构如图1(a)所示。样品由金属有机气相沉积(MOCVD)方法制备,由2.5 μm厚的n-GaN层、9个周期的InGaN(3 nm)/GaN(10 nm)的量子阱结构和100 nm厚的p-GaN层构成,其中量子阱中的In组分为0.27。器件的面积大小为 1 mm×1 mm,350 mA下的发光波长为521 nm。
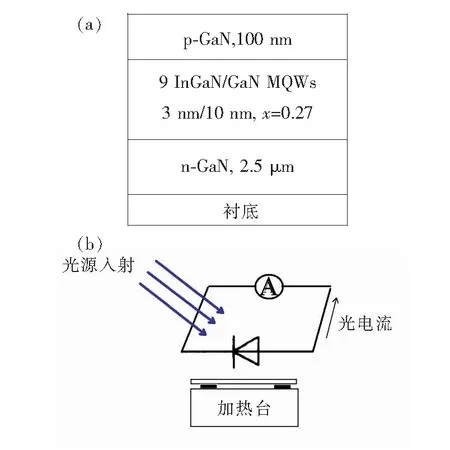
图1 (a) 样品结构示意图;(b) 实验测试方法简图。
Fig.1 (a) Schematic diagram of the structure of the sample. (b) Schematic diagram of the measurement.
图1(b)给出了实验测试装置的原理简图。我们通过光来激发LED器件,由微电流仪测量光电流的大小。样品温度由可控温加热台控制。光源分别为发光波长390 nm和504 nm 的LED,其芯片尺寸均为1 mm×1 mm。选择两个波长的光源是为了探究载流子被激发到不同能级的行为。
3 结果与讨论
考虑到典型的GaN基LED稳态工作时的结温可达80 ℃左右,本研究选择的温度点为300 K和360 K。图2给出了本研究使用的LED样品在300 K和360 K下的内量子效率(IQE)曲线,其中可以观察到J-droop效应和T-droop效应。当电流为350 mA时,从300 K升高到360 K,样品的IQE下降了约10%,这与文献中报道的典型结果相当[11,13-14]。可以看出,T-droop效应大幅降低了GaN基LED的发光效率,减弱了半导体照明的节能优势。

图2 样品在300 K和360 K下的发光效率随电流密度变化曲线
Fig.2 Luminous efficiency as a function of current density at 300 K and 360 K
为了探究T-droop效应主导的物理机制,我们通过测量样品的光电流来分析样品载流子泄漏电流的大小。由于LED中有源区存在自建电场,所以在量子阱中产生的载流子将有一部分可以被这个电场分离,它们到达电极后即形成光电流。载流子从量子阱中逃逸主要包括量子隧穿和热发射两种过程。关于InGaN/GaN量子阱的光伏效应已有不少研究[15],通常认为在AM1.5标准太阳光谱照射下,光生载流子的逃逸机制以隧穿为主[16]。由于载流子逃逸和复合是相互竞争的关系,在激发密度(产生率)相同的情况下,光电流的增加必然意味着载流子复合(包括辐射和非辐射过程)的减少。因此,光电流的大小是载流子从量子阱中泄漏程度的直接反映。需要指出的是,所谓InGaN/GaN多量子阱LED中的载流子泄漏指的是电子从量子阱中向p型区泄漏,而光电流的方向是电子向n型区逃逸。我们用ATLAS模拟程序[17]计算了在零偏压下InGaN/GaN量子阱中电子向n区逃逸需要越过的势垒高度和在35 A/cm2正向电流下电子从量子阱中向p区逃逸需要越过的势垒高度。如图3所示,在这两种条件下,电子从量子阱基态逃逸的势垒高度非常接近,因此我们认为用零偏压下的光电流来衡量LED在正向典型注入密度下的载流子泄漏是合理的。

图3 在零偏压光照下和正向注入35 A/cm2时的仿真能带图
Fig.3 Energy band diagrams of LED under 0 bias and 35 A/cm2
图4(a)和(b)给出了在390 nm和504 nm LED光源照射下,样品温度为300 K和360 K时的光电流随光源电流密度的变化曲线。需要说明的是,我们的LED光源没有采用特殊聚焦处理,虽然我们让光源和电池彼此尽量靠近,但光源发出的光仍只有一小部分被样品吸收,因此光电池受到的激发密度与光源的电流密度相比是很小的。

图4 (a)光源波长为390 nm,300 K和360 K下的光电流随激发密度的变化曲线;(b)光源波长为504 nm,300 K和360 K下的光电流随激发密度的变化曲线;(c)光源波长为504 nm,温度上升光电流的变化率的变化曲线。
Fig.4 (a) Photocurrentvs. excitation density at 300 K and 360 K with the light source wavelength of 390 nm. (b) Photocurrentvs. excitation density at 300 K and 360 K with the light source wavelength of 504 nm. (c) Change rate of photocurrentvs. excitation density with temperature increasing with the light source wavelength of 504 nm.
通过观察图4(a)和(b)的4条曲线不难发现,光电流都是随着激发密度的升高而变大,其变化趋势接近于线性。在激发密度较高时,曲线略向下偏离线性,这是由于光源输出强度偏离线性导致的。由于光源也是InGaN量子阱LED,如图2所示,其光输出强度随电流密度变化并不是线性的,在500 mA时其效率比最高效率下降约10%,图4所示的光电流曲线向下偏离线性正是光源效率下降的反映。进一步观察可以看到,在390 nm激发下,360 K和300 K时的光电流曲线基本重合,而504 nm激发下360 K时的光电流比300 K时明显升高。我们将504 nm激发下360 K时的光电流相对于300 K时升高的比例随激发密度的关系描绘于图4(c)中。从图中可以看见,光电流的增加幅度随激发密度的增大呈现指数函数形式的下降,从1 mA时的33%下降到500 mA时的19%。温度升高将导致半导体的带隙宽度收缩。对于体块材料而言,这将使吸收效率随激发光子能量以(E-Eg)1/2的关系增加。然而对于量子阱而言,由于其台阶状的态密度-能量关系,所以带隙收缩对吸收系数的影响很小。即使我们按(E-Eg)1/2的关系做一个估算,对于504 nm的激发波长来说,300~360 K的温升区间内样品的吸收率增加也不到15%。而图4(c)中任意激发密度下的电流增加比例都远大于15%。更为重要的是,由于吸收效率增大导致的光电流增加与激发密度应呈线性关系,而不是图4(c)所呈现的指数关系,因此我们可以判定,样品中光电流的增大主要不是由于吸收率增大引起的,而应归结于载流子的逃逸效率增大。
如前所述,处在量子阱中的载流子将有两种相互竞争的命运:复合和逃逸。光电流的增大表明载流子复合减少,逃逸(泄漏)效率增加。由于温度升高将导致新的非辐射复合中心产生,因此非辐射复合率将增大,这种机理常被用来解释低激发密度下温度升高使发光效率下降的原因。然而,图4中的数据表明,温度从300 K上升到360 K时,非辐射复合中心的增加并不严重,而载流子逃逸效率的增大超过了新增非辐射复合中心导致的复合率增加,并导致了光电流的增大。
接下来,我们对温度升高载流子泄漏增大的机理做一个简单的分析。Lai等也曾报道InGaN/GaN多量子阱太阳电池光电流随温度升高而增大的现象,他们把原因归结于带隙变窄效应或局部低In组分量子阱区域的价带激发态(E2)能级上的空穴热发射[18]。根据这一判断,应该是足够高光子能量的光源激发下才可能观察到这一现象,而我们的样品中出现的现象却完全相反。我们用低光子能量的光源激发样品,光电流增大明显;而用高光子能量激发样品时,光电流的增大反而不明显。因此,Lai等提出的机理对我们的样品是不适用的。
为了解释我们的实验现象,在这里我们引入量子点-量子阱复合模型[19-22]。众所周知,在InGaN量子阱生长过程中,In组分并不是完全均匀地分布在量子阱中,而是会发生In组分波动。所以在实际的样品当中,会存在富In区域的量子点。这种富In区域的带隙宽度比量子阱的带隙宽度更窄。图5给出了量子阱-量子点复合模型的能带结构示意图。为了方便讨论,这里只给出了一个量子阱的情况。由于量子点的In组分更高,所以对应的带隙宽度更低。当激发光光子能量较低时,只能激发量子点的带间跃迁而不能直接激发量子阱带间跃迁。此时产生在量子点中的电子和空穴被束缚而不能自由移动,也就无法贡献到光电流。当温度升高时,束缚在量子点中的电子和空穴将有更大机会被发射到量子阱的准连续能级,然后通过量子隧穿等过程逃逸出量子阱形成光电流,这就是图4(b)所示的情形。当激发光的光子能量足够大时,将直接激发量子阱带间跃迁,此时载流子可直接通过量子隧穿等机制逃逸出量子阱。由于隧穿过程与温度无关,因而该条件下光电流随温度升高无明显变化,这就是图4(a)所示的情形。



根据Richardson-Dushman方程,在我们的模型中热发射电流可表示为:
(1)

4 结 论
通过测量光电流,我们直接观察了InGaN/GaN量子阱中载流子的泄漏程度随温度升高的变化关系。当LED温度从300 K升高到360 K时,在相同的光照强度下,LED的光电流增大,说明温度上升之后载流子从量子阱中逃逸的数目更多,即载流子泄漏比例增大。同时,我们发现光电流的增大在激发密度较低的时候更明显,而且光电流随温度的增加幅度与激发光子的能量有关。用量子阱-量子点复合模型能很好地解释所观察到的实验现象。结果直接证明,随着温度的升高,InGaN/GaN量子阱中的载流子泄漏将显著增加,而且在低激发密度下这一效应更为明显。我们认为,温度升高导致的载流子泄漏增多是InGaN多量子阱LED发光效率随温度升高而降低的重要原因。
[1] NAKAMURA S, MUKAI T, SENOH M. High-power GaN P-N junction blue-light-emitting diodes [J].Jpn.J.Appl.Phys., 1991, 30(12A):L1998-L2001.
[2] 金尚忠, 张树生, 侯民贤. 白光照明LED灯温度特性的研究 [J]. 光源与照明, 2004(4):6-8. JIN S Z, ZHANG S S, HOU M X. The research of temperature characteristic in white light LED [J].LampsLight., 2004(4):6-8. (in Chinese)
[3] CAO K W, FU B L, LIU Z,etal.. Anomalous luminescence efficiency enhancement of short-term aged GaN-based blue light-emitting diodes [J].J.Semicond., 2016, 37(1):014008.
[4] KIM M H, SCHUBERT M F, DAI Q,etal.. Origin of efficiency droop in GaN-based light-emitting diodes [J].Appl.Phys.Lett., 2007, 91(18):183507-1-3.
[5] MEYAARD D S, LIN G B, SHAN Q F,etal.. Asymmetry of carrier transport leading to efficiency droop in GaInN based light-emitting diodes [J].Appl.Phys.Lett., 2011, 99(25):251115-1-2.
[6] MUKAI T, YAMADA M, NAKAMURA S. Characteristics of InGaN-based UV/blue/green/amber/red light-emitting diodes [J].Jpn.J.Appl.Phys., 1999, 38(7A):3976-3981.
[7] YANG Y, CAO X A, YAN C H. Investigation of the nonthermal mechanism of efficiency rolloff in InGaN light-emitting diodes [J].IEEETrans.ElectronDev., 2008, 55(7):1771-1775.
[8] HADER J, MOLONEY J V, KOCH S W,etal.. Density-activated defect recombination as a possible explanation for the efficiency droop in GaN-based diodes [J].Appl.Phys.Lett., 2010, 96(22):221106-1-3.
[9] HADER J, MOLONEY J V, KOCH S W. Temperature-dependence of the internal efficiency droop in GaN-based diodes [J].Appl.Phys.Lett., 2011, 99(18):181127-1-3.
[10] SHEN Y C, MUELLER G O, WATANABE S,etal.. Auger recombination in InGaN measured by photoluminescence [J].Appl.Phys.Lett., 2007, 91(14):141101-1-3.
[11] MEYAARD D S, SHAN Q F, CHO J,etal.. Temperature dependent efficiency droop in GaInN light-emitting diodes with different current densities [J].Appl.Phys.Lett., 2012, 100(8):081106-1-3.
[12] HUH C, SCHAFF W J, EASTMAN L F,etal.. Temperature dependence of performance of InGaN/GaN MQW LEDs with different indium compositions [J].IEEEElectronDev.Lett., 2004, 25(2):61-63.
[13] JIANG R, LU H, CHEN D J,etal. Temperature-dependent efficiency droop behaviors of GaN-based green light-emitting diodes [J].Chin.Phys. B, 2013, 22(4):047805-1-4.
[14] PLOCH N L, EINFELDT S, FRENTRUP M,etal.. Solar blind UV region and UV detector development objectives [J].Semicond.Sci.Technol., 2013, 28(12):2558-2562.
[15] JANI O, FERGUSON I, HONSBERG C,etal.. Design and characterization of GaN/InGaN solar cells [J].Appl.Phys.Lett., 2007, 91(13):132117-1-3.
[16] LANG J R, YOUNG N G, FARRELL R M,etal.. Carrier escape mechanism dependence on barrier thickness and temperature in InGaN quantum well solar cells [J].Appl.Phys.Lett., 2012, 101(18):181105-1-5.
[17] SILVACO INC. ATLAS User’s Manual 2012 [EB/OL]. (2013-10-02). http://www.silvaco.com.
[18] LAI K Y, LIN G J, CHEN C Y,etal.. Origin of hot carriers in InGaN-Based quantum-well solar cells [J].IEEEElectronDev.Lett., 2011, 32(2):179-181.
[19] O’DONNELL K P, MARTIN R W, MIDDLETON P G. Origin of luminescence from InGaN diodes [J].Phys.Rev.Lett., 1999, 82(1):237-240.
[20] KRESTNIKOV I L, LEDENTSOV N N, HOFFMANN A,etal.. Quantum dot origin of luminescence in InGaN-GaN structures [J].Phys.Rev. B, 2002, 66(15):155310-1-5.
[21] CHANG H J, CHEN C H, CHEN Y F,etal.. Direct evidence of nanocluster-induced luminescence in InGaN epifilms [J].Appl.Phys.Lett., 2005, 86(86):021911-1-3.
[22] SUN Q, YAN W, FENG M X,etal.. GaN-on-Si blue/white LEDs: epitaxy, chip, and package [J].J.Semicond., 2016, 37(4):044006.
[23] SANTI C D, MENEGHINI M, GRASSAM L,etal.. Role of defects in the thermal droop of InGaN-based light emitting diodes [J].J.Appl.Phys., 2016, 119(9):094501.

刘诗涛(1992-),男,湖南郴州人,硕士研究生,2010年于南昌大学获得学士学位,主要从事InGaN材料光电性能的研究。

E-mail: 464120296@qq.com 王立(1976-),男,江西井冈山人,博士,研究员,2006年于南昌大学获得博士学位,主要从事光电子材料与器件的研究。
E-mail: wl@ncu.edu.cn
中国物理学会发光分会第13届委员名单(30名)
江风益 康俊勇 李京波 刘佩华 刘益春 吕有明 彭俊彪 申德振
宋宏伟 孙甲明 汤子康 王笑军 王永生 王育华 肖志国 徐春祥
许 武 尹 民 张国义 许秀来 张洪杰 张建华 腾 枫 赵东旭
庄卫东 魏志鹏 周 济 张喜田 于 贵 刘 雷
中国物理学会发光分会第12届常委委员建议名单(11名)
江风益 刘益春 彭俊彪 申德振 汤子康 王永生 许 武 张国义
张洪杰 徐春祥 刘 雷
中国物理学会发光分会第12届领导名单
主 任:申德振
副主任:王永生 刘益春 许 武
秘书长:赵东旭
副秘书长:刘可为
Temperature-dependent Carrier Leakage in InGaN/GaN Multiple Quantum Wells Light-emitting Diodes
LIU Shi-tao1,2,3, WANG Li1,2,3*, WU Fei-fei1,2,3, YANY Qi1,2,3, HE Yuan-dan1,2,3, ZHANG Jian-li1,2,3, QUAN Zhi-jue1,2,3, HUANG Hai-bin1,2,3
(1.CollegeofMaterialScienceandEngineering,NanchangUniversity,Nanchang330031,China;
2.NationalEngineeringResearchCenteronSiSubstrate,NanchangUniversity,Nanchang330047,China;
3.CollegeofPhotovoltaic,NanchangUniversity,Nanchang330031,China)
*CorrespondingAuthor,E-mail:wl@ncu.edu.cn
By measuring the photocurrent, we directly observed the relationship between the degree of carrier leakage and the temperature in InGaN multiple quantum wells. When LED’s working temperature rises from room temperature to 360 K, the photocurrent increases under the same light intensity. The increase of the sample’s photocurrent means larger amount of carrier leakage when the temperature rises. At the same time, it is found that the carriers leak more in a lower density, and the increase of photocurrent is related to the emission photon energy. The model of quantum well-quantum dot can explain the phenomena observed in the experiment, such as the rise of temperature shows little influence on carrier leakage when the excitation light wavelength is relatively short, and causes more carrier leakage when the emission light wavelength is longer. Also, this model can well explain that the carriers leak more in a lower density and leak less in a higher density when the temperature rises. The experiment results suggest that the carrier leakage is the dominant mechanism for T-droop effect when the temperature rises from 300 to 360 K.
InGaN/GaN MQWs; light-emitting diodes; carrier leakage; quantum efficiency
2016-07-17;
2016-09-24
国家自然科学基金(61564007,11364034); 江西省科技支撑计划(2014BE50035)资助项目 Supported by National Natural Science Fundation of China(61564007,11364034); Jiangxi Provincial Sci-Tech Support Plan (2014BE50035)
1000-7032(2017)01-0063-07
TN383+.1; O484.4
A
10.3788/fgxb20173801.0063
