量子阱层和垒层具有不同Al组分的270/290/330 nm AlGaN基深紫外LED光电性能
2017-02-15王福学叶煊超
王福学, 叶煊超
(1. 无锡职业技术学院 汽车与交通学院, 江苏 无锡 214121; 2. 江南大学 理学院, 江苏 无锡 214122)
量子阱层和垒层具有不同Al组分的
270/290/330 nm AlGaN基深紫外LED光电性能
王福学1*, 叶煊超2
(1. 无锡职业技术学院 汽车与交通学院, 江苏 无锡 214121; 2. 江南大学 理学院, 江苏 无锡 214122)
为了研究AlGaN量子阱层和垒层中Al组分不同对AlGaN基深紫外发光二极管(LED)光电性能的影响,本文利用MOCVD生长、光刻和干法刻蚀工艺制备了AlGaN量子阱层和垒层具有不同Al组分的270/290/330 nm深紫外LED,通过实验和数值模拟计算方法发现,量子阱层和垒层中具有低Al组分紫外LED的AlGaN材料具有较低的位错密度、较高的光输出功率和外量子效率。通过电流-电压(I-V)曲线拟合出的较大的理想因子(>3.5)和能带结构图表明,AlGaN深紫外LED的电流产生是隧穿机制占据主导作用,这是因为高Al组分AlGaN量子阱中强极化场造成了有源层区域较大的能带弯曲和电势降。
AlGaN; 深紫外; 发光二极管; 数值模拟
1 引 言
基于高Al组分的AlGaN基深紫外发光二极管 (UV LED)在空气和水的净化、表面消毒、紫外线固化、医学光疗等方面有广泛的应用。虽然深紫外LED的光输出功率已经被大大提高[1-3],但是AlxGa1-xN基深紫外LED仍然存在外量子效率和发光功率低的瓶颈问题[4]。现有报道表明,发光波段在200~350 nm的深紫外LED的外量子效率通常都低于10%,相比于InxGa1-xN基的近紫外和可见光LED的外量子效率低一个数量级。导致AlGaN深紫外LED外量子效率过低的因素有很多。首先,高Al组分AlxGa1-xN材料和蓝宝石衬底之间具有较大的晶格失配和热失配,造成AlxGa1-xN在蓝宝石衬底上外延生长时会产生大的位错密度,形成严重的非辐射复合中心[5];其次,Ⅲ族氮化物的有源层异质结界面处诱发的自发和压电极化电荷使得量子阱能带发生倾斜,减弱了电子和空穴波函数的交叠,从而进一步降低了辐射复合速率[6-7]。此外,深紫外LED中空穴和电子注入不平衡而引起的电子溢漏被认为是内量子效率较低的重要因素[8]。目前研究者们采取多种方法来解决这些难题,例如,应用能带调控工程设计不同的能带结构[9-11],采用低位错密度的衬底材料并结合衬底减薄、封装、反射电极等技术[12-15]。但是,对于这些方法,通常很难分清每一个技术突破分别对内量子效率和外量子效率提高所做出的贡献,相关的物理机制也没有被研究清楚。
为了探究AlGaN多量子阱中Al组分变化对AlGaN基深紫外LED光电性能的影响,我们制备了3种波长的深紫外LED。在保持其他结构参数不变的情况下,通过调节AlGaN量子阱层和垒层中的Al组分使得它们的发光波长分别为270,290,330 nm。深入研究了Al组分变化对于深紫外LED的电致发光(EL)、外量子效率和电学性能的影响机理,并利用二维数值仿真计算对影响深紫外LED光电性能的内在物理机制进行了分析和解释。
2 实 验
图1是AlGaN基深紫外LED的结构示意图。LED外延片是通过金属有机化学气相沉积(MOCVD)在蓝宝石衬底上生长制作。三甲基镓(TMGa)、三甲基铝(TMAl)、硅烷、Cp2-Mg和氨气作为反应气体,H2为载气。在蓝宝石衬底上先生长薄层的AlN模板,然后生长AlN/AlGaN超晶格缓冲层,接着是2 μm厚的Si掺杂的n型AlGaN和AlGaN多量子阱有源层。有源层由5个周期的AlxGa1-xN/AlyGa1-yN量子阱层和垒层构成,AlxGa1-xN阱层和AlyGa1-yN垒层的单层厚度分别为3 nm和12 nm。AlN和AlGaN层的生长温度大约在1 100~1 200 ℃、反应压强为7 000 Pa、NH3流量为1 000 mL/min。对于AlxGa1-xN量子阱层,3种LED的TMAl流量都保持在160 mL/min;而对应270,290,330 nm的LED,TMGa流量分别为50,58,72 mL/min。生长AlyGa1-yN垒层时,3种LED的TMAl流量均保持为200 mL/min;而TMGa流量则分别为47,53,68 mL/min。最后,在量子阱有源层上生长p-AlGaN电子阻挡层(厚度为50 nm)和p-GaN接触层(厚度为100 nm)。对于270/290/330 nm 3种深紫外LED,量子阱层的Al组分分别为x=0.6,0.5,0.15,垒层组分分别为y=0.7,0.6,0.25。n-AlGaN和p-AlGaN的Al组分相同,分别为0.75,0.65,0.3。
LED芯片通过传统的光刻和干法刻蚀工艺制备:芯片尺寸为300 μm×300 μm,利用光刻和干法刻蚀工艺将n-AlGaN暴露出来,在950 ℃退火Ti/Al/Ti/Au(15/80/15/60 nm)形成n型欧姆接触,半透明电流扩展层Ni/Au(8/15 nm)金属沉积在p-GaN上。采用电致发光(EL)谱、探针台和Keithley源表表征LED的光电性能。

图1 AlGaN深紫外LED的结构示意图
3 结果与讨论
图2为270/290/330 nm深紫外LED在不同注入电流下的EL谱。当注入电流为20 mA时,能清晰地看到270 nm波段的LED半峰宽大约为16 nm,相比290 nm和330 nm波段的LED半峰宽大4 nm左右。此外,在270 nm 波段LED 的EL光谱图中可以看到一个主峰和一个在主峰右侧的强度较弱的带尾峰,但是在290 nm 和330 nm 波段的LED中只存在一个发光峰。这是由于在生长高Al组分的AlGaN时易产生相分凝现象,导致量子阱中的合金组分或阱层厚度发生变化,进而形成电势波动。水平相分凝的产生主要是由于Al和Ga吸附原子的生长不均匀以及迁移率不同导致的。因此在生长AlGaN层时会出现岛型、金字塔型以及V型沟道缺陷[16]。另一方面,在较低的电流注入下,随着电流的增加,波长较短的EL峰会出现显著蓝移现象。这是由于高Al组分量子阱中局域态的带隙填充和压电极化场的屏蔽效应引起的。从图中还可以观察到3个LED的EL发光峰随着电流的增加会出现红移现象,表明在连续电流注入模式下,LED产生了强烈的自加热作用[17]。

图2 270 nm (a)、290 nm (b)和330 nm (c)深紫外LED在不同注入电流下的电致发光(EL)谱。
Fig.2 EL spectra as a function of injection current for 270 nm (a), 290 nm (b), and 330 nm (c) UV LEDs.
图3(a) 和(b)分别为270/290/330 nm LED 的电流-光功率输出(I-L)曲线和归一化外量子效率特性。I-L曲线在较低的电流下呈现线性增长但随着电流的持续增加转化为亚线性增加,在高于70 mA电流下反而出现下降的趋势。这是由于自加热作用而导致的外量子效率降低。从图3可以明显看出,3个LED的光输出功率和外量子效率随着量子阱层和垒层的Al组分减少而增加。这是由于在蓝宝石衬底上生长较高Al组分的AlxGa1-xN薄膜时,会形成较大的位错密度从而形成大量的非辐射复合中心[18]。需要注意的是330 nm LED的最大外量子效率要明显高于270 nm和290 nm的LED。AlGaN基深紫外LED的光提取率受p-GaN吸收以及光的偏振特性影响,由于本文所生长的LED的p-GaN厚度一致,所以其光提取率主要受光偏振的影响。对于AlGaN基深紫外LED,随着Al组分的增加或者波长的降低,偏振光由TE波转换为TM波。由于TM波的光提取率要比TE波低得多,从而导致光提取率在短波处更低[19]。在330 nm波段的LED中,外量子效率达到最大值处的电流比270 nm和290 nm波段LED的电流要高。在达到最大值后,外量子效率随着注入电流的增加开始降低。这是由于在强极化场作用下,AlGaN量子阱发生能带弯曲而导致载流子在有源层的传输过程中发生溢漏现象。

图3 270/290/330 nm LED在不同注入电流下的光功率(a)和归一化的外量子效率(b)曲线
Fig.3 Current-dependent output power (a) and normalized EQE (b) of the three deep UV LEDs
图4为270/290/330 nm LED的电流-电压(I-V)曲线。在注入电流为5 mA时,3个LED的正向电压分别为5.3,5,4.5 V,表明LED的电学特性随着Al组分的增加而衰退。由于在高组分Al的AlxGa1-xN材料中,Al的激活能较高,从而导致空穴浓度较低,产生大的电阻率[20]。可以看出330 nm波段的LED在2~6 V的正向电压下,与其他两个LED相比呈现出明显不同的I-V特性。对于270 nm和290 nm的LED而言,有两个明显的指数增长区域,见图4插图部分;但是对于330 nm的LED,在相同的电压范围却只存在一个指数增长区域。在一般注入电压下LED的理想因子n可以用下式表示:
(1)
其中RP是并联电阻,RS是串联电阻,IS是饱和电流,k是波尔兹曼常量,T为绝对温度[21]。对于AlGaN基深紫外LED,RP大约为1011,远大于RS,从而上式中的V/RP和RS/RP可以忽略,式(1)可以简化为:
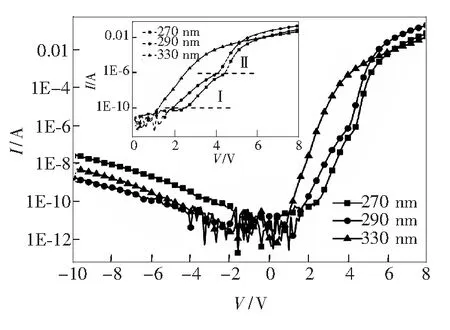
图4 270/290/330 nm 3种深紫外LED的I-V特性曲线,插图是相对应的正向I-V曲线。
Fig.4I-Vcurves of the three deep UV LEDs at room temperature. Inset: corresponding forwardI-Vcurves.
(2)
在区域Ⅰ, 270/290/330 nm LED的理想因子分别为8.01,7.8,5;在区域Ⅱ,270 nm和290 nm LED的理想因子分别为4.05和3.92。所有的理想因子均大于2,如此大的理想因子不能用肖克莱扩散和复合模型来解释,而是由于在适中的正向电压下,3个LED均存在较大的电流隧穿过程。同时理想因子随着AlGaN量子阱中Al组分的降低而降低,这是由于较高Al组分的AlxGa1-xN材料会产生较高的位错密度[22]。
为了进一步研究深紫外LED的光电特性和隧穿电流的物理机制,我们采用Silvaco Atlas 软件计算出3种LED的能带图,如图5所示。在计算中,AlGaN/AlGaN和AlGaN/GaN的带偏比例设为0.5/0.5[23],采用非完全电离模型计算离化电子和空穴浓度,电子和空穴的离化能分别为80 meV和300 meV。在求解泊松方程和载流子连续性方程时采用了载流子浓度和电场依赖的迁移率模型,并考虑了间接复合模型、表面复合模型、俄歇复合模型和光生复合模型[24]。根据Fiorentini等[25]的研究结果, 考虑到缺陷的屏蔽效应,由极化效应引起的纤锌矿型AlxGa1-xN材料的极化电荷有50%被缺陷和界面电荷补偿掉。另外,文中模拟采用的物理参数与文献[26]一致。从图5可以看出,在4 V正向电压下,270 nm和290 nm LED能带从p型到n型呈现较大的电势降;相反,330 nm LED在相同区域的电势降较为平坦。这是由于不同Al组分的AlxGa1-xN材料产生的极化场大小不同而引起能带的弯曲量不同,较大的能带弯曲会形成电子和空穴向有源层注入的势垒,从而导致LED发光效率和外量子效率的降低。这一模拟结果可以解释图2和图3的实验现象。此外,对于270 nm和290 nm LED而言,扩散电流被能带弯曲形成的势垒所抑制,总电流主要取决于载流子穿过有源层禁带通过缺陷能级复合形成的隧穿电流。

图5 采用二维数值仿真计算的270/290/330 nm LED在4 V正向偏压下的能带图
Fig.5 Energy band diagrams for 270, 290, 330 nm UV LEDs at forward voltage of 4 V calculated by 2-D numerical simulations.
4 结 论
综上所述,我们研究了AlGaN多量子阱阱层和垒层中Al组分的变化对AlGaN基深紫外LED光电性能的影响。高Al组分的AlGaN多量子阱由于较高的位错密度使得材料质量下降,以及光偏振效应的存在降低了LED输出功率和外量子效率。随着注入电流的增加,由于连续注入模式下的自加热效应,发光峰产生红移。从深紫外LED的I-V曲线计算得到较大的理想因子,表明电流的产生主要是由隧穿机制主导。通过二维数值模拟计算的能带结构图发现,AlGaN中Al组分的不同造成LED有源层区域极化强度和能带弯曲程度不同,LED中扩散电流被能带弯曲形成的势垒所抑制,总电流主要取决于载流子穿过有源层禁带通过缺陷能级复合形成的隧穿电流。
[1] SHATALOV M, YANG J W, SUN W H,etal.. Efficiency of light emission in high aluminum content AlGaN quantum wells [J].J.Appl.Phys., 2009, 105(7):073103-1-6.
[2] KHAN A, BALAKRISHNAN K, KATONA T. Ultraviolet light-emitting diodes based on group three nitrides [J].Nat.Photon., 2008, 2(2):77-84.
[3] FISCHER A J, ALLERMAN A A, CRAWFORD M H,etal.. Room-temperature direct current operation of 290 nm light-emitting diodes with milliwatt power levels [J].Appl.Phys.Lett., 2004, 84(17):3394-3396.
[4] SHATALOV M, SUN W H, LUNEV A,etal.. AlGaN deep-ultraviolet light-emitting diodes with external quantum efficiency above 10% [J].Appl.Phys.Express, 2012, 5(8):082101-1-3.
[5] HIRAYAMA H, YATABE T, NOGUCHI N,etal.. 231-261 nm AlGaN deep-ultraviolet light-emitting diodes fabricated on AlN multilayer buffers grown by ammonia pulse-flow method on sapphire [J].Appl.Phys.Lett., 2007, 91(7):071901-1-3.
[6] HUANG M F, LU T H. Optimization of the active-layer structure for the deep-UV AlGaN light-emitting diodes [J].IEEEJ.Quant.Electron., 2006, 42(8):820-826.
[7] 李杨, 冯列峰, 李丁, 等. 半导体GaN基蓝光发光二极管的精确电学特性 [J]. 光电子·激光, 2013, 24(4):663-668. LI Y, FENG L F, LI D,etal.. Accurate electrical properties of semiconductor GaN blue light emitting diodes at large forward bias voltage [J].J.Optoelectron.·Laser, 2013, 24(4):663-668. (in Chinese)
[8] KIM K H, FAN Z Y, KHIZAR M,etal.. AlGaN-based ultraviolet light-emitting diodes grown on AlN epilayers [J].Appl.Phys.Lett., 2004, 85(20):4777-4779.
[9] SCHUBERT M F, XU J R, KIM J K,etal.. Polarization-matched GaInN/AlGaInN multi-quantum-well light-emitting diodes with reduced efficiency droop [J].Appl.Phys.Lett., 2008, 93(4):041102-1-3.
[10] ZHANG J C, ZHU Y H, EGAWA T,etal.. Suppression of the subband parasitic peak by 1 nm i-AlN interlayer in AlGaN deep ultraviolet light-emitting diodes [J].Appl.Phys.Lett., 2008, 93(13):131117-1-3.
[11] GUTT R, PASSOW T, KUNZER M,etal.. AlGaN-based 355 nm UV light-emitting diodes with high power efficiency [J].Appl.Phys.Express, 2012, 5(3):032101-1-3.
[12] 樊晶美, 王良臣, 刘志强. 表面粗化对GaN基垂直结构LED出光效率的影响 [J]. 光电子·激光, 2009, 20(8):994-996. FAN J M, WANG L C, LIU Z Q. The influence of surface roughening on GaN based vertical-electrodes LEDs [J].J.Optoelectron.·Laser, 2009, 20(8):994-996. (in Chinese)
[13] SUN Q, YAN W, FENG M X,etal.. GaN-on-Si blue/white LEDs: eptaxy, chip, and package [J].J.Semicond., 2016, 37(4):044006.
[14] 吴震, 钱可元, 韩彦军, 等. 高效率、高可靠性紫外LED封装技术研究 [J]. 光电子·激光, 2007, 18(1):1-4. WU Z, QIAN K Y, HAN Y J,etal.. Study on packaging technology of ultraviolet LED with high efficiency and reliability [J].J.Optoelectron.·Laser, 2006, 18(1):1-4. (in Chinese)
[15] 杜帅, 张方辉. 基于液晶衬垫的OLED光萃取 [J]. 光电子·激光, 2016, 27(4):380-385. DU S, ZHANG F H. OLED light extraction based on liquid crystal spacer [J].J.Optoelectron.·Laser, 2016, 27(4):380-385. (in Chinese)
[16] GHERASIMOVA M, CUI G, REN Z,etal.. Heteroepitaxial evolution of AlN on GaN grown by metal-organic chemical vapor deposition [J].J.Appl.Phys., 2004, 95(5):2921-2923.
[17] YANG Y, CAO X A, YAN C H. Investigation of the nonthermal mechanism of efficiency rolloff in InGaN light-emitting diodes [J].IEEETrans.ElectronDev., 2008, 55(7):1771-1775.
[18] CHEN K X, DAI Q, LEE W,etal.. Effect of dislocations on electrical and optical properties ofn-type Al0.34Ga0.66N [J].Appl.Phys.Lett., 2008, 93(19):192108-1-3.
[19] RYU H Y, CHOI I G, CHOI H S,etal.. Investigation of light extraction efficiency in AlGaN deep-ultraviolet light-emitting diodes [J].Appl.Phys.Express, 2013, 6(6):062101-1-4.
[20] LI Y, CHEN S C, TIAN W,etal. Advantages of AlGaN-based 310-nm UV light-emitting diodes with Al content graded AlGaN electron blocking layers [J].IEEEPhoton.J., 2013, 5(4):8200309-1-10.
[21] WITTE H, ROHRBECK A, GÜNTHER K M,etal.. Electrical investigations of AlGaN/AlN structures for LEDs on Si (111) [J].Phys.Stat.Sol. (a), 2011, 208(7):1597-1599.
[22] LEE K B, PARBROOK P J, WANG T,etal.. The origin of the high ideality factor in AlGaN-based quantum well ultraviolet light emitting diodes [J].Phys.Stat.Sol. (b), 2010, 247(7):1761-1763.
[23] PIPREK J, LI S. Electron leakage effects on GaN-based light-emitting diodes [J].Opt.Quant.Electron., 2010, 42(2):89-95.
[24] YANG G F, LI G H, GAO S M,etal.. Characteristics of N-face InGaN light-emitting diodes with p-type InGaN/GaN superlattice [J].IEEEPhoton.Technol.Lett., 2013, 25(23):2369-2372.
[25] FIORENTINI V, BERNARDINI F, SALA F D,etal.. Effects of macroscopic polarization in Ⅲ-Ⅴ nitride multiple quantum wells [J].Phys.Rev. B, 1999, 60(12):8849-8858.
[26] VURGAFTMAN I, MEYER J R, RAM-MOHAN L R. Band parameters for Ⅲ-Ⅴ compound semiconductors and their alloys [J].J.Appl.Phys., 2001, 89(11):5815-5875.

王福学(1976-),男,山东济宁人,博士,2011年获得博士学位,主要从事宽禁带半导体光电材料与器件的研究。
E-mail: wangfuxue2008@163.com
270/290/330 nm AlGaN-based Deep Ultraviolet Light-emitting Diodes with Different Al Content in Quantum Wells and Barriers
WANG Fu-xue1*, YE Xuan-chao2
(1.SchooofAutomobileandTransportation,WuxiInstituteofTechnology,Wuxi214121,China;
2.SchoolofScience,JiangnanUniversity,Wuxi214122,China)
*CorrespondingAuthor,E-mail:wangfuxue2008@163.com
The optical and electrical properties of 270/290/330 nm AlGaN-based deep ultraviolet (UV) light-emitting diodes (LEDs) with different Al content in quantum wells and barriers were investigated systematically. Based on the experimental and numerical study, It is observed that the UV LEDs with longer wavelength and lower Al composition in AlGaN multiple quantum wells (MQWs) possess less dislocation density, higher light output power and internal quantum efficiency. The large ideality factors calculated fromI-Vcurves and simulated energy band profiles indicate that the current in the deep UV LEDs with high Al content is dominated by tunneling mechanism, which is attribute to the resulting potential drop in the active region caused by large polarization field in AlGaN MQWs.
AlGaN; deep ultraviolet; light-emitting diodes (LEDs); numerical simulation
2016-07-18;
2016-09-14
中国博士后科学基金(2014M561623); 江苏省博士后科研资助计划(1401013B)资助项目 Supported by China Postdoctoral Science Foundation(2014M561623); Jiangsu Planned Projects for Postdoctoral Research Funds(1401013B)
1000-7032(2017)01-0057-06
TN304.23
A
10.3788/fgxb20173801.0057
