CMOS有源像素图像传感器的电子辐照损伤效应研究
2017-02-13玛丽娅李豫东刘昌举
玛丽娅,李豫东,郭 旗∗,刘昌举,文 林,汪 波
(1.中国科学院特殊环境功能材料与器件重点实验室,
新疆电子信息材料与器件重点实验室,中国科学院新疆理化技术研究所,新疆乌鲁木齐 830011;2.中国科学院大学,北京 100049; 3.重庆光电技术研究所,重庆 400060)
CMOS有源像素图像传感器的电子辐照损伤效应研究
玛丽娅1,2,李豫东1,郭 旗1∗,刘昌举3,文 林1,汪 波1,2
(1.中国科学院特殊环境功能材料与器件重点实验室,
新疆电子信息材料与器件重点实验室,中国科学院新疆理化技术研究所,新疆乌鲁木齐 830011;2.中国科学院大学,北京 100049; 3.重庆光电技术研究所,重庆 400060)
对某国产CMOS图像传感器进行了两种不同能量的电子辐照试验,在辐照前后及退火过程中采用离线测量方法,考察了暗信号、饱和电压、光谱响应特性等参数,分析了器件的电子辐照效应损伤机理。结果表明:暗信号和暗信号非均匀性都随着辐照剂量的增加及高温退火时间的延长而增大;饱和电压在两种能量电子辐照下均出现较大幅度的减小,并在高温退火过程中有所恢复;光谱响应特性无特别明显变化。经分析,暗电流、饱和电压的变化主要由辐照诱发的氧化物陷阱电荷导致的光敏二极管耗尽层展宽和界面陷阱电荷密度增大导致产生-复合中心的增加所引起。
电子辐照;CMOS有源像素传感器;暗信号
1 引 言
固态图像传感器是星敏感器中的核心部件。从二十世纪七十年代末和八十年代初开始,电荷耦合器件(CCD)成为星敏感器的首选图像传感器。但是,CCD在应用过程中逐渐暴露出一些问题,如抗辐射能力差、供电复杂、兼容性差、成本高等[1]。CMOS有源像素图像传感器克服了CCD器件的很多缺点,具有成本和功耗相对较低、集成度高、抗辐射性能强以及没有拖影等优点[2-6],充分满足了星用载荷对图像敏感器件的要求。然而航天器及卫星所在的空间环境非常复杂且恶劣,充斥着γ射线、高能电子、质子以及其他重离子等[7]。高能粒子入射会导致星用光电器件的性能变差,严重时,使其彻底损坏。因此非常有必要开展CMOS有源像素图像传感器(APS)的辐照模拟试验研究,探索其辐射损伤机理。
国外研究人员在CMOS APS的辐射效应研究方面开展了大量工作。具有代表性的是Beaumel开展的CMOS APS图像传感器的总剂量辐照效应研究。他们选用γ射线、电子和质子辐照样品[8],结果发现辐照会导致CMOS APS图像传感器暗电流增加、光响应度降低、非均匀性增大、随机电报信号产生等现象。国内近几年来开展了一些CMOS APS图像传感器辐照效应方面的研究,但大部分集中在γ射线以及质子、中子辐照试验研究,对于卫星工作的空间环境中大量存在的高能电子对CMOS APS图像传感器的辐照损伤研究开展较少[9-14]。
为了获得CMOS APS图像传感器在电子辐照后的参数变化规律,分析其退化机理,为国产CMOS APS图像传感器的抗辐射加固提供数据支持,本文对某国产CMOS APS开展了电子束辐照试验研究,在辐照后进行了室温和高温退火实验,分析讨论了引起CMOS APS器件参数退化的原因。
2 实验方法
实验样品采用国产的特征尺寸为0.5 μm、CMOS N阱工艺制造的CMOS APS,像元数为256× 256,尺寸为25 μm×25 μm。像素单元结构如图1所示,器件包括像素单元、水平移位与垂直移位暂存器、时钟控制等数字电路与模拟电路部分,曝光时间控制是采用改变时序的方法实现的。像素单元中含有N型阱/P型衬底的光敏二极管,源极跟随器、复位管及行选通管等金属氧化物场效应晶体管(MOSFET)组成的有源电路[9],场氧厚度约为500 nm,栅氧厚度为12.5 nm。
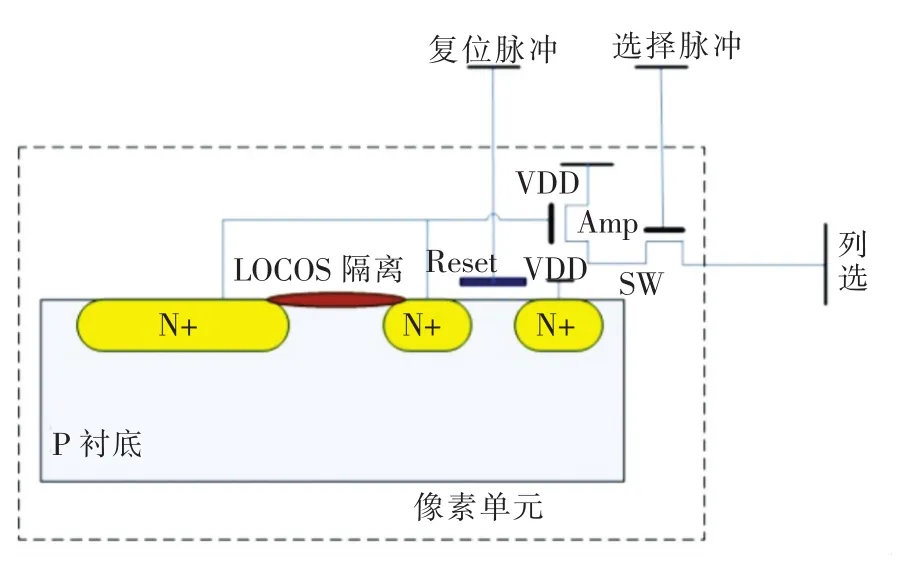
图1 像素单元结构示意图Fig.1 Pixel unit structure diagram
辐照试验在中国科学院新疆理化技术研究所ELV-8型2 MeV电子加速器上完成,待测器件放置于辐照源附近。采用驱动偏置电路提供器件的驱动时序及电源,使其处于正常工作状态。为避免驱动电路板受辐照后对实验结果的干扰,用铅砖对电路板进行屏蔽。试验中电子能量选取1 MeV、1.8 MeV两个能量,1 MeV电子辐照下经等效换算对应的剂量率为26.04 rad(Si)/s,1.8 MeV电子辐照下等效换算对应的剂量率为21.29 rad(Si)/s。在两种能量电子辐照下,器件均处于动态偏置状态,选取5,10,20,30,50,70 krad(Si)剂量点作移位测试。辐照实验完成后,进行50 h左右的室温加偏退火,以及168 h的100℃高温加偏退火,在退火达到一定时间时,也对器件作移位测试。

图2 测试系统的实物图Fig.2 Picture of testing system
实验过程中测试了器件的暗信号、暗信号非均匀性、饱和输出电压、光谱响应度等参数。所有参数测试均在30 min内完成。在中国科学院新疆理化技术研究所“光电成像器件辐射效应测试系统”上完成CMOS APS的光学、电学参数测试。测试系统的实物图如图2所示。该系统包括机械控制部分、电参数测试部分、光学部件等[15]。
3 结果与讨论
暗信号即为器件在完全没有光照的条件下输出的信号,具体的测试原理在文献[15-16]中已给出。暗信号和暗信号非均匀性随电子束辐照剂量及常温和高温退火时间的变化关系分别如图3和图4所示。在辐照过程中,暗信号和暗信号非均匀性都随着辐照剂量的增加而增大,在室温退火阶段继续增大,随着时间的延长趋于平缓;在高温退火前期,暗信号仍增大,120 h后开始趋于稳定,但仍远大于初始值;暗信号非均匀性则在高温退火期间无明显退火现象。

图3 暗信号随电子辐照剂量(a)、室温退火时间(b)和高温退火时间(c)的变化关系。Fig.3 Variation of dark signal of CMOS APS with electron-irradiation(a),room temperature annealing time(b)and high temperature annealing time(c),respectively.
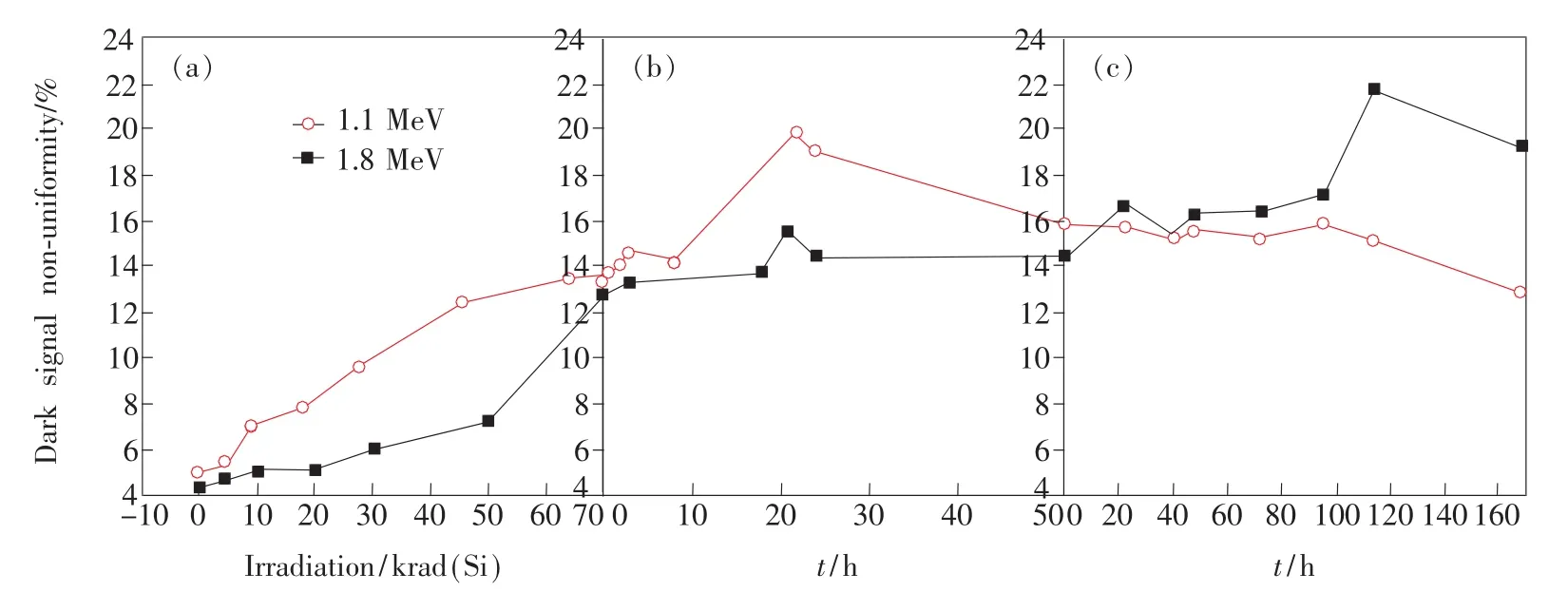
图4 暗信号非均匀性随电子辐照剂量(a)、室温退火时间(b)和高温退火时间(c)的变化关系。Fig.4 Variation of dark signal non-uniformity of CMOS APS with electron-irradiation(a),room temperature annealing time (b)and high temperature annealing time(c),respectively.
光电二极管中暗电流的主要来源为空间电荷区产生的漏电流。电子辐照CMOS APS图像传感器会产生总剂量效应[8]。高能粒子入射导致器件产生电离损伤,在CMOS图像传感器中具体表现为在光敏二极管的Si/SiO2界面形成界面陷阱电荷态以及在栅氧层内形成正的氧化物陷阱电荷[17]。
理想的p-n结反向电流表达式为[18]:

式中Isat表示中性区的扩散电流;Igr(Vrev)是从耗尽区和SiO2界面产生的电流。在假定中间态和捕获的空穴和通过截面的电子是等量的情况下,电流表达式为[18]:

式中:ni为载流子密度,是固有的常数;AJ为交界处的面积;K表示由少子扩散系数和掺杂密度共同决定的常数;Nt为产生和复合的中心密度;σ是捕获穿过横截面的电子和空穴;W表示耗尽区宽度;Vth为热速度;PJ为交界处的周长;nt是界面产生和复合中心的密度;Wint则表示SiO2-Si界面的耗尽区宽度;Vrev为反向电压。
在特定的CMOS图像传感器中,在反向电压不变时,影响暗电流的主要因素是热速度Vth和耗尽区宽度W。在SiO2中,由于电子辐照产生的氧化物陷阱电荷使得耗尽区变宽,导致光敏二极管暗电流增大[19-20],如图5所示。界面态缺陷促进了肖特基-里德-霍尔(SRH)产生过程,导致暗电流进一步增大。界面陷阱电荷随着室温退火时间的增加而逐渐积累增多,导致表面产生中心的密度增大,从而进一步引起表面漏电流的继续增大[9]。从式(1)和(2)可见,在其他条件保持相对稳定的情况下,暗信号增大的主要原因是辐照导致的耗尽区的展宽和界面态缺陷的逐渐增多。
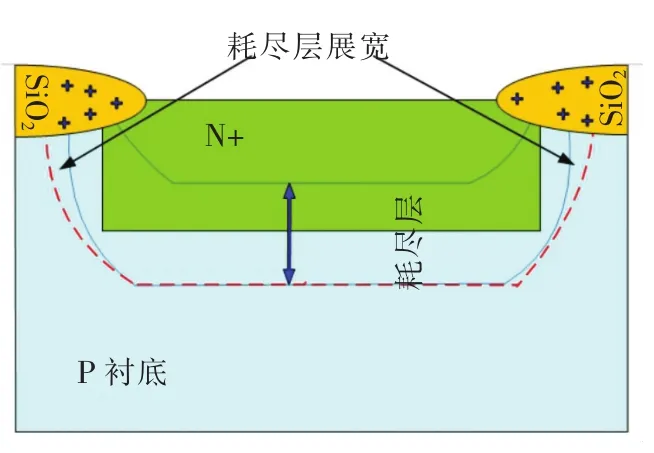
图5 电离辐射诱导氧化层缺陷电荷导致的耗尽层展宽Fig.5 Broadening of the photodiode depletion layer caused by irradiation-induced oxide trapped charge
像素放大器中的偏差和光电二极管的暗电流是引起暗信号非均匀性的主要来源。本试验中,样品电路通过采用相关双采样技术避免了像素放大器偏差带来的影响,因此光电二极管的暗电流是引发暗信号非均匀性增大的主要原因,这与暗信号变化规律是一致的。
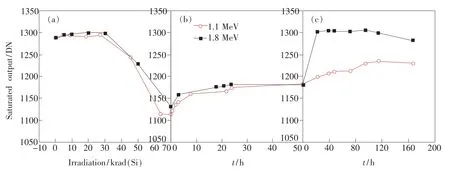
图6 饱和输出信号随电子辐照剂量(a)、室温退火时间(b)和高温退火时间(c)的变化关系。Fig.6 Variation of saturated output signal of CMOS APS with electron-irradiation(a),room temperature annealing time(b)andhigh temperature annealing time(c),respectively.

图7 1 MeV(a)和1.8 MeV(b)电子辐照前后的光谱响应曲线Fig.7 Spectral responses before and after 1 MeV(a)and 1.8 MeV(b)irradiation
饱和输出电压具体是指器件的光积分到达满阱容量时对应的输出信号,与器件本身工艺相关。如图6所示,在辐照过程中,饱和输出信号在两种能量电子辐照下均出现较大幅度的减小;在常温退火过程中无明显恢复;而在高温退火中,可以看到在1.8 MeV电子辐照下的芯片饱和输出信号基本恢复到辐照前的值,在1 MeV电子辐照下的芯片只有相对较小幅度的恢复。文献[19]认为,饱和输出电压的衰降与复位晶体管的阈值电压漂移有关。高温退火期间不同能量电子束辐照下的器件退火行为不同,表明饱和输出电压的变化与界面态缺陷有关,且1 MeV电子辐照引入的界面态缺陷密度比1.8 MeV电子辐照时大。
光谱响应是指器件对不同入射波长的响应度[21],而响应度是CMOS APS器件在单位入射光强下所输出的电压值。当器件处于某一特定波长的均匀光照下时,测量该器件的输出电压,已知相同光照条件下标准量子阱探测器的响应值,将两者相除,得到的就是该入射波长下的CMOS APS器件的响应度。采用同样的方法扫描器件的整个光谱响应范围,即可得出器件的光谱响应[16]。图7所示分别为1 MeV、1.8 MeV辐照前与辐照后(70 krad(Si))的光谱响应曲线。从结果可看出,在两种能量电子辐照下,CMOS APS的光谱响应均无特别明显变化。
4 结 论
通过对CMOS有源像素传感器的1 MeV、1.8 MeV电子束辐照试验,获得了器件的敏感参数,暗信号、暗信号非均匀性、饱和输出电压都随着辐照剂量的增加出现了较大的退化。分析认为,CMOS图像传感器中受高能粒子入射产生辐照损伤的主要是单元光敏二极管。电离辐射损伤在光敏二极管的SiO2/Si界面中形成界面陷阱电荷,在其栅氧层中则形成氧化物陷阱电荷。耗尽区由于氧化层缺陷电荷的存在而展宽,而界面态缺陷的增多也使产生-复合中心增加,通过形成可能的漏电流通道,导致器件的暗信号、暗信号非均匀性增加,饱和输出电压衰降。而不同能量电子辐照下器件的饱和输出电压的不同高温退火行为,表明饱和输出电压的变化与界面态缺陷有关,有待进一步设计单管实验进行研究。
[1]刘智.CMOS图像传感器在星敏感器中应用研究[D].长春:中国科学院长春光学精密机械与物理研究所,2004. LIU Z.Study on Application Technique of CMOS Imager in Star Tracker[D].Changchun:Changchun Institute of Optics,Fine Mechanics and Physics,2004.(in Chinese)
[2]BIGAS M,CABRUJA E,FOREST J,et al..Review of CMOS image sensors[J].Microelectron.J.,2006,37(5): 433-451.
[3]KEMPAINEN S.CMOS image sensors:eclipsing CCDs in visual information[J].EDN,1997,42(21):101-110.
[4]CHEN C H,TSAI H J,HUANG K S,et al..Study for cross contamination between CMOS image sensor and IC product [C].Proceedings of 2001 IEEE/SEMI Advanced Semiconductor Manufacturing Conference,Munich,Germany,2001:121-123.
[5]WONG H S P.CMOS image sensors-recent advances and device scaling considerations[C].Proceedings of International Electron Devices Meeting,Washington DC,USA,1997:201-204.
[6]THEUWISSEN A J P.CCD or CMOS image sensors for consumer digital still photography[C].Proceedings of 2001 International Symposium on VLSI Technology,Systems,and Applications,Hsinchu,Taiwan,China,2001:168-171.
[7]CLAEYS C,SIMOEN E.Radiation Effects in Advanced Semiconductor Materials and Devices[M].Berlin Heidelberg: Springer,2002.
[8]BEAUMEL M,HERVE D,VAN AKEN D.Cobalt-60,proton and electron irradiation of a radiation-hardened active pixel sensor[J].IEEE Trans.Nucl.Sci.,2010,57(4):2056-2065.
[9]汪波,李豫东,郭旗,等.60Co-γ射线辐照CMOS有源像素传感器诱发暗信号退化的机理研究[J].物理学报,2014,63(5):056102-1-7. WANG B,LI Y D,GUO Q,et al..Research on dark signal degradation in60Co γ-ray-irradiated CMOS active pixel sensor[J].Acta Phys.Sinica,2014,63(5):056102-1-7.(in Chinese)
[10]汪波,李豫东,郭旗,等.0.5 μm工艺CMOS有源像素传感器的总剂量辐射效应[J].发光学报,2015,36(2): 242-248. WANG B,LI Y D,GUO Q,et al..Total dose effects in 0.5 μm CMOS active pixel image sensor[J].Chin.J.Lu-min.,2015,36(2):242-248.(in Chinese)
[11]汪波,文林,李豫东,等.质子、中子、60Co-γ射线辐照对电荷耦合器件饱和输出电压的影响[J].红外与激光工程,2015,44(S):35-40. WANG B,WEN L,LI Y D,et al..Degradation of saturation output of CCD induced by proton,neutron and cobalt-60 irradiation[J].Infrared Laser Eng.,2015,44(S):35-40.(in Chinese)
[12]孟祥提,康爱国,黄强.γ射线辐照对数字型彩色CMOS图像传感器输出特性的影响[J].原子能科学技术,2004,38(S):231-235. MENG X T,KANG A G,HUANG Q.Effect of gamma-ray irradiation on output characteristic of color CMOS digital image sensors[J].Atom.Energy Sci.Technol.,2004,38(S):231-215.(in Chinese)
[13]周彦平,王晓明,常国龙,等.CMOS图像传感器的辐射实验[J].红外与激光工程,2011,40(7):1270-1273. ZHOU Y P,WANG X M,CHANG G L,et al..Radiation experiment of CMOS image sensor[J].Infrared Laser Eng.,2011,40(7):1270-1273.(in Chinese)
[14]汪波,李豫东,郭旗,等.CMOS有源像素传感器的中子辐照位移损伤效应[J].强激光与粒子束,2015,27(9): 094001-1-5. WANG B,LI Y D,GUO Q,et al..Neutron irradiation induced displacement damage effects on CMOS active pixel image sensor[J].High Power Laser Part.Beams,2015,27(9):094001-1-5.(in Chinese)
[15]李豫东,汪波,郭旗,等.CCD与CMOS图像传感器辐射效应测试系统[J].光学精密工程,2013,21(11):2778-2784. LI Y D,WANG B,GUO Q,et al..Testing system for radiation effects of CCD and CMOS image sensors[J].Opt.Precision Eng.,2013,21(11):2778-2784.(in Chinese)
[16]LI Y D,ZHANG L Q,GUO Q,et al..Radiation damage test method for CCD[C].National Academic Conference on Nuclear Electronics and Nuclear Detection Technology,Mianyang,Sichuan,2012.
[17]EID E S,CHAN T Y,FOSSURN E R,et al..Design and characterization of ionizing radiation-tolerant CMOS APS image sensors up to 30 Mrd(Si)total dose[J].IEEE Trans.Nucl.Sci.,2001,48(6):1796-1806.
[18]GOIFFON V,MAGNAN P,BERNARD F,et al..Ionizing radiation effects on CMOS imagers manufactured in deep submicron process[J].SPIE,2008:681607-1-12.
[19]GOIFFON V,ESTRIBEAU M,MAGNAN P.Overview of ionizing radiation effects in image sensors fabricated in a deepsubmicrometer CMOS imaging technology[J].IEEE Trans.Electron Dev.,2009,56(11):2594-2601.
[20]HOPKINSON G R,MOHAMMADZADEH A,HARBOE-SORENSEN R.Radiation effects on a radiation-tolerant CMOS active pixel sensor[J].IEEE Trans.Nucl.Sci.,2004,51(5):2753-2762.
[21]闫劲云,江洁,张广军.像增强型图像传感器在总剂量辐照下的光响应度[J].光学精密工程,2014,22(12): 3153-3159. YAN J Y,JIANG J,ZHANG G J.Photoelectric response of ICMOS on total dose irradiation[J].Opt.Precision Eng.,2014,22(12):3153-3159.(in Chinese)

玛丽娅(1987-),女,新疆乌鲁木齐人,博士研究生,2013年于中国科学院新疆理化技术研究所获得硕士学位,主要从事光电材料与器件辐射效应的研究。
E-mail:maria0511@163.com

郭旗(1964-),男,新疆乌鲁木齐人,研究员,博士生导师,1986年于北京理工大学获得学士学位,主要从事半导体材料与器件辐射效应的研究。
E-mail:guoqi2810@163.com
Electron Beam Radiation Effects on CMOS Active Pixel Sensor
MA Li-ya1,2,LI Yu-dong1,GUO Qi1,LIU Chang-ju3,WEN Lin1,WANG Bo1,2
(1.Key Laboratory of Functional Materials and Devices for Special Environments,Xinjiang Key Laboratory of Electronic Information Materials and Devices,Xinjiang Technical Institute of Physicsand Chemistry,Chinese Academy of Sciences,Urumqi 830011,China;2.University of Chinese Academy of Sciences,Beijing 100049,China;3.Chongqing Technical Institute of Photoelectronics,Chongqing 400060,China)∗Corresponding Author,E-mail:guoqi2810@163.com
Electron beam irradiation experiments were taken on the domestic CMOS image sensors,the irradiation effect and damage mechanism of the devices were analyzed.By using off-line measuring method before and after irradiation and in the process of annealing,the parameters such as dark signal,saturated voltage,spectral response characteristics were measured.The experiment results show that the non-uniformity of dark signal and dark current increase with the increase of irradiation dose and high temperature annealing time.The saturation voltages reduce significantly under the electron beam irradiation and recover in the process of high temperature annealing.There is no significant change for spectral response characteristics before and after the irradiation.The changes of the dark current,saturation voltage are due to the broadening of the photodiode depletion layer caused by irradiation-induced oxide trapped charge and the increase of recombination centers caused by irradiation-induced interface states.
electron irradiation;CMOS active pixel sensor;dark current
TN29
A
10.3788/fgxb20173802.0182
1000-7032(2017)02-0182-06
2016-08-22;
2016-09-21
国家自然科学基金(11005152,11275262)资助项目Supported by National Natural Science Foundation of China(11005152,11275262)
