一维GaN纳米材料制备及其光电器件研究进展*
2016-12-09贾若飞杨丽丽
贾若飞,杨丽丽,杨 丰,王 飞,杨 慧,李 岚
(天津理工大学,显示材料与光电器件教育部重点实验室,天津市光电显示材料与器件重点实验室,材料科学与工程学院,材料物理所,天津 300384)
一维GaN纳米材料制备及其光电器件研究进展*
贾若飞,杨丽丽,杨 丰,王 飞,杨 慧,李 岚
(天津理工大学,显示材料与光电器件教育部重点实验室,天津市光电显示材料与器件重点实验室,材料科学与工程学院,材料物理所,天津 300384)
一维GaN纳米材料相对于薄膜材料在光电器件应用方面具有诸多优势,本文主要论述一维GaN纳米材料的主要制备方法及其光电器件应用的研究进展。首先分别介绍采用MOCVD、MBE、CVD及模板法制备一维GaN纳米材料,重点论述GaN纳米材料的结构与形貌调控。其次介绍一维GaN纳米材料分别应用于主要光电器件包括LED、太阳能电池、激光器及光探测器的研究动态,讨论纳米材料性能、结构以及制备技术对其器件性能的影响。最后对一维GaN纳米材料的发展与应用前景进行展望。
GaN;纳米线;CVD法;LED;光探测器
0 引 言
一维GaN纳米材料是纳米技术应用领域最具发展潜力的材料之一,它具有直接带隙、较大的禁带宽度(室温下Eg=3.39 eV)[1-2]、高的电子迁移率[3-5]、和很好的热学稳定性[6-7],在紫外光或蓝光发射器、探测器、高速场效应晶体管以及高温微电子器件方面有很好的应用前景[8-13]。
首先,一维纳米线呈现出柱状形态,以及在二维方向上对电子、空穴以及光子具有限制作用,使其在纳米光电子器件的构建模块上具有广泛的应用[2,14]。其次,一维GaN纳米材料的长径比和比表面积高,有利于增强其光催化活性[15-16]。再次,与异质外延生长的GaN薄膜相比,薄膜中由于晶格失配会产生高的位错密度,而GaN纳米线则由于接触面积小而容易释放应力[17-18],这极大地降低了纳米线的内部缺陷密度,使其相应的光电子器件的效率更高以及使用寿命更长。另外GaN纳米棒阵列还可用于制造柔性器件[19-20],K. Chung等在石墨烯膜上生长一层GaN纳米棒,并且成功制备成垂直结构的柔性LED器件[19]。最后,GaN纳米线还具有优异的电子传输特性[4,21-22],可应用于太阳能电池并使其能量转换效率得到提高[23]。除此之外,GaN纳米线还可能实现在低成本衬底上制造复杂半导体光电子器件[24],同时GaN纳米线可以在多种基底上生长,因而可作为集成CMOS的备选材料。
目前,已有多种方法用于制备一维GaN纳米线,主要包括金属有机物化学气相沉积法(MOCVD)、分子束外延(MBE)、化学气相沉积法(CVD)以及模板法,同时基于一维GaN纳米线的光电子器件研究目前也如火如荼,主要是利用其一维GaN的异质结结构来制备光电子器件,其应用领域广泛,包括微腔激光器、光电探测器、LEDs、太阳能电池、化学和气体传感器、导波管和非线性光学转换器等。本文主要从一维GaN纳米材料制备和光电子器件两个方面进行阐述。
1 一维GaN纳米材料制备的研究进展
1.1 MOCVD法
MOCVD法是在气相外延生长的基础上发展起来的一种新型外延生长技术。T. Kuykendall[25]等首次通过MOCVD法合成了高质量的单晶GaN纳米线。以TMGa和NH3分别作为镓源和氮源,H2作为载气,在Si、a 面蓝宝石和c 面蓝宝石衬底上,以Au、Fe和Ni为催化剂,通过VLS机理生长出GaN纳米线。其结果观察到GaN纳米线直径在15~200 nm之间。TEM结果显示,GaN纳米线基本上沿[210]或[110]方向进行取向生长,在[210]晶向的纳米线中发现有三角形截面。J.F. Qian等[26]通过MOCVD法研究了生长温度对于GaN纳米线结晶性以及表面形态的影响。他们以硅烷作为n型掺杂剂,在蓝宝石衬底上采用低温(775 ℃)和高温(950 ℃)分别生长GaN纳米线。结果发现高温下生长的GaN纳米线具有更好的形态,其长度均一性好,表面平滑,具有三角形截面,直径为100~300 nm。其晶体结构为单晶纤锌矿,沿着[11-20]取向生长,如图1所示。
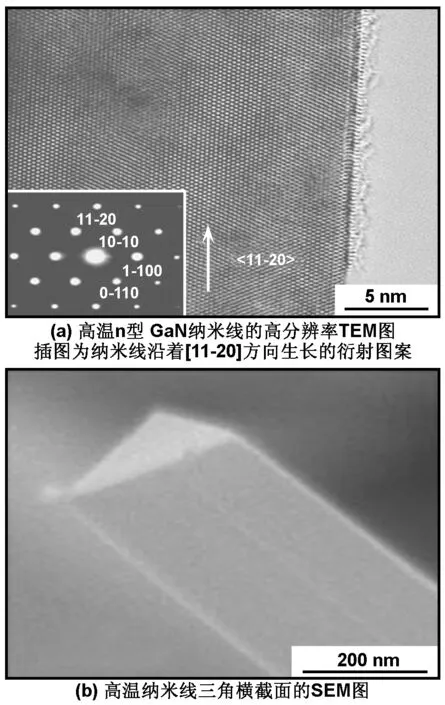
图1 (a) 高温n型 GaN纳米线的高分辨率TEM图,插图为纳米线沿着[11-20]方向生长的衍射图案, (b) 高温纳米线三角横截面的SEM图
Fig 1 (a) High-resolution TEM image of an n-type MOCVD GaN nanowire along[0001] zone axis and corresponding diffraction pattern indicating [11-20] growth direction, (b) triangular cross section SEM image of nanowires
随着研究的发展,柔性衬底的市场需求越来越大。石墨烯由于其柔韧性,透明性,便宜等优点,被用作柔性衬底开始引起人们极大的关注。J. B. Park等[16]采用MOCVD法在石墨烯衬底上生长GaN纳米线,不过同样需要Ni作催化剂,通过VLS机理生长单晶GaN纳米线。其具体步骤是先将石墨烯转移到SiO2/Si衬底上,然后在其上覆盖厚度为0.5~2 nm的Ni薄层,经过加热退火形成Ni液滴,最后以TMGa,NH3为镓源和氮源生长GaN纳米线。纳米线直径为50 nm,纳米线密度为5×109~7×109/cm2。实验表明,镍层的厚度会影响GaN纳米线形貌,其最优厚度为2 nm。此石墨烯上的GaN纳米线可应用于光催化器件,首先在大面积石墨烯薄膜上使用Ni催化剂生长GaN纳米线,之后将纳米线层转移到处理过的PET基材上,其制备过程如图2所示。为了解决纳米线与衬底之间的失配问题,K. Chung和H. Beak等[19]在石墨烯上预沉积GaN缓冲层,生长出均匀性好且覆盖整个石墨烯的GaN纳米棒,其面密度为107cm-2, 纳米线顶端呈六边形,并垂直排列于衬底上。这相对于直接在石墨烯上生长的GaN纳米线,其排列更加整齐。

图2 制备柔性GaN纳米线光催化剂器件示意图
Fig 2 A schematic diagram illustrating of the process used to fabricate the flexible photocatalysts using GaN nanowires grown on graphene films
1.2 MBE法
尽管目前基本上是通过VLS机理生长半导体纳米线,但是MBE法却能通过调整晶体表面热力学驱动力和晶面粘着系数等,直接无催化生长GaN纳米线。MBE法生长GaN纳米线,是一种利用自组织现象致使纳米线进行自诱导生长的方式。自诱导生长方式使得纳米线摆脱张力的束缚,直接在衬底上外延生长,其纳米线中无缺陷延伸,光致发光强度高,结晶较好,但纳米线会产生倾斜、扭曲生长,这主要是由Si-N非晶界面层造成。在洁净的MBE室中反应,纳米线杂质浓度极低,具有优越的显微结构和光学特性[28-31]。K. A. Bertness[27]实验表明,在830 ℃、超高压 N2条件下,因为GaN (0001)面的粘着系数高于(1100) 面,所以纳米线会自发形核和生长,研究组指出,当GaN纳米线顶端的粘着系数大于侧壁时,Ga原子会更多地撞击纳米线顶端生长,生长的纳米线直径约为500 nm,表现出垂直密集生长的特性,如图3所示。但在这种条件下,Ga液滴不稳定,不能作为纳米线生长的催化位点,这也解释了为什么在MBE中没有观察到Ga液滴。
R. Calarco研究组[32]采用频射等离子体分子束外延 (PAMBE) 法,在Si (111) 基底上无催化生长GaN纳米线。其纳米柱与衬底间的外延生长关系为GaN [0001]/Si (111),但有部分倾斜。实验发现基底温度极大地影响纳米线的形核时间,温度越高其形核时间越长。GaN纳米线能通过伪共晶生长,晶格失配小,位错密度低,结晶质量和荧光效率高。虽然MBE法能生长纳米线,但生长机制尤其是形核中存在许多不定因素。K. A. Bertness研究组[33]采用气源MBE法,在Si (111) 基底上无催化生长GaN纳米线。生长的GaN纳米线横截面为六边形,直径为50~150 nm,长约2 μm。GaN纳米柱在基底上垂直生长,其室温发光强度高,晶体质量很高,缺陷低。

图3 生长在Si基底上的GaN纳米线FESEM图
Fig 3 FESEM top view and side view of the morphology for GaN nanowire on Si substrates
1.3 模板法
模板法一般先用刻蚀等方法制备模板,并将其放在原料上方加热,气源通过模板的通道相互反应生成纳米材料,最后除去模板获得GaN纳米材料。1997年,S.S. Fan[34]以15 nm碳纳米管为模板,在900 ℃下采用CVD法反应合成了直径4~50 nm、长度20 μm的GaN纳米棒。具体为:将Ga和Ga2O的混合物放入坩埚中,再将碳纳米管放置在孔径为3~5 μm多孔氧化铝板上,加热时Ga2O气体向上流动至碳纳米管区域,并与NH3反应生成GaN纳米棒。早期的模板法非常简单,得到的GaN纳米线直径也较均匀,不足之处是GaN是无定形态。G.S. Cheng[35]采用阳极氧化铝 (AAO) 膜作模板,在1 000 ℃下利用纳米In颗粒作催化剂, Ga2O的气体通过AAO蜂窝结构中的纳米通道反应2 h,合成了长40~50μm、直径 20 nm的单晶GaN纳米线。该GaN纳米线高度有序,在可见光范围内有强荧光发射。P. D. Yang[36]先在蓝宝石晶圆上采用MOCVD法沉积ZnO纳米线 (110) 阵列,利用此ZnO阵列作模板沉积GaN,然后在600 ℃下利用H2和Ar2的混合气除去ZnO模板,最后得到了内径30~200 nm、壁厚5~20 nm的空心GaN纳米管。如图4所示,纳米管阵列高度有序,插图显示了纳米管和衬底之间的裂缝。相比之前的研究,P. D. Yang合成的单晶且空心GaN纳米管将有利于纳米光电子器件与生化传感器的应用,且空心GaN纳米管中残留的ZnO成分极少,克服了模板污染的缺点,并且此法也适用于其它半导体材料。

图4 模板法制备GaN空心纳米管阵列的SEM图
Fig 4 SEM image of the resulting GaN nanotube array
C.H. Chiu[37]利用SiO2纳米棒阵列作模板,在蓝宝石衬底上制备出了低位错密度的GaN纳米棒。他们首先采用MOCVD在衬底上沉积200 nm厚的SiO2,接着蒸镀一层10 nm的Ni,经快速退火得到自组装Ni团簇,然后自组装Ni团簇作为蚀刻掩模,采用离子蚀刻法得到SiO2阵列,最后采用MOCVD来生长GaN纳米棒。TEM表明,二氧化硅纳米棒之间的空隙和GaN横向外延生长法能引入堆垛层错,有效地减少穿透位错密度,并且在此基础上所制造的LED器件,其器件的输出功率和外部量子效率相比常规LED分别提高了52%和56%。
1.4 CVD法
CVD(化学气相沉积)法具有仪器简单,操作简便,制备成本低等优点。CVD法一般将衬底放置在石英管的下游,金属反应源放置在上游,并通入NH3作为反应气体,待石英管反应炉升温,保温一段时间使GaN成核、生长,通过控制气压、气体流速、生长温度及生长时间等参数来调节纳米线的形貌[39-41]。
目前CVD法主要有使用催化剂和无催化直接生长法。催化剂有利于GaN纳米线的成核和生长,但会引入催化剂颗粒杂质,从而影响器件性能;而无催化直接反应生长,其纳米线形貌不易控制,且难以得到高质量和形貌一致的纳米线。目前广泛采用Ni[8,42]、Au[15]、In[39]等金属颗粒作为催化剂来辅助生长,通过VLS生长机理来合成纳米线[43]。G. S. Cheng 等[39]以In纳米颗粒作催化剂合成GaN纳米线,在合成GaN纳米线的后半部分通过掺入Mg而形成具有p-n结的纳米线,在2.6 K的条件下显示出了优异的整流特性。A. Patra小组[15]以氧化镓和二氧化锰作为反应源,以Au纳米颗粒作催化剂,在Si(100)衬底上合成了锯齿状的GaN纳米线。通过SEM观察,单晶六方纤锌矿结构GaN纳米线浓密、均匀的覆盖在Si衬底表面,而且并没有引入Mn杂质。
R. Jacobs[28]等直接用金属镓和氨气在850~900 ℃反应,合成了大尺寸的六方纤锌矿GaN纳米线和纳米管,其长度大约为500 μm,直径在26~100 nm之间,实验表明纳米线的尺寸主要受反应温度和通入氨气流速的影响。V. Purushothaman等[44]用CVD法,通过自催化来生长GaN纳米线,他们主要研究了在不同反应压力下生长出纳米线的形貌差别。实验表明在大气压下通过V-L-S生长的纳米线杂乱无章的缠绕在一块,直径为80 nm,而在200Torr下通过V-S机理生长的纳米线为准阵列形貌,平均直径为160 nm。通过无催化剂CVD法制备GaN纳米线,如何控制纳米线的形貌以及其生长机理如何将会是研究重点。
2 一维GaN纳米材料制备光电器件的研究进展
2.1 一维GaN基LED器件
GaN是直接跃迁型半导体材料,有着诱人的光学性质,其合金的带隙覆盖了从红外到紫外的整个光谱范围,是目前制备LED的核心材料。H.M. Kim[45]采用HVPE法生长GaN纳米棒,并成功制备了纳米紫外p-n结型LED,实现了单晶GaN在纳米发光器件中的应用。其LED器件的发光波长为390 nm,正向偏置电压为0.5 V。此后H.M. Kim[46]采用MOCVD在蓝宝石衬底上制备了无位错InGaN/GaN多量子阱纳米棒式LED。此纳米LED采用“自下而上”法制备,即InGaN/GaN MQW纳米棒依次向上生长,形成多层结构的纳米柱阵列LED。该器件比传统LED具有更小的体积,驱动电流为20 mA时,发光峰位于460 nm,光发射强度为传统LED的4.3倍。图5为InGaN/GaN纳米棒多层量子阱示意图,插图为SEM观察的量子阱截面。
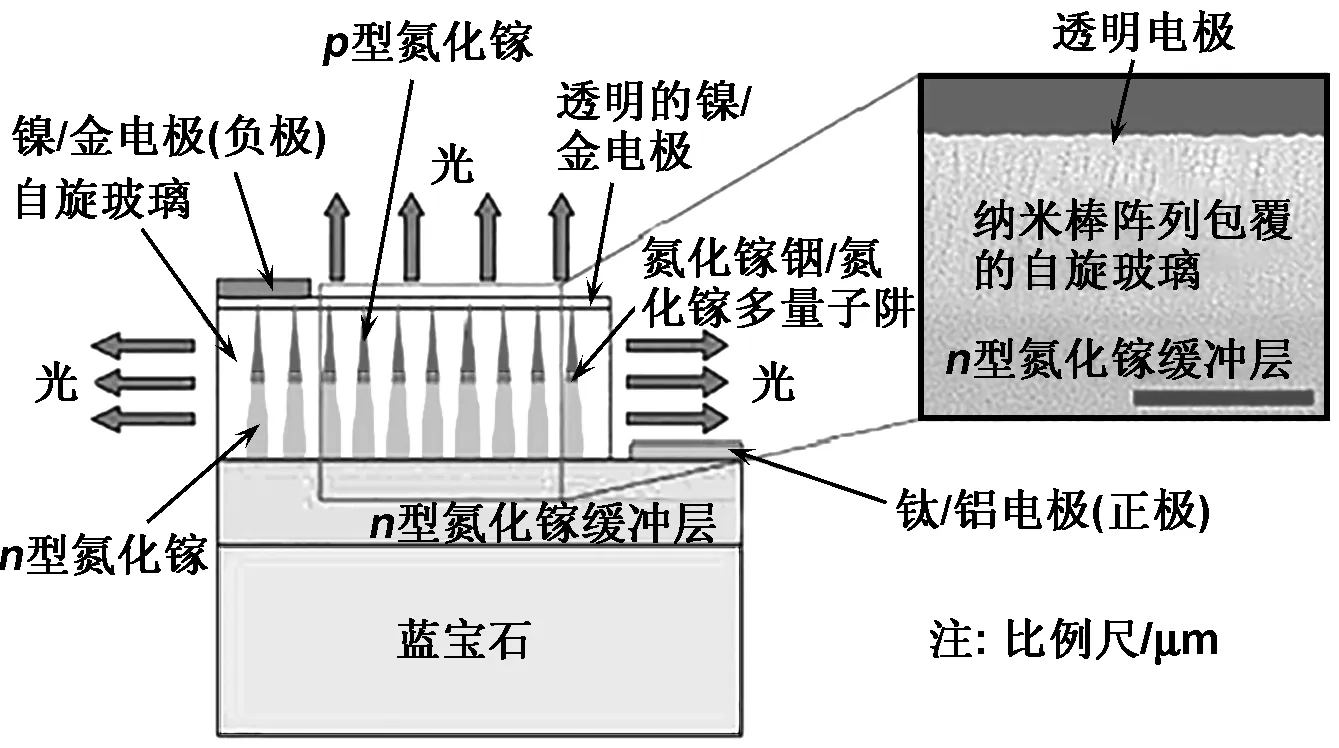
图5 InGaN/GaN纳米线线阵列多量子阱LED截面示意图(左)和SEM图(右)
Fig 5 Schematic diagram (left) and SEM image (right) of cross-sectional InGaN/GaN MQW NRA LEDs
C. Hahn[47]采用卤化物化学气相沉积在c面蓝宝石上制备了高品质长程有序的InGaN纳米线。光谱测试结果发现InGaN纳米线的直接带隙在黄-橙光区域,其LED器件实现发光波长可调,In含量依次从0.06,0.28变化到0.43,发光波长依次从蓝,绿变化到橙色。X. X. Fu[48]制备了以氧化铝膜光子晶体基础改进的GaN柱型LED,薄氧化铝膜衬底有良好的柔韧性,能与GaN柱保持良好的接触。其器件性能为:电流在20 mA下,发光效率比传统GaN薄膜型LED提高了94%,发光功率达到了12.2 mW/m2。C.Y. Chen[49]在Mg掺杂的GaN衬底上外延生长GaN纳米线,以此为基础制备了LED器件。导电AFM表征发现该器件的输出功率密度接近12.5 mW/m2,并且采用ZnO基的压电纳米发电机就可以点亮GaN纳米线LED。
2.2 一维GaN基光探测器
GaN禁带宽度为3.4 eV,纳米线可应用于365 nm以下的紫外光探测器,同时GaN和InN的合金能够生成禁带宽度能够在一定宽范围变化的InxGa1-xN,从而也能制成具有不同的截止波长的探测器。
S. Han等[7]研究小组使用单根GaN纳米线制备了FETs基紫外光探测器。首先利用CVD法VLS生长直径为15 nm的GaN纳米线,然后将GaN纳米线放置在覆盖500 nm SiO2的掺杂Si晶片上,再在单根GaN纳米线上进行光刻和沉积Ti/Au形成源、漏电极,源漏间沟道长度为2 μm,Si衬底作为背栅。该器件在254 nm UV光照射(100 s)时,具有稳定的高导电率状态,且无明显衰减现象。当器件在偏压为1 V并暴露在紫外光下,纳米线电导1 s内提高到饱和值的58.4%,并在2 s达到了81.9%。此GaN纳米线制成偏振的紫外光器件,其电导率随着入射光的偏振角度而周期性的变化。
J.W.Lee等[22]研究小组制备GaN纳米线栅门结构的光探测器。首先将GaN纳米线从Si衬底表面剥离下来,然后将其浸入在异丙醇中超声10 min,再将其制备栅门结构。施加电场使GaN纳米线排列分布在Ti/Au电极的边缘,器件性能是受电极端电压和电极图案大小的影响。经测试,最优条件是5 V电极电压和5 μm电极边缘尺寸,在365和254 nm紫外光照射下,不同的能量密度下均能获得很好的光响应性能,器件的开/关比为103,且GaN纳米线的电子浓度为1018/cm3和电子迁移率为52.1 cm/Vs 。
由于在紫外光谱波段尚缺乏透明导电材料,而目前石墨烯的出现,其高紫外光透过性和优异的导电性,使得紫外探测器性能能进一步提高。A.V. Babichev等[13]研究小组使用GaN纳米线和石墨烯复合制备紫外光探测器。首先GaN纳米线采用等离子辅助分子束外延生长,后将CVD生长的石墨烯湿转印到GaN纳米线上,再通过沉积Ti/Al/Ti/Au合金形成电极接触,并反应离子蚀刻使石墨烯结构化制成微型探测器,其结构示意图和探测器在不同情况下电流与电压的关系,如图6所示。该器件在1 V偏压、357 nm光照射下,其光响应度可达25 A/W。然而在高电场激发下,光电流饱和和光反应率都快速下降。

图6 探测器在暗处和在紫外光照射下电流与电压的关系。插图为设备原理图:1-石墨烯片,2和3-金属触点,4-n型掺杂Si(111)衬底,5-氮化镓纳米线
Fig 6 Current-voltage characteristics of the device in the dark and under UV illumination. Inset shows a device schematic with the following notations:1-graphene sheet, 2 and 3-metal contacts, 4-nt-doped Si (111) substrate, 5-GaN nanowires
2.3 一维GaN基激光器
GaN半导体能隙宽,广泛应用在电泵浦紫外蓝光LED、激光器和光电探测器上。 J. Piprek研究组[50]通过自洽激光模拟法分析蓝宝石衬底上氮化物的法布里-珀罗激光器的性能。其激光器活性区包含3个周期4 nm的InGaN量子阱,量子阱被夹在GaN单层和A1GaN/GaN超晶格包层之间。其测试结果发现器件的脉冲激光波长为420 nm,器件温度120 ℃。设计二维激光器模型有利于减少载流子漂移和扩散,使得激光器阈值降低,热耗减少。J. C. Johnson[2]报道了单晶GaN纳米线的紫外激光发射,他们运用近场和远场光学显微技术,在室温下表征了GaN纳米线波导模型结构的激光发射。此单晶GaN纳米线是通过镍催化合成的,纳米线直径在30~150 nm之间,线长达几百个微米。当GaN纳米线尺寸接近激子玻尔半径(GaN为11 nm)时,将显示增强激子效果,从而获得更低的激光阈值。如图7所示为单根GaN纳米线激光器远场光学照片。

图7 单根GaN纳米线激光器远场光学照片
2.4 一维GaN基太阳能电池
一维GaN材料在太阳能电池光电转化方面比GaN薄膜更具优势,一维纳米线具有很大的比表面积和粗糙的表面,可增强光捕获能力以及减少光反射。而且以一维纳米结构光伏太阳能电池有着更好的连续电子传输特性,有利于提高能量转化效率[51]。
Lieber研究组[52]首次制备了同轴n-GaN/i-InxGa1-xN/p-GaN结构的太阳能电池,其同轴结构截面示意图如图8所示,不同颜色的波浪箭头表示截面吸收不同波长的光,能带中的虚线表示费米能级的位置。通过控制In的含量,设计活性层带隙变化范围在2.25~3.34 eV,模拟太阳光照射测得器件的开路电压从1.0 V变化到2.0 V,短路电流密度从0.39 mA/cm2变化0.059 mA/cm2变化。Y. B. Tang等[53]在n型的Si衬底上外延生长掺Mg的GaN纳米棒,并制备了垂直结构的异质p-n结光伏电池。GaN纳米棒阵列及p-n结结构的光伏电池展现出了优异的整流特性,在黑暗条件下整流比超过104。纳米棒阵列在太阳能电池中还可作为防反射涂层,可以有效减少光损。在模拟太阳光照射条件下,器件短路光电流密度为7.6 mA/cm2,能量转换效率为2.73%。X. Y. Chen等[54]报道了GaN纳米线基染料敏化太阳能电池,其特点是在GaN纳米线外层包覆一层TiO2来增强对染料的吸附能力。测得电池的短路电流密度为1.83 mA/cm2,能量转换效率为0.44%。

图8 同轴n-GaN/i-InxGa1-xN/p-GaN异质结截面及其能带结构示意图
Fig 8 Cross-sectional view of p-GaN/i-InxGa1-xN/n-GaN heterojunction and it corresponding energy band diagrams
3 总结与展望
GaN材料因其具有优异的光电性能以及良好的化学及热力学稳定性,受到了人们的广泛关注。薄膜GaN纳米材料的制备及其应用近年来已经得到了很大的发展,一些薄膜制备技术已经能够制备出高质量、大面积的单晶GaN薄膜,但随着器件制备朝着柔性化方向的发展,一维GaN纳米材料展现出了巨大的发展前景。目前主要问题在于很难制备出整齐排列的GaN纳米线,这使得其器件应用受到很大的限制。MOCVD和MBE法虽然也可用来制备一维GaN纳米线,但制备成本很高,且不易控制纳米线的生长形貌。CVD法虽操作简便成本低,但一般需要通过使用催化剂来控制纳米线的生长,生长直径与位点依赖于催化剂颗粒的性质。目前采用模板法可得到纳米线阵列的,但纳米线直径由模板直径控制,且去除模板时可能会对一维GaN纳米线造成损伤,影响其器件性能。
一维GaN纳米材料应用于LED、光探测器、太阳能电池以及激光器等具有广阔前景,它可以与石墨烯及有机衬底结合制造柔性LED器件,可获得高灵敏度和响应速度的光探测器,独特的电子传输特性可以提高太阳能的转换效率。因此,未来如果能够有效控制一维GaN纳米线的生长形貌,将很大程度上推动以一维GaN纳米线为基础的柔性光电子器件的制备,且使得器件的性能更加优异。
[1] Nam C Y, Jaroenapibal P, Tham D, et al. Diameter-dependent electromechanical properties of GaN nanowries [J]. Nano Letters, 2006, 6(2):153-158.
[2] Justin C J, Choi H J, Knutsen K P, et al. Single gallium nitride nanowire lasers [J]. Nature Materials, 2002, 1(2): 106-110.
[3] Guo W, Zhang M, Banerjee A, et al. Catalyst-free InGaN/GaN nanowire light emitting diodes grown on (001) silicon by molecular beam epitaxy [J]. Nano Letters, 2010, 10(9):3355-3359.
[4] Chang C Y, Chi G C, Wang W M, et al. Electrical transport properties of single GaN and InN nanowires [J]. Journal of Electronic Materials, 2006, 35(4):738-743.
[5] Chen R S, Tsai H Y, Chan C H, et al. Comparision of CVD- and MBE-growth GaN nanowires: crystallinity, photominescence, and photoconductivity [J]. Journal of Electronic Materials, 2014, 44(1):177-187.
[6] Kim J R, So H M, Park J W, et al. Electrical transport properties of individual gallium nitride nanowires synthesized by chemical-vapor-deposition [J]. Applied Physics Letters., 2002, 80(19):3948-3951.
[7] Han S, Jin W, Zhang D H, et al. Photoconduction studies on GaN nanowire transistors under UV and polarized UV illumination [J]. Chemical Physics Letters, 2004, 389(1):176-180.
[8] Yan R X, Gargas D, Yang P D. Nanowire photonics [J]. Nature Photonias, 2009, 3(10):569-576.
[9] Tchernycheva M, Messanvi A, Bugallo A L, et al. Integrated photonic platform based on InGaN/GaN nanowire emitters and detectors [J]. Nano Letters, 2014, 14(6):3515-3520.
[10] Choi J H, Zoulkarneev A, Kim S I I, et al. Nearly single-crystalline GaN light-emitting diodes on amorphous glass substrates [J]. Nature Photonics, 2011, 5(12):763-769.
[11] Tsai T Y, Chang S J, Weng W Y, et al. GaN nanowire field emitters with the adsorption of Au nanoparticles [J]. Electron Device Letters, 2013, 34(4):553-555.
[12] Chen C P, Ganguly A, Lu C Y, et al. Ultrasensitive in situ label-free DNA detection using a GaN nanowire-based extended-gate field-effect-transistor sensor [J]. Analytical Chemistry, 2011, 83(6):1938-1943.
[13] Babichev A V,Zhang H, Lavenus P, et al. GaN nanowire ultraviolet photodetector with a graphene transparent contact [J]. Applied Physics Letters, 2013, 103(20):1031-1034.
[14] Kim J R, Oh H, So H M, et al. Rectifying diode made of individual gallium nitride nanowire [J]. Physica, 2003, 18(1):225-226.
[15] patra A, Ma Z, Menon L, et al. Optical properties of serrated GaN nanowires [J]. Optical Materials Express, 2014, 4(7):1371-1381.
[16] Park J B, Kim N J, Kim Y J, et al. Metal catalyst-assisted growth of GaN nanowires on graphene films for flexible photocatalyst applications [J]. Current Applied Physics, 2014, 14(11):1437-1442.
[17] Huang J Y, Zheng H, Mao S X, et al. In situ nanomechanics of GaN nanowires [J]. Nano Letters, 2011, 11(4):1618-1622.
[18] Frajtag P, Samberg P J, El-Masry N A, et al. Embedded voids format-ion by overgrowth on GaN nanowires for high-quality GaN films [J]. Journal of Crystal Growth, 2011, 322(1):27-32.
[19] Chung K, Beak H, Tchoe Y, et al. Growth and characterrizations of GaN micro-rods on graphene films for flexible light emitting diodes [J]. Applied Physics Letters Materials, 2014, 2(9):0925121-0925127
[20] Lee C H, Kim Y J, Hong Y J, et al. Flexible inorganic nanostructure light-emitting diodes fabricated on graphene films [J]. Advanced Materials, 2011, 23(40):4614-4619.
[21] Lai Y T, Ganguly A, Chen L C, et al. Direct votammetric sensing of L-Cysteine at pristine GaN nanowires electrode [J]. Biosensors and Bioelectronics, 2010, 26(4):1688-1691.
[22] Lee J W, Moon K J, Ham M H, et al. Dielectrophoretic assembly of GaN nanowires for UV sensor applications [J]. Solid State Communications, 2008, 148(5):194-198.
[23] Pearton S J, Norton D P, Ren F. The promise and perils of wide-bandgap semiconductor nanowires for sensing,electronic,and photonicapplications [J]. Small, 2007, 3(7):1144-1150.
[24] Garnett E C, Brongersma M L, Cui Y, et al. Nanowire solar cells [J]. Annual Review of Materials Research, 2011, 41(1):269-295.
[25] Kuykendall T, Pauzauskie P, Lee S, et al. Metalorganic chemical vapor deposition route to GaN nanowires with triangular cross sections [J]. Nano Letters, 2003, 3(8):1063-1066.
[26] Gradeĉak S, Qian J F, Li Y, et al. GaN nanowire lasers with low lasing thresholds [J]. Applied Physics Letters, 2005, 87(17): 1731111-1731113.
[27] Bertness K A, Roshko A, Mansfield L M, et al. Mechanism for spontaneous growthof GaN nanowires with molecular beam epitaxy [J]. Journal of Crystal Growth, 2008, 310(13): 3154-3158.
[28] Calarco R, Marso M, Richter T, et al. Size-dependent photoconductivity in MBE-grown GaN-nanowires [J]. Nano Letters, 2005, 5(5): 981-984.
[29] Geelhaar L, Cheze C, Jenichen B, et al. Properties of GaN nanowires grown by molecular beam epitaxy [J]. Selected Topics in Quantum Electronics, 2011, 17(4): 878-888.
[30] Richter T, Blomers C, Luth H, et al. Flux quantization effects in InN nanowires [J]. Nano Letters, 2008, 8(9): 2834-2838.
[31] Kishino K, Kikuchi A, Sekiguchi H, et al. InGaN/GaN nanocolumn LEDs emitting from blue to red [C]//Integrated Optoelectronic Devices 2007, International Society for Opticsand Photonics, 2007, 64:730T-64730T-12.
[32] Debnath R K, Meijers R, Richter T, et al. Mechanism of molecular beam epitaxy growth of GaN nanowires on Si (111) [J]. Applied Physics Letters, 2007, 90(12): 1231171-1231173.
[33] Bertness K A, Sanford N A, Barker J M, et al. Catalyst-free growth of GaN nanowires [J]. Journal of Electronic Materials, 2006, 35(4): 576-580.
[34] Han W, Fan S, Li Q, et al. Synthesis of gallium nitride nanorods through a carbon nanotube-confinedreaction [J]. Science, 1997, 277(5330): 1287-1289.
[35] Cheng G S, Chen S H, Zhu X G, et al. Highly ordered nanostructures of single crystalline GaN nanowires in anodic alumina membranes [J]. Materials Science and Engineering, 2000, 286(1): 165-168.
[36] Goldberger J, He R, Zhang Y, et al. Single-crystal gallium nitride nanotubes [J]. Nature, 2003, 422(6932): 599-602.
[37] Chiu C H, Yen H H, Chao C L, et al. Nanoscale epitaxial lateral overgrowth of GaN-based light-emitting diodes on a SiO2nanorod-array patterned sapphire template [J]. Applied Physics Letters, 2008, 93(8): 0811081-0811083.
[38] Li S, Fündling S, Sökmen Ü, et al. GaN nanorods and LED structures grown on patterned Si and AlN/Si substrates by selective area growth [J]. Physica Status Solid, 2010, 7(7-8): 2224-2226.
[39] Cheng G S, Kolmakov A, Zhang Y X, et al. Current rectification in a single GaN nanowire with a well-defined p-n junction [J]. Applied Physics Letters, 2003, 83(8):1578-1580.
[40] He M Q, Minus I, Zhou P Z, et al. Growth of largr-scale GaN nanowires and tubes by direct reaction of Ga with NH3[J]. Applied Physics Letters, 2000, 77(23):3731-3733.
[41] Wnag J C, Feng S Q, Yu D P. High-quality GaN nanowires synthesized using a CVD approach [J]. Applied Physics Letters, 2002, 75(6):691-693.
[42] Chen X H, Xu J, Wang R M, et al. High-quality ultra-fine GaN nanowires synthesized via chemical vapor deposition [J]. Advanced Materials, 2003, 15(5):419-421.
[43] Gottschalch V, Wagner G, Bauer J, et al. VLS growth of GaN nanowires on various substrates [J]. Journal of Crystal Growth, 2008, 310(23):5123-5128.
[44] Purushothaman V, Ramakrishnan V, Jeganathan K. Interplay of VLS and VS growth mechanism for GaN nanowires by a self-catalytic apporach [J]. Royal Society of Chemistry Advanced, 2012, 2(11):4802-4806.
[45] Kim H M, Kang T W, Chung K S. Nanoscale ultraviolet-light-emitting diodes using wide-bandgap gallium nitride nanorods [J]. Advanced Materials, 2003, 15(7-8): 567-569.
[46] Kim H M, Cho Y H, Lee H, et al. High-brightness light emitting diodes using dislocation-free indium gallium nitride/gallium nitride multiquantum-well nanorod arrays [J]. Nano Letters, 2004, 4(6): 1059-1062.
[47] Hahn C, Zhang Z, Fu A, et al. Epitaxial growth of InGaN nanowire arrays for light emitting diodes [J]. ACS Nano, 2011, 5(5): 3970-397.
[48] Fu X X, Zhang B, Kang X N, et al. GaN-based light-emitting diodes with photonic crystals structures fabricated by porous anodic alumina template [J]. Optics Express, 2011, 19(105): A1104-A1108.
[49] Chen C Y, Zhu G, Hu Y, et al. Gallium nitride nanowire based nanogenerators and light-emitting diodes [J]. ACS Nano, 2012, 6(6): 5687-5692.
[50] Piprek J, Sink R K, Hansen M A, et al. Simulation and optimization of 420-nm InGaN/GaN laser diodes [C]//: Symposium on Integrated Optoelectronics. International Society for Optics and Photonics, 2000: 28-39.
[51] Zhang G Q, Finefrock S, Liang D X, et al. Semiconductor nanostructure-based photovoltaic solar cells [J]. Nanoscale, 2011, 3(6):2430-2443.
[52] Dong Y J, Tian B Z, Kempa T J, et al. Coaxial group Ⅲ-nitride nanowire photovoltaics [J]. Nano Letters, 2009, 9(5):2183-2187.
[53] Tang Y B, Chen Z H, Song H S, et al. Vertically aligned p-type single-crystalline GaN nanorod arrays on n-type Si for heterojunction photovoltaic cells[J]. Nano Letters, 2008, 8(12):4191-4195.
[54] Chen X Y, Yip C T, Fung F K, et al. GaN-nanowire-based dye-sensitized solar cells [J]. Applied Physics A, 2010, 100(1):15-19.
Progress in the preparation and optoelectronic devices application of one-dimensional GaN nanomaterials
JIA Ruofei, YANG Lili, YANG Feng, WANG Fei, YANG Hui, LI Lan
(Material Science & Engineering School, Tianjin University of Technology, Tianjin 300384, China)
Compared with GaN film, one-dimensional GaN nanomaterial has many advantages in manufacturing optoelectronic devices. This paper synthetically narrated the main preparation methods of one-dimensional GaN nanomaterial and its application of optoelectronics devices. Firstly, the preparation methods including MOCVD, MBE, CVD and template method were introduced. The key analysis is about the growth parameters, morphology and structure control of one-dimensional GaN nanomaterial. Secondly, the optoelectronic devices such as LED, laser, solar cell as well as photodetector were interpreted, and mainly discussed the influence of the material properties, device structures and manufacturing technology on the device performance. In the end, the development and future application of one-dimensional GaN nanomaterials are prospected.
GaN; nanowire; CVD; LED; photodetector
1001-9731(2016)11-11034-07
天津市高等学校科技发展基金计划资助项目(20140301);天津市“131”创新型人才培养工程资助项目(401008002);天津理工大学大学生创新训练计划资助项目(X2015001);天津理工大学学生科技基金资助项目
2015-11-28
2016-03-25 通讯作者:杨 慧,E-mail: y.hui1021@tjut.edu.cn
贾若飞 (1995-),男,山西晋城人,本科,从事半导体发光材料研究。
TB383
A
10.3969/j.issn.1001-9731.2016.11.007
