全自动硅片显影设备的研究
2016-07-13郭帝江
郭帝江,王 玉
(中国电子科技集团公司第二研究所,山西 太原 030024)
全自动硅片显影设备的研究
郭帝江,王玉
(中国电子科技集团公司第二研究所,山西 太原 030024)
摘要:硅片显影设备可以对硅片表面已曝光的光刻胶完成显影腐蚀及清洗处理,但是国内的显影设备大多自动化程度低,难以精确控制显影参数,显影工艺稳定性得不到保证。本文通过对现有设备关键部件的研究论证,设计了一款全自动硅片腐蚀显影设备,提高了显影参数的控制精度,保证了显影工艺稳定性,在实际生产应用中取得了良好的效果。
关键词:硅片;腐蚀显影;清洗;全自动
1概述
分辨率、灵敏度、缺陷率是超大规模集成电路光刻十分重要的指标,这些都与硅片表面光刻胶的显影腐蚀过程有着十分紧密的联系。近些年来,随着IC行业生产规模的越来越大,对生产设备的功能、性能、产量等方面的要求同样越来越高。为了满足越来越高的产能和产量需求,许多厂家将设备的研发方向向着高自动化、高集成化的方面发展。本文着重就硅片表面光刻胶的显影腐蚀及清洗设备研究过程中的几个重要问题进行阐述。
2显影工艺介绍
显影过程是将曝光后的光刻胶中与紫外光发生化学反应的部分除去或保留下来的过程。通俗来讲即使曝光后的光刻胶与化学显影液发生化学反应溶于溶液的过程。一般而言,在此过程中会不可避免地造成其他部分光刻胶与溶液发生副化学反应而对硅片表面光刻胶图形造成损坏[1]。为了尽可能地降低这种副反应造成的影响,曝光后应尽快进行显影。显影主要有以下几个步骤:对准曝光→曝光后烘→显影→坚膜→显影检测。
由于曝光过程中入射光和反射光之间会产生相互干涉,其光强会沿胶体水平方向形成驻波;曝光后应尽快进行显影步骤的烘干处理,从而有效降低驻波效应的影响。
一般来说,显影过程中被曝光和未曝光部分的光刻胶都会与显影液发生化学反应,为了得到好的显影图像,我们希望溶解速率差越大越好,即曝光部分溶于显影液的速率越快越好,未曝光部分则反之。因此,为了得到良好的显影效果,可以通过控制影响溶解速率的一些因素来实现。通常,显影液成份,显影温度,显影方式,显影步骤等因素都会对溶解速率造成一定程度的影响,我们可以通过实验逐次得到最优的显影液配比,显影温度,显影方式,显影步骤。当对显影要求不是特别高时,可以直接将硅片放入显影液槽内浸泡后取出[1]。目前,显影主要有连续喷雾显影、旋转浸润显影和静态显影三种方法。
坚膜,又称为硬烘,是对显影后的光刻胶加热烘干,促使光刻胶与硅片粘合牢固,并且没有发生形变。坚膜阶段的温度一般控制在100 ℃~120 ℃之间,若加热温度过高会使得光刻胶软化,并导致后期去胶困难[2]。
显影检测,顾名思义是检查显影过程中硅片表面产生的缺陷。通常将一个无缺陷的标准图形存放于电脑上,然后用每个芯片的图形与标准图形相比较,观察出现多少不同的点,就会在硅片的defect map中显示多少缺陷。
在显影过程中,如果不能很好的控制显影过程,光刻胶图形就会出现显影不足,不完全显影,过显影等问题,如图1所示。
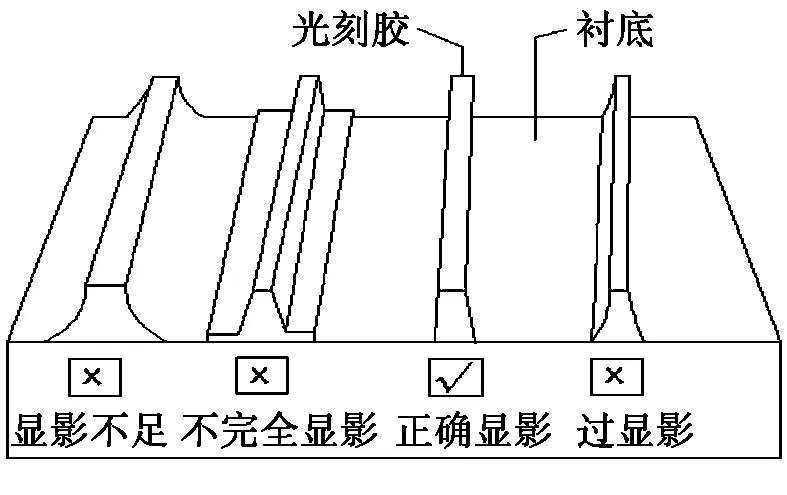
图1 光刻胶显影问题
3设备结构设计
设备总体拟采用全封闭结构,设有一组升降横移机械手,采用伺服电机及伺服控制器驱动。柜体主体采用聚丙烯板组合焊接而成,可耐酸碱腐蚀。排风系统为顶部后侧式,并设有风量调节装置,风量传感互锁设计,排风筒与外围排风风机系统相连。设备内部设有220 V、40 W黄光灯照明(有防护罩)。柜体底部装不锈钢调平地脚及聚氨酯万向脚轮,以便于搬运,具有锁定功能。设备中每个工位具备在特殊情况下进行手动操作的功能,可同时兼容4″、6″晶圆片。主要功能部件有:设备主体、控制系统、1#腐蚀槽、2#腐蚀槽、
3#腐蚀槽、4#清洗槽、机械手、管路系统和抽风系统等,总体结构示意图见图2。
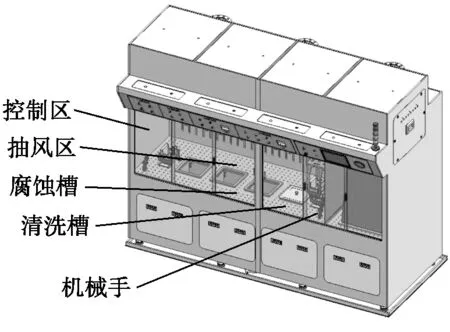
图2 设备总体结构
具体运动过程为:机械手移出到安装位置安装片架—开始—1#槽—2#槽—3#槽—清洗槽—鸣警提示—机械手移出到安装位置卸载片架—清洗甩干—鸣警提示。
3.1腐蚀槽
腐蚀槽为实现显影步骤的主要工艺槽,该工艺采用碱性溶液对硅片进行显影腐蚀,腐蚀槽采用进口316L不锈钢制作,保证能够满足工艺需求的同时具有较好的防腐性能。腐蚀槽通过气动隔膜阀控制上水,而显影液则是由程序设定,通过计量泵由下一级腐蚀槽或者显影原液提供,该溶液浓度可以通过程序设定,计量泵控制实现比较精确的溶液配比以满足工艺需要。同时,移载机械手可以在腐蚀过程中实现载片盒上下抛动。
3.2清洗槽
清洗槽整体采用NPP材质,采用内外槽结构,四面溢流,底部自动上水,槽体两侧喷淋,且流量可调。溢流排风管路安装有水阻率检测仪,可直观地显示当前清洗的洁净度。槽体底部设有氮气鼓泡装置,流量可调。装有兆声振板,兆声频率为950 kHz,兆功率为300 W,功率可调,定时设定通过PLC完成,超声换能器置于槽体底部。清洗槽排放方式采用底部快排气缸排放,排液时,槽体内液体经排放口快速排放至副槽内,保证排液时间不大于4s。清洗次数、各步骤的清洗时间、快排、溢流等工艺参数和功能选择可在触摸屏上编程控制,可自由选择只有快排清洗或只有溢流清洗或二者组合三种清洗模式。清洗槽主要结构件如图3。
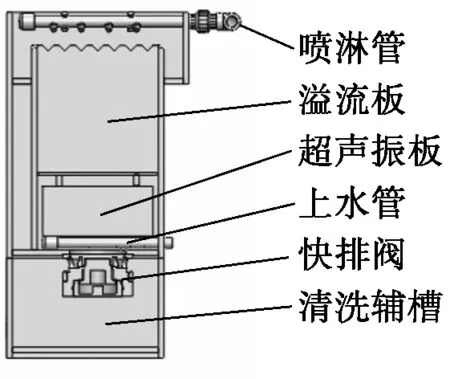
图3 清洗槽结构示意图
3.3机械手
机械手的主要作用是完成人工预先放置好的花篮的上下料,各个工位间的移动及抛动等功能。该部件可以提高设备的自动化程度,减少人工因素对显影腐蚀效果的影响,同时,可以保持设备在运行过程中大多数时间处于密封状态,尽量降低腐蚀性气体进入周围工作环境,减少对大气环境的污染及操作人员的伤害。
机械手主要由伺服电机、精密减速机、精密齿轮-齿条、滚珠滑轨、精密滚珠丝杠-螺母等组成。它的横向移动由进口伺服电机驱动,精密齿轮齿条传动;纵向移动同样由精密电机驱动,滚珠丝杠-螺母副传动,闭环控制,从而使设备的定位准确度达到±2 mm;加减速运动采用几何曲线控制,从而使机械部件冲击小,运动平稳。机械手升降部件及悬臂部均采用耐腐蚀材料,以延长部件使用寿命。具体结构见图4。

图4 机械手结构示意图
3.4排风系统
由于本设备中使用的显影液具有较强的腐蚀性及挥发性,要求设备具有性能良好的排风系统。整套设备采用操作面板后上部条缝式吸风,在柜体排风前板背部装有可调式风量调节阀门,可以手动调节风量的大小,在保证设备良好排风性能的同时尽量减少槽内溶液向槽外挥发。整套设备的排风口位于设备顶部,通过风量调节阀与外部抽风装置相连接。同时,在设备排风的出风口处安装有风压传感器,与设备的控制系统相连,低压报警,保证安全生产。
3.5控制系统
电气控制系统是整个设备的重要部分,整套控制系统以触摸屏为人机界面,PLC为核心,交流伺服系统为清洗花篮的移动执行机构。它通过编程控制设备的运行步骤、不同工序各个气动隔膜阀及计量泵的开关、各个工艺步骤的工作时间以及各个工艺模块的工作状态。
电气控制系统主要由操作面板、控制柜、伺服电机、气动阀、加热器、计量泵、传感器等组成。控制柜位于设备的后上部位,与设备工作空间及排风区域隔绝,以防止腐蚀性气体腐蚀电气元件,同时,在控制柜内通入压缩空气,使之形成正压,保护电气元器件。设备后部留有压缩空气、氮气、动力接头,直接与外部源头相连接即可正常使用。
3.6其他部件
本设备台面采用网孔活动台面,台面下部安装槽体部位有密封焊接的台面接液盘,并通过管道连接至设备总体排液管。设备内部两侧配有PFA材质的氮气枪及纯水枪,便于对台面进行清洁以及手动操作时的干燥。
机械手的升降臂需要在各个工位水平移动,在其活动区域难免造成槽体溶液挥发进入顶部机械手伺服控制区域,对电机及导轨等造成腐蚀。因此,本设备在升降臂两侧分别添加密封装置,在其移动时可以随之左右活动对升降臂活动区域进行密封,延长设备使用寿命。
4结论
对设备而言,结构的设计、功能的配置能否满足工艺需求是决定设备性能的关键因素。随着科技的日新月异,半导体行业工艺的逐渐完善[3],与之对应的半导体设备也随着新材料,器件等的涌现呈现出高集成化,自动化。二者共同推进着行业的发展。
参考文献
[1]席伟,陈军,管良梅.多品种小批量SMT生产[J].电子工艺技术,2012,33(4):226-228.
[2]王锐廷.半导体晶圆自动清洗设备[J].电子工业专用设备,2004(9):8-12.
[3]曹秀芳,曹颖杰,祝福生.300 mm全自动去胶清洗设备的研制[J].电子工业专用设备,201(7):36-38.
Research of Automatic Etching and Developing Apparatus
Guo Dijiang, Wang Yu
(The2ndResearchInstituteofCETC,TaiyuanShanxi030024,China)
Abstract:The exposed photoresist covering on the surface of silicon wafer can be developed based on the etching and developing equipment. However, the domestic equipment has problems such as low automation, low control precision for developing parameters and low process stability. In this paper, the critical components in domestic apparatus are studied, and one kind of fully automatic etching and developing equipment is designed. Compared to the domestic equipment, this apparatus has the features of better automation, better control precision and better process stability that have been examined in the actual production.
Key words:silicon wafer; etching and developing; cleaning; fully automatic
收稿日期:2016-03-08
作者简介:郭帝江(1988- ),男,山西运城人,助理工程师,主要从事湿法专用设备研发工作。
文章编号:1674- 4578(2016)03- 0083- 03
中图分类号:TN305.97
文献标识码:A
