封装与PCB复杂互连结构的传输特性研究
2016-02-27高振斌李雅菲
高振斌,李雅菲
(河北工业大学 电子信息工程学院 电子材料与器件天津市重点实验室,天津 300401)
封装与PCB复杂互连结构的传输特性研究
高振斌,李雅菲
(河北工业大学 电子信息工程学院 电子材料与器件天津市重点实验室,天津 300401)
鉴于晶片电子封装结构的一些精细电磁现象如复杂互连结构的不连续性、寄生效应带来的信号完整性等问题,采用电磁分析软件CST微波工作室,建立了封装与PCB复杂互连结构的物理模型,对信号传输性能进行仿真分析,并对简单等效电路模型进行改进。结果表明:增大焊球半径,采用低介电常数基板材料,可提高互连结构的信号传输效率。采用软件ADS模拟电路模型,其结果与软件CST的结果趋势基本吻合。
传输特性;电子封装;互连结构;CST;等效电路;ADS
由于集成电路芯片向高密度、小尺寸发展,因而出现了具有多引脚、信息处理量大的BGA封装。BGA封装作为集成电路的关键工艺,需要大量板级互连结构将不同功能器件整合。由过孔、焊点以及印制线构成的复杂互连结构是高密度集成电路的基本组成单元。
随着系统速率和边沿速率的增加,过去适用于低频的电路设计方法受到了越来越多的挑战,因此,准确地表征由于高频下不可控回流路径导致的重要电磁现象对封装设计至关重要。
国内外学者对板级信号完整性已有大量研究,但大多针对传输线[1]、过孔[2],对于BGA[3]焊点带来的信号完整性问题研究较少,尤其是由过孔、焊点以及印制线构成的复杂互连结构很少有考虑。然而随着频率升高,只考虑单个无源器件会缺失一些精细的物理现象,高层次的分析需要同时考虑封装和PCB互连结构的不连续性和寄生效应。因为封装和PCB之间可能会出现一些谐振和其他相互作用,所以需要综合考虑,进行精度更高的电磁场联合仿真。
本文建立了新型的BGA封装-PCB互连结构的三维电磁模型。对互连结构中关键参数进行仿真分析,并在ADS中建立简单等效电路模型,与CST结果对比验证。得到了设计参数对信号传输的影响趋势,对BGA封装-PCB互连结构的设计有很好的指导意义。
1 物理结构与仿真环境建模
1.1 物理结构
高速信号从芯片通过BGA焊脚到达PCB板表面,之后实现层间的互连必须经过焊盘和过孔。由于BGA焊点的排列是固定的,因此焊盘和过孔的位置取决于焊点的分布。即使过孔的长度通常远小于横向的互连的微带线,但其耦合的影响是不可忽视的。
互连结构的物理模型如图1所示。焊球与封装用通孔直接连接,BGA焊盘与PCB上过孔(图中均为通孔)焊盘采用印制线连接,杜绝过孔直接与焊盘连接或直接开在焊盘上。
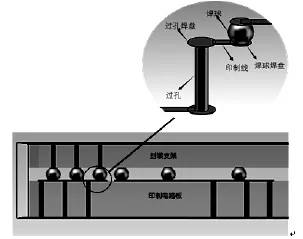
图1 BGA封装与PCB互连结构Fig.1 BGA package and PCB interconnection structure
1.2 仿真环境建模
集成电路的设计或复杂目标散射截面的计算等重要的电子工程技术问题都与三维电磁场的精确计算问题密切相关,本文采用的仿真环境为通用三维高频无源结构仿真软件CST微波工作室,集时域和频域算法为一体,含多个全波及高频算法,可仿真任意结构、任意材料下的S参数,并可以与电路设计软件联合仿真。
设计如下互连结构模型,采用FR4的四层PCB板,厚度为1.6 mm。封装支架材料也为FR4,厚度为0.3 mm,标准焊点直径为0.66 mm,焊点焊盘与过孔焊盘尺寸相同,半径0.25 mm,相距1 mm。过孔内径为0.254 mm。在CST中的模型如图2所示。

图2 CST中互连结构建模Fig.2 Interconnection structure modeling in CST
2 互连模型与分段模型对比
为观察互连结构的仿真与拆分仿真的区别,分别对结构上部分的焊球和微带、过孔加微带以及总体结构三种情况下进行仿真,结果见图3中曲线1,2,3,所对应的数据见表1。
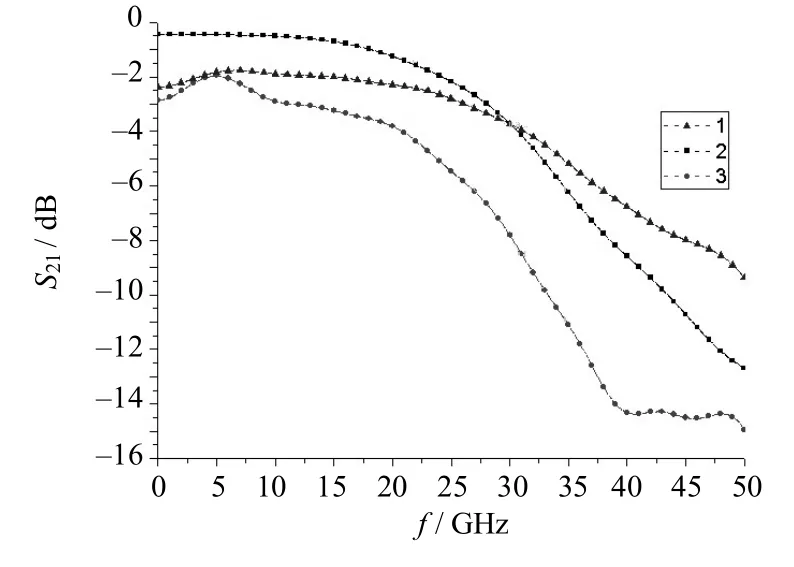
图3 封装-PCB拆分对比结果Fig.3 Results of packages-PCB section compared with total

表1 互连结构与分段结构传输特性对比Tab.1 Transmission characteristics of interconnection structure compared with segmental structure
图3中对比明显,曲线1表示焊球-印制线结构的插入损耗S21,曲线2表示过孔-印制线结构的插入损耗S21,曲线3表示过孔-印制线-焊球组成的互连结构的插入损耗S21。取不同频率值10,20,30,40 GHz时,由三者的具体数值对比可以看出:在0~5 GHz,f>35 GHz时,互连结构的损耗小于单个结构的和,原因可能是因为背板吸收抵消了一些损耗;在中间频段,互连结构损耗大于单个结构损耗之和。总之,总的互连结构的损耗并不是焊点结构损耗和过孔结构损耗之间简单的线性关系。
3 结构参数对传输特性的影响
3.1 最大外径的影响
BGA器件的封装结构按焊点形状分为两类[4]:球形焊点和柱状焊点。为了防止在更细间距的BGA或Flip Chip封装方式的电子连接过程中的桥联等问题的出现,并利用焊球在熔化过程中的“自对准效应”,BGA封装采用的焊球,具有相当高的尺寸及外形精度要求[5]。同时,随着频率升高,尺寸的微小差异对互连结构传输性能造成影响更加不可忽视。故取相同直径的焊球和圆柱体进行对比仿真,结果如图4所示。
由图4可得:直径为0.5,0.6,0.75 mm时,圆柱的插入损耗S21比球体小,故相同直径的圆柱与球体,球形的插入损耗较大,即传输特性较好。

图4 球体与圆柱体的传输函数S21Fig.4S21insertion losses of sphere and cylinder
焊球对信号传输的影响参数仅有材料和最大直径[6]。材料通常都采用无铅焊点,在此不做仿真。为研究焊球最大外径对传输特性影响,做以下仿真。固定焊点高度为0.5 mm,上下底径为0.45 mm,改变图1中单个焊点和互连结构中焊点的最大外径,仿真结果见图5。

图5 最大外径对传输特性的影响Fig.5 Maximum overall diameter’s influence on transmission characteristics
取最大外径分别为0.75,0.65,0.6,0.55和0.50 mm,由图5可以看出,在单个焊球和复杂互连两种结构中均符合随着频率升高传输特性变差,且频率越高降低越快。相同频率下,焊球最大外径越大,传输效果越好。由图明显可以看出在30 GHz时,单个焊球中相邻两外径,S21相差0.3 dB左右,而在互连结构中相差0.1 dB以内,互连结构中最大外径对传输特性影响相对减小。
3.2 基板材料对传输特性影响
随频率升高,信号传输的介质损耗急剧增加,而相对介电常数和损耗角正切为材料的主导因素。本文根据实际生产,选择了六种常用的高频材料进行仿真,相对介电常数如表2,仿真结果如图6。

表2 基板材料参数Tab.2 Substrate material parameters

图6 封装-PCB互连结构相对介电常数对S21的影响Fig.6S21insertion loss response for relative permittivity
由图6得,随着相对介电常数的升高,传输函数S21依次减小,相对介电常数为10.2时,传输性能迅速恶化。故在实际生产中,低相对介电常数的高频材料更有利于信号的传输。
4 互连结构等效电路模型
在GHz频率下,电路的损耗有回波损耗、介质损耗和导体损耗。总损耗等于入射损耗减去回波损耗,再除以入射损耗,用dB表示。传输损耗为总损耗减去回波损耗,而传输损耗为导体损耗与介质损耗的和。导体损耗是由于导体电导率、传播长度、有效电流密度面积所引起的不完全能量传输。随着频率越高,由于趋肤效应迫使电流集中在导体表面,横截面积减少,总的电流密度增加,因而单位热量、单位损耗都会随着增加。
目前对BGA封装与PCB互联结构的等效电路研究较少,而等效电路模型相对三维全波仿真能够减小计算量。高频时,互联结构的电流传输主要受趋肤效应的影响。引起寄生效应,导致电容电感参数变化趋肤深度δ可表示为[7]:

式中:μ=μ0μr;μ0为自由空间导磁率;μr为相对导磁率;σ为金属电导率;f为频率。
由于趋肤效应导致印制线单位导体的电阻为[7]:

式中:ρ为导体材料电阻率;w为印制线宽;
对于印制线单位长度电容的研究较多,但许多传输线的公式过于简单,Kaiser公式相对于其他公式更加适用高频环境。

式中:h为印制线与地间介质层厚度;印制线的单位长度电感L为[8]:

采用经典的物理模型参数得出的寄生电容、寄生电感公式如下[7]:

式中:D2为焊盘直径;D3为反焊盘直径;T为过孔高度;D1过孔内径。
上述公式当频率升高后不再适用,故本文对过孔采用参数提取的方式重新建立等效电路模型,因而更加准确。过孔寄生参数与过孔高度H(单位为mil,25.4 μm)的关系[12]如下:

式中:R为过孔的寄生电阻,单位为Ω;L为过孔的寄生电感,单位为pH;Cg为过孔的寄生电容,单位为fF。对焊点来说,高频时趋肤效应使得电流通过导体横截面积减小,电流密度升高,球面电容、电感相当于同心球体的电容电感。球面电容与球面电感公式如下[7]:

焊点的寄生电感和单位回路电感为:

根据分布参数模型提取公式建立过孔的参数值如表3。

表3 等效电路元件参数值Tab.3 Equivalent circuit component parameter values

图7 等效电路及仿真条件Fig.7 Equivalent circuit and the simulation conditions
在ADS中建立等效电路模型见图7(a),参数均按表3设置,其中MLIN为微带线,参数标准为(b)中的MSub。由于ADS局限性,频率较低时结果较为准确,设置仿真频率为1~15 GHz,计算S参数,得到ADS与CST仿真结果对比如图8。

图8 ADS 与CST在1~15 GHz的传输特性对比Fig.8 Transmission properties of 1-15 GHz in ADS and CST
图8中可以看到1~15 GHz内,二端口电路与CST的结果基本重合,最多相差0.3 dB;10~15 GHz时相差较多,为0.8 dB,且使用等效电路仿真的时间大大缩减,由此说明本文的等效电路能够很好地计算复杂互连结构。
5 结论
随着板级与封装级电子系统的高速发展,信号完整性成为高速电路设计与系统级封装中的研究热点。本文通过研究封装和电路板之间的过孔、焊球、印制线构成的互连结构,在CST中进行有效仿真,对互连结构和分段结构对比研究,并发现适当增加焊球最大外径,采用相对介电常数较小的基板材料可提高互连结构的传输性能,在实际生产中进行优化,改善其高频传输特性。之后在ADS中等效电路的研究便于在设计阶段对无源结构做出补偿,有利于实现芯片-封装-PCB板一体化设计。
[1] 卢秋朋, 张清鹏, 秦润杰. 传输线中趋肤效应的介绍及仿真 [J]. 电子测量技术, 2015, 38(6): 27-30.
[2] 杨洁. 一种微带线-带状线过孔互连结构的电磁特性仿真分析 [J]. 电子技术与软件工程, 2015, 8: 139-141.
[3] 石光耀, 尚玉玲, 曲理. BGA焊点形态和布局对信号完整性的影响[J].桂林电子科技大学学报, 2013, 33(4): 279-283.
[4] 孟真, 张兴成, 刘谋, 等. 芯片倒装封装中焊球及铜互连对高速差分信号传输特性影响的仿真研究 [J]. 电子与封装, 2015, 15(9): 1-5.
[5] 张文典, 林叶. 使用表面组装技术 [M]. 北京: 电子工业出版社, 2002.
[6] 高德云, 夏志东, 雷永平, 等. BGA封装锡球制备技术研究 [J]. 电子元件与材料, 2005, 24(10): 56-60.
[7] BOGATIN E. 李玉山, 李丽平. 信号完整性分析 [M]. 北京: 电子工业出版社, 2005: 74-151.
[8] 尚玉玲, 马剑锋, 李春泉. 复杂互连结构传输性能分析及等效电路[J].半导体技术, 2015, 40(5): 348-352.
[9] 余乐, 杨海钢, 谢元禄, 等. 三维集成电路中硅通孔缺陷建模及自测试/修复方法研究 [J]. 电子与信息学报, 2012, 9: 2247-2253.
[10] KAISER K L. Electromagnetic compatibility handbook [M]. Boca Raton, USA:CRC Press, 2005.
[11] YAO W, LIM J, ZHANG J, et al. Design of package BGA pin-out for >25Gb/s high speed SerDes considering PCB via crosstalk [C]// Electromagnetic Compatibility and Signal Integrity, 2015 IEEE Symposium. NY,USA:IEEE, 2015: 111-116.
[12] POH C H J, BHATAACHARYA S K, FERGUSON J, et al. Extraction of a lumped element equivalent circuit model for via interconnections in 3-D packages using a single via structure with embedded capacitors [C]// Proceedings - Electronic Components and Technology Conference. Las Vegas, USA, IEEE, 2010: 1783-1788.
[13] LI J, BENNETT B L, KARAM L J, at al. Stereo Vision based automated solder ball height and substrate coplanarity inspection [J]. IEEE Trans Autom Sci Eng, 2016, 13 (2): 757-771.
(编辑:陈渝生)
Analysis of package-PCB interconnect structure transmission performance
GAO Zhenbin, LI Yafei
(Tianjin Key Laboratory of Electronic Materials and Device, Institute of Information Engineering, Hebei University of Technology, Tianjin 300401, China)
In view of fine electromagnetic phenomenon of chip electronic packaging structure, such as discontinuity of complex interconnection structure and signal integrity generated by parasitic effect, the complex interconnection structure physical model of encapsulation and PCB was built by using electromagnetic analysis software CST microwave suit. Signal transmission performance was simulated and analyzed. Then the simple equivalent circuit was improved. The results show that the signal transmission efficiency of interconnection structure is increased by magnifying the ball radius and using substrate material with lowεrvalue. Finally, the result obtained by software ADS basically coincides with the result by CST.
transmission performance; electronic package; interconnect structure; CST; equivalent circuit; ADS
10.14106/j.cnki.1001-2028.2016.08.019
TN405.97
:A
:1001-2028(2016)08-0081-05
2016-05-08
:高振斌
河北省高等学校高层次人才科学研究项目资助(No. GCC2014011)
高振斌(1973-),男,河北衡水人,教授,研究方向为高速电路信号完整性,E-mail: gao_zb@163.com ;李雅菲(1992-),女,河北石家庄人,研究生,研究方向为高速电路信号完整性,E-mail: lyf2533@163.com 。
时间:2016-08-03 22:36
: http://www.cnki.net/kcms/detail/51.1241.TN.20160803.2236.019.html
