GaN-MOCVD设备MO源注入摩尔流量的精确控制
2015-07-18陈特超
刘 欣,魏 唯,陈特超
(中国电子科技集团公司第四十八研究所,湖南长沙410111)
GaN-MOCVD设备MO源注入摩尔流量的精确控制
刘 欣,魏 唯,陈特超
(中国电子科技集团公司第四十八研究所,湖南长沙410111)
分析了GaN-MOCVD设备中MO源注入摩尔流量控制的基本原理,给出了决定MO源注入摩尔流量的三个重要条件,然后针对于GaN-MOCVD中5种常用的金属有机源,根据工艺生长的需要,分别给出了MO源注入摩尔流量精确控制的解决方案。
半导体设备;GaN-金属有机化学气相沉积;金属有机化合物源;注入摩尔流量
MOCVD(Metal Organic Chemical Vapor Deposition)是生长高质量半导体薄膜材料的技术,在LED、半导体激光器、太阳能电池等多个领域都有应用。现有MOCVD设备的成本非常高,且完全依赖进口,进行MOCVD设备研究对国内半导体产业、新能源领域以及国防高端技术的发展都很有必要。MOCVD利用气相反应物之间化学反应将所需产物沉积在外延衬底表面形成所需要的外延层,外延层的晶相、成长速率以及组成成分会受到温度、压力、反应物种类、反应物浓度、反应时间、外延衬底材料、外延衬底表面性质等诸多因素的影响。其中反应物浓度的控制是非常关键的一环,对于GaN基半导体材料的生长,常用的金属有机源反应物有5种,分别是TMGa,TMAl,TEGa,TMIn,Cp2Mg,它们在MOCVD中作为反应物参与反应生长出多组分、大面积、薄层和超薄层异质材料。在GaN-MOCVD中,通过载气携带并注入到反应室的MO源注入摩尔流量是直接影响外延层薄膜生长的组分和质量的关键因素[1]。
本文分析了GaN-MOCVD设备中MO源注入摩尔流量控制的基本原理,给出了决定MO源注入摩尔流量的3个重要条件,然后针对GaN-MOCVD 中5种常用的金属有机源,根据工艺生长的需要,分别给出了每种MO源注入摩尔流量精确控制的解决方案,这对于GaN-MOCVD设备的MO源供给管路设计有着很强的指导意义。
1 MO源注入摩尔流量控制的基本原理
在MOCVD设备中,MO源通常都存放在特制的不锈钢源瓶中,而不锈钢源瓶则放置在高控制精度的恒温水浴槽中,高纯的氢气或者氮气通入源瓶并携带出气态的MO源,进入run/vent切换回路,准备进入反应室。MO源的注入摩尔流量计算公式为[2]:

其中Nmo为MO源摩尔流量 (mol/min),PMO为源的蒸汽压,Pbub为鼓泡钢瓶内的气体压力,F为载气流量(cm3/min),Vm等于22 414 cm3/mol。
由公式(1)所知,MO源由钢瓶到反应室的注入摩尔流量由以下条件决定:
(1)MO源载气的气体流量;
(2)在设定温度下材料的蒸汽压力;
(3)钢瓶起泡器内的绝对压力。
见图1液态MO源供给图,图2固态MO源供给图。载气的流量通过源瓶上游的MFC来控制,源瓶内的绝对压力则通过源瓶下游的PC来控制。而MO源的饱和蒸汽压又由源瓶的温度决定,常用MO源的物理参数见表1[3]。
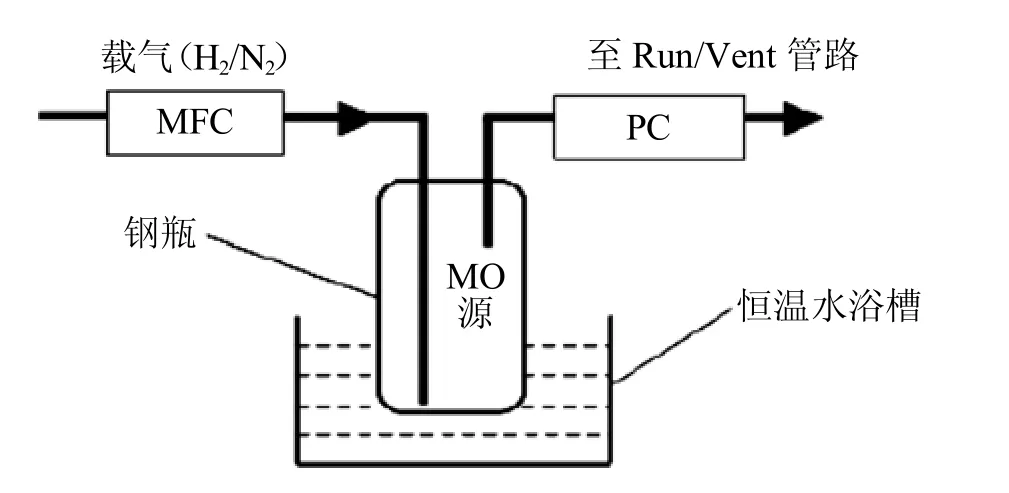
图1 液态MO源供给图

图2 固态MO源供给图
表1中的系数A、B是表征MO源的蒸汽压P的大小,具体公式为[4]:


表1 常用MO源列表
由上面的公式我们可以看出,MO源的蒸汽压只与温度有关,所以通过控制源瓶的温度就可以得到我们所希望的蒸汽压。而对于源瓶温度的控制,业界主要采用恒温水浴槽来进行控制。综上所述,通过对载气流量、源瓶内绝对压力,以及恒温槽温度进行控制,可实现对MO源注入摩尔流量的精确控制。
2 GaN-MOCVD中MO源注入摩尔流量的精确控制
对于GaN-MOCVD中常用的金属有机源反应物有5种,分别是TMGa,TMAl,TEGa,TMIn,Cp2Mg。在通常的水浴温度下TMGa,TMAl,TEGa是液体,TMIn,Cp2Mg是固体。每种MO源的物理特性各有不同,工艺生长时对于MO源的浓度高低的需求也有差别,因此针对GaN-MOCVD的工艺需要以及MO源的物理特性,分别设计不同的MO源供给管路满足对每种源的注入摩尔流量的精确控制。如图3。
2.1 满足高浓度需求的液态MO源注入摩尔流量的精确控制
如图1所示,载气进气管直接插入到液体里面,载气后通入液体中产生鼓泡效应,从而携带出高浓度的气态MO源,而恰好这种高浓度的MO源是外延层工艺生长时需要的,比如TEGa。对于此类情况根据MO源注入摩尔流量控制的基本原理来设计出标准管路,如图3。利用一个输入MFC 18控制载气的流量、一个输出PC 19控制源瓶的压力,恒温水浴槽来控制源瓶的温度,这样可对TEGa的注入摩尔流量进行精确控制。

图3 GaN-MOCVD设备MO源注入摩尔流量控制原理图
2.2 满足低浓度需求的液态MO源注入摩尔流量的精确控制
MOCVD常用于交替生长不同半导体材料的外延层,层厚都有不同,并且差别较大,如生长LED芯片的多量子阱层,每一层的厚度为几十纳米甚至只有几个纳米。液态MO源是通过载气通入液体中产生鼓泡效应,从而携带出高浓度的气态MO源,这样高浓度的MO源不能满足生长多量子阱层时极少反应摩尔流量的需求。比如说TMAl,在生长多量子阱层时需要较低浓度的Al元素,就可采用如图3中双稀释管路。除了标准管路的配置外,还有一个输入MFC 211与源瓶出口相连,对MO源提供一个可控的稀释作用。经过稀释后的MO源经过另外一个MFC 212,可根据需要控制流量进入run/vent切换回路,多余的MO源则经过PC 210排空。经过双稀释后的MO源摩尔流量的计算公式为:

其中:Nmo为MO源摩尔流量 (mol/min),PMO为源的蒸汽压,Pbub为鼓泡钢瓶内的气体压力,F1为载气流量,F2为稀释气体流量,F3为稀释后进入反应室混合气体流量,Vm等于22 414 cm3/mol。
2.3 注入剂量快速切换时MO源注入摩尔流量的精确控制
GaN基半导体材料生长时,外延层相邻层之间虽然组成元素相同但是组分不同,为了形成陡峭的界面,就需要MO源的注入剂量能够快速变化,在变化的同时也要保证注入摩尔流量的精确性。比如TMGa,在生长阱层和垒层时,组成元素都有Ga元素,但是需要的Ga元素的剂量却相差100甚至1 000倍以上,在层与层之间由于要形成陡峭的界面,注入剂量必须要快速变化,这对于MFC来说,在硬件上不可能做到如此宽量程的精确控制,因此可利用双重标准管路来实现,如图3。即设置两个相同的TMGa源标准管路,只是采用的输入MFC 38与MFC 48的量程不同,在生长多层结构时可快速切换注入剂量,并保持精确可控。
2.4 满足高浓度需求的固态MO源注入摩尔流量的精确控制
由图2可知,载气进气管不能伸入固态MO源的钢瓶底部而不能产生鼓泡效应,这样载气只能通过固态MO源的上方将其挥发出来的气态MO源带出钢瓶[5]。这种携带出的MO源的量是非常少的,不能满足外延层生长时对于高浓度的MO源的工艺需要。比如TMIn,因此设计出如图3中的双源瓶串联管路,将两个源瓶串联起来,载气进入第一个TMIn源瓶后携带出少量的MO源再进入第二个源瓶,再一次携带出MO源,这样可成倍提高MO源的浓度。经过双源瓶后的MO源的摩尔流量计算公式为:

其中Nmo2为经过双源瓶后的MO源摩尔流量,Nmo为经过第一个源瓶的MO源摩尔流量,PMO为源的蒸汽压,Pbub为鼓泡钢瓶内的气体压力,F为载气流量,Vm等于22414 cm3/mol。
2.5 输出剂量不稳定的固态MO源注入摩尔流量的精确控制
MOCVD中TMIn,Cp2Mg属于固态源,载气气体流过装有固态源的源瓶时经常出现固态床路径缩短的“沟流现象”造成固态源输出剂量不稳定,针对这种情况可使用超声波浓度计来解决,如图3中的浓度计管路,载气携带气态的Cp2Mg源从源瓶出来后先经过一个浓度计511,再经过控制源瓶出口压力的PC 59进入run/vent切换回路,利用超声波浓度计511可实时测量固态源输出的浓度,再通过计算机调整MFC 58的流量值达到精确控制MO源摩尔流量的目的。
3 结 论
本文通过分析GaN-MOCVD设备中MO源注入摩尔流量控制的基本原理以及外延层生长时对于每种MO源的工艺需求不同,给出了相对应的MO源注入摩尔流量精确控制的解决方案,主要的方案如下:
(1)对于高浓度的液态MO源需要时,主要是通过对载气流量、源瓶内绝对压力,以及恒温槽温度进行控制来实现;
(2)对于低浓度的液态MO源需要时,通过增加一路载气对携带出的混合气进行稀释,然后将稀释后的气体一分为二,选择需要的流量进入反应室,多余的则排空,完成二次稀释来实现;
(3)对于注入剂量需要快速切换时,通过采用两路相同MO源的控制管路,每条管路上输入MFC的量程不同来控制载气流量;
(4)对于高浓度的固态MO源需要时,通过采用载气两次进入源瓶来实现;
(5)对于输出剂量不稳定的固态MO源需要时,通过采用超声波浓度计来实现。
[1] 陆大成,段树坤.金属有机化合物气相外延基础及应用[M].北京:科学出版社,2009.
[2] 杨树人,丁墨元.外延生长技术[M].北京:国防工业出版社,1992.
[3] 文尚胜,廖常俊,范广涵,等.现代MOCVD技术的发展与展望[J].华南师范大学学报,1999(3):99-107. [4] 文尚胜,廖常俊,范广涵,等.LP-MOCVD生长InGaAlP系统中源气流量的动力学研究[J].半导体光电,2000,21(6):410-413.
[5] Smith LM,Odedra R,Kingsley A et al.The effect of different bubbler designs[J].Journal of Crystal Growth,2004(272):37-41.
Accurate Control of MO Source Injected Mol Flow of GaN-MOCVD
LIU Xin,WEI Wei,CHEN Techao
(The 48thResearch Institute of CETC,Changsha 401111,China)
The article analyses basic principle of control of MO source injected mol flow of GaN-MOCVD,and gives three important condition of decided MO Source Injected Mol Flow.Then to five familiar metal organic source of GaN-MOCVD,based of demand of technology growth,respectively gives solution of accurate control of MO source injected mol flow.
Semiconductor equipment;GaN-MOCVD;MO source;injected mol flow
TN305.3
B
1004-4507(2015)06-0031-05
刘欣(1980-),男,湖南人,硕士,工程师,目前主要从事半导体专用设备的研制。
2015-03-12
