电离辐照诱发面阵电荷耦合器暗信号增大试验
2014-11-26王祖军罗通顶杨少华刘敏波盛江坤
王祖军 罗通顶 杨少华 刘敏波 盛江坤
(西北核技术研究所强脉冲辐射环境模拟与效应国家重点实验室,西安710024)
1 引言
电荷耦合器件(CCD)是航天器成像系统中的核心元器件,星载CCD在空间轨道环境中应用时,会受到空间粒子或射线引起的辐照损伤影响。在低地球轨道环境中,空间辐射总剂量在10-3~10-2kGy(Si)/年;在中高地球轨道环境中,空间辐射总剂量高达0.1~1.0kGy(Si)/年。辐照损伤会诱发CCD暗信号增大,严重时甚至出现CCD像元势阱被暗信号电荷充满,从而导致功能失效。辐照损伤诱发产生的暗信号对科学级成像CCD的影响尤为突出,特别是在空间天文学中应用的CCD需要有较长的曝光时间,以便能探测到宇宙空间中的微弱信号,而辐照损伤诱发产生的大量暗信号会导致整个空间探测任务失败。基于地面模拟辐照试验的研究结果对预估空间辐射环境中在轨工作的电子系统可靠性具有重要价值。
国内外开展线阵CCD的辐照损伤效应研究较多,相关文献已报道了开展线阵CCD质子[1]、中子[2]、电子[3]和γ射线[4-6]辐照的试验规律及损伤机理研究,但国内关于面阵CCD辐照效应试验研究的报道很少,仅少量开展了辐照试验[7]。与线阵CCD相比,面阵CCD结构更复杂,引起暗信号增大的因素更多。目前国内外关于辐照诱发面阵CCD暗信号增大及其退火规律的试验研究报道较少。
面阵CCD的暗信号对电离辐照损伤特别敏感。鉴于索尼ICX285AL面阵CCD是国内在成像系统中应用广泛的一款商用科学级CCD芯片,其辐照效应试验研究的结果将对国内成像系统应用设计具有一定的参考价值。本文通过开展索尼ICX285AL面阵CCD的60Coγ射线总剂量辐照效应试验,分析了电离辐照诱发面阵CCD暗信号增大的试验规律;阐述了电离损伤诱发面阵CCD暗信号增大的物理机制。
2 试验与测试方法
面阵CCD电离辐照效应试验在抗辐射加固专用60Coγ射线源上开展。60Coγ射线源的光子能量为1.25MeV,源的不确定度为2.5%。辐照试验样品为索尼ICX285AL商用科学级面阵CCD。辐照剂量率为0.1Gy(Si)/s,分别在总剂量为0.05、0.10、0.15、和0.20kGy(Si)时进行离线测试。通过辐照板提供给被辐照器件偏置电压,选择两种偏置状态对CCD进行总剂量辐照试验,即不加偏置电压状态和加15V偏置电压状态,其中A07#CCD加偏置辐照,A08#CCD不加偏置辐照,A07#和A08#CCD的生产批号均为132JEYK。辐照试验和退火测试方法参考国军标GJB548B微电子器件试验方法和程序及美军标MIL-STD-883H,采用方法1 019.8、电离辐照试验程序。
在无光照条件下,CCD的输出信号会随积分时间线性增加。在规定条件下,通过改变器件的积分时间,测试对应积分时间下的输出信号,然后以积分时间为横坐标,输出信号为纵坐标,由测试数据给出散点图,并按最小二乘法拟合出一条直线,该直线的斜率KD即为器件单位时间的暗信号。
测试暗信号按下列步骤进行:
1)连接测试系统,给器件加上规定的电源电压,使器件处于正常工作状态;
2)通过图像采集软件采集图像数据,开始测试参数;
3)在无光照时,增大积分时间,对每次积分值采集F帧,计算所选积分像元区域内的输出信号(平均灰度值),并把输出信号与积分时间绘入关系曲线上;
4)按照最小二乘法计算输出信号与积分时间的直线方程系数,得到直线的斜率KD;需要计算器件的暗信号电压VD时,可按公式(1)计算。

式中VD为器件的暗信号;T为器件的积分时间。
面阵CCD在辐照试验测试时,积分时间选取8个,分别为115.76、127.69、139.62、151.55、163.48、175.41、187.34和199.27ms,然后按照最小二乘法计算输出信号与积分时间的直线方程系数,得到直线的斜率,即暗信号斜率KD。取积分时间为199.27ms时,计算出VD。
3 试验结果与分析
3.1 暗信号
CCD的暗信号是指CCD在既无光注入又无其他方式注入信号电荷的情况下输出的信号。辐照前,CCD的暗信号主要由3部分组成:耗尽层内的载流子产生的暗信号;衬底内的载流子产生的暗信号;Si/SiO2界面产生-复合中心产生的暗信号。辐照后,电离损伤破坏了CCD内电极、栅氧化层以及Si/SiO2界面的脆弱联系后,导致辐射感生氧化层陷阱电荷和界面态产生,这些氧化层陷阱电荷和界面态位于半导体能带的禁带中,促进了电子通过热运动由价带跃迁到导带,使CCD的暗信号增大。
A07#CCD加偏置辐照后,在不同总剂量下面阵CCD输出一帧暗场图像中各像元的平均灰度值随积分时间的变化如图1所示。图1中纵坐标平均灰度值的单位均为ADU,ADU代表一个数字量化单位。可以看到,辐照后面阵CCD输出一帧暗场图像中各像元的平均灰度值随积分时间增大而增大,且总剂量越大,增大趋势越明显。A08#CCD不加偏置辐照后,在不同总剂量下面阵CCD输出一帧暗场图像中各像元的平均灰度值在辐照后随积分时间的变化如图2所示。可以看到,辐照后,面阵CCD相机输出一帧暗场图像中各像元的平均灰度值也随积分时间增大而增大,且总剂量越大,增大趋势越明显。
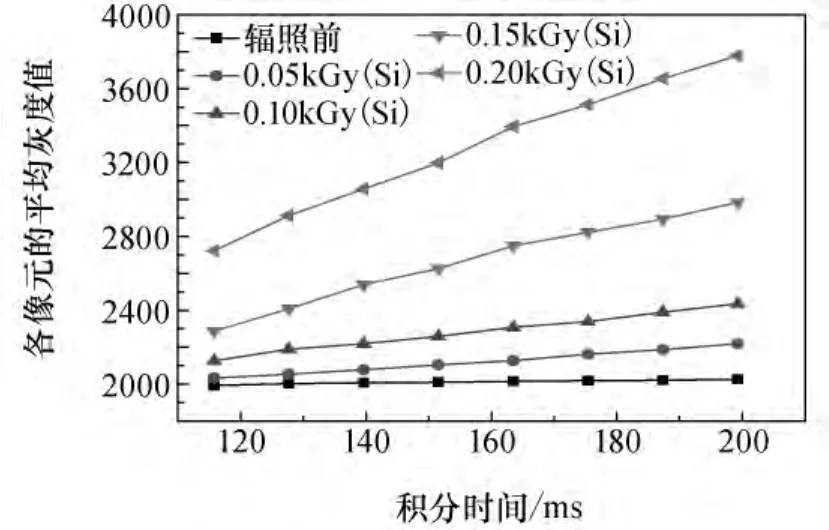
图1 A07#CCD暗场像元的平均灰度值随积分时间的变化Fig.1 Average gray-scale value of dark field versus integration time at the A07#CCD during irradiation
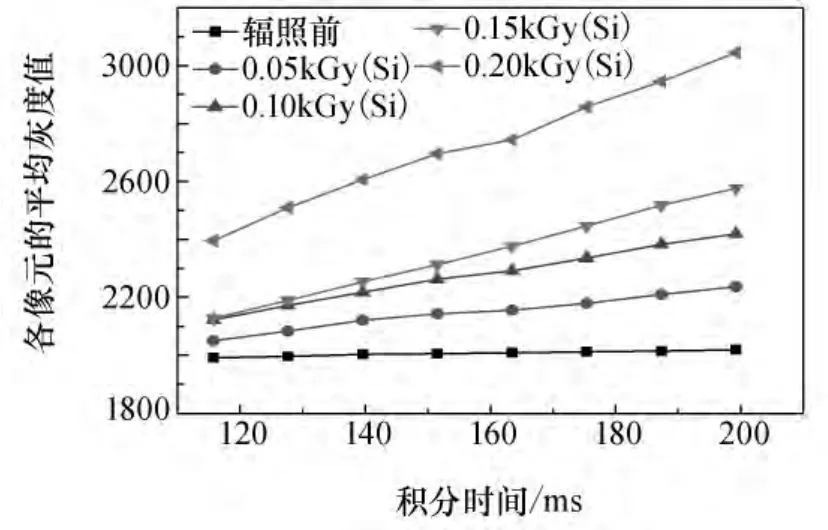
图2 A08#CCD暗场像元平均灰度值随积分时间的变化Fig.2 Average gray-scale value of dark field versus integration time at the A08#CCD during irradiation
面阵CCD的基本结构主要包括3部分:光敏区、转移区和输出放大区(见图3)。图3中面阵CCD的结构设计原理是采用逐行扫描输出的行间转移结构,其光敏区和转移区(包括纵向转移和横向转移)阵列由MOS型阵列结构组成,受电离辐照后,CCD栅氧化层内因能量沉积而产生电子-空穴对,这些辐射感生的电子和空穴在经历初始复合后,剩余的空穴一部分被SiO2中的深空穴陷阱俘获形成氧化层陷阱电荷;一部分在外电场作用下在SiO2中向Si/SiO2界面漂移,在Si/SiO2界面形成辐射感生界面态。辐射感生氧化层陷阱电荷和界面态密度在达到饱和前,随总剂量增大而增大。辐射感生氧化层陷阱电荷和界面态诱发产生的暗信号使面阵CCD像元势阱中的电荷量增多,因而导致面阵CCD输出一帧暗场图像中各像元的平均灰度值在辐照后增大。试验结果表明星载CCD在空间轨道中运行时,也会随着在轨时间累积导致总剂量增大,诱发面阵CCD相机暗信号增大,影响图像质量。
氧化层陷阱和界面态在半导体能带的禁带中形成的缺陷能级促进了热产生电子-空穴对,从而使暗信号增大。根据图1和图2中试验测试数据拟合计算可得到的辐照前后KD随总剂量增大的变化数据。剂量率为0.1Gy(Si)/s时,不同辐照偏置条件下KD随总剂量增大而增大的变化关系如图4所示。可以看到,当总剂量低于0.1kGy(Si)时,相同总剂量下,加偏置辐照后的KD与不加偏置辐照时相当,这是由于在该剂量率辐照下,当总剂量较小时,辐照损伤不明显;当总剂量高于0.1kGy(Si)时,相同总剂量下,加偏置辐照时的KD明显大于不加偏置辐照时的KD,这是由于加偏置电压时,电场对氧化层中非复合空穴的初始产生以及氧化层中产生电荷的迁移率有影响。不加偏置电压时,电子-空穴对复合增加,从而使被氧化层俘获的因辐射诱发产生的空穴要少一些,对Si/SiO2界面处的界面态产生起重要作用的氢离子也少一些,因而暗信号增大程度也比加偏置电压时小,当总剂量较低时,电离辐射诱发的电子-空穴对浓度要小一些,当总剂量较高时,电离辐射诱发的电子-空穴对浓度较大,因而加偏置电压带来的影响也更显著。剂量率为0.1Gy(Si)/s,积分时间为199.27ms时,不同辐照偏置条件下VD随总剂量增大而增大的变化关系如图5所示。试验结果还表明,当CCD受辐照总剂量达0.20kGy(Si)后,该面阵CCD性能已经受到严重影响,成像质量严重退化。
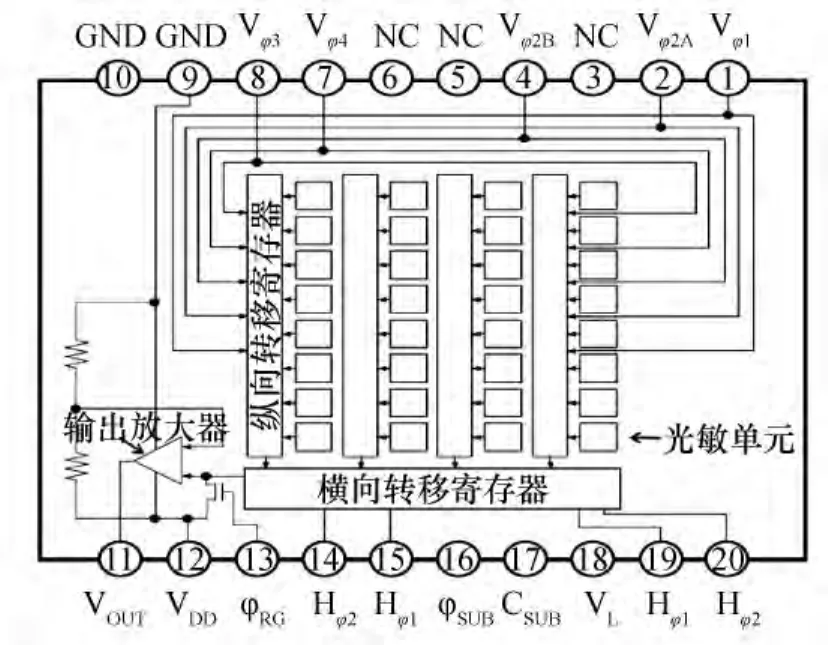
图3 面阵CCD芯片结构示意图Fig.3 Block diagram and pin configuration of the array CCD
面阵CCD的信号电荷需要在光敏区先转移到纵向转移寄存器,然后在纵向时序脉冲驱动电路作用下开始纵向转移,本文中面阵CCD的信号电荷是以行间转移的方式转移到横向转移寄存器,再在横向时序脉冲驱动电路作用下依次进行横向转移,直到信号经过放大器输出(见图3)。较线阵CCD仅进行横向转移相比,面阵CCD的驱动时序需要同时满足纵向驱动和横向驱动,面阵CCD的结构和时序脉冲驱动电路要更复杂,导致辐照诱发产生暗信号的因素增多。总剂量辐照导致面阵CCD的MOS型阵列结构的平带电压和阈值电压漂移,对光敏区和转移区的耗尽层(空间电荷区)大小产生影响,从而使辐照后面阵CCD像元势阱中的暗信号增大,暗信号不均匀性也随之增大。相比较而言,由于线阵CCD结构相对简单,辐射诱发线阵CCD产生的暗信号的因素要少一些,而面阵CCD产生暗信号的区域不仅包含横向转移区,而且包含纵向转移区。
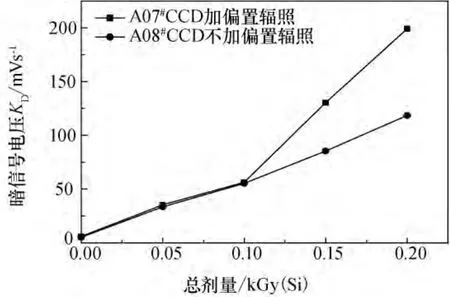
图4 暗信号斜率 (KD)随总剂量的变化Fig.4 Dark signal slope(KD)versus the total dose
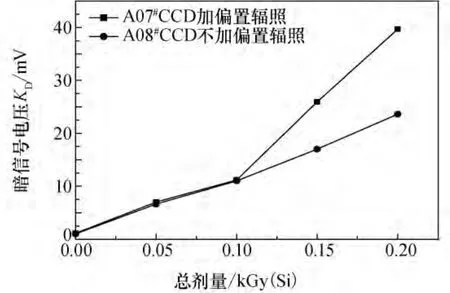
图5 暗信号电压 (VD)随总剂量的变化Fig.5 Dark signal voltage(VD)versus the total dose
电子元器件受电离辐照时,选取的不同辐照剂量率有时也会对辐照损伤带来影响,大量文献报道了双极器件在低剂量率辐照下出现低剂量率增强效应(ELDRS),一般认为双极器件的ELDRS显著,MOS型器件没有表现出ELDRS。CCD作为一种以MOS阵列耦合成像的光电图像传感器,其是否具有ELDRS,目前尚无定论,国内有单位通过开展商用线阵CCD试验认为CCD不存在ELDRS,而是一种时间相关性效应(TDE)[4];国外有研究机构通过开展线阵CCD试验认为CCD存在类似的ELDRS[8]。为此,开展了面阵CCD不同剂量率辐照的初步试验,辐照剂量率分别选取0.000 1、0.000 3、0.001、0.01、0.1和0.5Gy(Si)/s,初步的试验结果如图6所示。图6给出了总剂量为0.2kGy(Si)时,面阵CCD在不加偏置辐照条件下VD随剂量率的变化。初步的试验结果表明:剂量率从0.5Gy(Si)/s减小到0.001Gy(Si)/s时,呈低剂量损伤增强趋势;从0.001Gy(Si)/s减小到0.000 1Gy(Si)/s时,却呈低剂量损伤减弱趋势。通过等时退火测试比较,不同剂量率损伤差异仍然呈现上述规律。初步试验结果所呈现的现象仍需要进一步开展一系列相关辐照试验确认。由于面阵CCD结构复杂,面阵CCD芯片内部集成的输出放大结构易受电离辐照损伤影响,且无法对集成在芯片里的输出放大电路进行辐照屏蔽,导致面阵CCD测试参数受芯片内部输出放大电路辐照损伤的影响。面阵CCD芯片内部集成的输出放大结构受位移损伤的影响较小,从该型号面阵CCD受反应堆中子位移辐照损伤模拟试验结果进一步确认了电离损伤对面阵CCD输出放大结构的损伤对暗信号电压测试的影响。面阵CCD的光敏区和转移区的暗信号,经过输出放大结构输出,各部分均受到不同剂量率辐照损伤差异影响,导致其呈现出较复杂的试验现象规律,这也是目前CCD是否存在ELDRS尚无定论的一个重要原因。深入分析剂量率对CCD辐照损伤的影响,仍需要开展大量的辐照试验和理论研究,相关研究结果将在后续论文中进行讨论。
3.2 暗信号退火
总剂量达0.20kGy(Si)后,积分时间为199.27ms时,不同辐照偏置条件下VD随退火时间变化的关系曲线如图7所示。可以看到,辐照后室温退火,VD的退化程度有所恢复,这主要是由于电离辐照诱发的氧化层陷阱电荷在室温下容易退火,使电离辐照损伤诱发产生的缺陷密度在退火后减小,从而使面阵CCD辐照损伤程度在退火后有一定的恢复。面阵CCD在不同偏置条件下辐照后,经过室温退火,VD均减小,但没有恢复到辐照前的性能,说明电离辐照诱发面阵CCD的VD退化存在永久性损伤。不论是线阵CCD还是面阵CCD,如果退火后,暗信号电压的退化程度有所恢复,但没有恢复到辐照前的状态,则说明电离辐照诱发CCD暗信号电压的退化存在永久性损伤。
辐照后退火测试时间的选取,主要根据研究不同剂量率辐照损伤差异时,较高辐照剂量率辐照后的退火测试时间需要满足与低剂量率辐照到相同总剂量时的等时测试。例如,总剂量辐照到0.20kGy(Si)时,剂量率为0.1Gy(Si)/s时,需要退火约5h后,测试的参数可与剂量率为0.01Gy(Si)/s时进行比较;需要退火约50h后,测试的参数可与0.001Gy(Si)/s时进行比较;需要退火约550h后,测试的参数可与0.000 1Gy(Si)/s时进行比较,通过与低剂量率辐照到相同总剂量时的等时测试,来判定面阵CCD不同剂量率的辐照损伤是否为时间相关性。
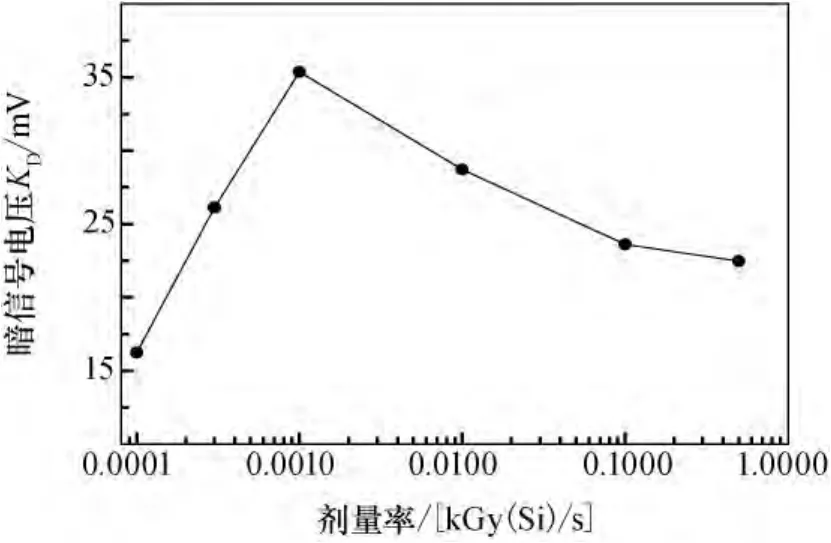
图6 面阵CCD在不加偏置辐照条件下,暗信号电压 (VD)随剂量率的变化Fig.6 Dark signal voltage(VD)of unbiased array CCDs versus the dose rates
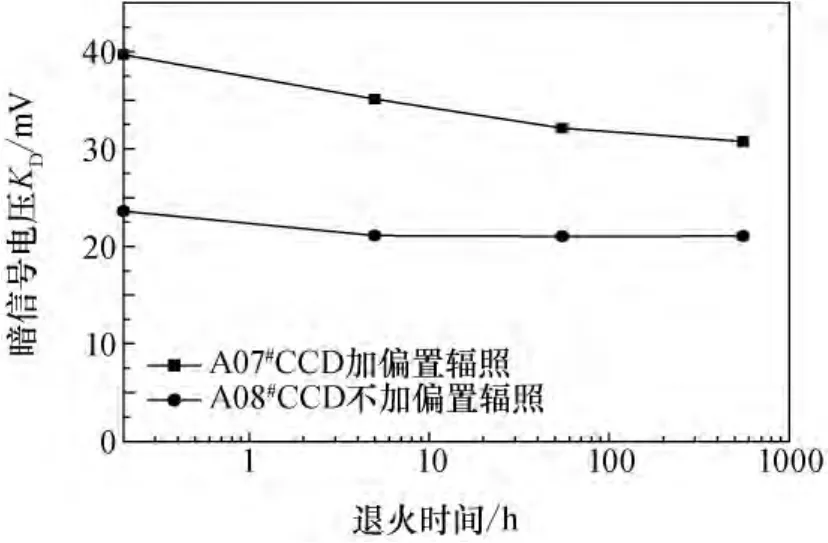
图7 暗信号电压 (VD)在辐照后随退火时间的变化Fig.7 Dark signal voltage (VD)versus the annealing time during irradiation
3.3 暗信号不均匀性
暗信号不均匀性(DSNU)是指在无光照条件下,单位积分时间内CCD光敏区各像元产生的输出信号与输出信号平均值的偏差,通常用VDEV表示。DSNU又称为固定图像噪声。测试前调节测试系统,在无光照条件和规定的积分时间下给器件加上规定的电源电压,使器件处于正常工作状态,设置积分时间,采集F帧信号,测试CCD光敏像元区域内各有效像元输出信号,并计算均方根偏差VDEV。DSNU的计算公式为

式中VDEV为输出信号均方根偏差;M为光敏面像元数;Voi为第i个像元的输出信号值;Vo为器件的输出信号平均值。
A07#CCD加偏置辐照后,在不同总剂量下DSNU随积分时间增大的变化关系曲线如图8所示。可以看到,辐照后DSNU随积分时间增大而增大,总剂量越大,DSNU随积分时间增大而增大程度越显著。
A08#CCD不加偏置辐照后,在不同总剂量下DSNU随积分时间增大的变化关系曲线如图9所示。也可以看到,辐照后DSNU随积分时间增大而增大,总剂量越大,DSNU随积分时间增大而增大程度越显著。
从图8和图9中均可以看到,在相同积分时间下,DSNU均随总剂量增大而增大。在相同总剂量下,加偏置电压辐照时的DSNU比不加偏置电压辐照时要大,这是因为加偏置电压辐照时,暗信号增大程度整体比不加偏置电压辐照时更大,且各个像元暗信号大小差异也比不加偏置电压辐照时更大,导致DSNU也比不加偏置电压辐照时更大。
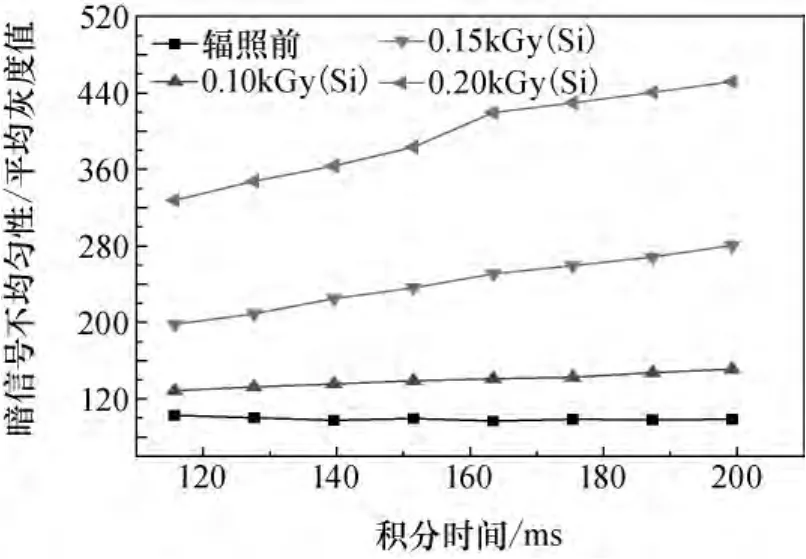
图8 A07#CCD加偏置辐照后,不同总剂量下暗信号不均匀性随积分时间的变化Fig.8 Dark signal no-uniformity(DSNU)versus integration time at the biased condition of A07#CCD during irradiation
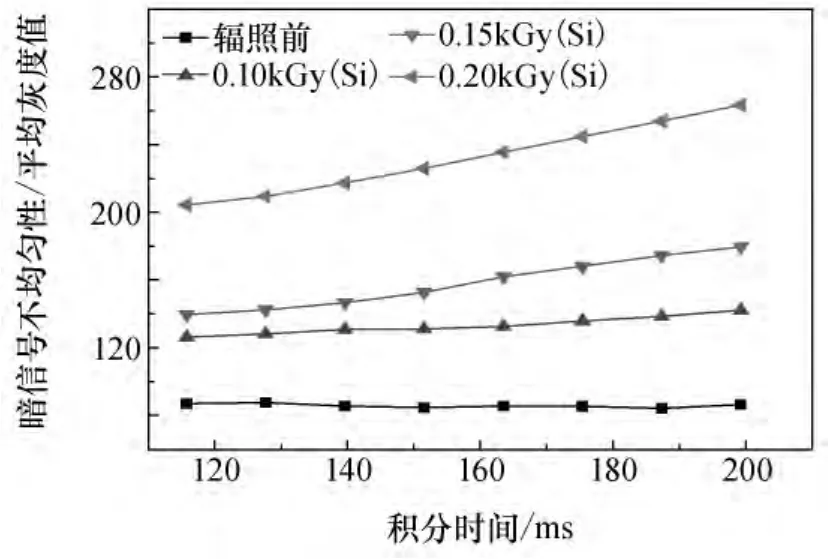
图9 A08#CCD不加偏置辐照后,不同总剂量下暗信号不均匀性随积分时间的变化Fig.9 Dark signal no-uniformity(DSNU)versus integration time at the unbiased condition of A08#CCD during irradiation
4 结束语
通过开展索尼ICX285AL科学级面阵CCD电离辐照试验及辐照后的退火测试,得到了电离辐照诱发面阵CCD暗信号退化的试验规律,试验结果表明:不同偏置条件下辐照后,面阵CCD暗信号退化程度均随总剂量增大而增大,加偏置比不加偏置辐照损伤更严重;室温退火后,暗信号退化程度有所恢复,但仍存在永久性损伤。电离辐照诱发面阵CCD暗信号增大主要归因于辐射感生氧化层陷阱电荷和界面态密度增大引起。辐照后DSNU随积分时间增大而增大,总剂量越大,DSNU随积分时间增大而增大程度越显著。
索尼ICX285AL面阵CCD的电离辐照试验结果还表明:当总剂量达到0.2kGy(Si)时,该型号CCD芯片受电离辐照损伤较严重,在不考虑空间位移损伤影响的前提下,在中高轨道环境中,该型号CCD芯片不超过两年的使用寿命,该型号芯片在低地球轨道环境下使用寿命会相对长一些。上述研究结果为开展星载面阵CCD辐照损伤预估和抗辐照加固防护技术研究提供了理论和试验技术支持。
[1]王祖军,唐本奇,肖志刚,等.质子辐照电荷耦合器件诱导电荷转移效率退化的试验分析 [J].物理学报,2010,59(6):4136-4142.WANG ZUJUN,TANG BENQI,XIAO ZHIGANG,et al.Experimental analysis of charge transfer efficiency degradation of charge coupled devices induced by proton irradiation [J].Acta Physica Sinca,2010,59(6):4136-4142.
[2]肖志刚,唐本奇,李君利,等.中子辐照导致线阵电荷耦合器件电荷转移效率退化试验研究 [J].原子能科学技术,2007,41(1):117-120.XIAO ZHIGANG,TANG BENQI,LI JUNLI,et al.Experimental study on neutron-induced charge transfer degradation of linear charge coupled device [J].Atomic Energy Science and Technology,2007,41(1):117-120.
[3]李豫东,郭旗,陆妩,等.CCD在不同注量率电子辐照下的辐射效应研究 [J].原子能科学技术,2012,46(3):346-350.LI YUDONG,GUO QI,LU WU,et al.Research on electron irradiation damage effects of charge coupled device[J].Atomic Energy Science and Technology,2012,46(3):346-350.
[4]李鹏伟,郭旗,任迪远,等.CCD器件总剂量辐射损伤的剂量率效应 [C]∥第十届全国抗辐射电子学与电磁脉冲学术年会论文集,沈阳:全国抗辐射电子学与电磁脉冲学术委员会,2009:178-185.
[5]WANG ZUJUN,TANG BENQI,XIAO ZHIGANG,et al.Different dose rate radiation effects on linear CCDs[J].IEEE Transcations on Nuclear Science,2010,57(3):1626-1631.
[6]王祖军,张勇,唐本奇,等.TCD132D线阵CCD总剂量效应的试验分析 [J].电子器件,2010,33(1):18-21.WANG ZUJUN,ZHANG YONG,TANG BENQI,et al.Analysis of experiments on total dose radiation effects on TCD132Dlinear CCD [J].Electron Device,2010,33(1):18-21.
[7]钟玉杰,周玉红,雷仁方,等.γ辐照对1024×1152可见光CCD的影响研究 [J].半导体光电,2010,31(6):846-853.ZHONG YUJIE,ZHOU YUHONG,LEI RENFANG,et al.Effects ofγirradiation on 1024×1152CCD [J].Semiconductor Optoelectronics,2010,31(6):846-853.
[8]MARTIN E,DAVID J P,NUNS T,et al.Dose rate and static/dynamic bias effects on CCDs [J].IEEE Transcations on Nuclear Science,2011,58(3):891-898.
