离子辐照缺陷对太赫兹波发射性能的影响
2014-03-22马明旺张增艳赵红卫朱智勇
黄 灿 杨 康 马明旺 海 洋 张增艳 赵红卫 朱智勇
1(中国科学院上海应用物理研究所 嘉定园区 上海 201800)
2(中国科学院大学 北京 100049)
3(中国工程物理研究院电子工程研究所 绵阳 621900)
太赫兹(THz)技术在材料科学、生物成像、反恐等领域有着广阔而重要的应用前景[1−2]。这项技术的巨大潜力促使研究者们努力寻找各种手段来优化太赫兹系统的功能。作为太赫兹系统中最核心的组件,太赫兹发射源的性能对整个系统的功能有着重要的影响,因此,太赫兹发射源的研究一直以来都是人们关注的重点。太赫兹波的发射效率非常显著地依赖于太赫兹波发射材料的性质。通常,人们采用低温生长的砷化镓(LT-GaAs)来制备太赫兹波发射材料。这种材料具有非常高的电阻率(>107Ω·cm)以及很好的载流子迁移率(100−300 cm2·V−1·s−1)[3],能够用于制备优良的太赫兹波发射源。然而,由于低温生长的砷化镓的性质非常敏感地依赖于其生长温度以及退火条件,因而在工业生产中不易有效地控制产品的质量。考虑到离子辐照技术能够通过调控辐照离子的种类、能量以及剂量来调控材料微观结构和宏观性能,人们开始尝试通过离子辐照技术来制备太赫兹波发射所需要的光电导材料[4−7]。已有的研究结果表明,辐照法制备的光电导材料能够具有和低温生长的砷化镓几乎相同的性能。
为了确定制备 THz光电导材料的最佳辐照条件,需要深入认识离子辐照材料产生THz波的内在机理。本工作实验测量了氮离子辐照砷化镓(GaAs)和掺铁磷化铟(InP(Fe))样品的太赫兹波发射性能,并通过数值模拟研究了辐照产生的缺陷对太赫兹波发射性能可能的影响。
1 实验方法
氮离子辐照实验在中国科学院兰州近代物理研究所的320 kV ECR平台上进行。由于飞秒激光在砷化镓与磷化铟晶体中的激发深度大约在1 μm,为了比较不同注入分布下的太赫兹波发射效率,辐照离子的能量分别选择为500 keV和1.5 MeV。图1显示了利用 SRIM[8]软件计算的辐照离子在晶体中的深度分布。从图1中看到,1.5 MeV的氮离子在砷化镓和磷化铟中的射程远超过1 μm的激发深度,而与此同时,500 keV的氮离子注入后则会停留在这一深度范围内。实验所选取的辐照剂量范围在1010−1015ions·cm−2,剂量率为2.1×107ions·cm−2·s−1,束斑大小为2.1 cm2的面积能够完全覆盖样品,辐照时样品的温度保持在50 °C左右。实验所用样品为合肥科晶材料技术有限公司生产的(100)晶面 N型砷化镓和掺铁(0.005%)的磷化铟晶片,厚400 μm,电阻率>107Ω·cm,迁移率>3 500 cm2·V−1·s−1。辐照后在样品的辐照面通过SC 7640型溅射镀膜机镀上两条相距0.4 mm的平行金属线作为THz波发射天线(图2),金属线长约5 mm,线宽0.4 mm。对所制备的光电导天线(PCA)在中国科学院上海应用物理研究所的太赫兹时域光谱仪(THz-TDS,Zomega公司)上作为 THz发射源进行了性能测试。测试采用重复频率为 80 MHz的锁模钛蓝宝石激光器(Mai Tai,光谱物理生产)作为飞秒激光光源,激光功率为0.59 W,中心波长800 nm,激光脉冲宽度约为100fs。

图1 GaAs在不同能量的N辐照时的注入分布情况Fig.1 Range profile of incident ions in GaAs at different implantation energies (SRIM calculation).

图2 氮辐照的砷化镓样品制成光电导天线的表面图Fig.2 Scheme of the photoconductive antenna prepared on N+ ion implanted GaAs surface.
2 计算模拟
为了研究离子注入半导体所产生的缺陷在太赫兹波发射中所起的作用,我们采用蒙特卡罗模拟对不同缺陷条件下光生载流子的超快动力学过程进行了分析。由于光电导天线中太赫兹波的产生是激光激发半导体产生的瞬态光电流所致,而缺陷对于光生载流子的捕获会导致载流子浓度的迅速变化,因此,模拟过程重点关注器件中光生载流子超快的浓度变化。模拟取样时间间隔为5 fs,总模拟时间为2ps,入射激光波长取为800 nm。因空穴的迁移率相比电子要小,因此在模拟中只考虑电子在外加偏置电场下的运动。由于光生载流子是激光激发产生的,载流子在器件中的分布应当依赖于激光能量在器件中的分布。因为激光能量在器件表面分布是高斯型的,而在深度方向的吸收是遵守朗伯比耳定律的指数分布,于是我们将载流子在器件表面的初始分布设置为高斯分布,在深度方向的初始分布设置为指数分布。用5000个超粒子模拟计算了光生载流子的超快变化过程。GaAs的能带结构采用三能谷模型,载流子的散射机制包括极性光学波散射、声学波形变势散射、中性空位散射[9]、等价谷间散射以及不等价谷间散射,在计算中忽略载流子间的相互作用。因光生载流子的浓度远大于材料常态下的载流子浓度,因此在计算中忽略了本底载流子的贡献。
载流子的产生由飞秒激光器的性质与半导体材料的能带结构所决定。根据激光器的功率分布,可取载流子的产生率G(t)为:

式中,I0是入射激光光强;Tcen是激光脉冲中心位置;tlas是激光半高宽。
载流子在偏压下的运动遵守牛顿方程。在运动过程中,光生载流子与晶格和缺陷发生各种散射作用[10]。为了准确反映载流子与缺陷间的相互作用过程,我们引入载流子捕获截面与陷阱浓度来研究不同缺陷对于载流子输运过程的影响。实验上人们通常采用载流子浓度的变化率作为测量值,载流子浓度随时间的变化由式(2)给出[11]:

式中,n是载流子浓度;N是陷阱浓度;

通过考虑不同类型的陷阱捕获截面以及不同的陷阱浓度[12],可以在各个时间抽样点计算得到每一个自由载流子的捕获概率。在整个蒙特卡罗模拟过程中,追踪这一超快过程中所有的光生载流子的产生、定向漂移、散射以及捕获行为。器件所发射的太赫兹电场ETHz与器件中载流子定向漂移形成的光电流的时间微分成正比[13],即:

3 结果与讨论
模拟计算结果显示,器件所发射的太赫兹波的脉冲宽度和峰值电场强度随着GaAs中的陷阱浓度(图 3(a))和陷阱捕获截面(图 3(b))的增大而显著减小。这是由于增大陷阱浓度和捕获截面都会增大载流子的捕获概率,引起载流子浓度的变化,即载流子的浓度会减小,且减小的速率增大,由此导致太赫兹波脉宽和太赫兹波峰值电场强度随之减小。

图3 不同陷阱浓度(a)和不同陷阱捕获截面(b)下计算出的太赫兹波形(a) 捕获截面取为1.3×10−13 cm2,(b) 陷阱浓度取为3×1017 cm−3Fig.3 THz waveform calculated at different trap densities (a) and capture cross sections (b).(a) Capture cross-section: 1.3×10−13 cm2, (b) Trap density: 3×1017 cm−3
对辐照样品的太赫兹波发射能力的实验测量显示,不同剂量辐照的样品所产生的太赫兹波的脉宽基本上没有变化,仅有峰值强度的变化(图4)。而当我们根据SRIM计算出的材料1 μm内的平均缺陷浓度来对样品发射出的太赫兹波峰值电流进行比较时,可以发现,尽管辐照离子的能量不同,但峰值电流却呈现出相似的规律性变化,即发射出的太赫兹波峰值电流仅仅会随着发射层内的缺陷浓度的增加先增大后减小,而与注入离子的能量无关。图 5说明注入的氮离子本身对太赫兹波的发射行为没有影响,关键因素在于发射区域内的缺陷浓度。由图5可见,在本实验条件下,当氮离子辐照产生的缺陷浓度约为3×1017cm−3时,离子辐照GaAs能制备出具有最佳太赫兹发射效率的材料,而对于掺铁磷化铟而言,氮离子辐照制备太赫兹波发射晶体的最佳缺陷浓度约为2.2×1017cm−3。
综合理论计算和实验测量上的太赫兹波发射性能的不同表现,我们推断,在本实验所用的样品中,材料本身所具有的陷阱在 THz波发射性能方面起到了重要的作用,而由氮离子辐照引入的缺陷不能有效地作为载流子捕获陷阱,而只是在此基础上对载流子的输运过程产生了诸如散射等影响,并由此改变了THz波的发射性能。为了分析太赫兹波峰值电流与缺陷浓度的关联,我们计算了不同辐照剂量下所产生的缺陷对载流子散射率的影响,结果如图6所示。
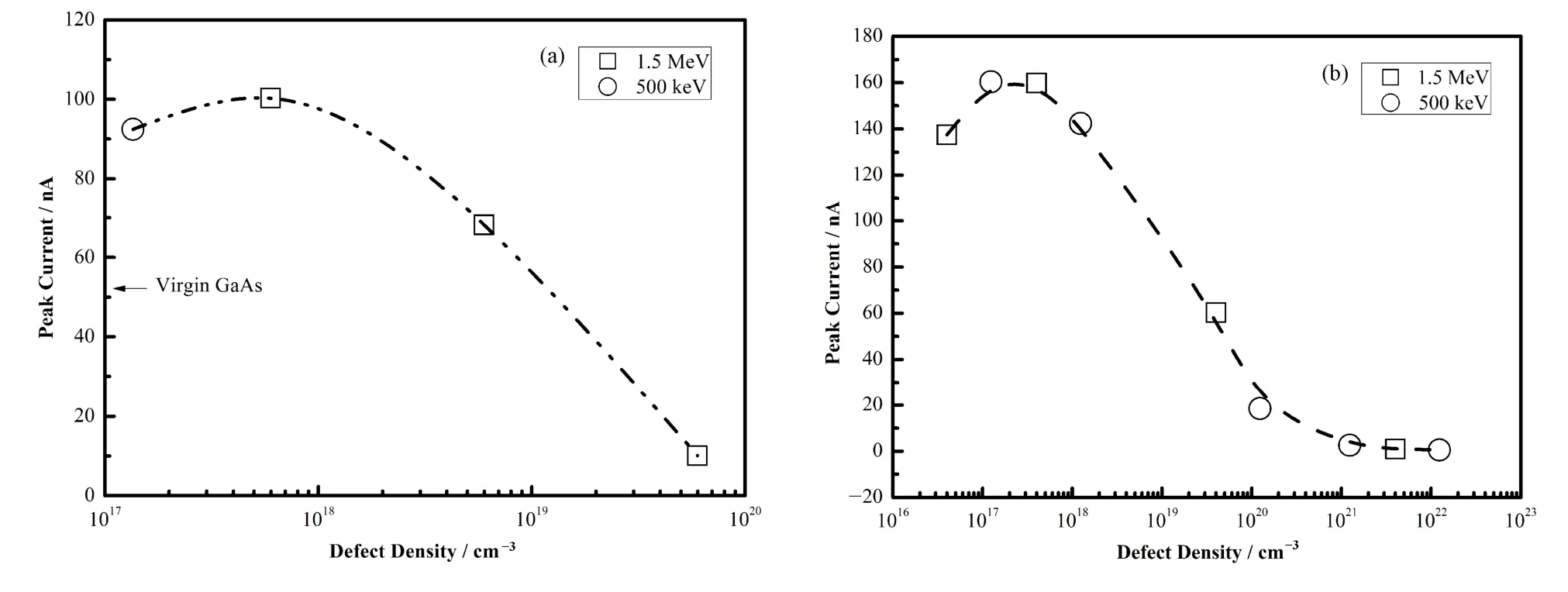
图5 太赫兹波峰值电流与辐照产生的缺陷浓度之间的关系,THz发射区缺陷浓度由SRIM程序计算得到(a) GaAs: 500 keV (1010 cm−3),1.5 MeV (1011 cm−3,1012 cm−3,1013 cm−3),(b) InP(Fe): 500 keV (1010 cm−3,1011 cm−3,1013 cm−3,1014 cm−3,1015 cm−3),1.5 MeV (1010 cm−3,1011 cm−3,1013 cm−3,1015 cm−3)Fig.5 THz peak current as a function of defect density for the 500 keV and 1.5 MeV N+ ion implanted GaAs (a) and Fe-InP (b). Defect densities were calculated by SRIM code. GaAs: 500 keV (1010 cm−3), 1.5 MeV (1011 cm−3, 1012 cm−3, 1013 cm−3),InP(Fe): 500 keV (1010 cm−3, 1011 cm−3, 1013 cm−3, 1014 cm−3, 1015 cm−3), 1.5 MeV (1010 cm−3, 1011 cm−3, 1013 cm−3, 1015 cm−3)

图6 不同剂量辐照后样品中载流子散射率与载流子能量的关系Fig.6 Scattering rate of carriers with different energies at various implantation doses.
由图6可以看到,低能载流子的散射率会随着辐照剂量(即缺陷浓度)的增加而迅速增大。由于峰值电场正比于平均电流除以电流的负荷比[14],而负荷比近似等于光生载流子的寿命与泵浦激光脉冲的时间间隔的比。因此:

式中,J是光电导间隙的平均电流;σ是平均电导率;λ是散射率;n是载流子浓度;Vb是偏压;D是光电导天线的间距;S是间隙的电流截面;Tint是激光脉冲间隔时间;τ是载流子的寿命。由于实验上不同辐照剂量下太赫兹波的脉宽不变(图4),这意味着辐照样品中的光生载流子的寿命不随辐照剂量变化,或者说辐照产生的缺陷的数量还不足以影响载流子的平均寿命。由此可见,本实验所观测到的峰值电流主要由载流子浓度与散射率的比值所决定。由于载流子的浓度与能级有如下关系[15]:

式中,ND是缺陷浓度;NC是导带态密度;gD是简并度;EC是导带能级;ED是缺陷能级。从式(6)看出,载流子浓度随着缺陷浓度的平方根呈正比关系,说明载流子浓度会随着注入剂量增加。而另一方面,如图6所示,载流子的散射率也随着缺陷浓度增加,可见实验所观测到的 THz波峰值信号随辐照剂量的变化是由载流子浓度与其散射强度两个因素相互竞争所致。低剂量下峰值信号的增加可能意味着辐照产生的缺陷的作用更多地增加了载流子浓度,而非增大散射中心的浓度。而在高剂量下时,由辐照所产生的载流子浓度的增加已远不及缺陷散射所产生的影响,这就导致了太赫兹波峰值信号在高剂量下的下降。实际上,太赫兹波峰值信号是增强还是减弱还依赖于本征的载流子浓度和散射中心的数量。如果材料初始状态下已经是处于载流子浓度饱和的状态,那么辐照产生的缺陷就只可能起到增加散射中心的作用。在这种情形下,辐照将会直接导致太赫兹波发射能力的下降。
4 结语
通过蒙特卡罗模拟计算以及实验测量综合研究了离子辐照产生的缺陷对砷化镓和掺铁磷化铟的太赫兹波发射性能的影响。实验结果显示,不同剂量辐照对太赫兹波的脉宽没有影响,仅峰值强度随辐照剂量发生变化,且太赫兹波的峰值电流仅仅依赖于辐照在THz发射区域所产生的缺陷的浓度,说明注入的氮离子本身对太赫兹波的发射行为没有影响。随缺陷浓度的增加,太赫兹波的峰值电流先增加后减小,由此确定氮离子辐照GaAs制备太赫兹波发射材料的最佳缺陷浓度约为3×1017cm−3。而对于掺铁磷化铟而言,氮离子辐照制备太赫兹波发射材料的最佳缺陷浓度约为2.2×1017cm−3。理论计算显示载流子捕获截面和陷阱浓度对载流子浓度的超快变化过程均有很大的影响。由于实验中太赫兹时域谱信号的脉宽并不随样品辐照剂量增加而变化,因此认为,辐照所产生的缺陷不能有效作为陷阱捕获载流子,而只是在材料原有缺陷的基础上影响载流子的数量和散射过程,并由此对材料太赫兹波的发射行为产生影响。
致谢 感谢中国科学院近代物理研究所的 320kV ECR平台的职工以及学生对于辐照实验给予的帮助。
1 Ferguson B, Zhang X C. Materials for terahertz science and technology[J]. Nature Materials, 2002, 1(1): 26−33
2 Siegel P H. Terahertz technology[J]. IEEE Transactions on Microwave Theory and Techniques, 2002, 50(3): 910−928
3 Smith F W, Le H Q, Diadiuk V, et al. Picosecond GaAs-based photoconductive optoelectronic detectors[J]. Applied Physics Letters, 1989, 54(10): 890−892
4 Mayorga I C, Michael E A, Schmitz A, et al. Terahertz photomixing in high energy oxygen- and nitrogen-ionimplanted GaAs[J]. Applied Physics Letters, 2007, 91(3): 031107−031103
5 Liu T A, Tani M, Pan C L. THz radiation emission properties of multienergy arsenic-ion-implanted GaAs and semi-insulating GaAs based photoconductive antennas[J]. Journal of Applied Physics, 2003, 93(5): 2996−3001
6 Salem B, Morris D, Salissou Y, et al. Terahertz emission properties of arsenic and oxygen ion-implanted GaAs based photoconductive pulsed sources[J]. Journal of Vacuum Science and Technology, 2006, 24(3): 774−777
7 Michael E A, Mayorga I C, Gusten R, et al. Terahertz continuous-wave large-area traveling-wave photomixers on high-energy low-dose ion-implanted GaAs[J]. Applied Physics Letters, 2007, 90(17): 171109
8 Ziegler J F, Biersack J P, Littmark U. The stopping power and ranges of ions in matter[M]. Pergamon: Oxford, 1985
9 Loyd-Hughes J, Castro-Camus E, Fraser M D, et al. Carrier dynamics in ion-implanted GaAs studied by simulation and observation of terahertz emission[J]. Physical Review B, 2004, 70(23): 235330
10 叶良修. 小尺寸半导体器件的蒙特卡罗模拟[M]. 北京:科学出版社, 1997
YE Liangxiu. Monte Carlo simulation of small size semiconductor device[M]. Beijing: Science Press, 1997
11 Lax M. Cascade capture of electrons in solids[J]. Physical Review, 1960, 119(5): 1502−1523
12 Martin G M, Mitonneau A, Mircea A. Electron traps in bulk and epitaxial GaAs crystals[J]. Electronics Letters, 1977, 13(7): 191−193
13 Rodriguez G, Taylor A J. Screening of the bias field in terahertz generation from photoconductors[J]. Optics Letters, 1996, 21(14): 1046−1048
14 Masahiko Tani, Michael Herrmann, Kiyomi Sakai. Generation and detection of terahertz pulsed radiation with photoconductive antennas and its application to imaging[J]. Measurement Science & Technology, 2002, 13(11): 1739−1745
15 叶良修. 半导体物理[M]. 北京: 高等教育出版社, 2007
YE Liangxiu. Semiconductor physics[M]. Beijing: Higher Education Press, 2007
