InN的光致发光特性研究*
2013-02-25谢自力
王 健 谢自力 张 荣 张 韵 刘 斌 陈 鹏 韩 平
(南京大学电子科学与工程学院,江苏省光电信息功能材料重点实验室,南京 210093)
(2012年8月29日收到;2013年1月28日收到修改稿)
1 引言
近年来,随着InN的带隙逐渐被证实为0.7 eV[1,2],InN以其本身具有的特殊的物理性质以及潜在的应用价值,正在逐渐受到人们的关注.与其他的Ⅲ族氮化物相比,InN具有最小的电子有效质量、最高的电子迁移率以及最高的饱和电子漂移速度[3-5].随着In组分的改变,InGaN的光谱可以覆盖到整个可见光甚至红外区域,在光电子器件方面有着重要的应用.但是由于InN的生长缺乏晶格常数以及热膨胀系数都匹配的衬底材料,并且由于InN自身较低的分解温度以及生长过程中需要较高的氮平衡蒸汽压,这使得InN的生长变得非常困难.近年来随着生长技术以及生长方法的改进,利用分子束外延(MBE)以及金属有机化学气相淀积(MOCVD)已经可以制备得到高质量的InN薄膜.Wang等采用边界温度控制外延的MBE生长方式生长出迁移率为 3280 cm2·V-1·s-1,载流子浓度为1.47×1017cm-3的高质量的InN薄膜[6].Miller等人证实了在Mg掺杂的InN中,在某一掺杂浓度范围内材料内部会实现p型,但是表面依然是n型,同时根据PL谱推算Mg的掺杂能级在价带之上约70 meV[7].但是由于材料质量的限制,目前对MOCVD制备的InN薄膜性质的研究还相对缺乏.
本文重点研究了利用MOCVD制备的InN薄膜的光致发光(PL)特性,分析了PL谱与半导体带隙以及载流子浓度之间的关系,同时观察了温度对材料发光特性的影响.
2 实验
实验中InN薄膜是采用了Thomas Swan MOCVD生长系统,在α—Al2O3蓝宝石(0001)的衬底上进行的异质外延生长.生长前首先通入NH3,在1150°C的条件下对衬底进行氮化,生长过程采用了两步法:首先在570°C的条件下生长GaN缓冲层,厚度大约为25 nm,然后在605°C的条件下生长InN外延层,生长时间为2.5 h,压强为 300 Torr(1 Torr=1.33322×102Pa),生长厚度大约为300 nm.生长过程中分别采用三甲基Ga(TMGa)、三甲基In(TMIn)和氨气(NH3)作为Ga、In以及N源,载气采用氮气(N2).
实验对InN进行了光致发光研究,采用了傅里叶变换红外光谱仪接受系统,激发光源为532 nm的半导体激光器,探测器为工作于液氮温度下的InSb,其响应波段为1.1—5.4µm.变温过程温度测量采用的是小型铑铁电阻温度计,分辨率为0.1 K.
3 结果与分析
3.1 理论模型
图1给出了本征与简并半导体的能带说明[8],InN本身具有很高的背景电子浓度,费米能级在导带之上,是简并半导体.从图中我们可以得到如下关系:

其中EPL(n)为光激荧光光谱峰值能量,Eg(n)为InN的带隙,EF(n)为费米能级.同时由于能带重整效应所产生的带隙随载流子浓度增加而减小的影响,我们可以得到

其中Eg为本征InN的带隙,当载流子浓度趋近于零时,Eg(n)趋近于Eg·ΔEg(n)为能带重整效应所产生的能带收缩,n为载流子浓度.
3.2 实验结果与讨论

其中γ为与能量有关的参数,对于InN而言,2≤γ≤4,f为费米狄拉克函数.拟合后我们可以得到Eg(n)=0.67 eV,这个值与文献中报道的InN的光学禁带宽度在0.65—0.8 eV的结果一致[10].同时我们可以得到另外两个参数:γ=3.1,EF=0.11 eV.
在各向同性条件下,EF与载流子浓度的关系式为[9]

其中m0为自由电子质量,me为有效电子质量,并且me=0.1m0,这样我们就可以根据上式求出载流子浓度n=5.4×1018cm-3.
通过以上办法,我们实现了在已知InN的PL图谱的情况下求出该InN半导体材料的带隙以及费米能级的位置,并且根据相关公式求出了此载流子浓度,从而找到了PL图与载流子浓度之间的联系.
为了研究InN的光致发光随温度的变化行为,我们测量了样品在13—300 K变温下的PL谱,如图3所示.

图2 低温(13 K)下的InN的PL图谱

图3 InN薄膜从13 K到300 K的变温PL谱
从图中我们可以很明显的看出,随着温度的升高,InN的带边发光峰的强度不断减弱,为了更清楚的看出发光峰位随温度的变化,图4给出了不同温度下发光峰的位置.
可以看出,随着温度的升高,带边发光峰逐渐红移,这种变化可以用下式来解释:

其中Eg(0)为0K下光致发光峰,式中第二项是表现带隙随温度升高而收缩的Varshni项,第三项代表了局域化作用,σE为载流子的局域化能量[11,12].通过拟合我们可以得到Eg(0)=0.77 eV,描述电子声子相互作用对能带影响的γ=0.14 meV,德拜温度β=864 K,与已有文献中的报道值接近[13,14].而拟合得到的σE很小,可以看出此样品中的载流子局域化作用并不明显.值得注意的是,文献中提到InN的发光峰位随温度会有“S”形非单调变化,原因在于InN中随机分布的杂质和缺陷态会产生载流子局域态,在温度较低时,载流子被冻结在局域态的低能量位置,导带和价带带尾的局域态之间的跃迁在光致发光中占主导作用,随着温度升高,热化能量使载流子能够越过局域态势垒成为自由载流子,此时光致发光主要在导带和价带顶之间进行.同时温度升高带来的能带收缩效应也会对InN的光致发光峰位产生影响,故最终会表现为“S”形.但在此我们并没有观察到文献中所提到的发光峰位随温度的“S”形变化,这种现象与我们得到的很小的σE的结果也是符合的.产生这种结果的原因可能是由于我们得到的光致发光光谱图半高宽较宽,使得能量位置的红移以及蓝移变得不明显[15],同时这种差异也可能与载流子浓度以及内建电场强度相关[16].
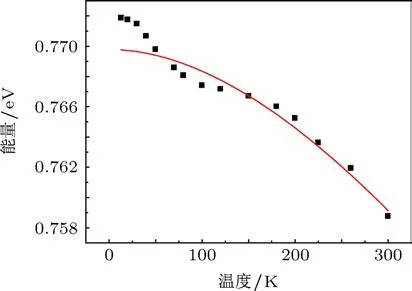
图4 InN的发光峰位随温度的变化
4 结论
本文研究了通过MOCVD制备的InN薄膜的光致发光特性.基于InN本身很高的载流子浓度,利用它的能带结构关系以及相关公式拟合PL图谱,可以得到材料的带隙为0.67 eV以及载流子浓度n=5.4×1018cm-3,从而找到了一种通过PL图求载流子浓度的方法.同时通过测量变温条件下InN的PL图,发现随温度升高发光强度逐渐降低,并且发光峰的位置逐渐红移,这是由于随着温度的升高,带隙逐渐减小所造成的.之所以没有出现文献中提到的“S”形非单调变化,主要是因为实验中得到的光致发光谱的半高宽太高所致.
感谢北京中国科学院半导体研究所半导体材料科学重点实验室的陈涌海教授和叶小玲老师,感谢张世著师兄对本实验的指导以及讨论.
[1]Davydov V Yu,Klochikhin A A,Seisyan R P,Emtsev V V,Ivanov S V,Bechstedt F,Furthmller J,Harima H,MudryiA V,Aderhold J,Semchinova O,Graul J 2002 Phys.Status Solidi(b)229 R1
[2]Wu J,Walukiewicz W,Yu K M,Ager III J W,Haller E E,Lu H,Schaff W J,Yoshiki Saito Yasushi Nanishi 2002 Appl.Phys.Lett.80 3967
[3]Foutz B E,OpLeary S K,Shur M S,Eastman L F 1999 J.Appl.Phys.85 7727
[4]Bockowski M 1999 Phys.B 265 1
[5]Higashiwaki M,Matsui T 2002 Jpn.J.Appl.Phys.41 L540
[6]Wang X Q,Liu S T,Ma N,Feng L,Chen G,Xu F J,Tang N 2012 Appl.Phys.Express 5 015502
[7]Miller N,Ager III J W,Smith III H M,Mayer M A,Yu K M,Haller E E,Walukiewicz W,Schaff W J,Gallinat C,Koblmller G,Speck J S 2010 J.Appl.Phys.107 103712
[8]Masataka Higashiwaki,Toshiaki Matsui 2004 Journalof Crystal Growth 269 162
[9]Davydov V Yu,Klochikhin A A,Emtsev V V,Kurdyukov D A,Ivanov S V,Vekshin V A,Bechstedt F Furthmller J,Aderhold J,Graul J,Mudryi A V,Harima H,Hashimoto A,Yamamoto A,Haller E E 2002 Phys.Stat.Sol.(b)234 787
[10]Bhuiyan A G,Hashimoto A,Yamamoto A 2003 J.Appl.Phys.94 2779
[11]Kuokstis E,Sun W H,Shatalov M,Yang J W,AsifKhan M 2006 Appl.Phys.Lett.88 261905
[12]Bell A,Srinivasan S,Plumlee C,Omiya H,Ponce F A,Christen J,Tanaka S,Fujioka A,Nakagawa Y 2004 J.Appl.Phys.95 4670
[13]Zhang Z,Zhang R,Xie Z L,Liu B,Xiu X Q,LiY,Fu D Y Lu H,Chen P,Han P,Zheng Y D,Tang C G,Chen Y H,Wang Z G 2009 Acta Phys.Sin.58 3416(in Chinese)[张曾,张荣,谢自力,刘斌,修向前,李弋,傅德颐,陆海,陈鹏,韩平,郑有炓,汤晨光,陈涌海,王占国2009物理学报58 3416]
[14]Wu J,Walukiewicz W Shan W,Yu K M,Ager III J W,LiS X,Haller E E,Lu H,Schaff W J 2003 J.Appl.Phys.94 4457
[15]Wu P F 2007 M.S.Dissertation(Taibei:Chung Yuan Christian University)(in Chinese)[吴佩芳2007硕士学位论文(台湾:中原大学)]
[16]LiQ,Xu S J,Xie M H,Tong S Y 2005 J.Phys.:Condens.Matter 17 4853
