栅控横向PNP双极晶体管电离辐射效应
2012-09-23席善斌任迪远王志宽
席善斌 陆 妩 任迪远 王志宽 周 东 文 林 孙 静
1(中国科学院新疆理化技术研究所 乌鲁木齐 830011)
2(新疆电子信息材料与器件重点实验室 乌鲁木齐 830011)
3(中国科学院大学 北京 100049)
4(模拟集成电路国家重点实验室 重庆 400060)
用于空间环境中的微电子器件和电路会受到各种粒子的电离和辐射,电离辐射会导致双极晶体管基极电流增加和电流增益减小。由于双极器件和电路中存在低剂量率辐照损伤增强效应,使其在卫星和航天器上的应用受到了限制[1]。自低剂量率辐照损伤增强效应(ELDRS)发现以来,国内外开展了大量工作,研究双极器件的低剂量率辐照损伤增强效应及其失效机理,但是多数都是对试验现象的定性分析,对感生电荷的定量分离一直是研究的难题[2-5]。自1993年Koiser及其同事利用栅控二极管研究辐照感生电荷[6],到1999年Barnaby提出栅控双极晶体管的研究方法[3,7,8],再到2004年Chen等利用栅控横向 PNP双极晶体管研究双极器件电离辐射效应,虽然对双极器件进行了大量研究,初步提出了电荷分离的有效手段,但是对电荷的定量分离,以及高、低剂量率辐照下双极晶体管中辐照感生电荷变化并没有进行系统、深入地研究[9-17]。在此基础上,我们设计并制作了栅控横向PNP双极晶体管结构,借鉴上述方法研究了国产栅控双极晶体管的电离辐射效应。并对其进行了高、低剂量率辐照下的电荷分离以及栅控与常规 PNP双极晶体管的比对试验。
1 试验样品和方法
试验样品为模拟集成电路国家重点实验室提供的相同工艺条件下加工的常规横向 PNP双极晶体管(LPNP BJTs)和栅控横向 PNP双极晶体管(Gate Controlled Lateral PNP BJTs, GCLPNP BJTs),两种晶体管结构示意图如图1所示,常规横向PNP双极晶体管图1(a)保持主流横向PNP双极晶体管结构和工艺参数不变,栅控横向双极晶体管图1(b)保持与常规双极晶体管结构工艺相同的基础上,在基区表面氧化层上多了一个栅极,其他结构参数保持一致。晶体管P型发射区类似于MOS场效应晶体管的源区,P型集电区类似于MOS场效应晶体管的漏区,双极晶体管的发射极、集电极和基区表面的栅极构成类似于PMOS场效应晶体管的测试结构,如图1(b)中虚线部分所示。通过控制栅极所加电压就可以控制双极晶体管基区表面载流子浓度,由于表面载流子浓度可以控制,那么在保持正向有源偏置的条件下,晶体管就可以在积累、耗尽、反型模式下工作[10,12]。由于栅电极的存在,从而可以让栅控双极晶体管既可以展现出 MOS场效应晶体管的特性,又可以展现出双极晶体管的特性。
国家自然科学基金资助项目(No.10975182)资助
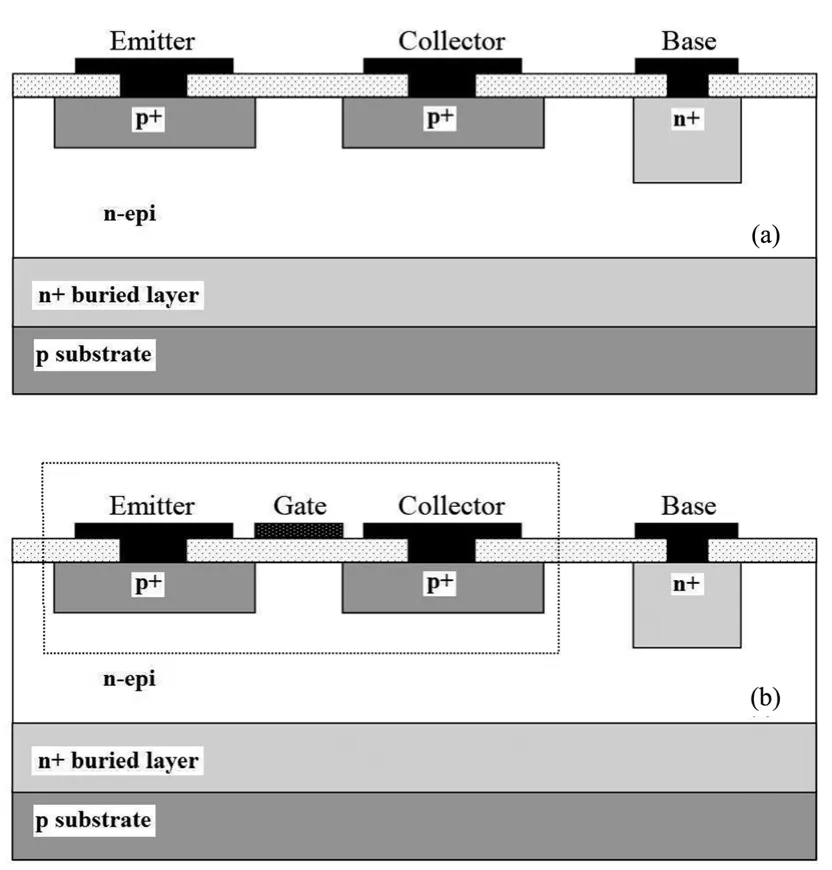
图1 常规横向PNP双极晶体管(a)和栅控横向PNP双极晶体管(b)横断面示意图Fig.1 Representational cross section of normal LPNP BJTs (a)and GCLPNP BJTs (b).
流片加工前,对设计的横向PNP双极晶体管结构进行了Silvaco计算机工艺和器件模拟,提取必要的参数,并获得性能预测结果,两种结构双极晶体管封装在12管脚双列直插式陶瓷管壳内,晶体管管脚独立,性能互不影响。
辐照试验是在中国科学院新疆理化技术研究所的大、小60Co-g辐照源上进行的。辐照总剂量为1000Gy(Si),辐照剂量率用热释光片进行标定,选择美军标规定范围的下限剂量率0.50Gy(Si)/s以及与实际空间低剂量率水平相当的0.10mGy(Si)/s。试验样品放置于依据美军标制作的铅铝屏蔽盒内,以消除低能散射影响,防止剂量增强效应的发生。辐照过程中,对常规和栅控横向PNP双极晶体管加以反向偏置,即基极接+2V,发射极、集电极接地,栅控晶体管栅极也接地,以降低对双极晶体管常规性能影响。
试验采取移位测试的方法,栅控晶体管参数利用Hp4142半导体参数分析仪进行采集,测试参数为:
1) 常规特性:基-射结电压(VBE)、基极电流(IB)、集电极电流(IC)以及电流增益(b);
2) 栅控特性:栅极电压(VGate)、基极电流(IB’)、漏极电流(ID)。
在此需要说明的是,基极电流(IB)是指常规晶体管的电流值,而基极电流(IB’)则是指利用栅扫描法测得随扫描栅压的基极电流值。辐照试验及其参数的测量都是在室温下进行的,每次参数的测试都在辐照或退火后20min内完成。常规晶体管参数测试方法在此不作介绍,栅控特性具体测试方法为:器件工作在正向有源模式下,保持晶体管基射结偏置状态不变,在栅极上加一扫描电压,改变栅极电压,然后测试基极电流(IB’)随栅极电压(VGate)、漏极(集电极)电流(ID)随栅极电压(VGate)的变化情况。
2 试验结果及分析
图2和图3所示为高、低剂量率辐照条件下,常规和栅控横向PNP双极晶体管电流增益变化,从图中可以看出,无论是高剂量率辐照还是低剂量率辐照,常规和栅控横向PNP双极晶体管都对60Co-g辐照表现比较敏感。在相同剂量率辐照条件下,两者对不同总剂量辐照响应相同,都随着总剂量的累积而表现出电流增益单向衰减的现象,衰减幅度基本相同。对比高、低剂量率辐照,可以看出,无论是栅控横向PNP双极晶体管还是常规横向PNP双极晶体管,它们在低剂量率辐照条件下电流增益衰减较高剂量率辐照更为严重,都表现出明显的低剂量率辐照损伤增强效应。

图2 高剂量率辐照常规(a)和栅控(b)横向PNP双极晶体管电流增益变化Fig.2 Current gain of LPNP (a) and GCLPNP (b) BJTs vs VBE under high dose rate irradiation.

图3 低剂量率辐照常规(a)和栅控(b)横向PNP双极晶体管电流增益变化Fig.3 Current gain of LPNP (a) and GCLPNP (b) BJTs vs VBE under low dose rate irradiation.
图(4)和图(5)所示为不同总剂量辐照条件下,高、低剂量率辐照栅控和常规横向PNP双极晶体管基极电流和集电极电流变化。可以看出两种晶体管在相同剂量率辐照条件下,基极电流和集电极电流辐射响应基本相同;在不同剂量率辐照条件下,两种晶体管在低剂量率辐照条件下基极电流变化较高剂量率辐照变化更为明显;集电极电流无论是在高剂量率辐照还是在低剂量率辐照条件下变化都不明显。这一现象也说明了晶体管电离辐照性能衰减主要是由于辐照导致的基极电流增加所造成的。

图4 高剂量率辐照常规(a)和栅控(b)横向PNP双极晶体管基极电流、集电极电流变化Fig.4 IB, IC of LPNP (a) and GCLPNP (b) BJTs vs VBE under high dose rate irradiation.

图5 低剂量率辐照常规(a)和栅控(b)横向PNP双极晶体管基极电流、集电极电流变化Fig.5 IB, IC of LPNP (a) and GCLPNP (b) BJTs vs VBE under low dose rate irradiation.
为了便于分析辐照前后双极晶体管性能变化,在此我们引入两个参数,归一化电流增益和过剩基极电流。归一化电流增益定义为辐照后双极晶体管电流增益b与辐照前电流增益b0的比值b/b0,过剩基极电流定义为辐照前后双极晶体管基极电流的变化量,为DIB=IB Post-rad—
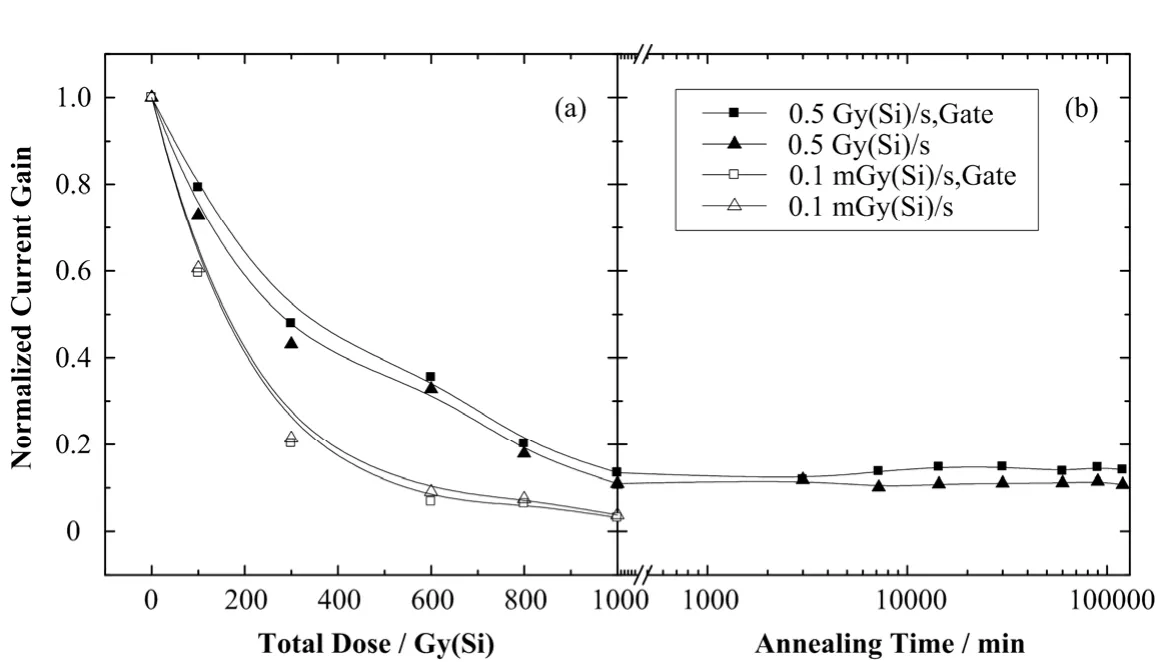
图6 常规和栅控横向PNP双极晶体管归一化电流增益随总剂量(a)和室温退火时间(b)变化Fig.6 b/b0 of LPNP and GCLPNP BJTs vs total dose (a) and post-irradiation annealing time (b).
图6 所示为常规横向PNP双极晶体管和栅控横向 PNP双极晶体管归一化电流增益随60Co-g辐照总剂量和室温退火时间变化关系。图中可以明显看出,常规晶体管和栅控晶体管对辐照响应非常近似,二者曲线变化基本相同,都表现出低剂量率辐照较高剂量率辐照性能衰减更为严重的现象。高剂量率辐照后的室温退火试验过程中,辐照引起晶体管性能损伤恢复程度有限,在长达115天的室温退火过程中,晶体管增益损伤基本没有恢复。

图7 常规和栅控横向PNP双极晶体管过剩基极电流随总剂量(a)和室温退火时间(b)变化Fig.7 DIB of LPNP and GCLPNP BJTs vs total dose (a) and post-irradiation annealing time (b).
图7 所示常规横向PNP双极晶体管和栅控横向PNP双极晶体管过剩基极电流随辐照总剂量和室温退火时间的变化。图7表现出与图6基本相同的变化趋势,常规和栅控PNP双极晶体管低剂量率辐照损伤更为严重,高剂量率辐照后的退火并不能彻底消除辐照引入的损伤。
对比图6和图7我们可以发现,低剂量率辐照导致常规和栅控横向 PNP双极晶体管在总剂量达到 600Gy(Si)以后,归一化电流增益衰减和过剩基极电流增减趋势迅速减缓。可能原因是,低剂量率辐照引入的感生缺陷饱和,或者多数都已经到达Si-SiO2界面形成辐照感生的氧化物陷阱电荷或界面陷阱电荷。图7中高剂量率辐照后的过剩基极电流退火过程中损伤恢复程度较图6归一化电流增益恢复程度明显很多,可能原因是双极晶体管电流增益定义为集电极电流与基极电流的比值即b=IC/IB。虽然退火过程中基极电流减小,表现出过剩基极电流减小的现象,但是如果退火过程中,集电极电流也相应的减小,那么电流增益变化就取决于二者的变化程度,当二者变化程度基本相同时,归一化电流增益就表现出基本不发生变化的现象。
利用栅控双极晶体管来研究常规双极晶体管电离辐射效应、失效机理以及低剂量率辐照损伤增强效应,国外已有初步报导。然而由于国内外半导体工艺之间的差异,国外的科研结果只能对国内研究国产双极晶体管辐射效应具有一定的借鉴经验,而不具有实际的指导意义。利用中带电压法(sub threshold-current technique)定量分离出国产栅控横向 PNP双极晶体管辐照感生的氧化物陷阱电荷和界面陷阱电荷,辐照感生电荷随辐照累积总剂量的变化关系如图8所示[9,14,18]。图中DN、DNot、DNit分别为双极晶体管电离辐照感生的总的陷阱缺陷密度以及氧化物陷阱电荷密度和界面陷阱电荷密度两个分量。图中可以看出,高、低剂量率辐照条件下,双极晶体管中感生的氧化物陷阱电荷和界面陷阱电荷都有明显的差别,正是因为感生电荷的差别才导致了双极器件及电路低剂量率辐照损伤增强效应的产生。

图8 控横向PNP双极晶体管辐照感生缺陷随总剂量(a)和室温退火时间(b)变化Fig.8 Radiation induced defects of GCLPNP BJTs vs total dose (a) and post-irradiation annealing time (b).
3 结论
设计并制作了可用于辐照试验的栅控横向PNP双极晶体管测试结构,并与常规横向PNP双极晶体管进行了高、低剂量率辐照试验以及高剂量率辐照后的室温退火试验。试验结果表明,栅极晶体管和常规晶体管在电流增益、基极电流、集电极电流、归一化电流增益以及过剩基极电流变化上都表现出一致的变化趋势。研究栅控双极晶体管辐照感生缺陷就可以客观反映出常规双极晶体管的辐照感生缺陷变化,利用中带电压法定量分理栅控横向PNP双极晶体管辐照感生的氧化物陷阱电荷和界面陷阱电荷变化,对研究双极晶体管低剂量率辐照损伤增强效应和失效机理具有一定的意义。
1 Enlow E W, Pease R L, Combs W, et al. Response of advanced bipolar processes to ionizing radiation[J]. IEEE Trans Nucl Sci, 1991, 38(6): 1342–1351
2 Fleetwood D M, Kosier S L, Nowlin R N, et al. Physical mechanisms contributing to enhanced bipolar gain degradation at low dose rates[J]. IEEE Trans Nucl Sci,1994, 41(6): 1871–1883
3 Barnaby H J, Cirba C, Schrimpf R D, et al. Minimizing gain degradation in lateral PNP bipolar junction transistors using gate control[J]. IEEE Trans Nucl Sci,1999, 46(6): 1652–1659
4 郑玉展, 陆妩, 任迪远, 等. 不同发射极面积 npn晶体管高低剂量率辐照损伤特性[J]. 物理学报, 2009, 58(8):5572–5577 ZHENG Yuzhan, LU Wu, REN Diyuan, et al.Characteristics of high and low dose rate damage for domestic npn transistors of various emitter areas[J]. Acta Phys Sin, 2009, 58(2): 5572–5577
5 Rashkeev S N, Cirba C R, Fleetwood D M, et al.Physical model for enhanced interface-trap formation at low dose rates[J]. IEEE Trans Nucl Sci, 2002, 49(6):2650–2655
6 Kosier S L, Schrimpf R D, Nowlin R N, et al. Charge separation for bipolar transistors[J]. IEEE Trans Nucl Sci,1993, 40(6): 1276–1285
7 Cazenave P, Fouillat P, Montagner X, et al. Total dose effects on gate controlled lateral PNP bipolar junction transistors[J]. IEEE Trans Nucl Sci, 1998, 45(6):2577–2583
8 Niu G F, Banerjee G, Cressler J D, et al. Electrical probing of surface and bulk traps in proton-irradiated gate-assisted lateral PNP transistors[J]. IEEE Trans Nucl Sci, 1998,45(6): 2361–2365
9 Chen X J, Barnaby H J, Pease R L, et al. Radiation induced base current broadening mechanisms in gated bipolar devices[J]. IEEE Trans Nucl Sci, 2004, 51(6):3178–3185
10 Ball D R, Schrimpf R D, Barnaby H J. Separation of ionization and displacement damage using gate-controlled lateral PNP bipolar transistors[J]. IEEE Trans Nucl Sci,2002, 49(6): 3185–3190
11 Pease R L, Platteter D G, Dunham G W, et al.Characterization of enhanced low dose rate sensitivity(ELDRS) effects using gated lateral PNP transistor structures[J]. IEEE Trans Nucl Sci, 2004, 51(6):3773–3780
12 Minson E, Sanchez I, Barnaby H J, et al. Assessment of gated sweep technique for total dose and dose rate analysis in bipolar oxides[J]. IEEE Trans Nucl Sci, 2004,51(6): 3723–3729
13 Nowlin R N, Pease R L, Platteter D G, et al. Evaluating TM1019.6 ELDRS screening methods using gated lateral PNP transistors[J]. IEEE Trans Nucl Sci, 2005, 52(6):2609–2615
14 Chen X J, Barnaby H J, Pease R L, et al. Estimation and verification of radiation induced Notand Nitenergy distribution using combined bipolar and MOS characterization methods in gated bipolar devices[J] IEEE Trans Nucl Sci, 2005, 52(6): 2245–2251
15 Chen X J, Barnaby H J, Schrimpf R D, et al. Nature of interface defect buildup in gated bipolar devices under low dose rate irradiation[J]. IEEE Trans Nucl Sci, 2006,53(6): 3649–3654
16 Adell P C, Pease R L, Barnaby H J, et al. Irradiation with molecular hydrogen as an accelerated total dose hardness assurance test method for bipolar linear circuits[J]. IEEE Trans Nucl Sci, 2009, 56(6): 3326–3333
17 Hughart D R, Schrimpf R D, Fleetwood D M, et al. The effects of aging and hydrogen on the radiation response of gated lateral PNP bipolar transistors[J]. IEEE Trans Nucl Sci, 2009, 56(6): 3361–3366
18 Mcwhorter P J, Winokur P S. Simple technique for separating the effects of interface traps and trapped‐oxide charge in metal-oxide-semiconductor transistors[J].Appl Phys Lett, 1986, 48(2): 133–135
