测定GaAs(001)衬底上InAs的生长速率
2011-09-27罗子江张毕禅尚林涛邓朝勇贵州大学理学院贵州贵阳550025贵州省微纳电子与软件技术重点实验室贵州贵阳550025贵州财经学院教育管理学院贵州贵阳550004贵州师范大学物理与电子科学学院贵州贵阳550001
郭 祥,罗子江,张毕禅,尚林涛,周 勋,邓朝勇,丁 召(1.贵州大学理学院,贵州贵阳550025;2.贵州省微纳电子与软件技术重点实验室,贵州贵阳550025;3.贵州财经学院教育管理学院,贵州贵阳550004;4.贵州师范大学物理与电子科学学院,贵州贵阳550001)
测定GaAs(001)衬底上InAs的生长速率
郭 祥1,2,罗子江1,3,张毕禅1,2,尚林涛1,2,周 勋1,4,邓朝勇1,2,丁 召1,2
(1.贵州大学理学院,贵州贵阳550025;2.贵州省微纳电子与软件技术重点实验室,贵州贵阳550025;3.贵州财经学院教育管理学院,贵州贵阳550004;4.贵州师范大学物理与电子科学学院,贵州贵阳550001)
报道了间接测定InAs生长速率的方法.通过设置不同Ga源温度,固定In源温度;和固定 Ga源温度,设置不同In源温度,在GaAs(001)衬底上生长 GaAs与InGaAs,用RHEED强度振荡测定GaA s与InGaAs的生长速率.验证了InGaAs的生长速率为GaA s的生长速率与InAs的生长速率之和,得到了In源温度在845~880℃时InAs的生长速率曲线.
MBE;RHEED;GaAs(001)衬底;强度振荡;InA s生长速率
1 引 言
由于InA s与GaA s的晶格失配度达7%,在GaA s(001)衬底上很难直接生长 InAs,所以在GaA s衬底上直接生长 InA s很难准确测量其生长速度.虽然直接在InAs衬底上生长InA s同质外延可以很好地测量InA s生长速率,但是InA s衬底的价格比较昂贵,仅仅为了测量 InA s的生长速率使用InA s衬底生长InA s显得没有必要.
本文从实验的角度出发,通过在 GaA s(001)衬底上生长GaA s和InGaA s,并且用反射式高能电子衍射仪(reflection high energy electron diffraction,RHEED)强度振荡测定 GaA s与 In-GaA s的生长速率.分析实验得到的 GaA s与In-GaA s生长速率的数据,提出了间接测定InA s生长速率的方法,在一定温度范围内获取InA s的生长速率曲线.
2 实 验
2.1 实验条件与准备
实验是在Omicron公司生产的超高真空(极限真空可达4×10-9~8×10-9Pa)分子束外延(molecular beam epitaxy,MBE)生长室中进行的.MBE生长室配备可以进行原位监测的装置RHEED.GaA s(001)衬底是可直接外延的样品,Si掺杂浓度 ND=1.49×1018cm-3.A s源炉是阀控制的裂解A s源,Ga(In,Si)源炉是带挡板的热蒸发 Knudsen式蒸发源炉.
进行本实验之前,利用束流监视器(beam flux monito r,BFM)先对A s(Ga,In)源的等效束流压强(beam equivalent p ressure,BEP)进行校准,得到不同温度下各源的蒸气压;在本实验过程中使用的As BEP为8.5×10-4Pa,并且对衬底温度进行校准,得到温差电偶测量的衬底标称温度对应的实际温度[3](文中的衬底温度 Tsub均是温差电偶标称温度).
2.2 实验过程
首先,对 GaA s(001)衬底脱氧处理60 min(衬底温度 Tsub=430 ℃).生长 GaA s缓冲层30 min(Tsub=420℃,Ga源温度 TGa=1 030℃,Si源温度 TSi=1 150℃),利用RHEED实时监测生长过程,生长完成后原位退火40 min.所有的InAs,GaA s,InGaA s都是在原子级平整的GaA s表面生长.
完成GaA s缓冲层的生长与退火以后,设置衬底温度为360℃,Si源温度为1 150℃.分别在Ga源温度为1 030℃,1 035℃,1 045℃的条件下生长GaA s.每次在360℃完成退火后,在In源温度为845℃时生长InGaA s.在固定的Ga源温度1 045℃下生长 GaA s,每次生长 GaA s在360℃完成退火后,分别在 In源温度为860℃,870℃,875℃,880℃条件下生长InGaA s.每次生长GaA s或InGaAs都用RHEED强度振荡测量生长速率,实时监测生长过程.

表1 GaAs,InAs,In GaAs的生长条件
3 结果与讨论
由于GaA s与InA s的晶格失配度达7%,因此在GaAs(001)衬底上直接生长InA s异质外延时,InA s首先以层状方式进行生长,但生长超过某一临界值时,InA s不再以层状均匀生长,而是进行非均匀的三维生长[4-6].通过RHEED振荡测量其生长速率,得到如图1所示的RHEED强度振荡图,图中在前20 s内有2个不规整的强度振荡周期,20 s后强度急剧下降,这说明InA s在生长了大约2个单层后进入了粗糙化的三维岛状生长,通过RHEED观察到RHEED衍射图像由图2所示的条纹状变成图3所示的网格状斑点.说明表面形貌已经开始粗糙化,表面应该形成了一些InAs三维岛.其他同行在 GaAs衬底上生长InA s量子点,生长到临界厚度大约为1.7个单层开始粗糙化,这与我们的RHEED振荡图像中不到2个周期后强度开始下降一致[5].如果利用图1来计算InA s生长速率,由于只有2个峰,并且2个峰不尖锐,直接测量将引入很大的误差,无法得到准确的生长速率.
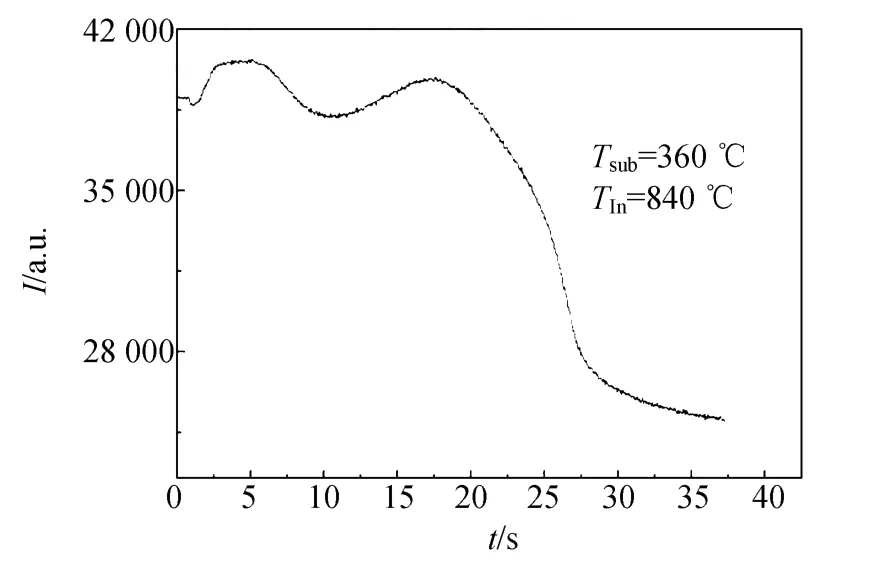
图1 InAs的RHEED强度振荡图

图2 T Ga=1 045℃生长GaA s的RHEED衍射图

图3 InAs[110],[100],方向的RHEED衍射图
在平坦的GaA s缓冲层上生长GaA s得到的RHEED强度振荡如图4所示.从图4中可以看出RHEED强度振荡周期非常均匀,根据振荡图可以算出 GaA s(TGa=1 045℃)的生长速率为0.337 ML/s(每秒0.337个原子单层).由于在衬底标称温度为360℃(实际温度约470℃),A s气压一定的情况下,根据图5[7]可以得到GaA s表面在此条件下应是C(4×4)重构.通过生长结束后的RHEED衍射图(图2)可知,在[110]方向是2×,在[100]方向是4×,在方向是2×,表面是C(4×4)重构与相图的结果相符合[6].

图4 GaAs的RHEED强度振荡图及电子束方向图
在GaA s衬底上生长InGaA s得到RHEED强度振荡图如图6所示,从图中可以看到连续的振荡波形,且周期性很强,这说明InGaA s还是以层状生长,根据振荡图计算出 InGaA s(TGa=1 045℃,TIn=870℃)生长速率为0.464 M L/s.Riposan等在生长InGaA s的实验中发现InGaA s表面是一种同时混有n×3与2×4的混合重构表面,RHEED衍射花样为比较模糊的2×3重构[8].在我们的实验中通过RHEED衍射图7可知,在[110]方向是2×,在[100]方向是1×,在方向是3×,InGaA s表面呈现(2×3)重构与Riposan的实验结果相似.
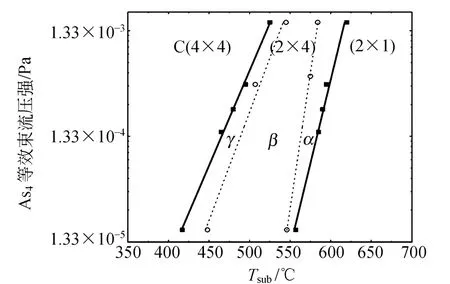
图5 富砷GaA s(001)表面重构相图
实验中,假设在某个确定的 Ga源温度条件下生长GaAs与某个确定的In源温度条件下生长InA s的生长速率之和等于在此 Ga源温度和In源温度条件下生长的InGaA s的生长速率,即


图6 生长InGaAs的RHEED强度振荡图

图7 T Ga=1 045℃,T In=870℃生长InGaA s的RHEED衍射图
仅仅通过1组GaA s与InGaAs生长的速率,还不能说明式(1)的假设成立.如果固定In源温度,在 Ga源温度变化的条件下得到的 vInAs是恒定值,那么可以认为假设是成立的.于是在固定In源温度为870℃的条件下,改变 Ga源温度(1 035℃,1 030℃)得到另外的2组GaA s与In-GaA s的生长速率,通过这3组数据和假设式(1)可以作图8,图中3个温度下的InA s生长速率都非常接近0.13 ML/s,是不随 Ga源温度变化的值.这个不变的值(vInAs=vInGaAs-vGaAs)可以认为是因为In源温度没有变化造成的,而 In源温度及其他生长条件正好是InA s的生长条件(未开Ga源),所以这个差值0.13 M L/s就是 InA s的生长速率.由于在GaA s(001)衬底上生长GaA s,InA s,InGaA s都是在 A s的过压的保护(防止Ga,In挥发)下进行生长的,As处于过剩的状态[9].In束流、Ga束流到达样品表面时有充足的A s与其结合,这样 In与As的结合和 Ga与As的结合可以认为是相互独立的,那么InGaA s的生长速率就是GaA s速率与InA s速率的叠加.

图8 InGaAs,GaAs,InAs的生长速率曲线图
固定Ga源温度为1 045℃,改变In源温度为845,860,870,875,880℃并采用上述方法测量InGaA s和GaA s生长速率得到了InA s的生长速率如图9所示.
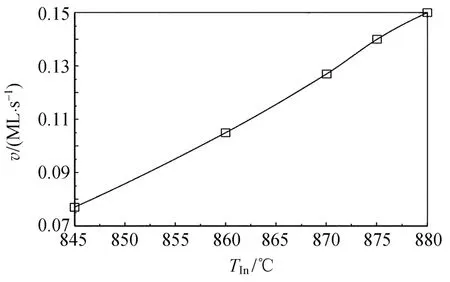
图9 InAs的生长速率曲线图
4 结束语
本文通过在 GaA s(001)衬底上多次生长GaA s与InGaAs,得到了间接测定 InAs生长速率的方法以及在不同In源温度条件下的InA s生长速率.这为在生长InGaA s时,确定InGaAs中In与 Ga的组分提供了一个间接的方法,这种间接测量方法可获得较准确的InA s生长速率.
[1]周勋,杨再荣,罗子江,等.RHEED实时监控的MBE生长 GaAs晶体衬底温度校准及表面相变的研究[J].物理学报,2011,60(1):590-594.
[2]Ramachandran T R,Heitz R,Chen P.Mass transfer in Stranski-Krastanow grow th of InA s on GaA s[J].App l.Phys.Lett.,1997,70(5):640.
[3]Snyder C W,Orr B G,Kessler D,et al.Effect of strain on surface mo rphology in highly strained In-GaAs[J].Phys.Rev.Lett.,1991,66:3032-3035.[4]Patella F,A rcip rete F,Placidi E.Structural study of the InAs quantum-dot nucleation on GaAs(001)[J].App l.Phys.Lett.,2002,81:12.
[5]Joyce PB,Krzyzew ski T J,Bell G R,et al.Composition of InAs quantum dots on GaA s(001):direct evidence for(In,Ga)As alloying[J].Phys.Rev.B,1998,58:R15981-R15984.
[6]LaBella V P,Bullock D W,Emery C.Enabling electron diffraction as a tool fo r determining substrate temperature and surface morphology[J].App l.Phys.Lett.,2001,79:3065.
[7]LaBella V P,Krause M R,Ding Zhao,et al.A rsenic-rich GaAs(001)surface structure[J].Surface Science Repo rts,2005,60:1-53.
[8]Riposan A.Surface reconstructions and mo rphology of InGaAs compound semiconducto r alloys[D].Ann A rbo r:University of M ichigan,2004:43-48.
[9]Xue Qi-Kun,Hashizume T,Sakurai T.Scanning tunneling microscopy of III-V compound semiconducto r(001)surface[J].Surface Science,1997,56(I/2):17-20.
[责任编辑:任德香]
Measuring the growth rate of InAs on GaAs(001)substrate
GUO Xiang1,2,LUO Zi-jiang1,3,ZHANGBi-chan1,2,SHANG Lin-tao1,2,ZHOU Xun1,4,DENG Chao-yong1,2,D ING Zhao1,2
(1.College of Science,Guizhou University,Guiyang 550025,China;2.Key Labo rato ry of M icro-Nano-Electronics of Guizhou Province,Guiyang 550025,China;3.Department of Educational and Management,Guizhou Finance College,Guiyang 550004,China;4.Department of Physics and Electronics,Guizhou Normal University,Guiyang 550001,China)
A n indirect method of measuring the grow th rate of InA s w as repo rted.In this experiment,w ith different Ga source temperatures,fixed In source temperature and fixed Ga source temperature,different In source temperatures,GaA s and InGaA swere grow n on GaA s(001)substrate.The grow th rates of GaA s and InGaA sweremeasured by RHEED oscillation.That the grow th rate of In-GaA swas the sum of that of GaAs and InA swas verified,and the curve of InA s grow th rate v.s.In source temperature between 845℃and 880℃was obtained.
MBE;RHEED;GaA s(001)substrate;intensity oscillation;InA s grow th rate
O484.1
A
1005-4642(2011)01-0011-05
2010-09-07;修改日期:2010-11-08
国家自然科学基金资助项目(No.60886001);贵州省委组织部高层人才科研特助项目(No.TZJF-2008-31);贵州省科技厅基金项目(黔科合J字[2007]2176号);贵州省优秀科技教育人才省长专项基金项目(黔省专合字(2009)114号);教育部新世纪优秀人才支持计划(No.NCET-08-0651);贵州省优秀青年科技人才培养计划(No.[2009]-15)
郭 祥(1987-),男,湖北仙桃人,贵州大学理学院硕士研究生,研究方向为半导体物理与半导体器件物理.
丁 召(1964-),男,贵州都匀人,贵州大学理学院教授,博士,研究方向为表面物理.
